常规IC封装需经过将晶圆与IC封装基板焊接,再将IC基板焊接至普通PCB的复杂过程。与之不同,WLP基于IC晶圆,借助PCB制造技术,在晶圆上构建类似IC封装基板的结构,塑封后可直接安装在普通PCB
2025-05-14 11:08:16 2423
2423 
传苹果(Apple)决定在下一款iPhone上采用扇出型晶圆级封装(Fan-out WLP;FOWLP)技术。由于半导体技术日趋先进,无须印刷电路板(PCB)的封装技术出现,未来恐发生印刷电路板市场逐渐萎缩的现象。
2016-05-06 09:05:33 2138
2138 有一种先进封装技术被称为“晶圆级封装”(WLP),即直接在晶圆上完成集成电路的封装程序。通过该工艺进行封装,可以制成与原裸片大小近乎相同的晶圆。
2020-10-26 15:01:10 1453
1453 技术成为实现系统性能、带宽和功耗等方面指标提升的重要备选方案之一。对目前已有的晶圆级多层堆叠技术及其封装过程进行了详细介绍; 并对封装过程中的两项关键工艺,硅通孔工艺和晶圆键合与解键合工艺进行了分析
2022-09-13 11:13:05 6190
6190 晶圆级封装(Wafer Level Packaging,缩写WLP)是一种先进的封装技术,因其具有尺寸小、电性能优良、散热好、成本低等优势,近年来发展迅速。根据Verified Market
2022-09-15 14:47:39 4770
4770 高端封装制造设备植球机的需求。介绍了晶圆植球这一 3D 封装技术的工艺路线和关键技术,以及研制的这一装备的技术创新点。以晶圆植球机 X - Y - θ 植球平台为例,分析了选型的技术参数。封装技术的研究和植球机的研发,为我国高端芯片封装制造业的同行提供了从技术理论到实践应用的参考。
2022-11-11 09:43:08 3232
3232 先进封装处于晶圆制造与封测的交叉区域 先进封装处于晶圆制造与封测制程中的交叉区域,涉及IDM、晶圆代工、封测厂商。先进封装要求在晶圆划片前融入封装工艺步骤,具体包括应用晶圆研磨薄化、重布线(RDL
2023-08-07 10:59:46 3328
3328 
扇出型晶圆级封装技术采取在芯片尺寸以外的区域做I/O接点的布线设计,提高I/O接点数量。采用RDL工艺让芯片可以使用的布线区域增加,充分利用到芯片的有效面积,达到降低成本的目的。扇出型封装技术完成芯片锡球连接后,不需要使用封装载板便可直接焊接在印刷线路板上,这样可以缩短信号传输距离,提高电学性能。
2023-09-25 09:38:05 3212
3212 
介绍了晶圆级封装的基本流程。本篇文章将侧重介绍不同晶圆级封装方法所涉及的各项工艺。晶圆级封装可分为扇入型晶圆级芯片封装(Fan-In WLCSP)、扇出型晶圆级芯片封装(Fan-Out WLCSP
2023-11-08 09:20:19 11649
11649 
的研究,由深圳市华芯邦科技有限公司(Hotchip)提出,可解决元器件散热、可靠性、成本、器件尺寸等问题,是替代传统封装技术解决方案之一。本文总结了HRP工艺的封装特点和优势,详细介绍其工艺实现路线,为传统封装技术替代提供解决方案。HRP晶圆级先进封装芯片
2023-11-30 09:23:24 3833
3833 
本篇文章将探讨用于晶圆级封装(WLP)的各项材料,从光刻胶中的树脂,到晶圆承载系统(WSS)中的粘合剂,这些材料均在晶圆级封装中发挥着重要作用。
2023-12-15 17:20:36 3691
3691 
在本文中,我们将重点介绍半导体封装的另一种主要方法——晶圆级封装(WLP)。本文将探讨晶圆级封装的五项基本工艺,包括:光刻(Photolithography)工艺、溅射(Sputtering)工艺
2024-01-24 09:39:09 3633
3633 
我们看下一个先进封装的关键概念——晶圆级封装(Wafer Level Package,WLP)。
2025-05-14 10:32:30 1534
1534 
晶圆级扇出封装(FO-WLP)通过环氧树脂模塑料(EMC)扩展芯片有效面积,突破了扇入型封装的I/O密度限制,但其技术复杂度呈指数级增长。
2025-06-05 16:25:57 2152
2152 
具有代表性的技术包括晶圆级封装(WLP)及采用TSV(硅通孔)的硅转接板等,潜藏着新的商机。
2011-08-28 12:17:46 4724
4724 
有人又将其称为圆片级-芯片尺寸封装(WLP-CSP),以晶圆圆片为加工对象,在晶圆上封装芯片。晶圆封装中最关键的工艺为晶圆键合,即是通过化学或物理的方法将两片晶圆结合在一起,以达到密封效果。如下
2021-02-23 16:35:18
晶圆级封装技术Wafer Level Package Technology Board Mounting Application Note for 0.800mm pitch
2009-06-12 23:57:22
晶圆级封装技术源自于倒装芯片。晶圆级封装的开发主要是由集成器件制造厂家(IBM)率先启动。1964年,美国IBM公司在其M360计算器中最先采用了FCOB焊料凸点倒装芯片器件。
2020-03-06 09:02:23
晶圆级封装类型及涉及的产品
2015-07-11 18:21:31
先进封装发展背景晶圆级三维封装技术发展
2020-12-28 07:15:50
晶圆级芯片封装技术是对整片晶圆进行封装测试后再切割得到单个成品芯片的技术,封装后的芯片尺寸与裸片一致。
2019-09-18 09:02:14
` 晶圆级封装是一项公认成熟的工艺,元器件供应商正寻求在更多应用中使用WLP,而支持WLP的技术也正快速走向成熟。随着元件供应商正积极转向WLP应用,其使用范围也在不断扩大。 目前有5种成熟
2011-12-01 14:33:02
`159-5090-3918回收6寸晶圆,8寸晶圆,12寸晶圆,回收6寸晶圆,8寸晶圆,12寸晶圆,花籃,Film Fram Cassette,晶元載具Wafer shipper,二手晶元盒
2020-07-10 19:52:04
RT,请教各位大神BGA植球是用现成的锡球更好吗?钢网刷球与治具植球是并列区分的还是递进同时存在的呢?贴片的话使用贴片机贴片好还是返修条贴片好呢?不考虑效率的话
2017-11-02 14:37:03
晶圆级芯片级封装; 49 bumps; 3.29×3.29×0.54mm(包括背面涂层)
2022-12-06 06:06:48
使用以太网线供电的优势是什么?PoE设备是怎么供电的?POE的关键技术有哪些?
2021-06-10 09:26:50
的安全。下面给大家重点介绍回扫型ESD的新型封装技术CSP: TVS新型封装CSPCSP封装的概念:Chip Scale Package 芯片级封装 (晶圆级封装)WLP (WLP,Wafer
2020-07-30 14:40:36
`本人有多年BGA植球技术,拥有自己专门的BGA手工艺技术,对各类电子产品的工艺 测试 焊接 植球技术以及BGA性能测试都非常熟悉,适用于现国内各种芯片的植球 返修。现主要从事BGA芯片焊接,植球
2017-06-15 11:19:29
`晶圆级封装(WLP)就是在其上已经有某些电路微结构(好比古董)的晶片(好比座垫)与另一块经腐蚀带有空腔的晶片(好比玻璃罩)用化学键结合在一起。在这些电路微结构体的上面就形成了一个带有密闭空腔的保护
2011-12-01 13:58:36
和测试都在晶片上进行。随着晶片尺寸的增大、管芯的缩小,WLP的成本不断降低。作为最早采用该技术的公司,Dallas Semiconductor在1999年便开始销售晶片级封装产品。2 命名规则 业界在
2018-08-27 15:45:31
的若干关键技术问题,并给出了相应的解决思路;首先通过开展电子装备多状态的关联性和继承性研究,实现装备潜在故障可靠性状态的科学评定;然后采取动态融合零失效检测数据和故障信息的方法获取潜隐性故障的小样
2010-05-13 09:08:10
好失望啊,没人回应。再放个岗位吧,要有遥感技术的博士都可找我岗位:卫星数据预处理研究工程师岗位介绍:1、负责卫星地面预处理关键技术研究;2、负责卫星地面预处理系统设计;3、负责预处理系统的持续优化
2014-03-18 16:03:22
固态图像传感器要求在环境大气中得到有效防护。第一代图像传感器安装在带玻璃盖的标准半导体封装中。这种技术能使裸片得到很好的密封和异常坚固的保护,但体积比较庞大,制造成本也比较高。引入晶圆级封装后
2018-12-03 10:19:27
汽车总线及其关键技术的研究
2012-07-10 11:33:28
随着集成电路设计师将更复杂的功能嵌入更狭小的空间,异构集成包括器件的3D堆叠已成为混合与连接各种功能技术的一种更为实用且经济的方式。作为异构集成平台之一,高密度扇出型晶圆级封装技术正获得越来越多
2020-07-07 11:04:42
由于视觉导航技术的应用越来越普及 ,因此 ,有必要对视觉导航中的关键技术及应用进行研究。文章对其中的图像处理技术和定位与跟踪技术进行了详细研究 ,并与此相对应 ,介绍的相关的应用。
2023-09-25 08:09:38
SRAM中晶圆级芯片级封装的需求
2020-12-31 07:50:40
穿过结构连接到封装下侧面的球栅阵列。这种技术能使封装很容易通过汽车环境测试。取消封装中的第二块玻璃晶圆也就去掉了相对昂贵的组件,因此第三代晶圆级封装比第一和第二代方案都要便宜一点。聚合体层也要比被它
2018-10-30 17:14:24
井下救援远距离视频传输系统关键技术研究
本文所涉及的井下救援远距离视频传输系统关键技术研究就是对于井下救援安全性需求所进行的分析、研究和
2008-11-26 08:45:35 1149
1149 市场分析:MEMS封装朝向晶圆级发展
传统的MEMS长期依赖陶瓷封装,虽然行之有效,但MEMS产业已经酝酿向晶圆级封装(WLP)技术转变,而这一转变的部分驱动力则来自于
2009-12-28 10:27:25 987
987 晶圆级封装产业(WLP),晶圆级封装产业(WLP)是什么意思
一、晶圆级封装(Wafer Level Packaging)简介 晶圆级封装(WLP,Wafer Level Package) 的一般定
2010-03-04 11:35:01 46790
46790 SMT行业应用植球技术变得越来越有必要,而EMS企业只有掌握了晶圆级和芯片级封装技术,才能响应OEM客户的要求。本文主要介绍应用在电路板上的植球技术
2011-07-05 12:01:10 5123
5123 本内容给提供了现代雷达信号处理机关键技术仿真
2011-08-26 14:37:11 0
0 混频器设计中的关键技术研究,混频器设计中的关键技术研究
2015-12-21 14:54:45 23
23 基于IPSec的VPN网关关键技术研究..
2016-01-04 15:26:58 10
10 线性调频基带数字产生的关键技术研究,又需要的下来看看
2016-01-15 15:58:20 5
5 高速数控加工的前瞻控制理论及关键技术研究
2016-05-03 13:52:59 14
14 传苹果在2016年秋天即将推出的新款智能型手机iPhone 7(暂订)上,将搭载采用扇出型晶圆级封装(Fan-out WLP;FOWLP)的芯片,让新iPhone更轻薄,制造成本更低。那什么是FOWLP封装技术呢?
2016-05-06 17:59:35 5105
5105 智能电网关键技术研究展望
2017-01-17 19:47:04 16
16 无线传感器网络关键技术研究综述_曹鹏飞
2017-03-15 11:25:16 0
0 微波煤脱硫的关键技术研究
2017-10-18 14:18:30 17
17 微波煤脱硫关键技术研究
2017-11-01 10:12:37 12
12 具有反馈调节功能的电动汽车无线充电关键技术研究
2017-12-07 14:36:33 4
4 具有反馈调节功能的电动汽车无线充电关键技术研究
2017-12-07 14:36:33 1
1 可见光通信及其关键技术研究
2018-04-02 17:08:46 6
6 作为华天集团晶圆级先进封装基地,华天昆山2008年6月落户昆山开发区,研发的晶圆级传感器封装技术、扇出型封装技术、超薄超小型晶圆级封装、晶圆级无源器件制造技术目前已达到世界领先水平。
2021-01-09 10:16:09 5508
5508 总结分析各项能力和政策制度需求得出技术谱系,同无人机反制能力需求树进行对比,得出无人机反制关键技术研究方向。
2021-04-12 11:11:14 2090
2090 在传统晶圆封装中,是将成品晶圆切割成单个芯片,然后再进行黏合封装。不同于传统封装工艺,晶圆级封装是在芯片还在晶圆上的时候就对芯片进行封装,保护层可以黏接在晶圆的顶部或底部,然后连接电路,再将晶圆切成单个芯片。
2022-04-06 15:24:19 12071
12071 晶圆级封装技术可定义为:直接在晶圆上进行大部分或全部的封装、测试程序,然后再进行安装焊球并切割,从而产出一颗颗的IC成品单元。
2022-07-10 11:23:51 2215
2215 晶圆级封装(Wafer Level Packaging,缩写WLP)是一种先进的封装技术,因其具有尺寸小、电性能优良、散热好、成本低等优势,近年来发展迅速。根据Verified Market
2023-02-24 09:35:05 3178
3178 晶圆级芯片尺寸封装-AN10439
2023-03-03 19:57:27 5
5 本应用笔记讨论ADI公司的晶圆级封装(WLP),并提供WLP的PCB设计和SMT组装指南。
2023-03-08 19:23:00 4780
4780 
当的方式为激光解键合。鸿浩半导体设备所生产的UV激光解键合设备具备低温、不伤晶圆等技术特点,并且提供合理的制程成本,十分适合应用于扇出晶圆级封装。 01 扇出晶圆级封装简介 扇出晶圆级封装(Fan Out Wafer Level Packaging, FOWLP,简称扇出
2023-04-28 17:44:43 2743
2743 
本文研究了一种用于5G通信的射频微系统与天线一体化三维扇出型集成封装技术. 通过在玻璃晶圆 上使用双面布线工艺,实现毫米波天线阵列的制作. 将TSV转接芯片与射频芯片倒装焊在玻璃晶圆上,再用树脂材料
2023-05-15 10:39:22 2695
2695 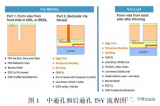
随着半导体工艺的不断进步,封装技术也在逐渐演变。晶圆级封装(Wafer-Level Packaging,WLP)和传统封装技术之间的差异,以及这两种技术在半导体行业的发展趋势和应用领域,值得我们深入了解。
2023-05-12 13:26:05 2457
2457 
量子计算具备可能超越经典计算的潜在能力,近年来在技术研究、应用探索及产业生态培育等方面取得诸多进展,整体发展进入快车道,已成为全球多国科研布局与投资热点。重点梳理分析量子计算关键技术研究进展、应用探索开展态势和产业生态培育等,并对未来发展趋势进行展望。
2023-08-08 11:32:31 2721
2721 
晶圆级封装是在整个晶圆(wafer)的级别上进行封装,而普通封装是在单个芯片级别上进行封装。晶圆级封装通常在晶圆制造完成后,将多个芯片同时封装在同一个晶圆上,形成多个封装单元。相比之下,普通封装将单个芯片分别封装在独立的封装器件上。
2023-08-30 16:44:57 5859
5859 5G通信FBAR滤波器镀膜关键技术研究
2023-09-19 15:25:36 1455
1455 
电子发烧友网站提供《步进电机驱动器的关键技术研究.pdf》资料免费下载
2023-10-09 16:30:07 0
0 晶圆级封装是指晶圆切割前的工艺。晶圆级封装分为扇入型晶圆级芯片封装(Fan-In WLCSP)和扇出型晶圆级芯片封装(Fan-Out WLCSP),其特点是在整个封装过程中,晶圆始终保持完整。
2023-10-18 09:31:05 4921
4921 
扇出型晶圆级封装技术的优势在于能够利用高密度布线制造工艺,形成功率损耗更低、功能性更强的芯片封装结构,让系统级封装(System in a Package, SiP)和3D芯片封装更愿意采用扇出型晶圆级封装工艺。
2023-10-25 15:16:14 2051
2051 
电子发烧友网站提供《基于GPRS无线远程监控系统的关键技术研究.pdf》资料免费下载
2023-10-27 09:09:34 0
0 近年来,随着晶圆级封装技术的不断提升,众多芯片设计及封测公司开始思考并尝试采用晶圆级封装技术替代传统封装。其中HRP(Heat Re-distribution Packaging)晶圆级先进封装工艺技术
2023-11-18 15:26:58 0
0 【科普】什么是晶圆级封装
2023-12-07 11:34:01 2771
2771 
传统封装需要将每个芯片都从晶圆中切割出来并放入模具中。晶圆级封装 (WLP) 则是先进封装技术的一种 , 是指直接封装仍在晶圆上的芯片。
2024-01-12 09:29:13 6843
6843 
共读好书 本篇文章将探讨用于晶圆级封装(WLP)的各项材料,从光刻胶中的树脂,到晶圆承载系统(WSS)中的粘合剂,这些材料均在晶圆级封装中发挥着重要作用。 光刻胶(Photoresists, PR
2024-02-18 18:16:31 2250
2250 
共读好书 在本文中,我们将重点介绍半导体封装的另一种主要方法——晶圆级封装(WLP)。本文将探讨晶圆级封装的五项基本工艺,包括:光刻(Photolithography)工艺、溅射
2024-03-05 08:42:13 3555
3555 
随着微电子技术的飞速发展,集成电路(IC)封装技术也在不断进步,以适应更小、更快、更高效的电子系统需求。焊线封装、晶圆级封装(WLP)和系统级封装(SiP)是三种主流的封装技术,它们在结构、工艺、性能及应用方面各有特点。本文将详细探讨这三种封装技术的区别与应用。
2024-04-07 09:46:15 3450
3450 
直接影响器件与电路的性能及可靠性,现从植球工艺路线、BGA连接器设计要求、植球工艺参数及关键技术、试验及检测要求等几个方面,阐述了影响BGA连接器植球工艺实现的各种因素,借以提高BGA连接器产品的可靠性及稳定性。
2024-07-15 15:42:26 761
761 
在本系列第七篇文章中,介绍了晶圆级封装的基本流程。本篇文章将侧重介绍不同晶圆级封装方法所涉及的各项工艺。晶圆级封装可分为扇入型晶圆级芯片封装(Fan-In WLCSP)、扇出型晶圆级芯片封装
2024-08-21 15:10:38 4450
4450 
领域的关键技术之一。它通过在芯片表面制作金属凸块提供芯片电气互连的“点”接口,广泛应用于FC(倒装)、WLP(晶圆级封装)、CSP(芯片级封装)、3D(三维立体封装
2024-11-14 11:32:18 3022
3022 
晶圆微凸点封装,更常见的表述是晶圆微凸点技术或晶圆级凸点技术(Wafer Bumping),是一种先进的半导体封装技术。以下是对晶圆微凸点封装的详细解释:
2024-12-11 13:21:23 1416
1416 和低成本等优点,成为满足现代电子产品小型化、多功能化和高性能化需求的关键技术。本文将详细解析晶圆级封装的五项基本工艺,包括光刻(Photolithography)工
2025-01-07 11:21:59 3195
3195 
随着半导体技术的飞速发展,晶圆级封装(WLP)作为先进封装技术的重要组成部分,正逐渐成为集成电路封装的主流趋势。在晶圆级封装过程中,Bump工艺扮演着至关重要的角色。Bump,即凸块,是晶圆级封装中
2025-03-04 10:52:57 4980
4980 
经过半年的测试,普莱信智能和某顶级封装厂就其巨量转移式板级封装设备(FOPLP)设备XBonder Pro达成战略合作协议,这将是巨量转移技术在IC封装领域第一次规模化的应用,将掀起晶圆级封装和板级
2025-03-04 11:28:05 1186
1186 
了解晶圆级封装如何进一步提高芯片的连接密度,为后续技术发展奠定基础。
2025-06-27 16:51:51 614
614 圆片级封装(WLP),也称为晶圆级封装,是一种直接在晶圆上完成大部分或全部封装测试程序,再进行切割制成单颗组件的先进封装技术 。WLP自2000年左右问世以来,已逐渐成为半导体封装领域的主流技术,深刻改变了传统封装的流程与模式。
2025-05-08 15:09:36 2068
2068 
在微电子行业飞速发展的背景下,封装技术已成为连接芯片创新与系统应用的核心纽带。其核心价值不仅体现于物理防护与电气/光学互联等基础功能,更在于应对多元化市场需求的适应性突破,本文着力介绍晶圆级扇入封装,分述如下。
2025-06-03 18:22:20 1055
1055 
晶圆级封装中,锡膏是实现电气连接与机械固定的核心材料,广泛应用于凸点制作、植球工艺及芯片 - 基板互连等关键环节。主流采用 SAC 系、Sn-Cu 系、Sn-Bi 系等无铅锡膏,需满足高精度印刷、优异润湿性、高可靠性及低残留等严苛要求。
2025-07-02 11:16:52 1059
1059 
晶圆级封装含扇入型、扇出型、倒装芯片、TSV 等工艺。锡膏在植球、凸点制作、芯片互连等环节关键:扇入 / 扇出型植球用锡膏固定锡球;倒装芯片用其制作凸点;TSV 堆叠靠其实现垂直连接。应用依赖钢网
2025-07-02 11:53:58 947
947 
我将从超薄晶圆浅切多道切割技术的原理、TTV 均匀性控制的重要性出发,结合相关研究案例,阐述该技术的关键要点与应用前景。
超薄晶圆(
2025-07-15 09:36:03 487
487 
在晶圆级封装(WLP)中,Bump 凸点是芯片与基板互连的关键,主流实现方式有电镀法、焊料印刷法、蒸发 / 溅射法、球放置法四类,差异显著。选型需结合凸点密度、成本预算与应用特性,平衡性能与经济性。
2025-10-23 14:49:14 1704
1704 
、核心需求、及技术突破等角度,解析激光微植球技术的应用。一、芯片植球行业背景芯片植球行业主要涉及半导体制造中的高密度表面安装封装技术,包括晶圆植球机和BGA(球栅阵列
2025-11-19 16:26:42 543
543 
本文聚焦晶圆级封装 Bump 制作中锡膏与助焊剂的核心应用,以焊料印刷法、植球法为重点展开。印刷法中,锡膏是凸点主体,需依凸点尺寸选 6/7 号超细粉,助焊剂融入其中实现氧化清除与润湿;植球法里锡膏
2025-11-22 17:00:02 601
601 
扇出型晶圆级封装(FOWLP)的概念最早由德国英飞凌提出,自2016 年以来,业界一直致力于FOWLP 技术的发展。
2026-01-04 14:40:30 199
199 
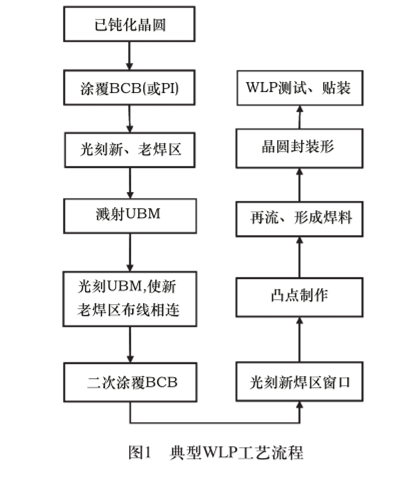

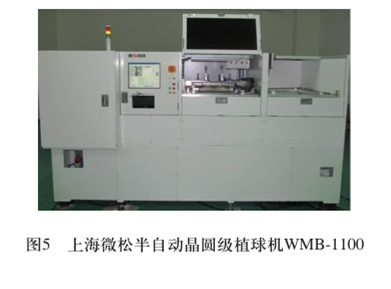
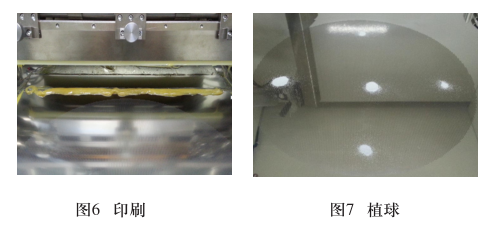
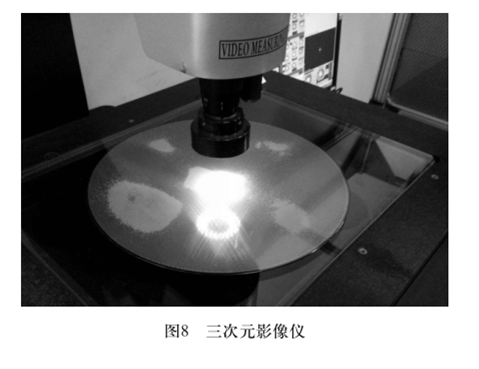
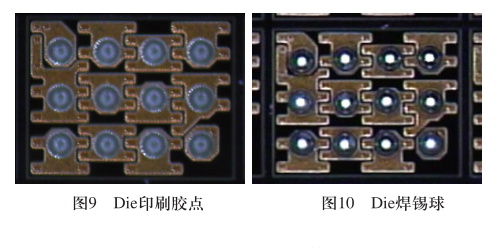
 电子发烧友App
电子发烧友App






















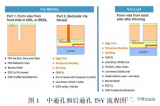




























评论