采用电感耦合等离子体刻蚀法对氮化镓基发光二极管结构进行干法刻蚀,刻蚀气体为氯气,添加气体为三氯化硼。研究了刻蚀气体流量、电感耦合等离子体功率、射频功率和室压等关键工艺参数对氮化镓基发光二极管结构刻蚀
2022-04-26 14:07:28 1775
1775 
等离子体图形化刻蚀过程中,刻蚀图形将影响刻蚀速率和刻蚀轮廓,称为负载效应。负载效应有两种:宏观负载效应和微观负载效应。
2023-02-08 09:41:26 2489
2489 单晶硅刻蚀用来形成相邻晶体管间的绝缘区,多晶硅刻蚀用于形成栅极和局部连线。
2023-02-13 11:13:23 5966
5966 
在干法蚀刻中,气体受高频(主要为 13.56 MHz 或 2.45 GHz)激发。在 1 到 100 Pa 的压力下,其平均自由程为几毫米到几厘米。
2023-06-20 09:49:16 3767
3767 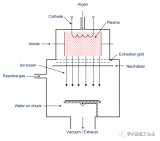
湿法刻蚀由于精度较差,只适用于很粗糙的制程,但它还是有优点的,比如价格便宜,适合批量处理,酸槽里可以一次浸泡25张硅片,所以有些高校和实验室,还在用湿法做器件,芯片厂里也会用湿法刻蚀来显露表面缺陷(defect),腐蚀背面多晶硅。
2023-08-28 09:47:44 908
908 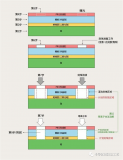
在半导体制程工艺中,有很多不同名称的用于移除多余材料的工艺,如“清洗”、“刻蚀”等。如果说“清洗”工艺是把整张晶圆上多余的不纯物去除掉,“刻蚀”工艺则是在光刻胶的帮助下有选择性地移除不需要的材料,从而创建所需的微细图案。半导体“刻蚀”工艺所采用的气体和设备,在其他类似工艺中也很常见。
2023-09-24 17:42:03 1020
1020 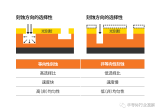
。常见的干法刻蚀设备有反应离子刻蚀机(RIE)、电感耦合等离子体刻蚀机(ICP)、磁性中性线等离子体刻蚀机(NLD)、离子束刻蚀机(IBE),本文目的对各刻蚀设备的结构进行剖析,以及分析技术的优缺点。
2024-01-20 10:24:56 1160
1160 
在半导体加工工艺中,常听到的两个词就是光刻(Lithography)和刻蚀(Etching),它们像俩兄弟一样,一前一后的出现,有着千丝万缕的联系,这一节介绍半导体刻蚀工艺。
2024-01-26 10:01:58 582
582 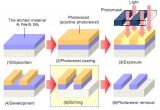
影响深硅刻蚀的关键参数有:气体流量、上电极功率、下电极功率、腔体压力和冷却器。
2024-02-25 10:40:16 19
19 
随着ALD厚度的增加,SiN /基底界面处的孔形状从方形变为圆形,并且逐渐变小。在足够的ALD厚度下,菱形孔的尖端可视度有限,这会导致较低的刻蚀速率且刻蚀保持圆形。
2021-11-15 14:34:30 1697
1697 
的成熟程度也间接决定了产品的良率和吞吐量。 这每一道工序中,都有所需的对应设备,比如光刻所需的EUV、DUV光刻机,刻蚀所需的干法、湿法刻蚀机,以及化学、物理气相沉积所需的CVD、PVD设备等等。光刻机作为半导体制造的核心
2023-07-30 03:24:48 1564
1564 
(干法刻蚀硅)17、 RIE SiO2 (干法刻蚀二氧化硅)18、 RIE Si3N4 (干法刻蚀氮化硅)19、 RIE Al、AlN、Ti、TiN (干法刻蚀金属,包括干法刻蚀铝、干法刻蚀氮化
2015-01-07 16:15:47
AOE刻蚀氧化硅可以,同时这个设备可以刻蚀硅吗?大致的气体配比是怎样的,我这里常规的刻蚀气体都有,但是过去用的ICP,还没有用过AOE刻蚀硅,请哪位大佬指点一下,谢谢。
2022-10-21 07:20:28
新加坡知名半导体晶圆代工厂招聘资深刻蚀工艺工程师和刻蚀设备主管!此职位为内部推荐,深刻蚀工艺工程师需要有LAM 8寸机台poly刻蚀经验。刻蚀设备主管需要熟悉LAM8寸机台。待遇优厚。有兴趣的朋友可以将简历发到我的邮箱sternice81@gmail.com,我会转发给HR。
2017-04-29 14:23:25
蒸发,所以刻蚀要在一个装有冷却盖的密封回流容器中进行。主要问题是光刻胶层经不起刻蚀剂的温度和高刻蚀速率。因此,需要一层二氧化硅或其他材料来阻挡刻蚀剂。这两个因素已导致对于氮化硅使用干法刻蚀技术。蒸汽刻蚀
2018-12-21 13:49:20
半导体光刻蚀工艺
2021-02-05 09:41:23
的加工工艺流程,加工过程中需要运用刻蚀机在晶圆上把复杂的3D图形一层一层“堆叠”起来,实现单片机IC芯片的更小化。芯片,本质上是一片载有集成电路(IC:Integrated circuit)的半导体元件
2018-08-23 17:34:34
台面刻蚀深度对埋栅SITH栅阴击穿的影响针对台面刻蚀深度对埋栅型静电感应晶闸管(SITH)栅阴击穿特性的影响做了实验研究。实验结果表明,随着台面刻蚀深度的增大,器件栅阴击穿由原来的软击穿变为硬击穿
2009-10-06 09:30:24
就能对层上的特定部分进行选择性地移除。在有的情况中,罩的材料为光阻性的,这和光刻中利用的原理类似。而在其他情况中,刻蚀罩需要耐受某些化学物质,氮化硅就可以用来制造这样的“罩”。“干法”(等离子)刻蚀用于
2017-10-09 19:41:52
最近需要用到干法刻蚀技术去刻蚀碳化硅,采用的是ICP系列设备,刻蚀气体使用的是SF6+O2,碳化硅上面没有做任何掩膜,就是为了去除SiC表面损伤层达到表面改性的效果。但是实际刻蚀过程中总是会在碳化硅
2022-08-31 16:29:50
本帖最后由 gk320830 于 2015-3-7 11:21 编辑
释放MEMS机械结构的干法刻蚀技术湿法刻蚀是MEMS 器件去除牺牲材料的传统工艺,总部位于苏格兰的Point 35
2013-11-04 11:51:00
因产品配置不同, 价格货期需要电议, 图片仅供参考, 一切以实际成交合同为准全自动离子刻蚀机 MEL 3100伯东公司日本原装进口全自动离子刻蚀机 MEL 3100
2022-11-07 17:22:14
摘要 利用Cl2/BCl3/CH4电感应耦合等离子体(ICP)干法刻蚀技术,实现了对AlGaInAs,InP材料的非选择性刻蚀。AlGaInAs与InP的刻蚀速率分别为820nm/min与770nm/min,获得了刻蚀深度为4.9μm,垂直光滑的A
2010-11-30 14:58:45 17
17 释放MEMS机械结构的干法刻蚀技术
湿法刻蚀是MEMS 器件去除牺牲材料的传统工艺,总部位于苏格兰的Point 35 Microstructures在SEMICON C
2009-11-18 09:17:32 882
882 干法刻蚀原理
刻蚀作用:去除边缘PN结,防止上下短路。干法刻蚀原理:利用高频辉光放电反应,使CF4气体激活成活性粒子,这些活性
2010-07-18 11:28:20 5650
5650 本文在浅沟槽隔离刻蚀过程中发现,当刻蚀腔室上石英窗口的温度超过85℃时,刻蚀终止出现在300mm晶圆的中心。我们认为刻蚀终止的原因是由于某些低挥发SiOxCly刻蚀产物再淀积。石英
2012-05-04 17:09:37 2810
2810 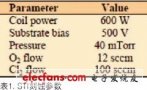
晶体硅太阳能电池生产线刻蚀工序培训 1、刻蚀的作用及方法;2、刻蚀的工艺设备、操作流程及常用化学品;3、主要检测项目及标准;4、常见问题及解决方法;5、未来工艺的发展方向;
2017-09-29 10:29:09 24
24 目前市场上,一台新的干法刻蚀设备使用的射频源售价大概在1万美金左右,而维修一台射频源的费用一般也要1万元人民币以上,可见其费用相当昂贵。本着节约成木的原则,本单位对在使用中出现故障的射频源进行自主
2018-06-08 09:19:00 7416
7416 
钝化层刻蚀对厚铝铝须缺陷影响的研究
2018-03-06 09:02:50 5616
5616 反刻是在想要把某一层膜的总的厚度减小时采用的(如当平坦化硅片表面时需要减小形貌特征)。光刻胶是另一个剥离的例子。总的来说,有图形刻蚀和无图形刻蚀工艺条件能够采用干法刻蚀或湿法腐蚀技术来实现。为了复制硅片表面材料上的掩膜图形,刻蚀必须满足一些特殊的要求。
2018-12-14 16:05:27 68554
68554 深反应离子刻蚀工艺,是实现高深宽比特性的重要方式,已成为微加工技术的基石。这项刻蚀技术在众多领域均得到了应用:1)MEMS电容式惯性传感器;2) 宏观设备的微型化;3) 三维集成电路堆叠技术的硅通孔工艺。
2020-10-09 14:17:35 12760
12760 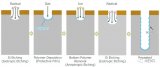
北方华创(Naura)官方宣布,ICP等离子刻蚀机第1000腔交付仪式近日在北京亦庄基地举行,NAURA刻蚀机研发团队见证了这一历史性时刻。
2020-12-11 15:30:09 2183
2183 北方华创(Naura)官方宣布,ICP等离子刻蚀机第1000腔交付仪式近日在北京亦庄基地举行,NAURA刻蚀机研发团队见证了这一历史性时刻。 北方华创表示,这不仅是公司发展征程中的重要里程碑,更是
2020-12-11 15:37:38 2665
2665 摘要:在半导体制造工艺的湿法刻蚀中,用热磷酸刻蚀氮化硅和氮氧化硅是其中一个相对复杂又难以控制的工艺。在这个工艺中,热磷酸刻蚀后的去离子水(DIW)清洗更是一个非常重要的步骤。主要分析了由于去离子水
2020-12-29 14:36:07 2523
2523 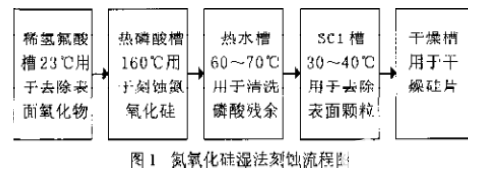
形貌。在优化后的刻蚀工艺条件下GaN材料刻蚀速率达到340nm/min,侧墙倾斜度大于8O。且刻蚀表均方根粗糙度小于3nm。对引起干法刻蚀损伤的因索进行了讨论,并介绍了几种减小刻蚀损伤的方法。 氮化镓(GaN
2020-12-29 14:39:29 2911
2911 
在集成电路的制造过程中,刻蚀就是利用化学或物理方法有选择性地从硅片表面去除不需要的材料的过程。从工艺上区分,刻蚀可以分为湿法刻蚀和干法刻蚀。前者的主要特点是各向同性刻蚀;后者是利用等离子体来进行
2020-12-29 14:42:58 8568
8568 
兼容性好.采用电感耦合等离子体源(inductivelycoupledpla蛐,I凹)技术对金属钛进行三雏深刻蚀,采用不同刻蚀掩模、氯基刻蚀气体,研究了线圈功率、平板功率和娼流量对刻蚀速率和选择比等工艺参数的影响,并对砸深刻蚀参数进行了优化,得到0.
2020-12-29 14:47:00 2385
2385 摘要:简述了在SiC材料半导体器件制造工艺中,对SiC材料采用干法刻蚀工艺的必要性.总结了近年来SiC干法刻蚀技术的工艺发展状况. 半导体器件已广泛应用于各种场合,近年来其应用领域已拓展至许多
2020-12-30 10:30:11 7689
7689 
芯片制造有三大核心环节:薄膜沉积、光刻与刻蚀。其中,光刻环节成本最高,其次便是刻蚀环节。光刻是将电路图画在晶圆之上,刻蚀则是沿着这一图案进行雕刻。这一过程中,会用到的设备便是刻蚀机。
2021-01-18 11:34:22 4048
4048 刻蚀是半导体制造中十分关键的一环,刻蚀通过物理或化学方法将硅片表面不需要的材料去除,从而将掩膜图形正确的复制到涂胶硅片上。
2021-02-23 16:41:57 3386
3386 本文研究了湿化学清洗过程中硅(001)表面形成的天然氧化物的均匀性。均匀性由光激发氟刻蚀初始阶段的表面形貌决定。由于光激发氟蚀刻硅的速度比蚀刻氧化硅快40倍,它突出了硅表面上的硅原生氧化物,使它们
2021-12-30 15:14:12 316
316 
刻蚀机不能代替光刻机。光刻机的精度和难度的要求都比刻蚀机高出很多,在需要光刻机加工的时候刻蚀机有些不能办到,并且刻蚀机的精度十分笼统,而光刻机对精度的要求十分细致,所以刻蚀机不能代替光刻机。
2022-02-05 15:47:00 39932
39932 刻蚀速率是指在刻蚀过程中去除硅片表面材料的速度通常用Å/min表示, 刻蚀窗口的深度称为台阶高度。 为了高的产量, 希望有高的刻蚀速率。 在采用单片工艺的设备中, 这是一个很重要的参数。 刻蚀速率由工艺和设备变量决定, 如被刻蚀材料类型、 蚀机的结构配置、 使用的刻蚀气体和工艺参数设置。
2022-03-15 13:41:59 2921
2921 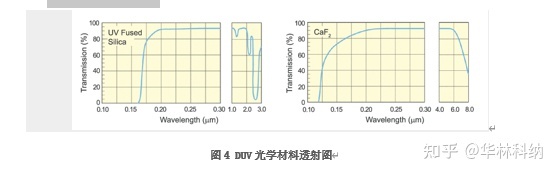
我们研究了碱性刻蚀表面形貌对p型单晶硅片少数寿命的影响,在恒温下分别使用30%和23%的氢氧化钠和氢氧化钾溶液,表面状态通过计算算术平均粗糙度(Ra)和U-V-可见光-近红外光学反射率来表征,而电学
2022-04-24 14:59:54 442
442 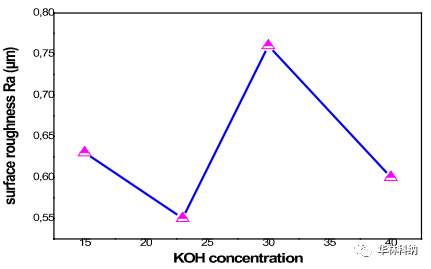
我们测量了硅化物膜(CoSi2、NiSi2、TiSi2和WSi)的溅射刻蚀速率,并研究了离子能量的依赖性,发现它们与二氧化硅薄膜的相对溅射刻蚀速率几乎与溅射离子能量无关,从相对溅射蚀刻速率和计算
2022-05-07 15:41:46 1139
1139 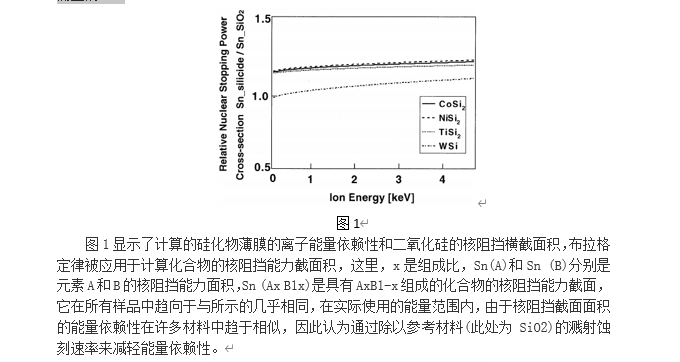
我们华林科纳研究了一种干法各向异性刻蚀石墨和石墨烯的方法,能够通过调整蚀刻参数,如等离子体强度、温度和持续时间,从边缘控制蚀刻,蚀刻过程归因于碳原子的氢化和挥发,蚀刻动力学与甲烷形成一致,这种简单、干净、可控且可扩展的技术与现有的半导体处理技术兼容。
2022-05-19 17:06:46 1785
1785 
刻蚀室半导体IC制造中的至关重要的一道工艺,一般有干法刻蚀和湿法刻蚀两种,干法刻蚀和湿法刻蚀一个显著的区别是各向异性,更适合用于对形貌要求较高的工艺步骤。
2022-06-13 14:43:31 6
6 湿法刻蚀也称腐蚀。硅的湿法刻蚀是 MEMS 加工中常用的技术。其中,各向同性 (Isotropic)湿法刻蚀常用的腐蚀剂是由氢氟酸(HF)、硝酸( HNO3)和乙酸(CH3COOH)组成的混合物
2022-10-08 09:16:32 3605
3605 在 MEMS 制造工艺中,常用的干法刻蚀包括反应离子刻蚀 (Reactive lon Etching, RIE)、深反应离子刻蚀(Deep Reactive lon Etching, DRIE) 和XerF2各向同性蚀刻。
2022-10-10 10:12:15 3290
3290 干法刻蚀工艺流程为,将刻蚀气体注入真空反应室,待压力稳定后,利用射频辉光放电产生等离子体;受高速电子撞击后分解产生自由基,并扩散到圆片表面被吸附。
2022-11-10 09:54:19 3301
3301 湿法刻蚀是集成电路制造工艺最早采用的技术之一。虽然由于受其刻蚀的各向同性的限制,使得大部分的湿法刻蚀工艺被具有各向异性的干法刻蚀替代,但是它在尺寸较大的非关键层清洗中依然发挥着重要的作用。
2022-11-11 09:34:18 7311
7311 每一台刻蚀设备都需做好在最佳条件下运行的准备。我们的刻蚀工艺工程师运用精湛的制造技术,完成这一细节工艺的处理。
2023-01-07 14:08:36 3176
3176 刻蚀是移除晶圆表面材料,达到IC设计要求的一种工艺过程。刻蚀有两种:一种为图形 化刻蚀,这种刻蚀能将指定区域的材料去除,如将光刻胶或光刻版上的图形转移到衬底薄膜 上
2023-02-01 09:09:35 1767
1767 刻蚀速率是测量刻蚀物质被移除的速率。由于刻蚀速率直接影响刻蚀的产量,因此刻蚀速率是一个重要参数。
2023-02-06 15:06:26 4054
4054 湿法刻蚀利用化学溶液溶解晶圆表面的材料,达到制作器件和电路的要求。湿法刻蚀化学反应的生成物是气体、液体或可溶于刻蚀剂的固体。
2023-02-10 11:03:18 4108
4108 刻蚀有三种:纯化学刻蚀、纯物理刻蚀,以及介于两者之间的反应式离子刻蚀(ReactiveIonEtch,RIE)。
2023-02-20 09:45:07 2612
2612 。本研究采用电感耦合等离子体刻
蚀法对氮化镓基发光二极管结构进行干法刻蚀,刻蚀气体为氯气,添加气体为三氯化硼。研究了刻蚀气体流量、电感耦合等离
子体功率、射频功率和室压等关键工艺参数对氮化镓基发光二极管结构刻蚀性
2023-02-22 15:45:41 0
0 从下图中可以看出结合使用XeF2气流和氯离子轰击的刻蚀速率最高,明显高于这两种工艺单独使用时的刻蚀速率总和。
2023-02-23 17:17:20 2717
2717 等离子体最初用来刻蚀含碳物质,例如用氧等离子体剥除光刻胶,这就是所谓的等离子体剥除或等离子体灰化。等离子体中因高速电子分解碰撞产生的氧原子自由基会很快与含碳物质中的碳和氢反应,形成易挥发的co,co2和h2o并且将含碳物质有效地从表面移除。这个过程是在带有刻蚀隧道的桶状系统中进行的(见下图)。
2023-03-06 13:50:48 1081
1081 严重的离子轰击将产生大量的热量,所以如果没有适当的冷却系统,晶圆温度就会提高。对于图形化刻蚀,晶圆上涂有一层光刻胶薄膜作为图形屏蔽层,如果晶圆温度超过150摄氏度,屏蔽层就会被烧焦,而且化学刻蚀速率
2023-03-06 13:52:33 832
832 对于湿法刻蚀,大部分刻蚀的终点都取决于时间,而时间又取决于预先设定的刻蚀速率和所需的刻蚀厚度。由于缺少自动监测终点的方法,所以通常由操作员目测终点。湿法刻蚀速率很容易受刻蚀剂温度与浓度的影响,这种影响对不同工作站和不同批量均有差异,因此单独用时间决定刻蚀终点很困难,一般釆用操作员目测的方式。
2023-03-06 13:56:03 1786
1786 DRAM栅工艺中,在多晶硅上使用钙金属硅化物以减少局部连线的电阻。这种金属硅化物和多晶硅的堆叠薄膜刻蚀需要增加一道工艺刻蚀W或WSi2,一般先使用氟元素刻蚀钧金属硅化合物层,然后再使用氯元素刻蚀多晶硅。
2023-04-07 09:48:16 2230
2230 金属刻蚀具有良好的轮廓控制、残余物控制,防止金属腐蚀很重要。金属刻蚀时铝中如果 有少量铜就会引起残余物问题,因为Cu Cl2的挥发性极低且会停留在晶圆表面。
2023-04-10 09:40:54 2360
2360 压力主要控制刻蚀均匀性和刻蚀轮廓,同时也能影响刻蚀速率和选择性。改变压力会改变电子和离子的平均自由程(MFP),进而影响等离子体和刻蚀速率的均匀性。
2023-04-17 10:36:43 1959
1959 但是,HCl为基体的刻蚀溶液,会严重地侵蚀Ni(Pt)Si或Ni(Pt)SiGe,使金属硅化物阻值升高。这就要求有一种刻蚀剂是无氯基体,而且对Ni(Pt)Si或Ni(Pt)SiGe无伤害、对金属选择性又高。这就是目前常用的高温硫酸和双氧水混合液
2023-05-29 10:48:27 1479
1479 
硅的碱性刻蚀液:氢氧化钾、氢氧化氨或四甲基羟胺(TMAH)溶液,晶片加工中,会用到强碱作表面腐蚀或减薄,器件生产中,则倾向于弱碱,如SC1清洗晶片或多晶硅表面颗粒,一部分机理是SC1中的NH4OH
2023-06-05 15:10:01 1614
1614 光刻工艺后,在硅片或晶圆上形成了光刻胶的图形,下一步就是刻蚀。
2023-06-08 10:52:35 3412
3412 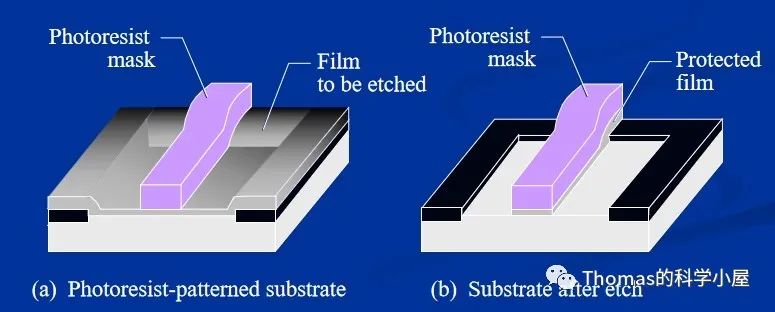
在半导体制程工艺中,有很多不同名称的用于移除多余材料的工艺,如“清洗”、“刻蚀”等。如果说“清洗”工艺是把整张晶圆上多余的不纯物去除掉,“刻蚀”工艺则是在光刻胶的帮助下有选择性地移除不需要的材料,从而创建所需的微细图案。半导体“刻蚀”工艺所采用的气体和设备,在其他类似工艺中也很常见。
2023-06-15 17:51:57 1188
1188 
:使用特定的化学溶液进行化学反应来去除氧化膜的湿法刻蚀,以及使用气体或等离子体的干法刻蚀。1、湿法刻蚀使用化学溶液去除氧化膜的湿法刻蚀具有成本低、刻蚀速度快和生产率高
2022-07-12 15:49:25 1462
1462 
Dimension, CD)小型化(2D视角),刻蚀工艺从湿法刻蚀转为干法刻蚀,因此所需的设备和工艺更加复杂。由于积极采用3D单元堆叠方法,刻蚀工艺的核心性能指数出现波动,从而刻蚀工艺与光刻工艺成为半导体制造的重要工艺流程之一。
2023-06-26 09:20:10 822
822 
第一种是间歇式刻蚀方法(BOSCH),即多次交替循环刻蚀和淀积工艺,刻蚀工艺使用的是SF6气体,淀积工艺使用的是C4F8气体
2023-07-14 09:54:46 3306
3306 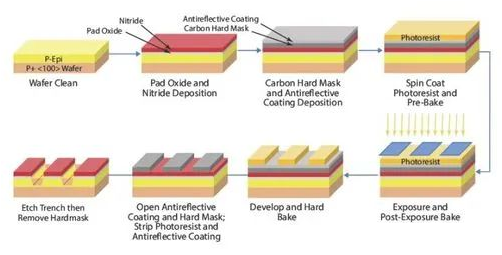
刻蚀(Etching)的目的是在材料表面上刻出所需的图案和结构。刻蚀的原理是利用化学反应或物理过程,通过移除材料表面的原子或分子,使材料发生形貌变化。
2023-08-01 16:33:38 3977
3977 PVP可以在刻蚀过程中形成一层保护性的膜,降低刻蚀剂对所需刻蚀材料的腐蚀作用。它可以填充材料表面的裂缝、孔洞和微小空隙,并防止刻蚀剂侵入。这样可以减少不需要的蚀刻或损伤,提高刻蚀的选择性。
2023-08-17 15:39:39 2916
2916 9月17日,北方华创在投资者互动平台表示,公司前期已经发布了首台国产12英寸CCP晶边干法刻蚀设备研发成功有关信息,目前已在客户端实现量产,其优秀的工艺均匀性、稳定性赢得客户高度评价。
2023-09-20 10:09:49 562
562 在半导体制造中,刻蚀工序是必不可少的环节。而刻蚀又可以分为干法刻蚀与湿法刻蚀,这两种技术各有优势,也各有一定的局限性,理解它们之间的差异是至关重要的。
2023-09-26 18:21:00 3375
3375 
有过深硅刻蚀的朋友经常会遇到这种情况:在一片晶圆上不同尺寸的孔或槽刻蚀速率是不同的。
2023-10-07 11:29:17 1506
1506 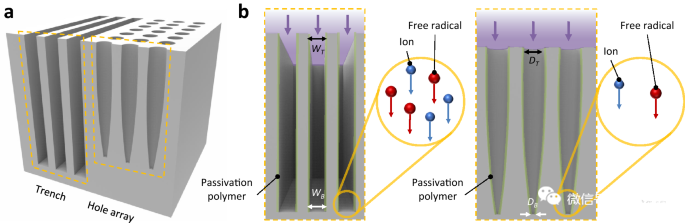
刻蚀(或蚀刻)是从晶圆表面去除特定区域的材料以形成相应微结构。但是,在目标材料被刻蚀时,通常伴随着其他层或掩膜的刻蚀。
2023-10-07 14:19:25 2125
2125 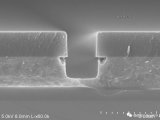
但是,在刻蚀SOI衬底时,通常会发生一种凹槽效应,导致刻蚀的形貌与预想的有很大出入。那么什么是凹槽效应?什么原因引起的?怎么抑制这种异常效应呢?
2023-10-20 11:04:21 471
471 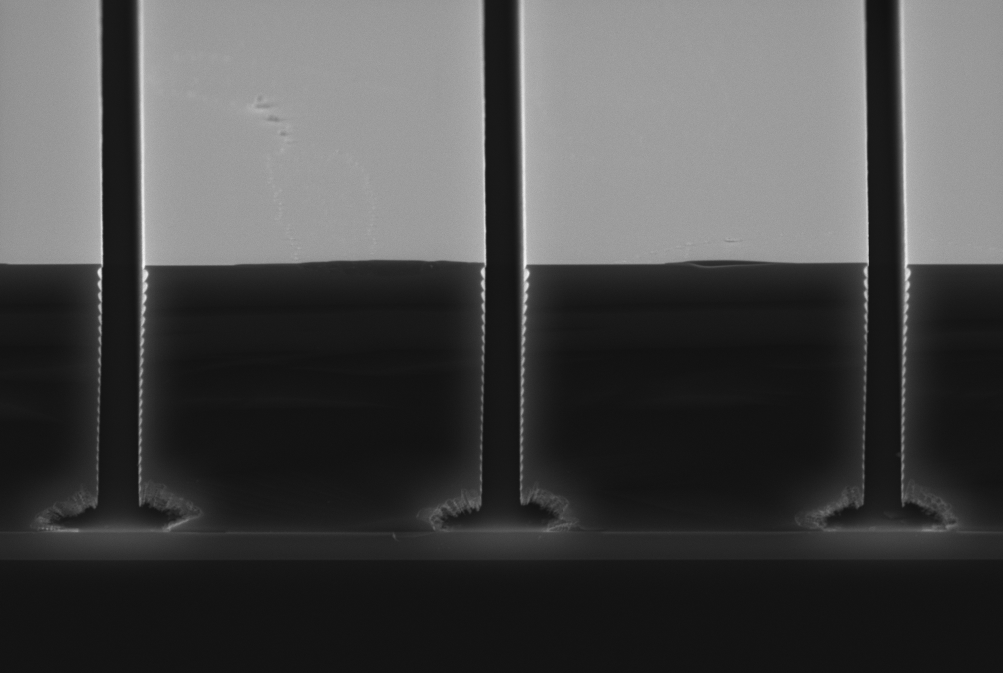
据工信部网站11月16日消息,工信部公开征集了《半导体设备 集成电路制造用干法刻蚀设备测试方法》等196个行业标准、1个行业标准外文版、38个推荐性国家标准计划项目的意见。
2023-11-16 17:04:49 655
655 
半导体前端工艺(第四篇):刻蚀——有选择性地刻蚀材料,以创建所需图形
2023-11-27 16:54:26 259
259 
湿法刻蚀由于成本低、操作简单和一些特殊应用,所以它依旧普遍。
2023-11-27 10:20:17 470
470 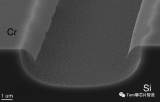
W刻蚀工艺中使用SF6作为主刻步气体,并通过加入N2以增加对光刻胶的选择比,加入O2减少碳沉积。在W回刻工艺中分为两步,第一步是快速均匀地刻掉大部分W,第二步则降低刻蚀速率减弱负载效应,避免产生凹坑,并使用对TiN有高选择比的化学气体进行刻蚀。
2023-12-06 09:38:53 1642
1642 该专利详细阐述了一种针对含硅有机介电层的高效刻蚀方法及相应的半导体工艺设备。它主要涉及到通过交替运用至少两个刻蚀步骤来刻蚀含硅有机介电层。这两个步骤分别为第一刻蚀步骤和第二刻蚀步骤。
2023-12-06 11:58:16 381
381 
在红外探测器的制造技术中,台面刻蚀是完成器件电学隔离的必要环节。
2024-01-08 10:11:01 213
213 
对DRIE刻蚀,是基于氟基气体的高深宽比硅刻蚀技术。与RIE刻蚀原理相同,利用硅的各向异性,通过化学作用和物理作用进行刻蚀。不同之处在于,两个射频源:将等离子的产生和自偏压的产生分离
2024-01-14 14:11:59 541
541 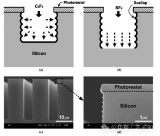
使用SEMulator3D®工艺步骤进行刻蚀终点探测 作者:泛林集团 Semiverse Solutions 部门软件应用工程师 Pradeep Nanja 介绍 半导体行业一直专注于使用先进的刻蚀
2024-01-19 16:02:42 136
136 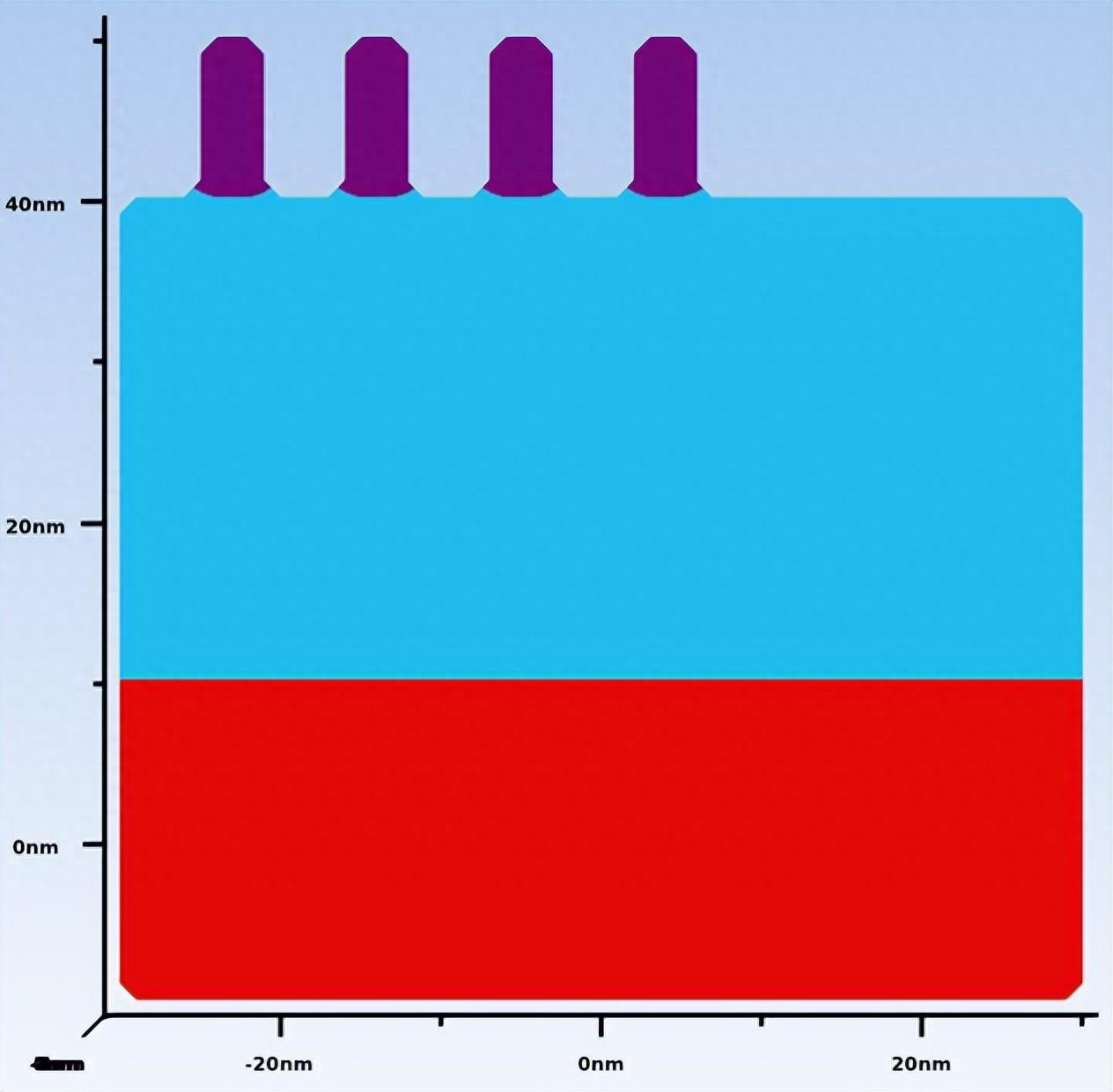
影响深硅刻蚀的关键参数有:气体流量、上电极功率、下电极功率、腔体压力和冷却器。
2024-02-25 10:44:39 312
312 
刻蚀机的刻蚀过程和传统的雕刻类似,先用光刻技术将图形形状和尺寸制成掩膜,再将掩膜与待加工物料模组装好,将样品置于刻蚀室内,通过化学腐蚀或物理磨蚀等方式将待加工物料表面的非掩膜区域刻蚀掉,以得到所需的凹槽和沟槽。
2024-03-11 15:38:24 572
572 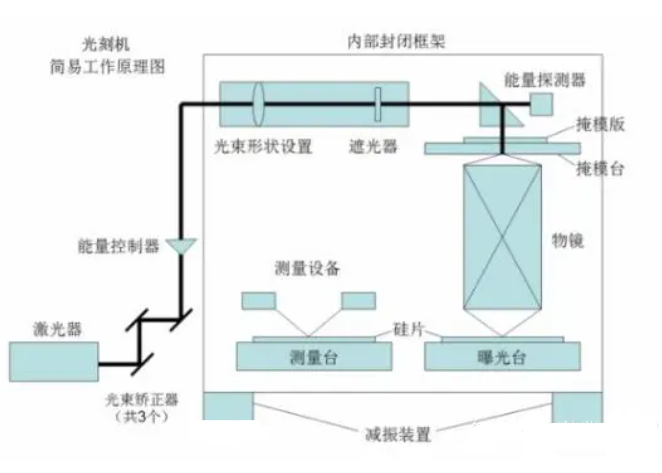
正在加载...
 电子发烧友App
电子发烧友App






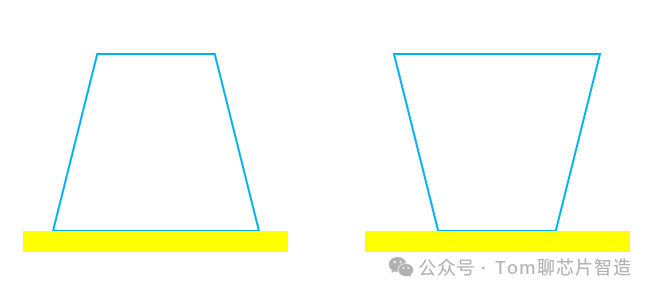








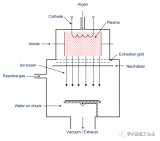
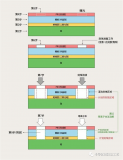
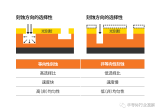

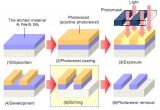














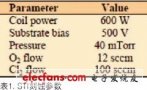

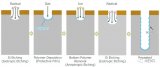
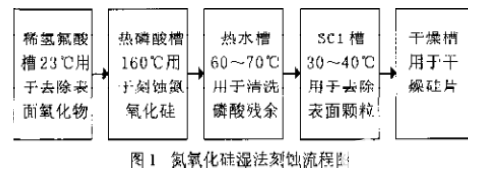




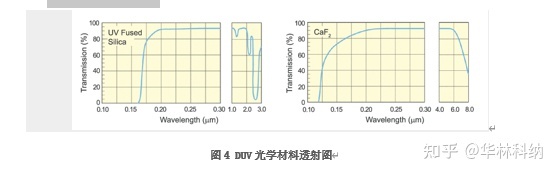
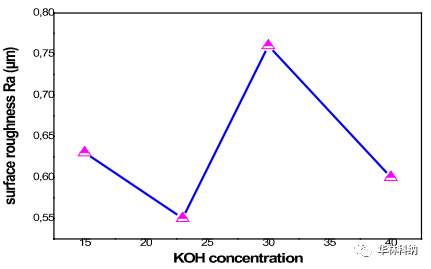
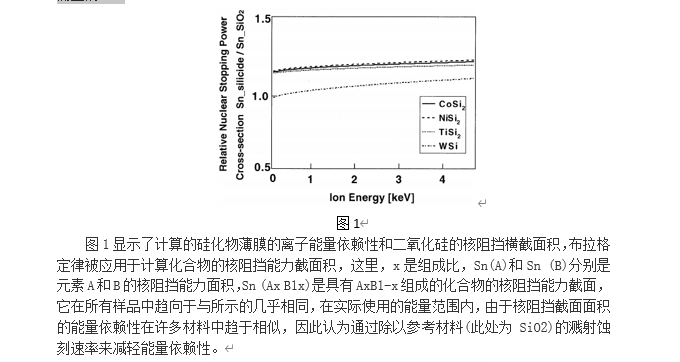


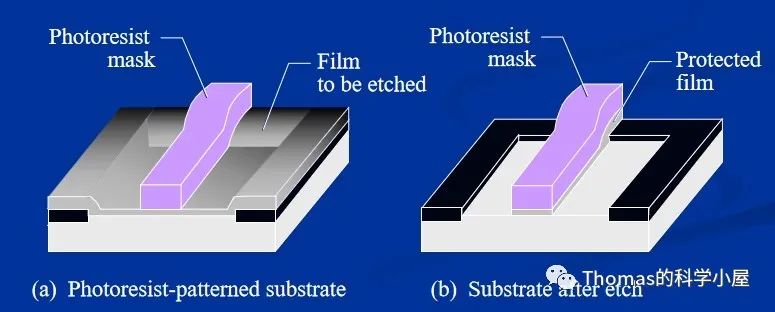



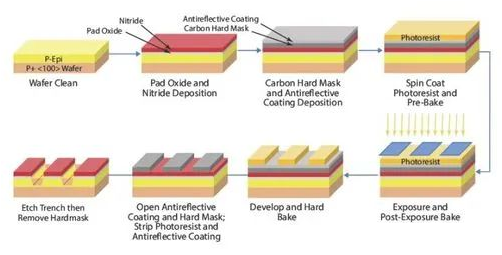

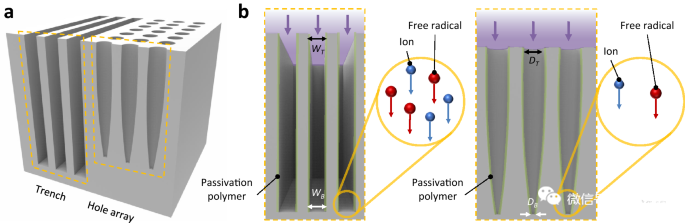
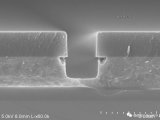
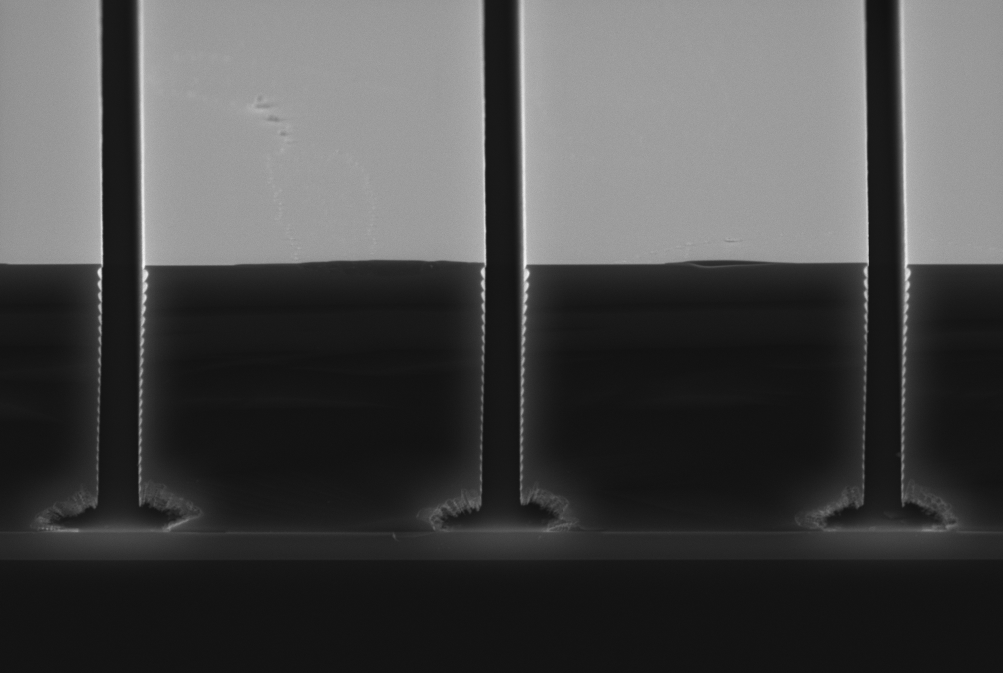


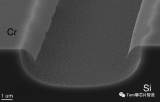


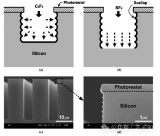
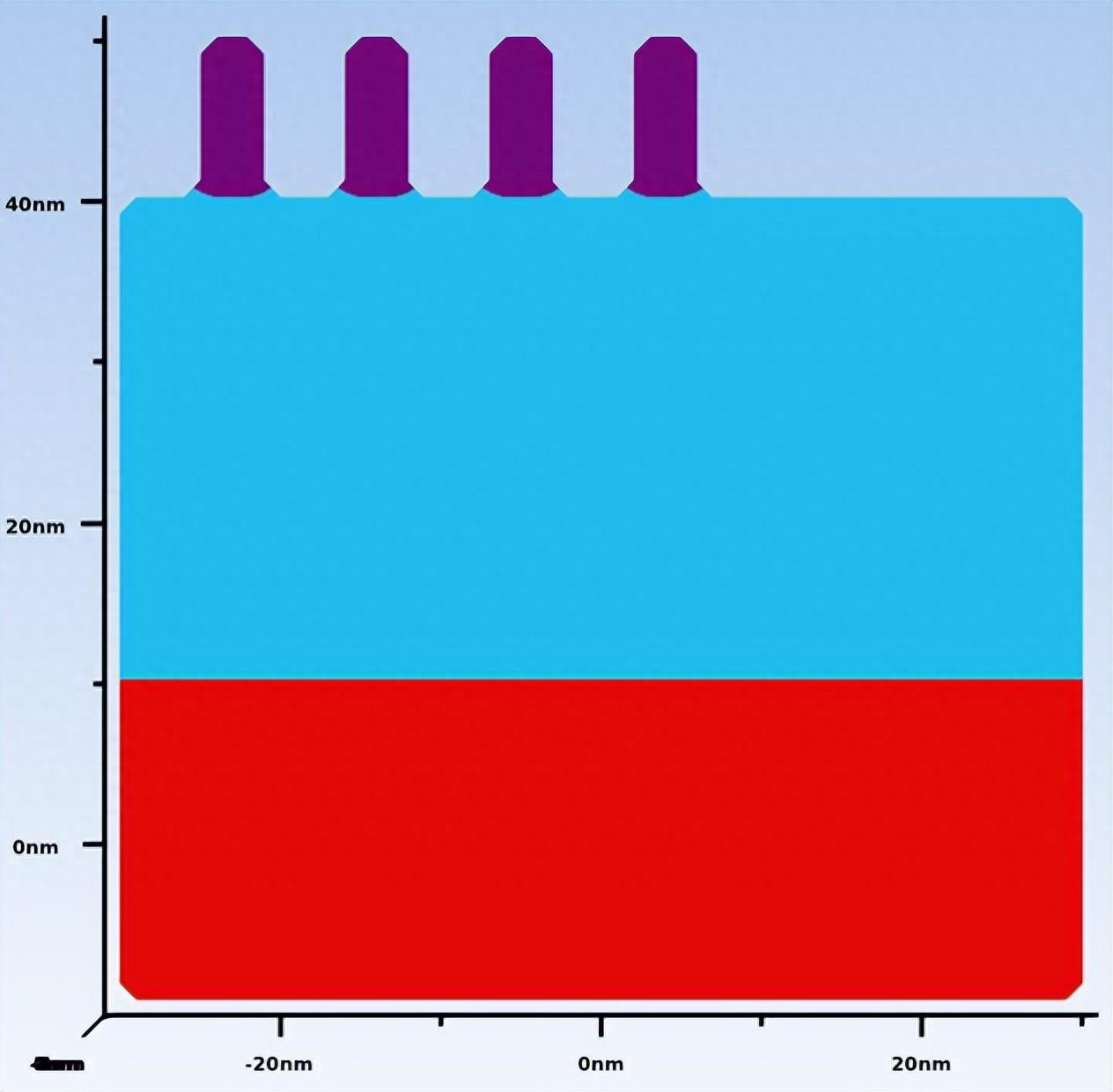

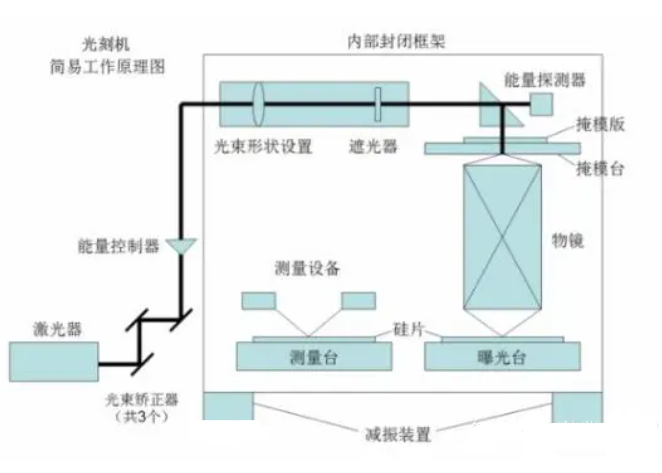










评论