在业界先进封装技术与传统封装技术以是否焊线来区分,先进封装技术包括FC BGA、FC QFN、2.5D/3D、WLCSP、Fan-Out等非焊线形式。先进封装技术在提升芯片性能方面展现的巨大优势,吸引了全球各大主流IC封测厂商在先进封装领域的持续投资布局。
中国IC封装业起步早、发展快,但目前仍以传统封装为主。虽然近年中国本土先进封测四强(长电、通富、华天、晶方科技)通过自主研发和兼并收购,已基本形成先进封装的产业化能力,但从先进封装营收占总营收的比例和高密度集成等先进封装技术发展上来说,中国总体先进封装技术水平与国际领先水平还有一定的差距。
1.中国先进封装营收占总营收比例约为25%,低于全球水平
据集邦咨询顾问统计,2018年中国先进封装营收约为526亿元,占中国IC封测总营收的25%,远低于全球41%的比例。
2018年中国封测四强的先进封装产值约110.5亿元,约占中国先进封装总产值的21%,其余内资企业以及在大陆设有先进封装产线的外资企业、台资企业的先进封装营收约占79%。
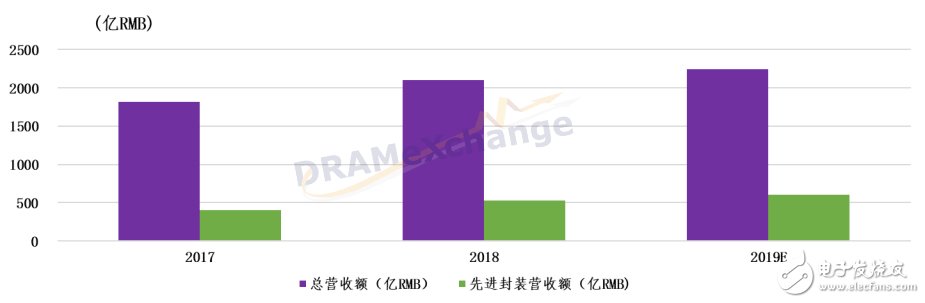
图:2017-2019年中国先进封装营收规模
2. 中国封装企业在高密度集成等先进封装方面与国际领先水平仍有一定差距
近年来国内领先企业在先进封装领域取得较大突破,先进封装的产业化能力基本形成,但在高密度集成等先进封装方面中国封装企业与国际先进水平仍有一定差距。
比如在HPC芯片封装技术方面,台积电提出新形态SoIC多芯片3D堆叠技术,采用“无凸起”键合结构,可大幅提升CPU/GPU处理器与存储器间整体运算速度,预计2021年量产;同时IDM大厂Intel提出Foveros之3D封装概念,可将存储芯片堆叠到如CPU、GPU和AI处理器这类高性能逻辑芯片上,将于2019下半年迎战后续处理器与HPC芯片之封装市场。
相对而言,国内封装技术领先企业在HPC芯片封装方面采用的FOWLP技术、2.5D封装所能集成的异质芯片种类、数量、bumping密度与国际上领先的3D异质集成技术存在一定的差距,这也将降低产品在频宽、性能、功耗等方面的竞争力。

图:HPC各封装形式对比
3.未来中国先进封装格局的变化趋势
近几年的海外并购让中国封测企业快速获得了技术、市场,弥补了一些结构性的缺陷,极大地推动了中国封测产业的向上发展。但是由于近期海外审核趋严而使国际投资并购上受到阻碍、可选并购标的减少,集邦咨询顾问认为中国未来通过并购取得先进封装技术与市占率可能性减小,自主研发+国内整合将会成为主流。
在自主研发方面,由于先进封装涉及晶圆制造所用技术类型与设备等资源,封装厂在技术、资金受限情况下可能选择与晶圆制造厂进行技术合作,或是以技术授权等方式(且依目前国内晶圆制造厂的制程来看,两者合作的方向主要是晶圆级封装及低密度集成,在高密度集成方面的研发仍有一段较长的路),然后搭配封测厂庞大的产能基础进行接单量产,共同扩大市场;
另外,随着封装技术复杂度的提高,资本投入越发庞大,越来越少的封测厂能够跟进先进封装技术的研发,规模较小的封测厂商如果无法占据利基市场,在行业大者恒大的趋势下竞争力将会下滑,由此可能引发新的兼并收购,提高封测市场的集中度。
-
封装技术
+关注
关注
12文章
558浏览量
68079
发布评论请先 登录
相关推荐
埃克斯工业CEO李杰:以AI重塑半导体制造生态
英飞凌第一季度营收同比下滑但优于预期
联发科2024年12月营收环比下滑
佳恩半导体IGBT项目科技成果达到国际先进水平
联赢激光牵头项目新突破,动力锂电池激光焊接技术达国际领先

CET中电技术电能质量相关科技成果获国际领先、国际先进认定

华光光电一项科技成果达到国际先进水平
字节跳动上半年营收稳健增长,国际业务表现亮眼
世界先进9月营收大幅增长34%
日月光资本支出加码,先进封装营收明年望倍增
AI应用致复杂SoC需求暴涨,2.5D/Chiplet等先进封装技术的机遇和挑战





 我国先进封装营收占比低于全球水平 与国际领先水平仍有一定差距
我国先进封装营收占比低于全球水平 与国际领先水平仍有一定差距

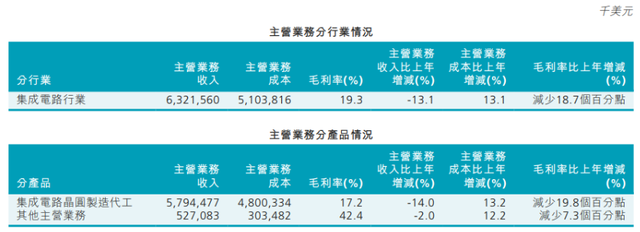










评论