集微网消息,近日,晶洲装备(KZONE)面向AMOLED主工艺量产设备通过Particle、Defect、CD等单元工艺指标验证,压力流量等各Parameter等设备指标均通过自检及客户端验收,在武汉客户面向折叠及柔性AMOLED产线上成功完成量产任务,并取得包括屏下摄像头等全新领域湿法工艺的全面开拓。
晶洲装备(KZONE)AMOLED主工艺设备正式从进入客户武汉厂开始,晶洲迅速完成设备安装、调试、硬件马拉松测试、设备最优工艺参数测试、工艺马拉松测试、多种工艺制程验证等一系列工作,并进入正式产品量产。在20天内,晶洲装备(KZONE)实现了国产AMOLED主工艺设备产品跑片的阶段性目标。
晶洲装备(KZONE)总经理蒋新指出,“中国作为全球最大的消费电子市场,在平板显示领域,由于国内相关产业发展晚于日韩企业,国外的技术垄断与封锁等原因,造成该领域的前、中段生产设备主要仍由国外企业垄断,在一些核心技术和设备上无法突破,屡屡受制于人。而由于研发周期长、设计门槛高、资金投入大,国内厂商少有涉足显示设备领域。晶洲装备经过持续多年的研发和测试,终于让显示设备市场看见来自我们中国设备企业的产品。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
相关推荐
在半导体制造的复杂流程中,晶圆历经前道工序完成芯片制备后,划片工艺成为将芯片从晶圆上分离的关键环节,为后续封装奠定基础。由于不同厚度的晶圆具
![的头像]() 发表于
发表于 02-07 09:41
•687次阅读

半导体新建项目洁净室工艺设备泊苏防微振平台施工流程1.引言近年来高科技产业在国内经济发展上有着举足轻重的作用,半导体晶片、TFT-LCD平面显示等大型的厂房也在国内不断的兴建,规模也在不断的扩大
![的头像]() 发表于
发表于 02-05 16:47
•156次阅读

一、概述
晶圆背面涂敷工艺是在晶圆背面涂覆一层特定的材料,以满足封装过程中的各种需求。这种工艺不仅可以提高芯片的机械强度,还可以优化散热性能,确保芯片的稳定性和可靠性。
二、材料选择
![的头像]() 发表于
发表于 12-19 09:54
•454次阅读

浙江晶能微电子有限公司近日宣布成功完成5亿元的B轮融资,本轮融资由秀洲翎航基金独家投资。至此,晶能已完成四轮融资,其中高榕创投曾在2022年
![的头像]() 发表于
发表于 10-28 18:22
•568次阅读
联得装备近期在面向多领域机构的调研中透露了其在多个前沿科技领域的最新进展与布局。在折叠屏技术的关键供应链环节,公司凭借其在贴合类工艺设备领域的深厚积累,成功推出了整体解决方案,并已转化为实际销售订单,实现了产品的顺利出货,这标志着联得装
![的头像]() 发表于
发表于 09-26 16:05
•746次阅读
苏州晶洲装备科技有限公司近日宣布成功完成数千万元的B轮融资,此次融资由众行资本携手多家产业方共同投资,标志着众行在泛半导体关键前道湿法装备领
![的头像]() 发表于
发表于 08-26 16:29
•772次阅读
近日,华虹无锡集成电路研发和制造基地传来喜讯,其二期项目12英寸生产线的首批关键工艺设备已顺利搬入,标志着这一先进产能的扩展计划正式进入实质性建设阶段。此前,华虹无锡一期项目已实现稳步运营,总产能达到9.45万片/月,五大工艺平台均实现了规模化生产,为二期项目的顺利推进奠
![的头像]() 发表于
发表于 08-26 09:51
•694次阅读
在本系列第七篇文章中,介绍了晶圆级封装的基本流程。本篇文章将侧重介绍不同晶圆级封装方法所涉及的各项工艺。晶圆级封装可分为扇入型晶圆级芯片封装
![的头像]() 发表于
发表于 08-21 15:10
•2176次阅读

考拉悠然自主研发的国内首台玻璃基Micro LED晶圆量检测设备近日正式完成出货。这标志着考拉悠然已完成产品的技术研发并获得客户认可,同时具备了Micro LED
![的头像]() 发表于
发表于 08-10 11:18
•635次阅读
近日,京东方华灿光电珠海MicroLED晶圆制造和封装测试基地项目工艺设备搬入仪式在珠海市金湾区隆重举行。这一标志性活动不仅标志着项目向着点亮投产迈出了关键的一步,更是彰显了公司在科技创新领域的不懈追求。
![的头像]() 发表于
发表于 05-31 10:15
•781次阅读
具体来说,这种晶舟包括副晶舟支架,能够在批量半导体工艺处理达到预定进度时,以上下层叠的方式支撑多个晶圆,使其暂时离开主
![的头像]() 发表于
发表于 04-19 09:32
•626次阅读
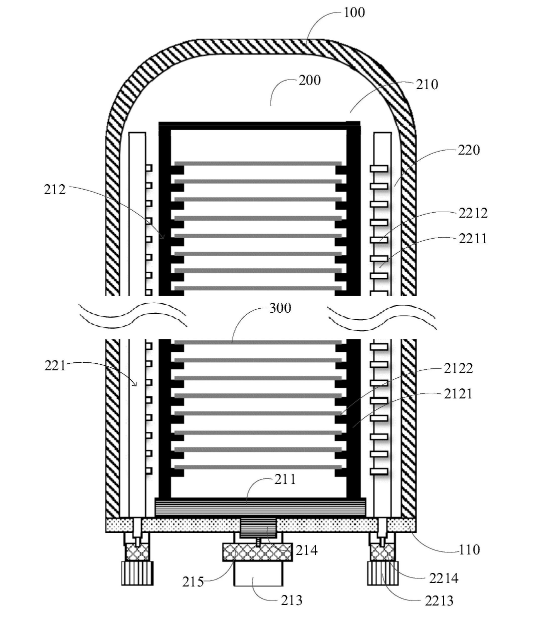
近日,半导体工艺设备商迈睿捷(南京)半导体科技有限公司成功完成了数千万元人民币的Pre-A轮融资。
![的头像]() 发表于
发表于 04-16 14:54
•1195次阅读
此项专利主要涉及半导体工艺技术领域的设备改进,包含腔室主体、机械手和环状体等部件。其中,机械手的固定端与腔室主体的底壁紧固衔接;而环状体则呈环绕状布置在腔室主体底部,并围绕着机械手的旋转轴组件。
![的头像]() 发表于
发表于 04-13 09:45
•630次阅读

晶圆经过前道工序后芯片制备完成,还需要经过切割使晶圆上的芯片分离下来,最后进行封装。
![的头像]() 发表于
发表于 03-17 14:36
•2191次阅读

共读好书 魏红军 段晋胜 (中国电子科技集团公司第二研究所) 摘要: 论述了 TSV 技术发展面临的设备问题,并重点介绍了深硅刻蚀、 CVD/PVD 沉积、电镀铜填充、晶圆减薄、晶圆键合等几种制约
![的头像]() 发表于
发表于 03-12 08:43
•1204次阅读









 晶洲装备AMOLED主工艺设备完成量产
晶洲装备AMOLED主工艺设备完成量产


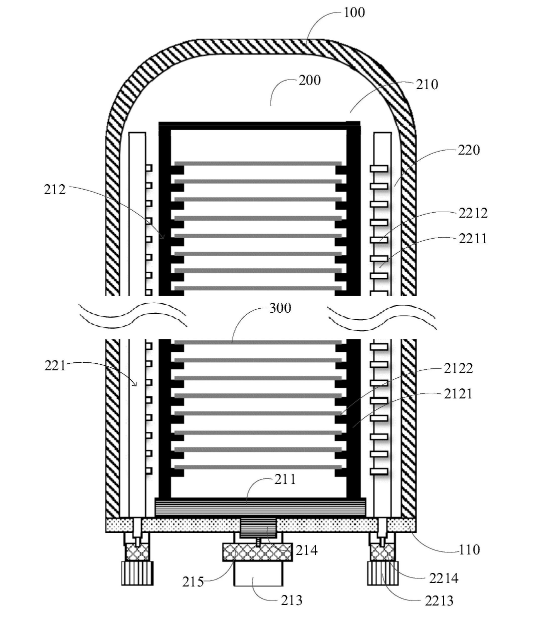











评论