介绍
聚乙烯醇刷洗是化学溶液清洗过程中常用的方法。聚乙烯醇刷擦洗可分为两大类,根据其接触类型(非接触,完全接触)。全接触擦洗被认为是去除晶片表面污染物的最佳有效清洁方法之一。然而,许多研究人员指责全接触擦洗导致了晶片表面的划痕,并建议应避免全接触。非接触式去除力较弱,但不会产生划痕。如果在非接触模式下,去除力可以通过流体动力阻力的最大化来克服与清洗液的附着力,那么非接触模式擦洗将是最佳的清洗方法。为了通过刷子和晶片之间的小间隙使流体动力阻力最大化,压电传感器安装在晶片上以检测由接触产生的信号。为了研究磨料颗粒对铜和聚硅酸乙酯的粘附性,测量了胶体二氧化硅磨料、铜和聚硅酸乙酯之间的相对zeta电位。本文研究了聚乙烯醇刷非接触擦洗对化学机械抛光后清洗的影响。
实验结果和讨论
图1表示240rpm时信号的快速傅里叶变换(FFT)。在接触模式下,在接近的64㎐处显示出高振幅。当刷子不与晶片进行接触时,接触信号在接近的64hz时消失,可以获得最小的刷子间隙。

图1:根据接触模式进行的信号FFT分析
图2显示不同刷旋转rpm清洗后铜表面的FESEM图像。清洗前,铜表面有大量的磨料颗粒。当刷子转速为60rpm时,铜表面仍存在大量的磨料颗粒。磨料颗粒在120rpm时没有被完全去除,但在240rpm时被完全去除。
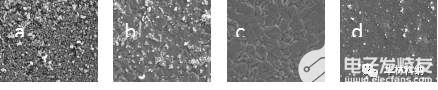
图2:清洗后铜表面的FESEM图像:a)60rpm60秒,b)120rpm60秒,c)240rpm60秒,d)抛光铜上的240rpm60秒
另一方面,在240rpm时,抛光的铜表面并没有完全去除颗粒。胶体二氧化硅可能通过CMP过程中产生的机械力嵌入在铜表面。去除力不超过包括变形附着力在内的附着力。图3显示了用280rpm清洗120秒后的互连结构的FESEM图像。完全清洁的表面可以在更高的转速和更长的工艺时间内获得。
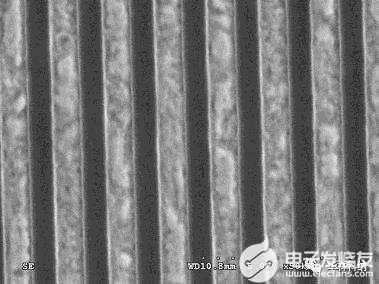
图3:清洗后互连结构的FESEM图像(280rpm,120秒)
结论
本文对于由铜和PETEOS清洗组成的互连结构,铜清洗是铜和胶体硅之间相对zeta电位迹象不同的关键问题。我们可以使小间隙和高水动力阻力来检测接触信号。在240rpm时,水动力阻力高于附力,但在变形附力下低于附力。更高的速度和更长的处理时间(280rpm,120秒)可以去除磨料颗粒。在不破坏铜表面的情况下有效去除铜表面的磨粒。
审核编辑:符乾江
-
半导体
+关注
关注
335文章
27971浏览量
225146 -
晶片
+关注
关注
1文章
405浏览量
31651
发布评论请先 登录
相关推荐
SiC清洗机有哪些部件构成

全自动晶圆清洗机是如何工作的
如何使用cmp进行数据库管理的技巧
cmp在数据处理中的应用 如何优化cmp性能
CMP的平坦化机理、市场现状与未来展望

揭秘PCB板清洗过程:每一步都关乎产品质量!

SMT锡膏钢网的清洗工艺主要有哪些?
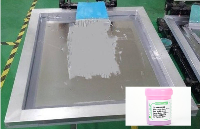
网纹辊超声波清洗机的结构原理

INA205 cmp1复位引脚拉高、cmp1 in没有输入的情况下,cmp1 out会输出高电平,为什么?
硅晶片清洗:半导体制造过程中的一个基本和关键步骤
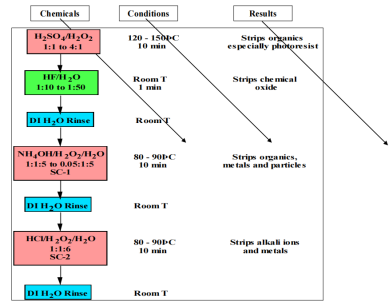




 PVA刷擦洗对CMP后清洗过程的影响
PVA刷擦洗对CMP后清洗过程的影响















评论