引言
将ZnO:Al薄膜织构化与沉积条件的依赖性分开是优化ZnO作为太阳能电池中的光散射、透明接触的一个重要方面。对于给定的多晶ZnO:Al薄膜,凹坑的密度和形状可以通过改变各种酸的温度和浓度来控制。凹坑密度通常随着温度的升高、浓度的降低或通过在小分子大小的弱酸中蚀刻而增加。观察到的多晶ZnO:Al膜的腐蚀趋势在ZnO单晶上得到证实。我们从蚀刻速率和凹坑形成的角度详细讨论了蚀刻过程。根据最近提出的ZnO腐蚀模型解释了结果,并给出了可能的物理解释。
介绍
织构化的ZnO:Al薄膜可用于在硅薄膜太阳能电池中同时实现前接触、窗口层和光捕获源的作用。对于溅射的ZnO:Al膜,在通过化学蚀刻沉积后引入表面纹理。虽然单独的沉积和纹理化步骤表面上允许单独优化光电和光散射特性,但事实证明实现起来很困难,因为最终蚀刻坑的大小和形状也取决于制备条件。
ZnO具有纤锌矿晶体结构,因此它不具有沿c轴的反转对称性。
(1)(01)和(00-1)平面分别是Zn-和O-封端的。Zn-O键主要是离子键,这些极性键导致带正电的锌和带负电的氧原子的平面垂直于c轴。几十年前报道了ZnO单晶的蚀刻,并且可以基于悬挂键模型进行解释:酸性溶液中的水合氢离子容易蚀刻O-端接侧,而蚀刻仅发生在Zn-端接侧的缺陷处[9]。然而,多晶ZnO薄膜的详细蚀刻模型是最近发展的结果[10]。该模型的基础包括以下三个假设。
溅射的ZnO:Al生长为Zn封端的,并且像Zn封端的单晶一样,该(001)晶面不被蚀刻,但是每个晶界都有可能被蚀刻,然而,因为蚀刻剂可以接触到其他平面。如我们之前关于蚀刻模型的论文中所定义的,这种蚀刻潜力描述了特定位置在蚀刻时作为成核中心形成凹坑的可能性,并归因于晶界的致密性。
(2)蚀刻剂溶液和条件限定了蚀刻阈值。蚀刻电位高于阈值的晶界被更积极地蚀刻。
(3)垂直和水平蚀刻速率也由溶液决定。垂直蚀刻速率沿着晶界进行,蚀刻电位高于溶液的阈值,并且受到晶界的性质以及蚀刻剂的流动性和尺寸的限制。水平蚀刻速率受到蚀刻剂浓度和晶体结构的限制,蚀刻在(101)面停止。
结果
盐酸(HCl)
图1 (a)和(b)分别给出了不同浓度下作为HCl溶液温度的函数的ZnO:Al薄膜蚀刻速率和不同温度下作为HCl溶液浓度的函数的相同数据。蚀刻速率随着温度和浓度而增加。指数函数和线性函数分别用作图1 (a)和(b)中的拟合曲线。指数拟合很好地代表了实验温度依赖性。浓度大于1 w/w%时,观察到偏离线性行为;在线性拟合中忽略1 w/w%以上的浓度,并在图1 (b)中用粉红色标记。具有大蚀刻速率(高于40 nm/s)的样品的误差条变得相当大,因为高达一秒的假定误差是总蚀刻时间的25 %。
图2显示了按HCl溶液的温度和浓度组织的光学显微镜图像矩阵。请注意,图像帧的颜色代码提供了右侧刻度给出的蚀刻速率范围。光学图像没有给出表面的精确表示,因为分辨率不够高,不足以观察小的特征,并且光学对比度不一定揭示特征的形状。然而,即使低于微米范围的凹坑的密度和尺寸分布也容易检测。通过提高HCl温度和降低HCl浓度,所得凹坑的密度增加。
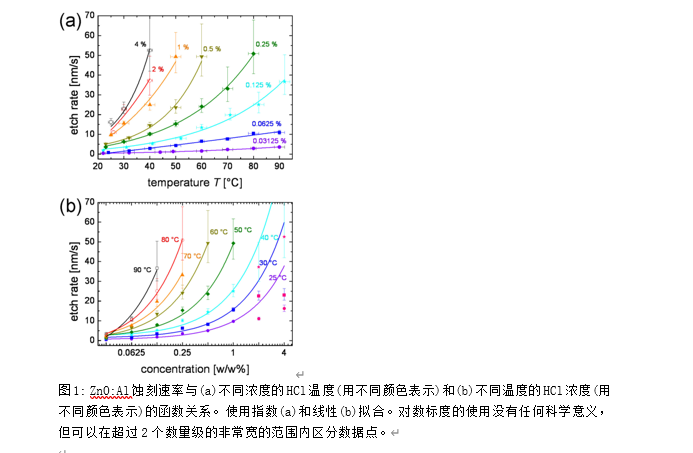
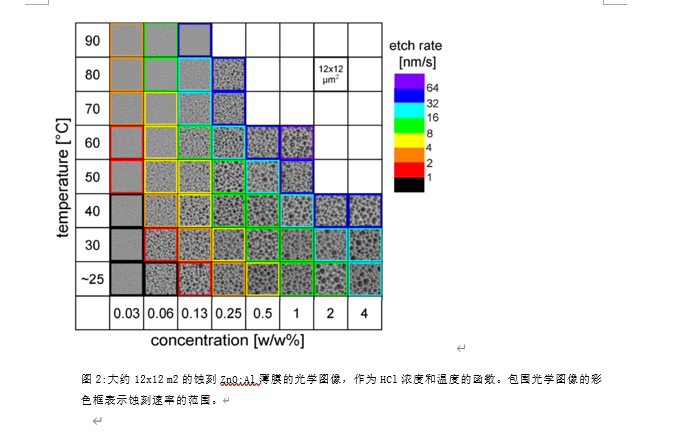
为了更精确地观察不同温度和浓度下表面结构的差异,进行了三个系列的AFM测量。首先,当温度变化时,HCl浓度保持恒定在0.125 w/w%。第二,温度在室温下保持恒定,而HCl浓度变化。第三,当温度和浓度变化时,蚀刻速率保持恒定在约25 nm/s(如图1所示)。图3给出了三个AFM系列的统计评估(恒温、浓度和蚀刻速率)。在图3 (a)和(b)中分别给出了作为温度和浓度的函数的凹坑密度(左轴)和平均凹坑面积(右轴)。图3 (c)和(d)分别给出了均方根粗糙度与温度和浓度的函数关系。这四个图表还包括蚀刻速率恒定但温度和浓度变化的系列的统计数据。随着盐酸温度的升高,观察到凹坑密度从3.4m-2增加到28 m-2,凹坑尺寸从0.3m-2减少到0.04m-2,均方根粗糙度从100减少到26 nm(图2和图3 (a)和(c))。随着HCl浓度的增加,观察到凹坑密度从21m-2减少到1.9 m-2,凹坑尺寸从0.05m-2增加到0.6m-2,RMS粗糙度从26nm增加到130 nm(图2和图3 (b)和(d))。以恒定速率蚀刻的样品显示出相似的趋势;然而,温度和浓度的影响通过相应的其它参数的调整而复合。具体来说,在高温低浓度HCl中蚀刻的样品比在低温高浓度HCl中蚀刻的样品具有更高密度的小凹坑(图2和图3 (a-d))。
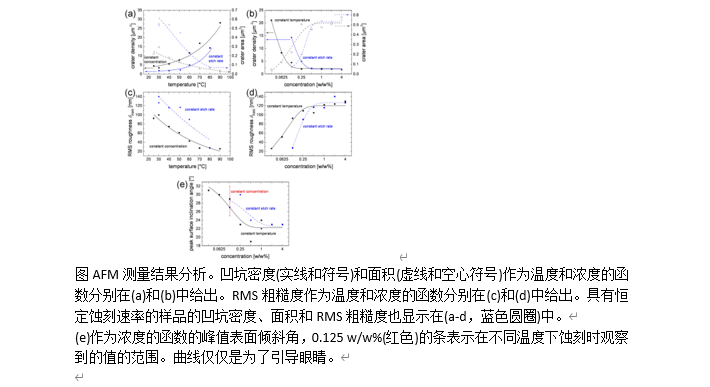
结论
我们已经表明,对于给定的具有固定晶界蚀刻电位分布的多晶ZnO:Al薄膜,可以通过改变酸的类型、温度和浓度来控制凹坑覆盖范围。根据最近开发的多晶ZnO:Al蚀刻模型解释了这些结果[10]。晶界腐蚀电位的建议阈值与由腐蚀速率确定的假活化能有关。对于强离解酸(HCl)或大的弱离解有机酸(CH3CO2H),升高温度或降低浓度会降低蚀刻阈值,导致更高的凹坑密度。这些蚀刻特性在单晶ZnO晶片上得到证实。还表明,通过降低少量弱解离酸(HF)的浓度,弹坑形状可以从水平限制变为垂直限制。对每一种腐蚀行为给出了可能的物理解释。
审核编辑:汤梓红
-
薄膜
+关注
关注
0文章
304浏览量
29845 -
蚀刻
+关注
关注
9文章
420浏览量
15540 -
晶片
+关注
关注
1文章
405浏览量
31609
发布评论请先 登录
相关推荐
单晶圆系统:多晶硅与氮化硅的沉积

碳化硅薄膜沉积技术介绍
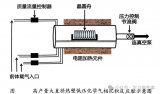
RS-ALD技术制备的Al2O3薄膜在TOPCon电池边缘钝化中的应用研究

多晶氧化物中的晶界和异质界面概念、形成机理以及如何表征

氮化硅薄膜的特性及制备方法

湿法蚀刻的发展

薄膜电容的频率特性
玻璃电路板表面微蚀刻工艺
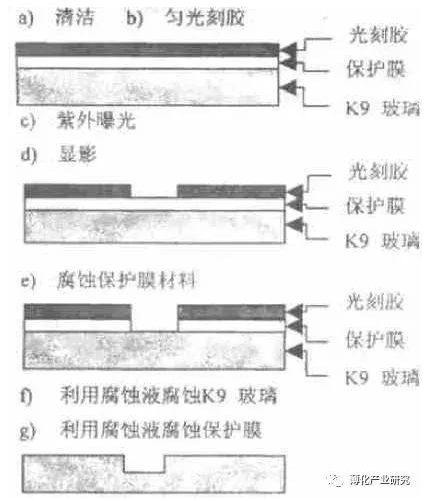
Molex薄膜电池具有哪些产品特性?-赫联电子
ZnO电阻片在低电场区域的泄漏电流及其电阻的负温度系数
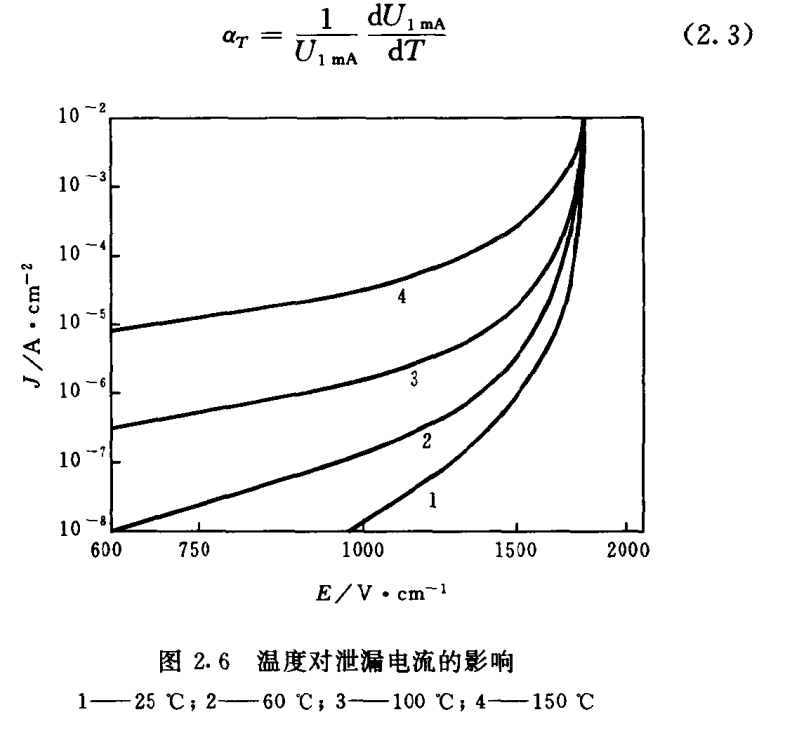
直流输电系统氧化锌ZnO电阻设计方案
影响pcb蚀刻性能的五大因素有哪些?

冲击电流作用下氧化锌电阻片的动态伏安特性
沉积温度和溅射功率对ITO薄膜性能的影响研究





 多晶ZnO:Al薄膜的蚀刻特性研究
多晶ZnO:Al薄膜的蚀刻特性研究











评论