本文描述了我们华林科纳单晶片超电子清洗方法的开发、测试和验证,该传感器设计满足极端颗粒中性、颗粒去除效率(PRE)和生产规模晶片粘合的可重复性要求,以及其他需要极低颗粒水平的应用。不同的微电子过程需要在颗粒污染方面进行非常清洁的表面处理,其中,直接晶片粘接在颗粒清洁度方面有非常积极的要求,直接的晶片键合包括通过简单地使两种材料光滑和干净的表面接触而将它们连接在一起(图1)。
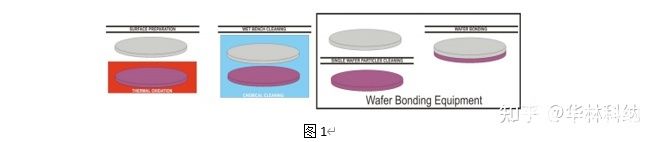
在室温压力和温度下,两种材料表面的分子/原子之间形成的范德华力会产生粘附,由于接触的两个表面是刚性的,被困在表面之间的粒子产生不接触的区域(未粘合的区域或空隙),从而降低了产率,已知直径为1微米的粒子会产生直径为1cm的粘合缺陷,为了防止这种情况发生,集成了一个由单个晶片清洗过程组成的典型工艺步骤。
晶片粘接在衬底清洁度方面非常严格,如果对于CMP后清洗过程,传入晶片将显示数千或数万的颗粒水平,通过清洗过程去除数百或数十个颗粒,如果直接粘合,成功和可靠的晶片粘合所需的颗粒水平范围为200毫米/以下10个颗粒或300毫米直径晶片(颗粒尺寸>0.12微米),有了这样的成功标准,这种新型清洁方法的效率也必须通过粒子中性来确定。
在这些实验中使用了两种不同的径向均匀面积元电子传感器模型(图2),该换能器将声能耦合到由基板和换能器面形成的流体填充间隙中,该形状和谐振器的设计保证了在旋转基板的整个表面上的均匀的声学剂量,而没有扫描运动,持续监测前向和反射射频功率以及PZT晶体温度,确保一致和可重复的声学处理条件。

PFA涂层旨在提供一个无金属的表面,同时确保与晶片清洗和蚀刻中使用的各种化学溶液的兼容性。当应用大电子能量时,PFA材料不是颗粒中性的,而PFA涂层本身实际上可以产生亚于100纳米的颗粒,因此不能用于这种预结合清洗应用,PFA涂层谐振器也被证明是非常敏感的,因为它可以通过接触硬物质,例如一个破碎的晶圆碎片,在最好的情况下,材料的分数或破坏将提供额外的颗粒来源,在最坏的情况下,将下面的金属谐振器暴露在工艺流体中。
为了满足直接晶片键合清洗的要求,研究了替代谐振器材料,由于石英的化学相容性有限和邻近系统的寿命有限(侵蚀和点蚀),由于优异的物理鲁棒性和抗化学性,最终选择了单晶蓝宝石作为V3模型的谐振器,单晶蓝宝石具有可控的谐振器厚度和晶体取向,也是一种高效的声波导体,蓝宝石也兼容共晶PZT到谐振器键的方法,消除了环氧/粘接的需要。
虽然颗粒去除效率(PRE)结果显示了良好的标准应用价值,但实验数据显示产生了在100纳米以下的颗粒,采用单晶蓝宝石谐振器,并重新启动测试。清洁的晶片被大小在50纳米到200nm之间的氮化物颗粒污染,然后将晶圆加载到单个晶圆清洗站,本实验测量的最小粒径为0.09微米,随后的SP2分析显示均匀去除,PRE值>为95%,通常>为100%。
在许多关键的清洗步骤中,晶片尺度键合需要一个无粒子表面来形成无缺陷键,这一要求规定了在结合工艺步骤之前的最后一个单晶片清洗步骤,该步骤能够去除剩余的少数颗粒,同时不添加任何额外的颗粒或金属离子污染。
最后的清洗步骤是在过去通过刷洗、大型喷嘴或矩形大型区域传感器来完成的,由于晶片间存在交叉污染或接触活性表面的风险,均匀性相对较差的风险(喷嘴清洗涉及直径为几毫米的水流扫描晶片),甚至由于声波(例如矩形换能器)而导致地下缺陷,在单晶片预键清洗站中实现,提供了高颗粒去除效率,并不加颗粒添加(颗粒中性),这种传感器的专有设计确保了跨晶片的径向均匀性的非接触清洗,使用清洗化学物质(例如稀释的氢氧化铵)可以提高清洗效果。
审核编辑:符乾江
-
半导体
+关注
关注
335文章
27826浏览量
223845 -
清洗
+关注
关注
2文章
75浏览量
13975
发布评论请先 登录
相关推荐
起点,经过点,终点,三点xyz,画三维圆弧。
用于薄晶圆加工的临时键合胶
芯碁微装推出WA 8晶圆对准机与WB 8晶圆键合机助力半导体加工
晶圆键合设备:半导体产业链的新“风口”





 基于晶圆键合的三维集成应用中的高效单片清洗
基于晶圆键合的三维集成应用中的高效单片清洗

















评论