已经为基于 GaN 的高电子迁移率晶体管 (HEMT)的增强模式开发了两种不同的结构。这两种模式是金属-绝缘体-半导体 (MIS) 结构,2具有由电压驱动的低栅极漏电流,以及栅极注入晶体管 (GIT),3具有脊结构和高阈值电压。两者也都有一些缺点。MIS 对栅极干扰的可靠性较低,阈值电压较低,而 GIT 的栅极开关速度较慢,栅极漏电流较高。
图 1 显示了用于测试这两种结构的设置。单一模型可用于 MIS 和 GIT 结构。GIT 用于使用电流模型开发等效电路,而 MIS 用于核心漏极电流建模。4此后,S 参数测量用于评估这些器件中的每一个的电路。
设备结构
图 1a 显示了 MIS 晶体管的基本结构以及嵌入式源极场板 (ESFP)。金属有机化学气相沉积用于在其上形成氮化硅 (SiN) 钝化层。使用载流子密度为 1.4 × 1,013 cm 2、迁移率为 1,203 cm 2 V/s、薄层电阻为 382 W/square的二维电子气 (2DEG)薄片。由位于金属间电介质 MO 薄膜顶部的500 nm 厚的二氧化硅 (SiO 2 ) 薄膜制成的栅电极延伸到钝化薄膜上,从而降低了 C gs。ESFP 将栅漏电场分成两个峰值。这会由于负偏压而降低电子密度,并在有源偏压下增加栅极绝缘膜下的密度。
图 1b 显示了脊 GIT 晶体管和源极场板 (SFP) 的基本结构。其结构有一个 10 纳米的氮化铝镓 (AlGaN) 层作为阻挡层和一个 60 纳米的 p-GaN 层。在使用 ICP 蚀刻器蚀刻表面后,栅极表面用 100 nm 厚的 SiN 膜保护。漏极和源极也由蚀刻的 SiN 薄膜形成,从而产生欧姆电极。源极电极在栅极上延伸到漏极侧以形成 SFP。SFP 将栅极到漏极的电场分成两个峰值,从而降低了栅极边缘下方的电场强度。用于这些实验的测量值是:L mask = 0.8 mm,W mask = 100 mm,源极到栅极距离 = 0.9 mm,栅极到漏极距离 = 3.5 mm,栅极电容(Cox ),可以使用栅极氧化膜厚度 (T ox ) 和 SiO 2的介电常数 (ε ox ) 计算。如图 2b 所示,很难使用 pn 二极管空穴注入中累积的电子密度准确计算栅极沟道电容 (C ch )。因此,在任何参数提取过程开始之前测量C ch 。
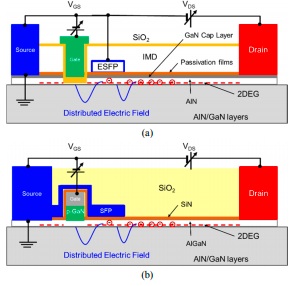
图 1:简化的测试结构
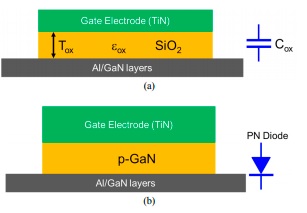
图2:大门放大图
漏电流方程
MIS-HEMT 的栅氧化层电容

脊形 HEMT 的栅沟道电容
脊形 GIT HEMT 的肖特基接触和 pn 结如图 2b 所示。沟道区由从沟道注入空穴的 2DEG 区的 p 型栅极组成。漏极电流导数包含每面积的栅极沟道电容 (C ch )。
阈值电压

电子迁移率

漏源电阻
等效电路

图 3 显示我们的模型 MIS 和 ridge HEMT 具有相同的宏电路。主 HEMT 晶体管用作 FET 以减少漏极电场,而子晶体管用作 SFP。图 4 显示了 MIS 和脊形 HEMT 类型的具有固有小信号的交流等效电路。
金属互连电感标记为 L g、 L d和 L s,而栅极电容标记为 C gs和 C gd,它们使用经验函数分为常数(C gs0和 C gd0)和偏置相关电容。10漏极到源极的电容标记为 C ds。色散电阻为 R dis_T,而电容标记为 C dis_T 和 C gdis。栅源内部电阻为 r i。栅极、漏极和源极电阻由 R g , R表示d_T和 R s_T分别。栅漏电阻由R gd表示。可扩展的栅极电容 C gs_sfp和 C gd_sfp与 C ds并联,因为 ESFP 必须连接在漏极和地之间。
栅极注入 pn 二极管中脊形 HEMT的扩散电容 ( C_diffusion ) 和结电容 ( C_junction ) 如图 4b 所示。11此处使用的端子位于源极和栅极之间。C _diffusion甚至可以作为 C dis_T工作。
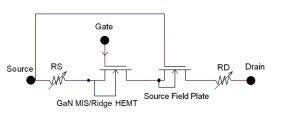
图 3:MIS 和 ridge HEMT 模型的电路

图 4:等效电路
实验与讨论
具有脉冲测量模式的曲线跟踪器用于测量所采用的两种晶体管结构的 DC。为此提供的偏置具有 100 ms 的脉冲宽度和 50% 的占空比。
在实验之前使用多栅极长度和宽度器件进行测量,以获得线性和饱和漏极电流、阈值电压的模型参数以及栅极通道中的长度和宽度依赖性。
该模型具有高精度,可用于 MIS 和脊形 HEMT 器件,用于在线性和饱和区激发静态漏极电流。这在图 5 和图 6 中得到了清晰的体现。S 参数测量以及小信号 AC 表征可以有效地用于评估等效电路。1
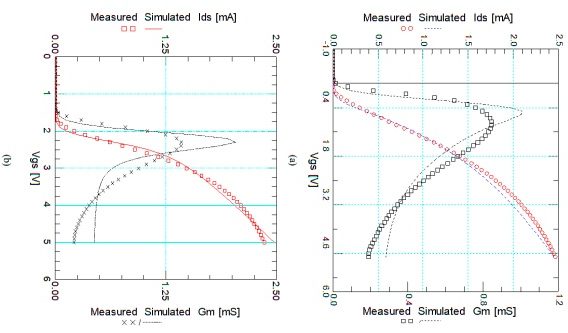
图 5:测量和模拟的 Ids-Vgs
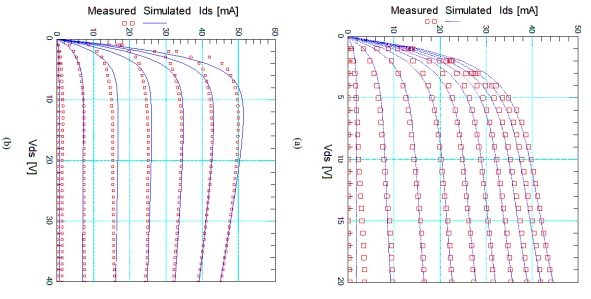
图 6:测量和模拟的 Ids-Vds
结论
本文总结了 HEMT 的两种模型:漏极电流模型 MIS 和脊 GIT。用于交流和瞬态仿真的小信号等效电路模型也使用测量值和 S 参数制作。对于脊形 HEMT,详细讨论了栅极泄漏电流模型以及过量漏极电流。可以使用 MIS-HEMT 模型创建漏极电流模型的其他修改方程。HSPICE 与 Verilog-A 语言结合使用来创建此模型。我们的测试设置与该模型及其参数配合良好,可应用于电源设计。可以设计瞬态和噪声等效电路以及模型方程来更快速地切换电源。
-
氮化镓
+关注
关注
67文章
1921浏览量
120224 -
HEMT
+关注
关注
2文章
81浏览量
14550
发布评论请先 登录
N沟道增强型绝缘栅场效应管所加电压UGS为什么不能小于0
N沟道增强型绝缘栅场效应管所加电压UGS为什么不能小于0
GaN HEMT在电机设计中有以下优点
基于GaN HEMT的半桥LLC优化设计和损耗分析
GaN HEMT增强型器件技术路线及关键科学问题
肖特基二极管和耗尽型 HEMT 与200-V GaN IC的单片集成
增强型GaN HEMT的漏极电流特性
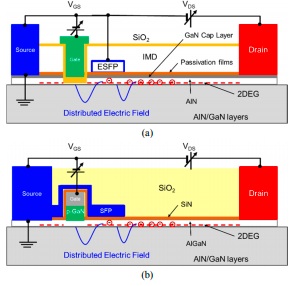



 增强型GaN HEMT的漏极电流特性
增强型GaN HEMT的漏极电流特性

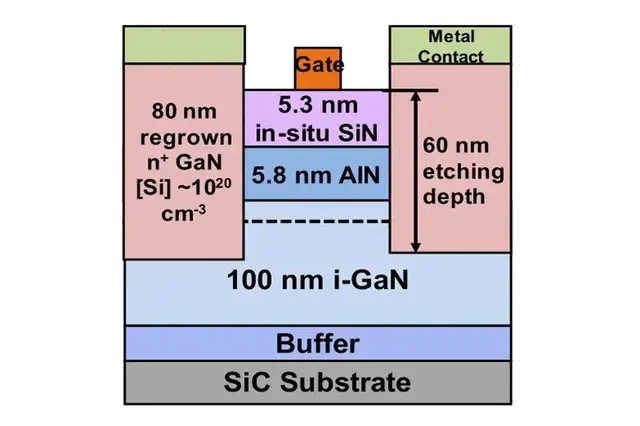



评论