湿法刻蚀也称腐蚀。硅的湿法刻蚀是 MEMS 加工中常用的技术。其中,各向同性 (Isotropic)湿法刻蚀常用的腐蚀剂是由氢氟酸(HF)、硝酸( HNO3)和乙酸(CH3COOH)组成的混合物(也称为 HNA 腐蚀剂);对硅的刻蚀速率和对掩模材料的刻蚀选择性可通过各组分比例的不同来调节。目前,各向同性湿法刻蚀的实际应用较少。
硅的各向异性(Anisotropic)湿法刻蚀技术已成功用于多种 MEMS 产品中,如硅压力传感器、加速度计、MEMS 传声器等。硅的各向异性腐蚀主要是利用各个硅晶体面腐蚀速率不同而实现的。利用这种特性,可以在硅衬底上加工出多种多样的结构,如凹槽(可应用于压力传感器的腔体等)、金字塔结构(可应用手原子力显微镜探针等)或悬浮结构(可应用于加速度计的悬臂梁等)等。
在各向异性湿法刻蚀中,随着腐蚀时间的推移,快速腐蚀面将消失,仅留下低速腐蚀面,此时腐蚀腔体的形状几乎不再变化,但其尺寸会随着慢速腐蚀面的腐蚀而略有增大,这时获得的腔体称为自限制图形。
对于 「100」 硅衬底,预测任-意掩模图案的自限制图形腐蚀窗口的方法为:1.确定掩模图案上沿《110》晶向的上下左右4个方向上的最上点、最下点、最左点和最右点; 2.过这4个点做平行于《110》晶向的4 条直线; 3.这4条直线围成的区域即为自稳定图形的窗口形貌;4.腐蚀的深度由硅片厚度,有无自停止层和窗口尺寸共同决定。
在某些加工中,往往需要避免出现凸角刻蚀。例如,当需要的一个矩形凸台时,凸角腐蚀将导致矩形的4个角严重失真。此时,就需要利用凸角补偿方法来完成腐蚀。常见的凸角补偿主要是在掩模版设计时,在凸角处增加图形,完成对凸角的保护,补偿图形的尺寸与形状随腐蚀深度与腐蚀液种类的不同而调节,通过控制补偿图形,可以得到非常理想的凸角结构。
-
传感器
+关注
关注
2553文章
51511浏览量
757256 -
mems
+关注
关注
129文章
3968浏览量
191220 -
硅晶体
+关注
关注
0文章
10浏览量
3592
原文标题:湿法蚀刻(Wet Etching)
文章出处:【微信号:Semi Connect,微信公众号:Semi Connect】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
相关推荐
等离子体刻蚀和湿法刻蚀有什么区别
半导体湿法刻蚀残留物的原理
芯片湿法刻蚀残留物去除方法
如何提高湿法刻蚀的选择比
晶圆湿法刻蚀原理是什么意思
湿法刻蚀步骤有哪些
半导体湿法刻蚀设备加热器的作用
PDMS湿法刻蚀与软刻蚀的区别
天线系数与天线增益的关系
雷尼绍测头为什么具有各向同性
什么是线刻蚀 干法线刻蚀的常见形貌介绍

锗化硅(SiGe)和硅(Si)之间的各向同性和选择性蚀刻机制
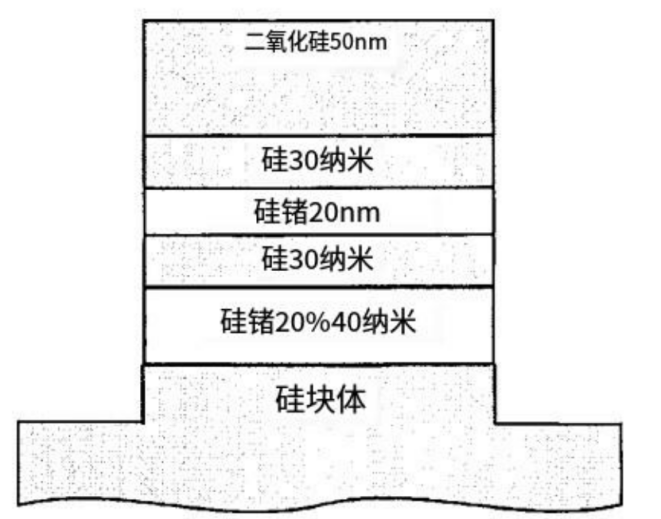




 常见的各向同性湿法刻蚀的实际应用
常见的各向同性湿法刻蚀的实际应用

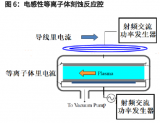










评论