来源:Manz
· 成功克服面板翘曲,打造业界最大生产面积700mm x 700mm
· 板级封装为芯片整合注入新生产模式;也为中国芯片产品自主化注入新契机
Manz亚智科技研发部协理 李裕正博士于会中解说Manz FOPLP工艺突破之处以及未来应用
活跃于全球并具有广泛技术组合的高科技设备制造商Manz 集团,掌握全球半导体先进封装趋势,加速开发新一代专利垂直电镀生产设备并无缝整合湿法化学工艺设备、自动化设备,以优异的设备制程经验以及机电整合能力, 打造新一代板级封装中的细微铜重布线路层(RDL)生产线,生产面积达业界最大基板尺寸700mm x 700mm,创下板级封装生产效率的新里程碑!
Manz板级封装的突破,为半导体封装开启另一扇门,技术日上专家云集。友威科技研发与市场开发副总经理 刘品均、苏州晶方半导体科技股份有限公司副总裁 刘宏钧、华天科技(昆山)电子有限公司研究院院长 马书英博士、中国半导体行业协会封测分会秘书长 徐冬梅教授、Manz亚智科技总经理 林峻生、无锡华润安盛科技有限公司总经理 吴建忠、国际半导体产业协会 Semi China 中国区高级总监 张文达、Manz亚智科技研发部协理 李裕正博士、麦德美集成电路事业处大中华区业务总监 成云远以及KLA产品营销经理 王勇(由左到右)
板级封装是兼具大产能及成本优势的新技术, Manz是板级封装RDL工艺的市场领跑者之一,从研发515mm x 510mm面板开始,再演进至600mm x 600 mm,今年成功克服面板翘曲而打造700mm x 700mm的业界最大面板生产尺寸。目前,Manz生产设备已出货全球知名半导体制造商,应用于车载与射频芯片的封装量产,展现了新技术的实力!
由Manz新一代板级封装RDL自动化生产线试生产的产品
Manz新一代板级封装 RDL生产线不仅仅提升生产效率,同时也兼顾成本及产品性能。该生产线以大面积电镀制作精密的RDL层铜线路,克服电镀与图案化均匀度、分辨率与高度电气连接性的挑战,涵盖传统强项湿法化学工艺的洗净、显影、蚀刻、剥膜与关键电镀铜设备,同时实现全线的自动化生产。此外,Manz还积极整合材料商、上下游设备商,为客户提供完整的RDL生产设备及工艺规划服务,从自动化、材料使用与环保多维度协助客户打造高效生产解决方案并优化制程良率及降低制造成本。
Manz亚智科技总经理 林峻生先生、销售副总 简伟铨先生以及研发部协理 李裕正博士为媒体老师解说目前Manz板级封装技术及未来策略发展
创新无治具板级电镀系统,兼顾大面积与高均匀度之应用需求
在大面积板级封装生产时,要达成高均匀线路重分布层的实践,电镀设备是关键。Manz创新杯式垂直电镀系统设计,不需笨重密封的阴极治具,多分区阳极设计,能达成高均匀性电镀。
高精度自动化移载系统,达成自动化生产
搭配无治具基板之高精度移载与上下板技术,开发新移载架构,取代机械手臂,以缩小系统占地面积。并结合真空吸盘设计,无损基板且避免断电掉板之生产问题。
板级封装技术━━车规级芯片中功率半导体、传感器及通信芯片最佳生产解决方案之一
全球芯片应用端在发生变化,消费性电子产品如智能手机、 PC 、 NB 等供需紧张情形趋缓,取而代之的是5G、物联网、车用电子对芯片的需求成为持续驱动芯片生产的主要动能。相关机构预测,到2026年时,车用芯片市场占有率及年增长率将双双提升。
中国电动汽车发展迅速,2021年纯电车产量已占全球的50%,但功率半导体、传感器及通信芯片等主要车用芯片的国产化率却不及12%。要快速发展国内车规芯片,先进封装技术是一条可靠的技术路径。
众多先进封装技术之中,板级封装技术因具备大产能且更具成本优势,是目前高速成长功率、传感器、通信等车规级/芯片生产的最佳解决方案。未来,随着政策继续力挺半导体产业,电动车持续带动车规级芯片市场需求,车规级芯片国产化进程有望加速,将促进板级封装技术同步发展。
Manz集团亚洲区总经理 林峻生先生展示以Manz新一代板级封装 RDL自动化生产线所试生产的产品。
Manz亚智科技与国内产业链进行过多次深入合作,涵盖产、学、研,旨在有效推进国内板级封装的建设。Manz集团亚洲区总经理林峻生先生表示:“我们将继续发挥自身在技术和市场方面的积累,通过整合,积极推动板级封装实现产业化落地,全方位推进国内在先进封装的发展,为整个产业生态的建设贡献出更多的力量。”
中国半导体行业协会封测分会秘书长 徐冬梅教授于Manz技术日上致词
政府在政策层面上给予先进封装诸多的支持,各地十四五规划都将发展先进封装列入其中,以不断增强产业国际竞争力、创新力及技术力。林峻生先生指出:“为了给予客户全方位的技术工艺与服务,迎接这一波板级封装的快速成长,我们在上下游制程工艺及设备的整合、材料使用皆与供应链保持密切合作,藉由凝聚供应链共同目标,提供给客户更创新的板级封装制程工艺技术,为客户打造高效生产解决方案的同时优化制程良率及降低制造成本。我们提供以市场为导向的板级封装RDL一站式整体解决方案,打造共荣共赢的供应链生态。”
*日本研调机构富士经济(Fuji Keizai)
关于Manz
擘划创新设备成就生产力 —— ENGINEERING TOMORROW'S PRODUCTION
Manz 集团是一家活跃于全球的高科技生产设备制造商。集团核心技术涵盖自动化、湿法化学工艺、检测系统和激光加工;凭借着核心技术及超过三十年的生产设备制造经验,专注于开发设计创新的高效生产设备,应用于电子产品、汽车和电动车和医疗等市场的生产设备解决方案,涵盖半导体板级封装、显示器、IC载板、锂电池以及电池CCS组件等制造,从用于实验室生产或试生产和小量生产的订制单机、标准化模块设备和系统生产线,到量产线的整厂生产设备解决方案。
集团销售活动分为两个市场:车用与锂电池解决方案和产业解决方案。车用与锂电池解决方案专注于高效锂电池的智慧生产解决方案。产业解决方案专注于电子零组件、电子电力以及消费性电子产品、电动动力系统组件的组装和生产解决方案。
Manz集团成立于 1987 年,自 2006 年起在法兰克福证券交易所上市。全球约 1,400 名员工位于德国、斯洛伐克、匈牙利、意大利、中国大陆和台湾进行开发和生产;美国和印度也设有销售和客户服务子公司。2021财年集团的收入约为 2.27 亿欧元。
审核编辑黄昊宇
-
半导体
+关注
关注
335文章
27850浏览量
223993 -
封装
+关注
关注
127文章
8042浏览量
143558
发布评论请先 登录
相关推荐
Manz集团成功交付多尺寸板级封装RDL量产线
Manz亚智科技RDL制程打造CoPoS板级封装路线,满足FOPLP/TGV应用于下一代AI需求

Manz亚智科技RDL制程打造CoPoS板级封装路线, 满足FOPLP/TGV应用于下一代AI需求

Manz亚智科技RDL设备切入五家大厂
使用SiC技术应对能源基础设施的挑战

扇入型和扇出型晶圆级封装的区别
台积电开始探索面板级封装,但三星更早?
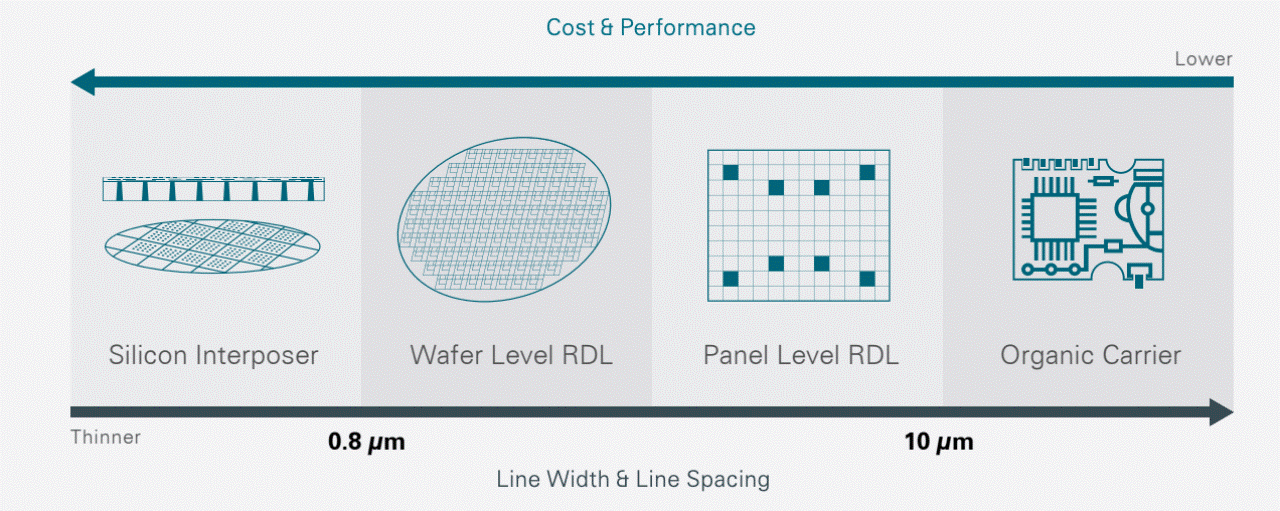
台积电加速先进封装产能建设应对AI芯片需求
技术突破:铝合金板件正面保护与3D视觉引导的完美结合

通富微电先进封装项目签约
产能之外,HBM先进封装的竞争
Manz亚智科技 RDL先进制程加速全球板级封装部署和生产





 Manz亚智科技板级封装突破业界最大生产面积 完美应对产能、成本双挑战
Manz亚智科技板级封装突破业界最大生产面积 完美应对产能、成本双挑战
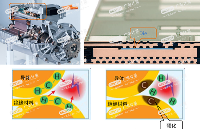










评论