半导体制造起始于对硅的加工,首先是将纯度达到 99.9999%的硅晶柱切割成不同厚度的晶圆,一般来说4in晶圆的厚度为 520um,6in 的为670um,8in 的为 725m,12in的为 775um。在晶圆上按照窗口刻蚀出一个个电路芯片,整齐划一地在晶圆上呈现出小方格阵列,每一个小方格代表着一个能实现某种特定功能的电路芯片。本文__【科准测控】__小编就来介绍一下半导体集成电路封装流程的划片方式、划片工艺步骤、准备工作以及晶圆切割、芯片拾取等!
在半导体制造过程中,受到圆形影响,晶圆边缘一定区域芯片图形工艺不完整,大致有三种情况如图 2-1 所示。考虑边缘区域图形不完整,制作掩模版时将其去除,每一个图形都是工艺、功能完整的晶粒、以便于良率统计、晶粒分拣、盲封。硅晶柱的尺寸越大,能切割出来的晶圆面积就越大,能产出功能完整的有效芯片晶粒数量就越多。所以芯片制造工艺越先进,晶圆尺寸越大,其中的每一只电路芯片的成本越能摊薄,半导体的生产成本就能下降。
半导体器件的发展方向是单个芯片越来越小,且单个芯片集成的晶体管数量越来越多。硅晶圆的发展趋势是晶圆尺寸越来越大,硅晶柱随着工艺的进步能生长为1in、2in、4in、6in(约150mm)、8in(约200mm),近年来发展出12in甚至研发更大规格(14in、16in,甚至20in以上)。
in英寸(旧也作时),lin~2.54cm。
一片晶圆上重复刻蚀了几只至几十万只电路芯片。晶圆上,电路芯片单元之间通过一定区域相互隔离开来,称作芯片晶粒隔离区域称作划片槽,如图2-2、图2-3所示。在使用芯片晶粒前需要通过有效的手段将其分割并单独取下。这时,就需要划片这道工序,将晶圆分割成一个个单独的芯片晶粒,再对芯片晶粒进行镜检、焊接、键合、封盖等工序,从而封装出能实现各种功能且不易被环境损伤的成品集成电路。
晶圆生产线制造好的一整片晶圆,在经过了探针台电测试后,通过切割工艺分割成制作集成电路所需的具有电气性能的独立芯片的过程,称为晶圆切割或划片。
图2-4给出了集成电路制造封装流程及划片工序位置。晶圆划片是电子封装工艺流程的首道工序,主要通过研磨、灼烧等方式完成分割。期间伴随着对晶圆的固定、清洗等工艺步骤,以保证芯片不被划片过程中产生的污物污染,保持晶粒的洁净度。同时,还要保证在划片过程中芯片电路功能的完整性和可靠性。
划片方式
最早的晶圆切割方法是物理切割,通过划片刀横、纵的切割运动,将晶圆分割成方形的芯片晶粒。现在,用金刚石砂轮划片刀(见图2-5)进行晶圆切割的方法仍然占据主流地位。机械划片的力直接作用在晶圆表面,会使晶体内部产生应力损伤,容易造成芯片崩边及晶圆破损。特别是对厚度在 100um 以下的晶圆划片时,极易导致晶圆破碎。机械划片速唐一般为810mm/s,划片速度较慢,且要求划片槽宽度大于 30um,高可靠电路的划片槽宽度则应更大,甚至达到 5060um,以确保芯片划片后的完整性和可靠性。一般芯片的预留划片槽宽度与切制用金刚石砂轮划片刀的推荐值如表 2-1 所示。机械划片原理示意如图 2-6所示。
激光切割属于无接触式划片,不对晶圆产生机械应力,对晶圆的损伤较小,可以避免芯片破碎、损坏等问题 (见图 2-7)。由于激光在聚焦上可达到亚微米数量级的特点,对晶圆的微处理更具有优势。同时激光划片速度可达 150mm/s,较机械划片速率有很大提高,并可以胜任较薄晶圆的加工任务,也可以用来切割一些较为复杂形状的芯片,如六边形。但是昂贵的设备成本是制约激光划片普及的因素之一。
划片工艺步骤
划片工艺开始前,首先要进行必要的准备工作;之后,是将待切割的晶圆片粘贴到蓝膜上,将蓝膜框架放人划片机开始划片过程,并实时清除掉划片产生的硅渣和污物;最后,把分割开的芯片拾取、保存,具体步骤如图 2-8 所示。
1. 准备工作
采用乙醇、无尘布擦拭贴膜机,并用氮气枪吹净工作台面及区域,必要时,打开去离子风扇,吹淋工作区域,去除静电干扰。检查待划片的晶圆(见图2-9),核对晶圆数量、批次信息,确保晶圆完好无破损。
2、贴装蓝膜
贴装蓝膜后的晶圆如图 2-10 所示。
- 蓝膜
蓝膜用来把晶圆背面固定在金属膜框上,起到固定晶圆、束缚晶粒的作用,从而使晶圆被切割分开成晶粒后晶粒不会散落。晶圆一般按照尺寸区分,这里的尺寸指的是晶圆的直径,常见的有6in、8in、12in。现在使用的高可靠电路,有一些稳定的老品种也使用4in 晶圆。蓝膜也具有相应尺寸的不同规格。
蓝膜的特征参数是厚度与黏附力。大多数用于硅晶圆划片的蓝膜厚度为 80~95um。膜的黏附力必须足够大,保证划片过程中能将已分离的每个晶粒牢牢地固定在膜上。当划片完成后,又能很容易地从膜上取下晶粒。
最常用的是普通蓝膜和紫外 (UV) 膜。普通蓝膜的成本大约是 UV 膜的 1/3。UV 膜的粘接强度是可变的,经紫外线照射之后,由于其粘接剂聚合发生固化,其黏附力减小90%.更易脱膜、揭膜,且无残留物。UV 膜具有极强的黏附力以固定晶圆,即使小晶粒也不会发生位移或剥除问题。通过紫外线照射降低黏附力,即使大晶粒也能轻松分拣,应力极其微弱,且晶粒背面无残留物。
(2) 贴膜框
贴膜框又称为晶圆环、膜框、金属框架等,采用金属材质,且具有一定的刚性,不会轻易变形,与贴膜机配套使用。贴膜框用于绷紧蓝膜,固定晶圆,便于后期的晶圆划片、晶粒分拣,避免晶圆切割后晶粒间由于蓝膜褶皱相互碰撞挤压而造成的损伤。
(3)装配过程
图2-11 给出了晶圆、蓝膜及贴膜框的装配图,图 2-12给出了晶圆、蓝膜及贴膜框的装配过程。首先,取出一片晶圆,正面朝下,背面朝上,将其放置在贴膜机工作盘上,打开真空开关,吸住晶圆。然后,将贴膜框放置在贴膜机工作台上,使其中心与晶圆中心对齐,并将侧边定位框移动至贴膜框外侧,将其左右限位。最后,拉出足够长度的蓝膜,拉紧后,贴在贴膜机后部,覆盖整个贴膜框区域,用滚筒压过蓝膜,将晶圆、蓝膜及框架装配到一起。
3、晶圆切割
按照芯片大小将晶圆分割成单一的晶粒,用于随后的芯片贴装、引线键合等工序。虽然,机械划片存在很多可靠性和成本上的问题,如晶圆机械损伤严重、晶圆划片线宽较大、划片速度较慢、需要冷却水切割、刀具更换维护成本较高等,但是,机械切割现在仍然是主要的划片方式。人们通过调整划片工艺参数、选择最佳的刀具类型、采用多次划片等方式,来解决机械划片中芯片崩边、分层、硅渣污染等问题。划片机切割晶圆如图 2-13所示。
4、清洗
晶圆切割过程中主要是清洗划片时产生的各种硅碎屑、粉尘,清洁晶粒,并对划片刀起到降温冷却作用。
冷却介质根据划切材料的质量要求,用去离子水或自来水及其他冷却介质。冷却流量一般用流量计调节控制流量大小,正常为 0.2~4L/mn。流量大小要根据刀刃及划切材料的种类和厚度来调节,流量大会冲走划切中粘接不牢固的芯片,对特别薄的刀刃,流量大有时也影响刀刃的刚性:流量小又会影响刀刃寿命和划切质量。
5、芯片拾取
用UV 光照射后,UV 膜黏性减退,便于拾取分割好的晶粒,如图 2-14 所示
表 2-2 给出了划片工序涉及的主要设备、部件及耗材和作用。
以上就是关于半导体集成电路封装划片方式、工艺步骤、准备工作及晶圆切割、芯片拾取的分享了,希望对大家能带来帮助!如果您对半导体芯片、集成电路、推拉力测试机有任何不清楚的问题,欢迎给我们私信或留言,科准测控的技术团队都会为大家解答!还想了解更多有关半导体集成电路的知识,敬请关注!
审核编辑 黄宇
-
芯片
+关注
关注
455文章
50729浏览量
423182 -
集成电路
+关注
关注
5387文章
11535浏览量
361652 -
半导体
+关注
关注
334文章
27298浏览量
218130 -
封装
+关注
关注
126文章
7879浏览量
142898
发布评论请先 登录
相关推荐
芯和半导体将参加2024集成电路特色工艺与先进封装测试产业技术论坛
ASIC集成电路设计流程
集成电路工艺学习之路:从零基础到专业水平的蜕变

集成电路封装基板工艺详解:推动电子工业迈向新高度!
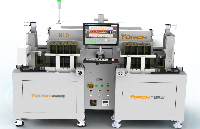




 半导体集成电路封装流程|划片工艺详解
半导体集成电路封装流程|划片工艺详解

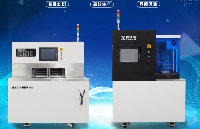










评论