
集成电路封装作为集成电路产业链中不可或缺的环节,一直伴随着集成电路芯片技术的不断发展而变化。传统上,封装的作用包含对芯片的支撑与机械保护,电信号的互连与引出,电源的分配和热管理。
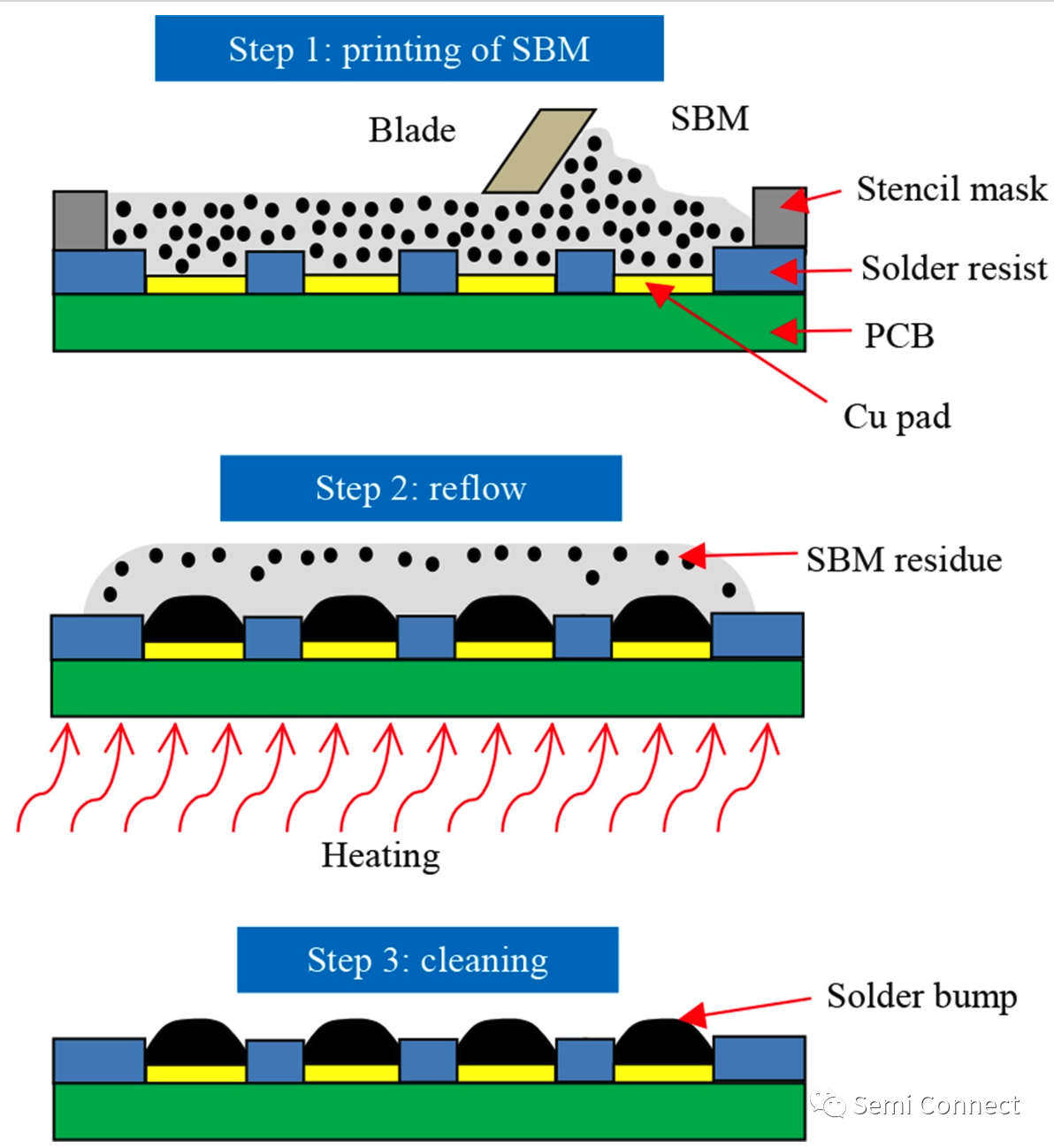
随着芯片技术的发展,封装具有了新的作用,如功能集成和系统测试。从封装类型的发展来看,早期的封装主要是金属晶体管外形 (Transistor Out-line, TO)封装和陶瓷双列直插封装(CeramicDual In-line Package, CDIP),它们都属于通孔插装型(Pin ThroughHole, PTH) 的封装形式。随着集成电路芯片技术的进步,对封装密度提出了越来越高的要求,这就导致了越来越多封装形式的出现。从20世纪90年代初期开始,双列直插的通孔插装型封装逐渐转向了适应于表面贴装的封装形式,典型的形式包括小外形封装(Small Outline Package, SOP )、四面引线扁平封装(Quad Flat Package, QFP)、球栅阵列 (Ball Crid Aray, BGA)封装等。
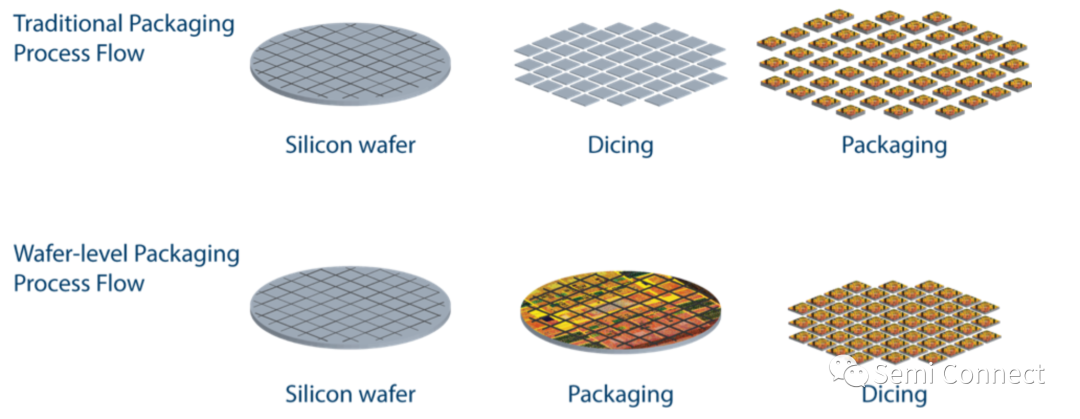
随着技术的进一步发展,圆片级封装 ( Wafer Level Package, WLP)、三维封装 (Three Dimension Package, 3DP)和系统级封装 (Systemin Package, SiP) 等形式相继出现,封装形式与封装技术之间在名称上的区分也越来越模糊。按照芯片到封装体之间的互连方法划分,目前通常有引线键合 ( Wire Bonding, WB)、载带自动键合 (Tape Autorated Bonding, TAB)、倒装芯片 (Flip Chip, FC) 和硅通孔(Through silicon Via, TSV)技术等。 传统的封装形式主要是利用引线框架作为载体,采用引线键合互连的形式(如DIP、SOP 和QFP 等);之后出现了采用引线键合互连并利用封装基板来实现(如 BGA、LGA 等)的封装形式,并逐渐采用在封装基板上的倒装芯片实现(如 FC-BGA 等)。
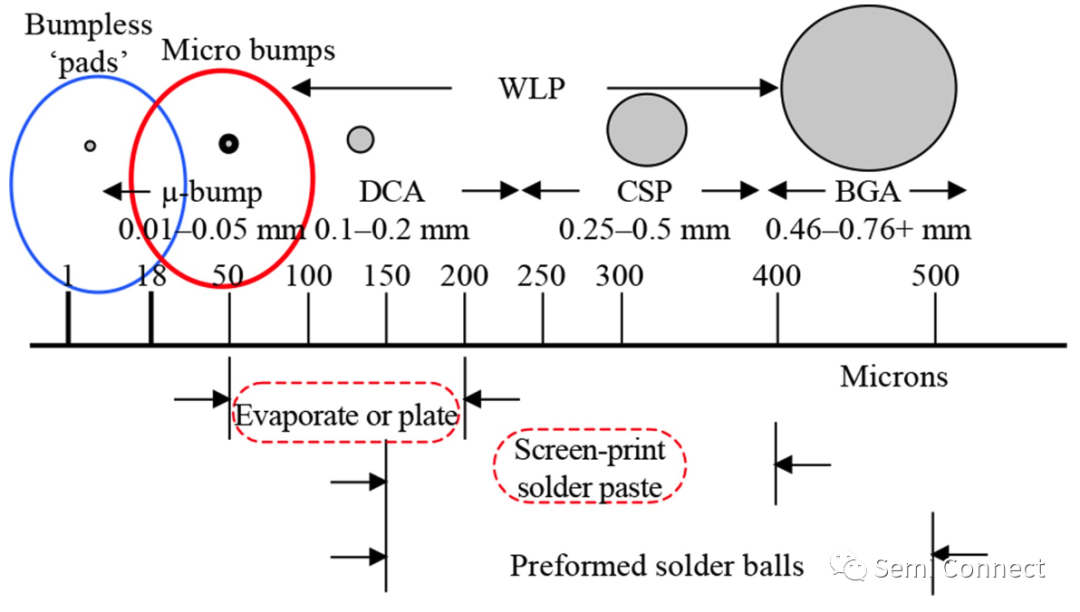
国际半导体技术路线图(ITRS)曾经明确提出了未来集成电路技术发展的两个方向:一是 More Moore,即延续摩尔定律;二是 More than Moore,即拓展摩尔定律。沿着拓展摩尔定律方向发展的技术路线,更关注将多种功能芯片集成在一个系统中,包括信息处理芯片(如处理器、存储器等)和信息交互芯片(如射频芯片、传感器等),因此系统级封装成为了末来封装技术和系统集成的主流技术路线之一。
审核编辑 :李倩
-
集成电路
+关注
关注
5396文章
11643浏览量
363722 -
产业链
+关注
关注
3文章
1352浏览量
25900 -
封测
+关注
关注
4文章
351浏览量
35262
原文标题:全球封测业发展现状与趋势
文章出处:【微信号:Semi Connect,微信公众号:Semi Connect】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
相关推荐
中国功率器件市场发展现状
全球机器人发展现状
2017全球LED照明驱动电源市场发展现状及未来趋势概述
2017全球电子书阅读器市场发展现状及未来趋势概述
广播电视发展现状及趋势
云计算产业发展现状及趋势
浅析变频器发展现状和趋势
中国智能制造发展现状及趋势分析报告
中国芯片发展现状和趋势
深度解读工控安全技术发展现状与应用趋势





 全球封测业发展现状与趋势
全球封测业发展现状与趋势










评论