封装的热特性对于IC应用的性能和可靠性至关重要。本文介绍标准的热封装特性:热阻(称为“θ”或 Θ)、ΘJA、ΘJC 和 ΘCA。提供了热计算和有关热管理的更多信息的参考。
介绍
在选择封装时应考虑热管理,以确保高产品可靠性。所有IC在通电时都会产生热量。因此,为了将器件的结温保持在允许的最大值以下,从IC通过封装到环境的有效热流至关重要。本文可帮助设计人员和客户了解基本的IC热管理概念。在讨论封装传热时,它定义了热表征的重要术语,从热阻及其各种“θ”表示开始。本文还提供了热计算和数据,以确保正确的结(芯片)、外壳(封装)和电路板温度。
热阻的重要性
半导体的热管理涉及热阻,这是描述材料传热特性的重要品质因数。在计算中,热阻被识别为“Theta”,源自希腊语中的热“热水瓶”。我们特别感兴趣的是热阻。
IC封装的热阻是衡量封装将IC(芯片)产生的热量传递到电路板或环境的能力的指标。给定两点的温度,从一个点到另一个点的热流量完全由热阻决定。通过了解封装的热阻,可以计算给定功耗下的IC结温及其参考温度。
定义
以下部分定义了 Theta (Θ) 和 Psi (Ψ),这是 IC 封装热表征中使用的标准术语。
ΘJA是从结点到环境的热阻,测量单位为°C/W。 环境被视为热“接地”。 ΘJA取决于封装、电路板、气流、辐射和系统特性。一般来说,辐射的影响可以忽略不计。ΘJA值仅针对自然惯例条件(无强制空气)列出。
ΘJC是从结到外壳的热阻。外壳是包装外表面上的指定点。ΘJC取决于封装材料(引线框架、模塑料、芯片粘接粘合剂)和特定的封装设计(芯片厚度、裸露焊盘、内部热通孔和所用金属的导热性)。
对于引线封装,ΘJC 外壳上的参考点是引脚 1 从塑料中出现的位置。对于标准塑料封装,ΘJC 在引脚 1 的拐角处测量。它是在裸焊盘封装的裸焊盘表面的中心测量的。The Θ杰克通过将封装直接连接到“无限散热器”来完成测量,“无限散热器”通常是液冷铜块,可以吸收任何数量的热流而没有热阻。测量表示纯粹通过传导将热量从芯片传递到封装表面。
注意 Θ杰克仅考虑到封装表面的热流路径的阻力。因此,ΘJC 始终小于 ΘJA.因此,ΘJC 代表特定的、导电的热路径热阻,而 ΘJA表示传导、对流和辐射热路。
ΘCA是从外壳到环境的热阻。ΘCA包括从封装外部到环境的所有热路径的热阻。
鉴于上述定义,我们看到:
ΘJA = ΘJC + ΘCA
ΘJB是从结到电路板的热阻。Θ新山量化结到板热路径,通常在靠近引脚1(距离封装边缘1mm<<>mm)附近的电路板上进行测量。Θ新山包括来自两个来源的热阻:从IC的结点到封装底部的参考点,以及通过封装下方的电路板。
测量 ΘJB,来自封装顶部的对流被阻挡,并且冷板附着在与封装位置相对的电路板远侧。请参见下面的图 1。
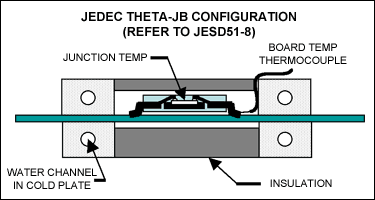
图1.θ JB 测量过程图示。
ΨJB是结到板热特性参数,以°C/W为单位进行测量。JESD51-12《封装热信息报告和使用指南》阐明了热特性参数与热阻不同。相反,ΨJB测量流经多个热路径而不是单个直接路径的组件功率,如热阻,ΘJB.因此,ΨJB热路径包括来自封装顶部的对流,这一事实使ΨJB对客户应用更有用。
设计人员可以确定 ΘJB和 ΨJB通过热建模或直接测量的值。在任一情况下,请按照以下步骤操作:
控制适合 ΘJB 或 ΨJB 的功耗条件。
确定芯片温度,通常使用片上二极管。
确定距离封装边缘 < 1mm 处的 PCB 温度。
确定功耗。
ΨJT是测量结温与封装顶部温度之间的温度变化的表征参数。ΨJT可用于在已知封装顶部温度和功耗时估算结温。
热计算
结温
TJ = 结温
TA= 环境温度,以及
P = 功耗(瓦特)
TJ 也可以通过使用 ΨJB 或 ΨJT 值作为来计算。TJ = TB + (ΨJB × P)
其中:
TB = 在封装 1mm 范围内测得的电路板温度
TJ = TT + (ΨJT × P)
其中:
TT = 在封装顶部中心测量的温度。
注意:产品数据手册规定了每个器件的最大允许结温。
最大允许功耗
Pmax = (TJ-max - TA) / ΘJA
Maxim列出的最大允许功率假设环境温度为+70°C,最大允许结温为+150°C。
减额功能
此功能描述在+70°C以上每°C环境温度下必须降低多少功耗。 减额函数以 mW/°C 表示。
减额函数= P / (TJ - TA)
其中:
TA 通常为 +70°C(商用)
和:
TJ是最高允许结温,通常为+150°C。
要找到环境温度高于 +70°C 时的最大允许功率(例如,扩展温度范围内的 +85°C),请执行以下操作:
Pmax85C = Pmax70C - (Deration Function × (85 - 70))
热表征和测量条件
IC封装的热性能必须使用JEDEC标准的方法和设备进行测量。使用特定应用的电路板进行表征可能会产生不同的结果。还可以理解,JEDEC 定义的配置并不代表典型的实际系统。相反,JEDEC 配置允许标准化的热分析和测量以保持一致性;它们对于比较封装变化之间的热品质因数最有用。
JEDEC 规范标题
JESD51:元件封装的热测量方法(单半导体器件)
JESD51-1:集成电路热测量方法—电气测试方法(单半导体器件)
JESD51-2: 集成电路热测试方法环境条件—自然对流(静止空气)
JESD51-3: 用于引线表面贴装封装的低效导热测试板
JESD51-4:热测试芯片指南(引线键合型芯片)
JESD51-5:直接热连接机制封装热测试板标准的扩展
JESD51-6:集成电路热测试方法环境条件—强制对流(流动空气)
JESD51-7: 用于引线表面贴装封装的高效导热测试板
JESD51-8:集成电路热测试方法环境条件—结到板
JESD51-9: 面阵表面贴装封装热测量测试板
JESD51-10: 用于通孔周界引线封装热测量的测试板
JEDEC51-12:报告和使用电子封装热信息指南
JEDEC 散热多层测试板规范 JESD51-7 摘要
用于引线表面贴装封装的高效导热测试板
JESD51-7规范中描述的热测试板最适合Maxim IC应用。
材料:FR-4
层:两个信号(正面和背面)和两个平面(内部)
成品厚度:1.60±0.16毫米
金属厚度:
正面和背面:2oz铜(0.070mm成品厚度)
两个内部平面:1盎司铜(0.035mm成品厚度)
介电层厚度:0.25毫米至0.50毫米
电路板尺寸:76.20mm x 114.30mm ±0.25mm,适用于侧面小于27mm的封装
组件侧迹线设计
走线的布局应使测试设备在电路板上居中。走线必须从封装主体边缘延伸至少 25 毫米。对于 0.25mm 或更大间距封装,走线宽度应为 10.0 ±5%。对于间距较细的封装,走线宽度应等于引线宽度。走线模式和走线端接要求在JESD51-7中规定。
背面走线设计
端接通孔的元件侧走线可以通过走线或电线(22 AWG 或更小的铜线)连接到边缘连接器。JESD51-7规定了不同导线尺寸的电流限值。
电源和接地层必须不间断,但通孔隔离间隙模式除外。平面不得出现在边缘连接器图案的 9.5mm 范围内。
裸焊盘封装
裸焊盘 (EP) 封装(如 QFN、DFN(双扁平封装无引线)和 EP-TQFP)对热性能的一个关键要求是裸焊盘焊点下的热通孔设计。在典型的热特性板设计中,有 4、9 或 16 个热通孔阵列连接到最近的接地层。热改善在 25 个过孔以上变得渐近。了解电路板热通孔与系统热性能之间的直接关系至关重要。请参考JESD51-5,了解裸焊盘封装的电路板设计增强功能。
焊料覆盖范围
当客户表征他们的电路板焊接工艺时,他们应该以焊点覆盖率达到 90% 或更高的目标。当焊点空隙接近50%或更多时,由此产生的热通孔断开将对热阻产生灾难性影响。
热建模
FLOTHERM 和其他热分析软件程序可实现准确的封装和系统热预测。当适当的热模型与经验数据相结合时,用户可以高度确信结果准确反映了实际应用。
电气设计工具(如PSPICE或Cadence工具)可用于制作封装的简单热模型。封装元件表示为电阻器网络中连接到电路板的电阻器。当确认封装模型与经验数据一致时,该模型可用于预测封装变化,包括:芯片尺寸、裸焊盘尺寸、熔丝引线或连接到平面的接地数。这些“假设”模型可以相当准确地预测自定义配置。
审核编辑:郭婷
-
芯片
+关注
关注
456文章
51157浏览量
426788 -
散热器
+关注
关注
2文章
1057浏览量
37720 -
辐射
+关注
关注
1文章
604浏览量
36412
发布评论请先 登录
相关推荐
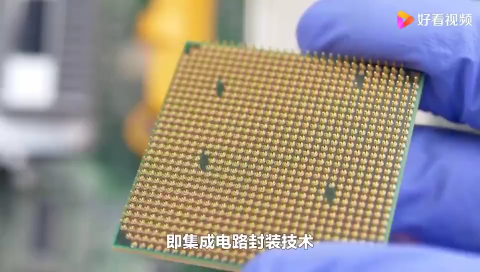




 IC封装的热表征
IC封装的热表征













评论