引言
在过去时间里,在三维与非型碰撞记忆制造中,氮化硅/氧化硅堆栈的数量增加,SiNx/SiOy层重复层的厚度随着垂直存储密度的增加而不断减小。因此,在SiNx/SiOy堆栈中,SiNx层均匀、超高选择性的对SiOy层的蚀刻越来越具挑战性。到目前为止,SiNx在SiNx堆/SiOy堆中的选择性蚀刻是通过使用热磷酸(h3po4)3-6进行湿式蚀刻来实现的。(江苏英思特半导体科技有限公司)
此外,一些用于提高SiNx/SiOy蚀刻选择性的添加剂被发现会在蚀刻后引起氧化物再生问题,除非其工艺条件没有被仔细控制5。为了解决这些问题,需要开发一种各向同性和选择性蚀刻的干法工艺,作为三维非和型碰撞存储器制造的替代技术。(江苏英思特半导体科技有限公司)
实验
图1是本研究中使用的一种远程型电感耦合等离子体(ICP)蚀刻系统的示意图。工艺室内的Te通过阳极氧化法涂覆了氧化铝层。用对流计测量的工艺室的基本压力保持在3×10-3Torr,用电容压力计(气压计)监测的工作压力保持在200 mTorr。对腔室上部的平面型ICP线圈施加13.56 MHz射频功率。(江苏英思特半导体科技有限公司)
对于SiNx的各向同性蚀刻,在ICP反应器中心设置了半径为1.5 mm的多孔的双栅,以防止离子轰击,并在基底上传递自由基。样品温度在样品下方的样品阶段测量,该温度由热电偶监测,并通过连接到外部电源的碳化硅(碳化硅)加热器从25调整到500°C。三氯(ClF3,>99.9%,200 sccm)、H2(>99.999%)和氩(>99.999% Ar,200 sccm)通过圆形气体分配器融合到工艺室。
结果和讨论
图2显示了仅使用三氟化氯气体和三氟化氯远端等离子体的SiNx和SiOy的蚀刻特性。对于三氟化氯远端等离子体,在200 sccm的三氟化氯中加入200 sccm,以提高等离子体的稳定性。如图2a所示,随着射频功率的增加,由于三氟化氯的解离增强,SiNx和SiOy的蚀刻率逐渐增加,分别在~ 90和~ 0.8 nm/min时达到SiNx和SiOy的最大蚀刻率。需要注意的是,SiNx对SiOy的蚀刻选择性对100~400 W的射频功率没有明显变化。如图2b所示,SiNx和SiOy也可以仅通过混合三氟化氯气体进行蚀刻,而不通过射频等离子体解离三氟化氯,而底物温度的升高提高了两种flms的蚀刻速率。
然而,三氟化氯气体处理的整体SiNx蚀刻率仅比三氟化氯远端等离子体蚀刻要低得多,这表明三氟化氯远程等离子体蚀刻比无等离子体热蚀刻是更有效的SiNx蚀刻方法。同时,尽管两种材料的蚀刻速率都随着衬底温度的升高而提高,但SiNx对SiOy的蚀刻选择性都降低了。远端等离子体蚀刻也有同样的趋势。如图2c所示,在300 W的弯曲射频功率下,随着底物温度升高到500°C,蚀刻选择性在40以下逐渐降低,而在600 nm/min时SiNx蚀刻速率增加。(江苏英思特半导体科技有限公司)
图1.远程型电感耦合等离子体(ICP)蚀刻器示意图。
图2.SiNx和SiOy (a)的蚀刻特性作为三氟化氯远程等离子体射频功率的函数,(b)作为基底温度和三氟化氯气体化学蚀刻的函数,(c)作为三氟化氯远程等离子体衬底温度的函数。
结论
利用带有ICP源的ClF3/H2远端等离子体,研究了SiNx在SiOy上的各向同性和选择性蚀刻作用。与仅采用热蚀刻或等离子体蚀刻相比,采用等离子体辅助热工艺的Te SiNx蚀刻显示出最高的蚀刻速率和最光滑的表面形态。在三氟化氯远端等离子体中,SiNx和SiOy的温度温度依赖性蚀刻特性表明,SiOy的活化能高于SiNx。
此外,在三氟化氯等离子体中加入H2(20%)提高了SiNx对SiOy的蚀刻选择性,从130提高到200,尽管SiNx的蚀刻率从83降低到23nm/min。我们相信,快速、超高选择性的SiNx蚀刻技术不仅可以应用于下一代三维非和型碰撞存储器制造工艺,还可以应用于需要精确的SiNx蚀刻的各种半导体工艺。(江苏英思特半导体科技有限公司)
审核编辑 黄宇
-
半导体
+关注
关注
335文章
28004浏览量
225446 -
蚀刻
+关注
关注
9文章
422浏览量
15635 -
氮化硅
+关注
关注
0文章
77浏览量
380
发布评论请先 登录
相关推荐
等离子体蚀刻工艺对集成电路可靠性的影响

LPCVD氮化硅薄膜生长的机理

OptiFDTD应用:纳米盘型谐振腔等离子体波导滤波器
氮化硅薄膜的特性及制备方法

等离子体发射器的工作原理
等离子体技术在航天中的作用
等离子体电导率的影响因素
等离子体的定义和特征
等离子体在医疗领域的应用
等离子体清洗的原理与方法
氮化硅薄膜制备方法及用途

什么是电感耦合等离子体,电感耦合等离子体的发明历史
利用氨等离子体预处理进行无缝间隙fll工艺的生长抑制





 使用 ClF 3 H 2远程等离子体在氧化硅上选择性蚀刻氮化硅
使用 ClF 3 H 2远程等离子体在氧化硅上选择性蚀刻氮化硅

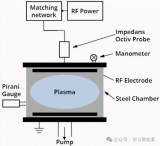










评论