四面无引线扁平 (Ouad Flat No-lead Package, QFN)封装属于表面贴装利封装,是一种无引脚且星方形的封装,其封装四侧有对外电气连接的导电焊盘(引脚),引脚节距一般为 0.65mm、0.5mm、0.4mm、0.35mm。 由于封装体外部无引脚,其贴装面积和高度比 QFP 小。QPV 封装底部中央有一个大面积外歸的导热焊盘。QFN 封装无鸥翼状引线,内部引脚与焊盘之问的导电路径短,自感系数及体内线路电阻低,能提供优越的电性能。外露的导热焊盘上有散热通道,使 QFN 封装具有出色的散热性。
如下图所示的分别是 WB-QFN ( Wire Bonding-QFN) 和FC-OFN(Filp Chip-QFN)基本结构示意图。这些结构加上 MCP 技术和 SiP 等封装技术,为 QFN 的灵活多样性提供了良好的 I/O 设计解快方案,也进一步提高了封装密度。

QFN 封装工艺流程与传统封装的接近,主要差异点如下所述。
(1)QPN 产品框架在塑封前一般采取贴膜工艺,进行球焊时的球焊参数模式与传统的有差异,若控制不当,会造成焊线第2点的断裂;另外,矩阵框架的塑封工艺必须采取多段注射方式来避免气泡和冲线的发生。
(2)QFN产品的分离是采取切割工艺来实现的,切割过程中要采取合适的工艺(如低温水)来避免熔锡,采用树脂软刀来减少切割应力,采用合适的切割速度来避免分层等。
(3) QFN 产品通过选择不同收缩率的塑封料来控制翘曲,不同厚度和大小的芯片需要选择不同收缩率的塑封料。
(4) QFN 产品的框架均为刻蚀框架,框架设计包含应力、抗分层、预防毛刺等考虑因素,框架设计的好坏决定着产品品质的水平。传统上芯(装片)的 QFN 产品的生产工艺流程如下:

倒装上芯的 QFN 产品的生产工艺流程如下:

随着现代电子信息技术的飞速发展,对电子产品的小型化、便携化、多功能、高可靠性和低成本等提出 了越来越高的要求,因 QFN 封装可以很好地适应了这个需要,所以其市场份额将会越来越大。
审核编辑:汤梓红
-
SiP
+关注
关注
6文章
543浏览量
107990 -
封装
+关注
关注
128文章
9317浏览量
149024 -
qfn
+关注
关注
3文章
216浏览量
58455 -
引脚
+关注
关注
16文章
2119浏览量
56000 -
焊盘
+关注
关注
6文章
605浏览量
39886
原文标题:QFN 封装工艺,QFN 封装製程,QFN Process
文章出处:【微信号:Semi Connect,微信公众号:Semi Connect】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
半导体封装工艺流程的主要步骤

IC芯片的封装工艺流程
倒装晶片的组装工艺流程
SMT组装工艺流程的应用场景(多图)
SMT组装工艺流程的应用场景
BGA的封装工艺流程基本知识简介
芯片封装工艺流程是什么
芯片封装工艺流程讲解
博捷芯划片机:QFN封装工艺流程揭秘及芯片切割分离技术及工艺应用




 浅谈QFN封装工艺流程
浅谈QFN封装工艺流程

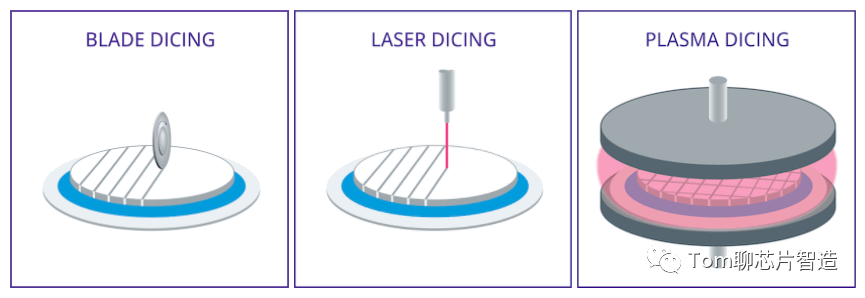





评论