陶瓷封装工艺是指采用陶瓷外壳 (Ceramic Packaging Shell, CPS)或陶瓷基板作为封装载体,在陶瓷外壳的芯腔或陶瓷基板芯片安装区黏结或焊接上芯片,再通过号线键合或倒装焊等进行芯片与外壳或基板的互连,然后用金属或陶瓷盖板、管帽将芯片密封在空腔中的一类半导体组装工艺过程。陶瓷封装是为了适应电子产品在恶劣环境(如高温、高湿度、高能辐照环境等)、长寿命等需求而发展起来的高可靠性封装。
陶瓷封装材料有氧化铝(A1₂O₃,)、氮化铝(AIN)、碳化硅(SiC)等。高功率密度集成电路封装通常采用高热导率陶瓷外壳或基板。按烧成温度的不同,它们又分为高温共烧陶瓷 ( High Temperature Co-fired Ceramics, HTCC)和低温共烧陶瓷 (Low Temperature Co-fired Cerarnics, LTCC)外壳或基板,LTCC 中又有与 FR4 等有机基板热膨胩系数接近的高热膨账系数陶瓷基板,以及与硅芯片等热膨胀系数较为接近的低热膨胀系数陶瓷基板。
陶瓷封装主要包括陶瓷双列直插封装(CDIP)、陶瓷无引线片式载体封装(CLCC)、陶瓷双列无引脚(CDFN)封装、陶瓷四面无引线扁平(CQFN)封装、陶瓷四面引线扁平封装 (CQFP)、陶瓷“丁”形引线四面扁平(CQFJ) 封装、陶瓷小外形封装(CSOP)、陶瓷“丁”形引线小外形(CSOJ)封装、陶瓷针栅阵列(CPGA)封装、交错式针栅阵列 (Staggered Pin Grid Array, SPGA)封装、微型针栅阵列(从PGA)封装、陶瓷触点阵列 (CIGA)封装、陶瓷球栅阵列(CBGA)封装、陶瓷焊柱阵列 (CCGA)封装、低温玻璃熔封系列陶瓷封装、带光窗结构的陶瓷封装等。不同的陶瓷封装形式的封装工艺是有差异的;针对不同的质量要求,封装工艺也会有所不同。
下图所示为陶瓷封装典型工艺流程图。

陶瓷封装工艺流程中的许多工艺与塑料封装流程中的许多工艺是相同的,如圆片减薄、圆片背面金属化、芯片贴装、引线键合(焊线)、倒装焊、回流焊、底部填充、植球或植柱、打标、成型剪边(需要时)、包装等。而密封、检漏、植柱是陶瓷封装中所特有的工艺。
(1)密封:密封工艺有平行缝焊、玻璃熔封、合金焊料熔封、激光封焊等,与金属封装工艺中的密封工艺基本相同,但金属封装中的储能焊不适合作为陶瓷封装的密封工艺,陶瓷封装中的玻璃熔封工艺不适合作为金属封装的密封工艺。
(2)检漏:是指对有内空腔的集成电路通过加压示踪气体(如氦、氪一85 等)、示踪剂(如氟碳化合物、染料等),在规定压强、时间下通过漏孔渗人,再在规定时间内用可以定量分析示踪气体释放来判断密封漏率大小及是否合格的过程。对薄型盖板集成电路,也可通过加一定气压使之变形,再用光干涉仪观测盖板变形来确定漏率并判断其是否合格。
(3)植柱:植柱与 PBGA 或 CBGA 植球工艺基本相同。下图所示为典型CCGA 植柱工艺示意图。植柱采用焊膏印刷工艺、回流焊工艺,在焊柱过程中必须采用模具以保证焊柱与外壳或基板面垂直,以及焊柱外端面的共面性在0.1mm 内。

审核编辑:刘清
-
cps
+关注
关注
2文章
45浏览量
17513 -
SiC
+关注
关注
30文章
2977浏览量
63345 -
PGA封装
+关注
关注
0文章
5浏览量
9619 -
LTCC技术
+关注
关注
0文章
22浏览量
3993
原文标题:陶瓷封装工艺,陶瓷封裝製程,Ceramic PackagingProcess
文章出处:【微信号:Semi Connect,微信公众号:Semi Connect】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
相关推荐
一文详解2.5D封装工艺

封装工艺简介及元器件级封装设备有哪些

功率模块封装工艺

瑞沃微:一文详解CSP(Chip Scale Package)芯片级封装工艺

陶瓷垫片的性能特点和安装工艺

芯片封装工艺集成工程师的必修课程指南
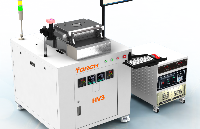
京瓷光源用的陶瓷封装产品介绍

Nand Flash常用的封装工艺
mos封装工艺是什么,MOS管封装类型
闲谈半导体封装工艺工程师
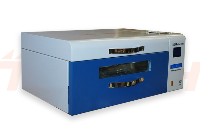
常见的BGA混装工艺误区分享





 陶瓷封装工艺介绍
陶瓷封装工艺介绍











评论