通过测量晶片上的残留物得知,晶片上已经分配并干燥了含有金属盐作为示踪元素的溶液。假设有两种不同的沉积机制:吸附和蒸发沉积。
第一种机制是污染物和晶圆表面之间吸引相互作用的结果,而第二种机制是由于干燥过程中的液体蒸发。
对于第二种情况,蒸发膜厚度被引入作为所研究干燥过程的品质因数。将旋转干燥与两种基于 Marangoni 的干燥进行了比较:在垂直移动的晶圆上和在水平旋转的晶圆上。
结果表明,对于旋转干燥,会发生两个连续的阶段:在旋转的前几秒,液体对流去除是主要机制,随后是蒸发接管的阶段。旋转干燥过程中液体蒸发量与旋转速度的平方根成反比。这表明晶片表面上的气流夹带液体是蒸发的主要机制。这一发现与描述旋转基板夹带的气体流动的流体动力学模型一致。在垂直移动的晶圆上和水平旋转的晶圆上。
审核编辑:汤梓红
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
芯片
+关注
关注
463文章
54484浏览量
469846 -
半导体
+关注
关注
339文章
31298浏览量
266894 -
晶圆
+关注
关注
53文章
5454浏览量
132816
发布评论请先 登录
相关推荐
热点推荐
一机覆盖六大高端场景,CSE智净工作站适配半导体全产业链需求
半导体湿制程工艺应用场景多元,从晶圆制造、芯片封装到新材料研发、科研中试,不同场景对设备的低氧性能、洁净等级、安全标准有着严苛且差异化的要求。华林科

定义光刻精度标准——华林科纳显影湿法设备:纳米级图形化解决方案
提供可靠的图形化保障。以下深度解析其工艺优势与技术创新。 一、设备核心工艺流程 华林科纳四步闭环工艺,实现亚微米级图形保真 (1)预处理(Pre-wetting) 去离子水浸润:均匀润湿晶

晶圆去胶工艺之后要清洗干燥吗
在半导体制造过程中,晶圆去胶工艺之后确实需要进行清洗和干燥步骤。以下是具体介绍:一、清洗的必要性去除残留物光刻胶碎片:尽管去胶工艺旨在完全去除光刻胶,但在实际操作中,可能会有一些微小的


晶圆清洗后如何判断是否完全干燥
判断晶圆清洗后是否完全干燥需要综合运用多种物理检测方法和工艺监控手段,以下是具体的实施策略与技术要点:1.目视检查与光学显微分析表面反光特性观察:在高强度冷光源斜射条件下,完全干燥的

晶圆边缘 TTV 测量的意义和影响
摘要:本文探讨晶圆边缘 TTV 测量在半导体制造中的重要意义,分析其对芯片制造工艺、器件性能和生产良品率的影响,同时研究测量方法、测量设备精度等因素对测量结果的作用,为提升





 华林科纳的半导体晶圆干燥的研究
华林科纳的半导体晶圆干燥的研究





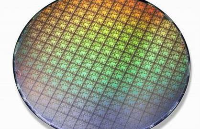






评论