镀银晶圆的材料特性
晶圆经过背面研磨减薄后,经由背面蒸镀金属,切片加工而成的芯片将在器件热阻降低、工作散热和冷却、封装厚度减薄等各个方面实现很大的改善。
在晶圆背面金属化过程中,一般选择钛、镍、银作为三层背面金属,厚度在10μm以内。
通常,切割的晶圆的质量标准是:如果背面碎片的尺寸在10µm以下,忽略不计,当尺寸大于25µm时,可以看作是潜在的受损,50µm的平均大小可以接受。当然,具体切割要求也要根据晶圆的厚度来定。
镀银晶圆的应用
晶圆背面金属化的主要目的是使接触电极形成良好的欧姆接触,经过背面金属化的芯片具有饱和压降小、焊接可靠、通态源漏电阻小、散热性好、工作能耗低等特点,常用于中小功率晶体管。
选刀要点
切片系统与刀片之间的协作是必要的,刀片在晶圆切片工艺优化中起着主要的作用。金刚石尺寸、金刚石含量和粘结剂的类型,是决定刀片特性的三个关键参数,决定着刀片的寿命和切削质量,改变任何一个这些参数都将直接影响刀片特性与性能。为一个给定的切片工艺选择最佳的刀片需要在刀片寿命与切削质量之间作出平衡。


西斯特科技
深圳西斯特科技有限公司 (简称西斯特SST) ,以“让一切磨削加工变得容易”为主旨,倡导磨削系统方法论,2015年金秋创立于深圳,根植于技术创新的精神,屹立于创造价值、追求梦想的企业文化。
基于对应用现场的深度解读、创新性的磨具设计和磨削系统方法论的实际应用,西斯特秉承先进的磨削理念,践行于半导体、消费电子、汽车零部件等行业,提供高端磨具产品以及“切、磨、钻、抛”系统解决方案,在晶圆与封装基板划切、微晶玻璃和功能陶瓷磨削、汽车零部件精密磨削等领域应用广泛。
西斯特科技始终以先进的技术、创新的产品、优质服务的理念,引领产业革命,创造无限可能。
-
晶圆
+关注
关注
52文章
4923浏览量
128083
发布评论请先 登录
相关推荐
晶圆背面涂敷工艺对晶圆的影响

怎么制备半导体晶圆片切割刃料?

碳化硅晶圆和硅晶圆的区别是什么
Monaco 新款 50W 紫外飞秒激光器,助力晶圆和堆叠 OLED 屏的高效切割

一文看懂晶圆级封装

突破划片机技术瓶颈,博捷芯BJX3352助力晶圆切割行业升级
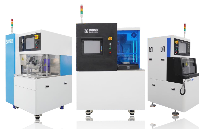
芯片制造全流程:从晶圆加工到封装测试的深度解析





 案例分享第七期:背银晶圆切割实例
案例分享第七期:背银晶圆切割实例
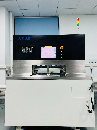
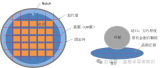















评论