车载定位仪BGA芯片底部填充胶由汉思新材料提供
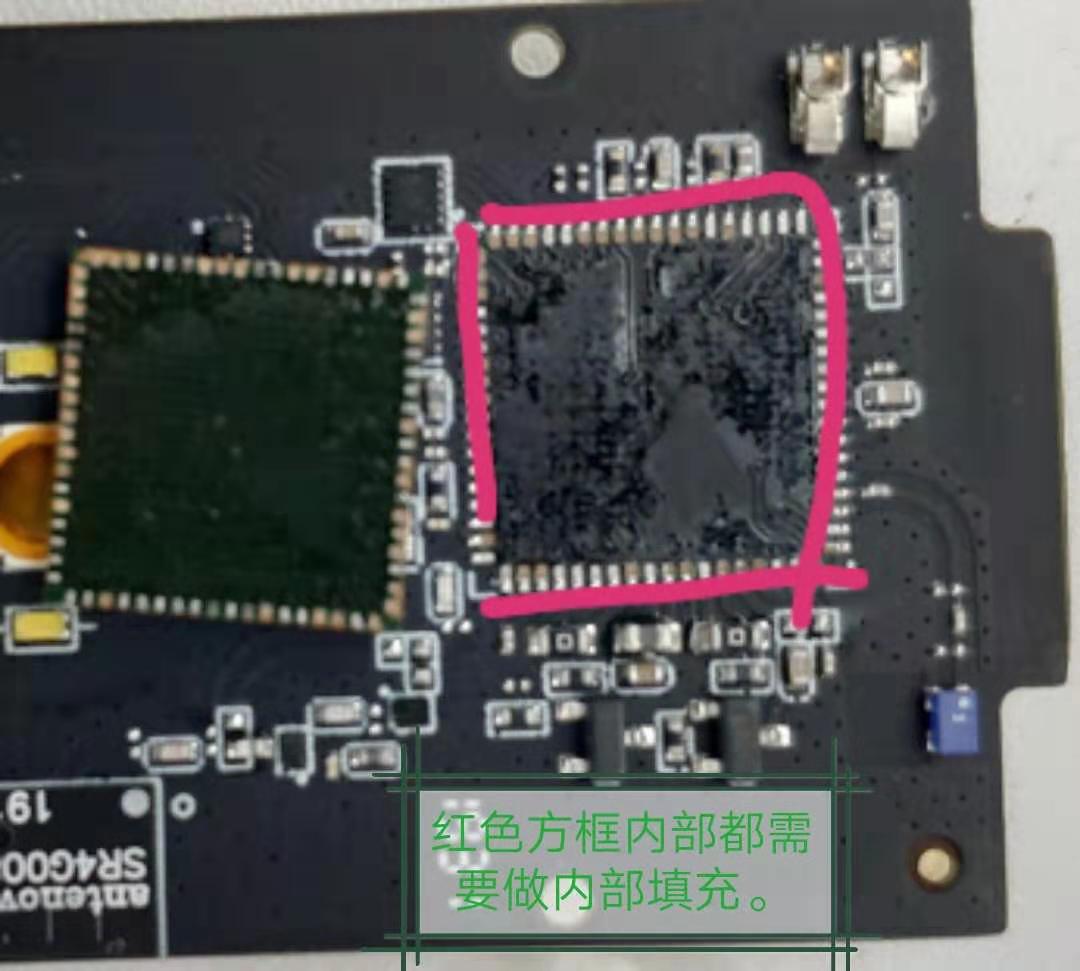
客户的产品是车载定位仪,需要用胶的是一块QFN芯片,正方形10mm×10mm,18个脚×4。
客户需要解决芯片加固,防止跌落时芯片脱落。
客户需要做跌落测试:
1.5米整个芯片跌落3次.老化测试.
客户主要是新产品的研发,第一次可能用胶量比较少,头批生产数量450pcs.试胶地点是北京公司合作的SMT工厂。
通过我司技术人专案研究,最终推荐HS710底部填充胶,客户已经和他们的SMT厂确认好试胶,并记录试胶结果。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
BGA
+关注
关注
5文章
549浏览量
47227 -
定位仪
+关注
关注
0文章
34浏览量
7948
发布评论请先 登录
相关推荐
先进封装Underfill工艺中的四种常用的填充胶CUF,NUF,WLUF和MUF介绍
今天我们再详细看看Underfill工艺中所用到的四种填充胶:CUF,NUF,WLUF和MUF。 倒装芯片的底部填充工艺一般分为三种:毛细

芯片封装胶underfill底部填充胶点胶工艺基本操作流程
一、烘烤烘烤,主要是为了确保主板的干燥。实施底部填充胶之前,如果主板不干燥,容易在填充后有小气泡产生,在最后的固化环节,气泡就会发生爆炸,从而影响焊盘与PCB之间的粘结性,也有可能导致





 车载定位仪BGA芯片底部填充胶
车载定位仪BGA芯片底部填充胶

















评论