随着功率MOSFET和IGBT的出现,双极型晶体管的发展受到一定影响。但在更高电压、更大电流的应用中,随着外延层(或单晶)厚度、电阻率的的增加,MOSFET、IGBT导通压降随之大幅上升。而双极型晶体管、晶闸管及其衍生器件由于其具有电导调制效应,可改善大电流情况下的导通压降,因此,在高压、低频应用领域有着广泛的需求。在结构方面,MCT多晶硅栅电极下具有双沟道,分别为开通沟道和关断沟道。MCT将晶闸管的大电流容量、高阻断电压、低饱和压降特点和MOS场控器件的栅极控制能力结合在一起,降低了低频应用中晶闸管驱动功率和驱动电路的复杂性。由于MCT芯片结构较复杂、制备难度较大、工作条件较严苛,因此为了改善MCT的电学特性,需要在深刻理解器件导通机理的基础上,对器件结构参数和工艺条件进行精细的设计和优化。
1 MCT单胞结构及物理模型选择
图1为MCT半单胞结构。为了使得仿真结果具有实际参考意义,根据电参数指标要求,利用TCAD半导体器件仿真软件对MCT单胞横向、纵向结构参数进行了设计,后续的仿真研究以此为基础。表1为MCT电参数指标。设计得到的MCT结构参数和工艺参数为:沟道宽度为4×106μm;单胞半宽度为15μm,窗口区半宽度为5μm,多晶硅区半宽度为10μm;P+衬底厚度和掺杂浓度分别为150μm和1×1019cm-3,衬底晶向为<100>;N-外延层厚度和掺杂浓度分别为160μm和7×1013cm-3(外延层电阻率为63Ω.cm)栅氧化层厚度为60nm,注入过程中牺牲氧化层厚度为20nm;P-体区注入剂量和能量分别为3.5×1014cm-2和60KeV,P-体区退火时间和温度分别为70min和1150℃;N+体区窗口区宽度为0.5μm,N+体区磷注入剂量和能量分别为8×1014cm-2和60KeV;N-体区磷注入剂量和能量分别为5×1014cm-2和60KeV, N-体区退火时间和温度分别为130min和1150℃;P+阴极区窗口宽度为2μm,P+阴极区硼注入剂量和能量分别为2×1015cm-2和50KeV, P+阴极区退火时间和温度分别为1min和1000℃;开通沟道长度和关断沟道长度分别为2.7μm和0.8μm;侧墙氧化层厚度为0.5μm;硅材料原始少子寿命为10μs;P+阳极区与N-外延层之间采用N+缓冲层结构,N+缓冲层为均匀掺杂,掺杂浓度和厚度为变量。纵向结构采用传统的晶闸管工艺实现,横向采用DMOS硅栅工艺,终端采用终端结扩展结构。
工艺流程为:扩散P+区→光刻(一次光刻)扩散P-体区→光刻(二次光刻)扩散N+区→生长栅氧化层→生长多晶硅→光刻(三次光刻)扩散N-阱→自对准扩散P+→生长SiO2和Si3N4→光刻(四次光刻)引线孔→蒸铝→反刻(五次光刻)→钝化→钝化光刻(六次光刻)。图2为设计得到MCT输出特性曲线,由图2可知,设计得到的MCT电学性能满足电参数指标要求,表明结构参数设计和工艺条件选择较合理。
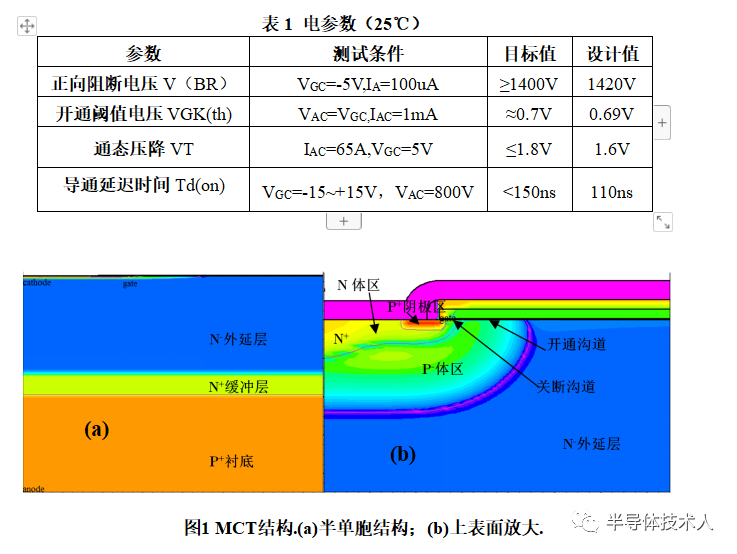
2、N+缓冲层结构对MCT瞬态特性(TLP)的影响
vgate=5V,vanode=800V;IApeak=150A,上升时间10ns,脉宽6μs,下降时间150ns,周期150μs
2.1 N+缓冲层掺杂浓度的影响,N+缓冲层厚度35μm
(1)1E17cm-3

(2)3E17cm-3
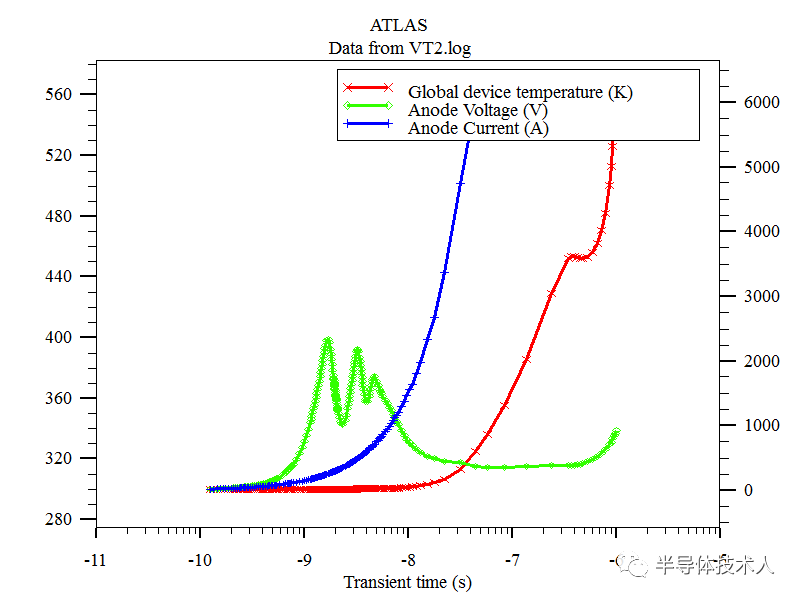
(3)5E17cm-3


(4)7E17cm-3
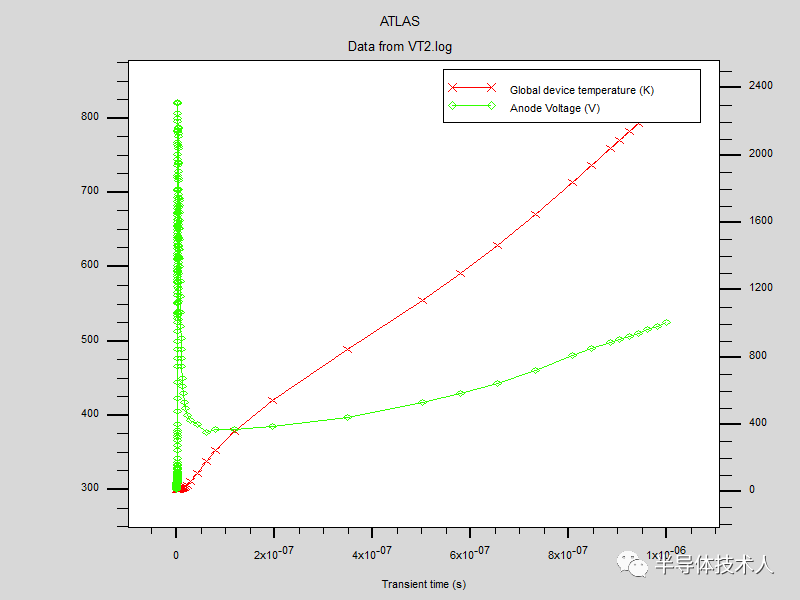
(5)9E17cm-3

2.2 N+缓冲层厚度的影响
(1)25μm

(2)30μm
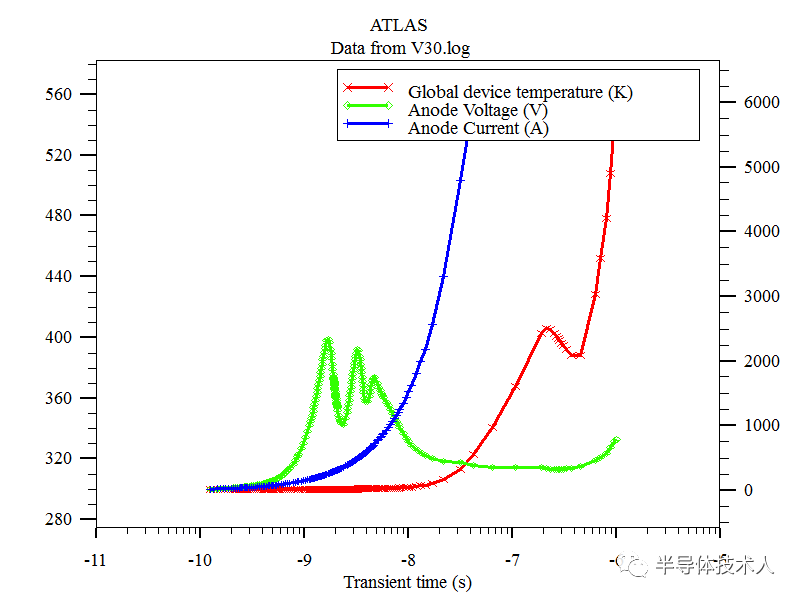
(3)35μm

-
MOSFET
+关注
关注
147文章
7310浏览量
214744 -
晶闸管
+关注
关注
35文章
1106浏览量
77518 -
IGBT
+关注
关注
1269文章
3855浏览量
250535 -
MCT
+关注
关注
0文章
16浏览量
5649
发布评论请先 登录
相关推荐
labview 瞬态特性测量
N沟道增强型MOS场效应管的结构与原理
解读太阳能电池的基本特性
超级结MOSFET的优势
雷达目标空频域瞬态极化特性及其在几何结构反演中的应用
新型功率器件MCT关断模型的研究
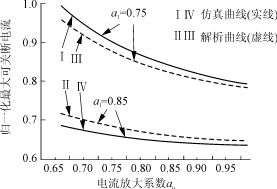
MOS控制晶闸管(MCT),MOS控制晶闸管(MCT)是什么
n埋层PSOI结构射频功率LDMOS的输出特性
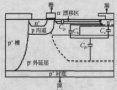
高频通过特性小型光继电器:TLP3375,TLP3275

N+缓冲层对PT-IGBT通态压降影响的研究





 N+缓冲层结构对MCT瞬态特性(TLP)的影响
N+缓冲层结构对MCT瞬态特性(TLP)的影响

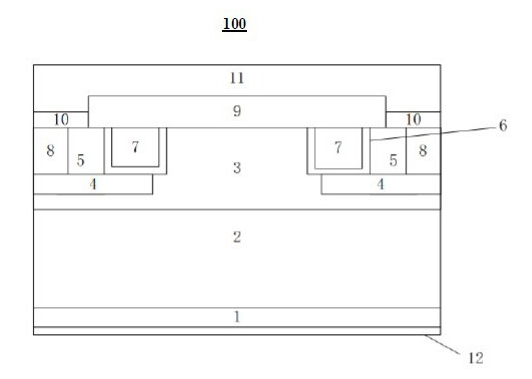










评论