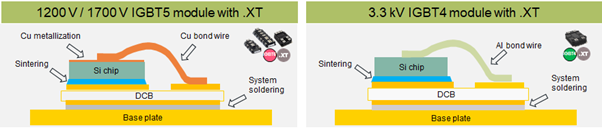
GVF9800预烧结银焊片
DTS+TCB预烧结银焊盘工艺提高功率器件通流能力和功率循环能力
在新能源汽车、5G通讯、光伏储能等终端应用的发展下,SiC/GaN等第三代半导体材料水涨船高,成为时下特别火热的发展领域之一。终端应用市场对于高效率、高功率密度、节能省耗的系统设计需求日益增强,与此同时,各国能效标准也不断演进,在此背景下,SiC凭借耐高温、开关更快、导热更好、低阻抗、更稳定等出色特性,正在不同的应用领域发光发热。
新型SiC芯片可用IPM、TPAK方式封装,以应用于电动车逆变器SiC导线架技术为例,导线架Copper Clip和SiC芯片连接采用烧结银AS9385连接技术,可实现高可靠、高导电的连接的需求,很多Tier 1的控制器公司和Tier 2功率模组制造商,在汽车模组中均或多或少的采用该烧结银技术,目前烧结银技术主要用于对可靠性和散热高要求的市场,在引线框架制作上除了要提供高可靠度的镀银品质以符合烧结银的搭接技术以外,由于烧结银的膜厚只有20um-50um,不像传统的锡膏搭接方式可透过锡膏量的调整补正搭接面共平面度不佳造成的搭接问题,烧结银的搭接技术对于搭加处的共平面度要求公差只有20um,对于这种复杂的折弯成型式技术是一大挑战。
在成型技术也相当困难,由于电镀银是局部镀银,相较于全镀,部分镀银技术很难,必须做模具,且放置芯片处用局部银,一个导线架搭两个芯片,芯片必须採局部银,其他导线架必须用镍钯金,材料差异对导线架制作是很大的技术挑战。
众所周知,在单管封装中,影响器件Rth(j-c)热阻的主要是芯片、焊料和基板。SiC芯片材料的导热率为370W/(m.K),远高于IGBT的Si(124W/(m.K)),甚至超过金属铝(220W/(m.K)),与Lead Frame的铜(390 W/(m.K))非常接近。而一般焊料的导热率才60 W/(m.K)左右,典型厚度在50-100um,所占整个器件内部Rth(j-c)热阻之权重,是不言而喻的。所以,单管封装中引入扩散焊“Diffusion Soldering”,省了芯片与lead frame之间的焊料,优化了器件热阻。以1200V/30mOhm的SiC MOSFET单管为例,基于GVF预烧结银焊片工艺,相比当前焊接版的TO247-3/4L,可降低约25%的稳态热阻Rth(j-c),和约45%的瞬态热阻。
目前,客户存的最大痛点是键合时良率低,善仁新材推出的预烧结焊片主要优势是:提高芯片的通流能力和功率循环能力,保护芯片以实现高良率的铜线键合。
功率半导体是电子装置中电能转换与电路控制的核心,主要用于改变电子装置中电压和频率、直流交流转换等。可分为功率IC和功率分立器件两大类,二者集成为功率模块(包含MOSFET/IGBT模块、IPM模块、PIM模块)。随着电力电子模块的功率密度、工作温度及其对可靠性的要求越来越高,当前的封装材料已经达到了应用极限。
善仁新材的GVF9700无压预烧结焊盘和GVF9800有压预烧结焊盘,为客户带来多重便利,包括无需印刷、点胶或干燥,GVF预烧结银焊片工艺(DTS+TCB(Die Top System +Thick Cu Bonding)可以将铜键合线和烧结工艺很好结合在一起,同时具有较高的灵活性,可以同时让多个键合线连接在预烧结焊盘上来进行顶部连接。
GVF预烧结银焊片工艺(DTS+TCB(Die Top System +Thick Cu Bonding)不仅能显著提高芯片连接的导电性、导热性,以及芯片连接的可靠性,并对整个模块的性能进行优化,还能帮助客户提高生产率,降低芯片的破损率,加速新一代电力电子模块的上市时间。
GVF预烧结银焊片工艺(DTS+TCB(Die Top System +Thick Cu Bonding))能够将电力电子模块的使用寿命延长50多倍,并确保芯片的载流容量提高50%以上。
GVF预烧结银焊片还可以使结温超过200°C。因此,GVF预烧结银焊片可大幅降低功率限额,或者在确保电流相同的情况下缩小芯片尺寸,从而降低电力成本。
SHAREX的GVF预烧结银焊片工艺(DTS+TCB(Die Top System +Thick Cu Bonding)是结合了烧结银,铜箔和其他材料的一种复合材料,由以下四个部分组成:具有键合功能的铜箔;预涂布AS9385系列烧结银;烧结前可选用临时固定的胶粘剂;保护膜或者承载物。
GVF预烧结银焊片工艺(DTS+TCB(Die Top System +Thick Cu Bonding)和金,银,铜表面剪切强度都很大。
GVF预烧结银焊片工艺(DTS+TCB(Die Top System +Thick Cu Bonding)的使用方法为:Pick & Place;
GVF预烧结银焊片工艺(DTS+TCB(Die Top System +Thick Cu Bonding)可以广泛用于:Die Attach, Die Top Attach, Spacer Attach等。
采用了GVF预烧结银焊片工艺的Diffusion Soldering(扩散焊)技术。简而言之,就是在特定温度和压力条件下,使得SiC芯片的背面金属,与Lead Frame表面金属产生原子的相互扩散,形成可靠的冶金连接,以釜底抽薪之势,一举省去中间焊料,所谓大道至简、惟精惟一,惟GVF预烧结银焊片。一言以蔽之:采用了GVF预烧结银焊片工艺时,降低器件稳态和瞬态热阻,同时提高器件可靠性。
在能源效率新时代,SiC开始加速渗透电动汽车、光伏储能、电动车充电桩、PFC/开关电源、轨道交通、变频器等应用场景,接下来将逐步打开更大的发展空间。

DTS烧结银焊片
审核编辑:汤梓红
-
芯片
+关注
关注
458文章
51407浏览量
428503 -
DTS
+关注
关注
1文章
50浏览量
16191 -
功率器件
+关注
关注
42文章
1806浏览量
90740 -
焊盘
+关注
关注
6文章
558浏览量
38269
发布评论请先 登录
相关推荐
低温无压烧结银在射频通讯上的5大应用,除此之外,烧结银还有哪些应用呢?欢迎补充
深入探索研究SiC功率器件高效互连技术
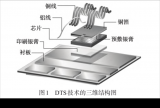
SiC功率器件先进互连工艺研究
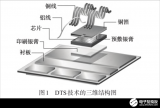




 DTS+TCB预烧结银焊盘工艺提高功率器件通流能力和功率循环能力
DTS+TCB预烧结银焊盘工艺提高功率器件通流能力和功率循环能力



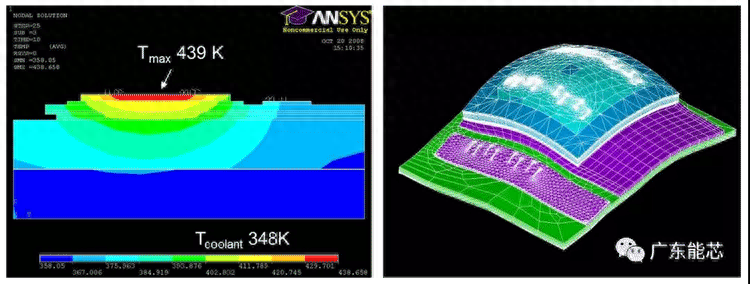





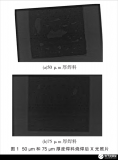










评论