目前,碳化硅(SiC)这种半导体材料因其在电力电子应用中的出色表现引起了广泛的关注。对晶圆和器件的研究在近年来已经取得很大进展。
碳化硅是一种宽禁带(WBG)半导体材料。禁带通常是指价带和导带之间的电子伏(eV)能差。价电子和原子结合形成传导电子需要这种能量,而这种传导电子可在晶格中自由移动,并可作为电荷载子导电。绝缘体拥有极高的禁带宽度,通常要高于4eV。
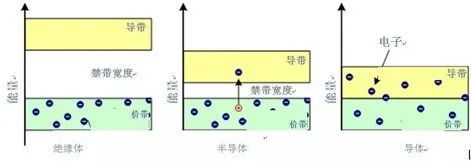
两者均为半导体材料,但碳化硅的性能明显优于硅材料(Si),如表1所示

表1:碳化硅与硅的性质
碳化硅的禁带宽度是硅材料的3倍,击穿电场的大小则是后者的10倍。这意味着,在相同的闭塞电压下,碳化硅器件的漂移区域间隔可以减少至硅器件的十分之一。此外,就漂移区域的掺杂浓度而言,碳化硅器件比硅器件高100倍。大部分高阻塞电压功率器件的导通电阻都是漂移区电阻。因此,在相同的闭塞电压下,碳化硅器件的导通电阻(RDSon)是硅功率器件的千分之一。
碳化硅的电子漂移速度是硅材料的两倍左右。此外,在相同的闭塞电压下,碳化硅器件的漂移距离比硅器件要短。所有这些特性都表明,与硅器件相比,碳化硅器件可在更高的开关频率下工作。
最后,碳化硅的热导率是硅材料的三倍左右。此外,碳化硅的半导体固有温度远高于1000°C。因此,在高温环境下,碳化硅器件的稳定性要优于硅器件。

1
对市场和应用的影响
与硅器件相比,碳化硅器件拥有更低的运行损耗、更快的开关速度和更出色的高温工作稳定性。这些特征能带来许多系统优势,对于下一代电源模块很有吸引力。
高温稳定性意味着碳化硅不仅可以在更高的温度下工作,而且还可以经受住不时出现的温峰(取决于任务要求)。此外,更高的开关频率能够减少产品的大小和重量,因为笨重的磁性组件被换成外形更小的元件。最后,更快的开关时间和更低的导通电阻能够减少开关和传导损耗,进而提高系统效率。
即使碳化硅属于价格(更)高的组件,系统成本通常也能得到降低。但这需要进行详尽的调查,因为碳化硅对所有常用的电力电子应用而言情况不同。Power America和欧洲电力电子中心(ECPE)等组织发布了宽禁带路线图,表明了基于碳化硅的电源模块的主要市场和应用场景。光伏逆变器、不间断电源(UPS)和电动汽车的逆变器可在短期内从碳化硅中获利,而高电压应用的实现还需要一定时间。
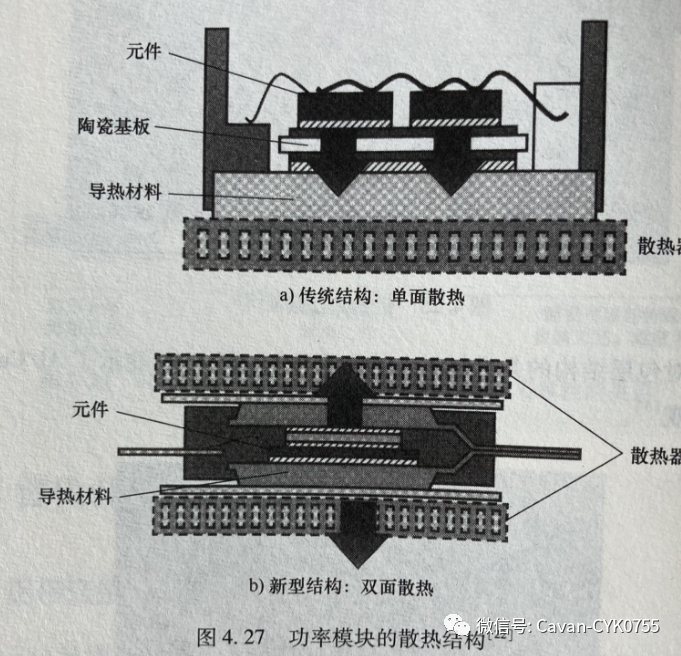
2
封装是一个限制因素
有了碳化硅器件后,应用不仅能够实现显著的效率改进,而且能够降低体积和重量。前提是,将该器件整合入应用的过程并不会抵消这些优点。因此,作为第一步,封装方面需要特别注意。
前面说过,每块芯片的开关和传导损耗将会极大地减少,而芯片面积也会继续缩小。最后,功率损耗的密度将会增加,从而必须仔细选择封装方式以解决较高的散热需求。此外,器件能够在更高的结温下工作,而温升还会增加。因此,对于高温稳定性、冷却和可靠性的要求将会更加严苛,必须根据情况选择模块外壳、器件连接、散热底板和散热所用的封装材料。模块外壳的新材料可能需要满足高工作温度的要求。互联器件的新技术将代替传统笨重的铝线。现在,在氮化硅活性金属钎焊(Si3N4 AMB)基板上银烧结模具能够更好地解决这些冷却和可靠性问题。我们也可以期待一些采用厚铜层、低热阻和综合散热器的创新解决方案,以优化热容、热扩散以及从芯片到冷却剂散热距离。
除上述挑战外,碳化硅快切器件还可能出现一些电气方面的问题。在断开闭锁模式这一极短的开关时间中,电压的下降会产生电流斜率,进而导致明显的过电压和振荡。放慢器件的速度并不是一个明智的选择。这种问题可通过电源模块内或附近的低电感电流解决。短路环、相反平面中的电流以及多条对称的电流路径是在设计电源模块、直流基板(包括电容)及其连接时必须考虑的基本要素。另一个问题与交流电和地面间的电容耦合有关。当开关速度极快时,这一耦合就成为了系统的关键,因为其会产生极高的电磁干扰。同样地,电源模块的巧妙设计能够尽量减少这一影响。
最后,成本或将成为碳化硅器件推广面临的最大挑战。虽然这些器件价格高昂,但它们能够大幅降低成本。但是,由于这些器件会影响系统成本,我们必须尽可能地在满足要求的情况下,减少所用的器件数量。因此,需要热管理解决方案在缩小芯片面积的同时,最大化紧凑轻巧封装的输出功率。
IGBT芯片是IGBT器件的主要部分,通常由硅制成。它由四个区域组成:N+型集电极、P型漏极、N型沟道和P+型栅极。IGBT芯片中使用的重要技术是沟道控制、载流子注入和处理高电压的结构设计。IGBT芯片集IGBT的驱动电路、控制电路、保护电路于一体。
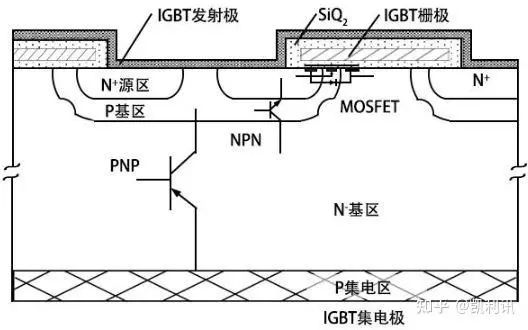
图示:IGBT基本结构
那为什么不使用SiC来制造IGBT呢?那就要从SiC本身的特性开始说起~
优点:耐高温、高压、损耗低,用在高压大功率的应用中再合适不过了。
缺点:存在很多技术问题,包括周期时间、成本预算、器件良品率不一致等。

图示:SiC性能五属性比较
着重要声明的是,SiC其实是可以做IGBT的,而我们看不到的原因是:因制备成本太高,且性能“过剩”,因此在大多数应用场合都“毫无竞争力”,因此目前无存活空间,所以你就基本看不到商业化的SiC IGBT了。
Si材料的Mosfet存在一个问题,即耐受电压能力高了芯片就会相应地变厚,导通损耗也就很高,所以硅材料的Mosfet一般只能做低压器件。
SiC是一种宽禁带半导体材料,可以做到很高的耐压下芯片还很薄,而现在SiC的Mosfet可以做到6500V耐压,已经能覆盖现在的IGBT耐压水平了,且Mosfet的芯片结构比IGBT简单,所以目前没有必要用SiC来做IGBT浪费成本。除非以后需要10kV级别的器件才有可能考虑SiC的IGBT。
不过其实SiC IGBT已经有了,但是只是在高耐压开关的场合小范围内使用,例如某些换流站和牵引站,目前还没有大规模的推广碳化硅的IGBT。
未来是否会大规模的使用SiC来做IGBT呢?
目前全球都对碳化硅寄予厚望,认为SiC是一种具有巨大潜力和优势的半导体材料,可以用于高压大功率领域,提高电力电子技术的效率和密度。也是一种战略性新材料,对于提升国家科技实力和能源安全有重要意义。
国际上有很多公司和机构在研究和开发SiC器件和应用,如Infineon, Creei, Rohm, STMicroelectronics等。国内如中科院半导体所、中电科、中电49所、中微半导体、华大半导体等。但是想用MOSFET完全取代IGBT并没有明确的肯定答案。分析下MOSFET和IGBT各自的优缺点就可知道原因。MOSFET可以取代低压低电流的IGBT,因为MOSFET有更低的导通损耗和更快的开关速度。但是MOSFET不能取代高压高电流的IGBT,因为MOSFET的耐压能力和电流承受能力都比IGBT低,而且MOSFET的导通损耗会随着电压和电流的增加而急剧增加。IGBT可以取代大部分的MOSFET,但是这样做可能会造成性能的浪费和成本的增加,因为IGBT有更高的导通压降和更慢的开关速度。
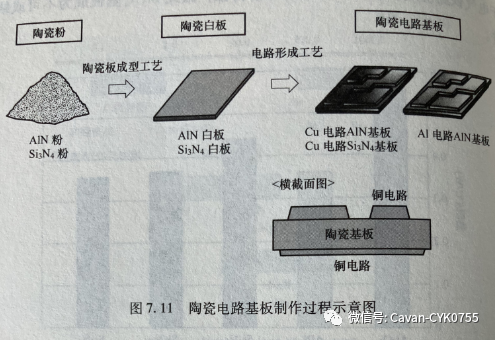
绝缘衬底主要是作为半导体芯片的底座,同时会在绝缘衬底上沉积导电材料、绝缘材料和阻性材料,还能形成无源的元器件。作为功率模块机械支撑的结构,需要能够耐受不同的工作环境,并且需要有足够的热导率将芯片等产生的热量快速传递出去。并且,一些后续的工艺,如薄膜,绑定,间距等等,需要绝缘衬底能够拥有一个较为合理的平整度。
功率模块的衬底选择标准
电气特性
高体电阻率:>1012Ω/cm
高介电强度:>200V/mil (1mil=0.0254mm)
低介电常数:<15
热特性
高导热率:有效热传导>30W/m·K
与半导体芯片的热膨胀系数较为匹配:一般选择在
2~6×10-6/℃
高耐温:一般能够满足后续加工工艺的最大温度
机械特性
高抗拉强度:>200MPa
高抗弯强度:>200MPa
硬度较合理
机械可加工性:易于磨削、抛光、切削和钻孔等
可金属化:适用于较为常见的金属化技术,如薄膜和厚膜工艺、电镀铜等等,这段我们下篇聊
化学特性
耐酸、碱及其他工艺溶液的腐蚀
低吸水率、空隙小
无毒性
不会等离子化
密度
低密度:机械冲击能够最小化
成熟度
技术较为成熟
材料供应能够满足
成本尽可能低,(说性价比高更为合适,毕竟不同的应用所能容许的成本高低不同)
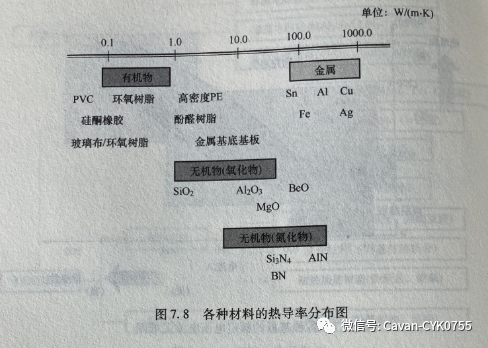
目前几种适用于功率半导体器件应用的绝缘衬底材料有下面几种:
❖陶瓷材料(3种):Al2O3(96%,99%)、AlN、BeO
❖硅基衬底:Si3N4
其中属氧化铝较为常见,不过在功率半导体芯片等框架确定时,一些供应商会通过改变模块中的其他成分,来达到要求,所以AlN和Si3N4也算常见。下面,我们来聊聊这几种绝缘衬底材料的优劣。
一、氧化铝(Al2O3)
优势:
是绝缘衬底最为常用的材料,工艺相对较为成熟;成本较低;性能能够满足我们上述的要求;
劣势:
导热系数较低,热膨胀系数(6.0~7.2×10-6/℃)与半导体芯片(Si基的一般为2.8×10-6/℃)的热膨胀系数不算太匹配;高介电常数;抗酸性腐蚀性能一般;
所以,氧化铝适用于中、低功率器件;适合高压和低成本器件;适用于密封封装;99%的氧化铝性价比更高一些。
二、氮化铝(AlN)
优势:
热导率高,约为Al2O3的6倍,较为适合大功率半导体器件的应用;AlN的热膨胀系数为4.6×10-6/℃,较为匹配芯片;性能同样满足我们上述的要求;
劣势:
是一种较新的材料,但与氧化铝和氧化铍相比工艺还不算成熟;在其表面直接敷铜的难度较大,易发生热疲劳失效;成本约为氧化铝的4倍;并且在较高温度和较大湿度下可能会分解为水合氧化铝;
适合大功率半导体器件的理想衬底之一,由于其机械断裂强度一般,应用时需要合金属底板配合使用。
三、氧化铍(BeO)
优势:
极其优异的热导率,约为Al2O3的8倍;同样适合大功率半导体器件的应用;工艺成熟;
劣势:
无论是固态粉末还是气态都是有毒性的;热膨胀系数相对较大,约为7.0×10-6/℃;机械强度较差,只有Al2O3的60%左右;成本是氧化铝的5倍;
有毒性大大限制了这种材料的使用。
四、氮化硅(Si3N4)
优势:
热膨胀系数约为3.0×10-6/℃,与半导体芯片较为接近;机械性能优越:是Al2O3和AlN的2倍以上,是BeO的3倍;热导率高,是Al2O3的2.5倍;适合大功率半导体的应用;高温强度高,抗热震性优良;
劣势:
技术相对还没有那么成熟,所以供应商也相对有限;不适合酸性环境下的应用;成本是Al2O3的2~2.5倍;
对于大功率半导体器件的应用来说,Si3N4应该是目前最优的衬底材料,CTE和热导率较为优势,可靠性也较高。
以上4种绝缘衬底,最常见的氧化铝,最不常见的氧化铍,以及较为优异的碳化硅,很多厂家都在针对不同的应用来搭配不同的绝缘衬底,这一点能够在芯片技术发展的同时,间接地更大效率地发挥已有芯片的性能。
-
半导体
+关注
关注
335文章
27970浏览量
225146 -
IGBT
+关注
关注
1270文章
3865浏览量
250920 -
SiC
+关注
关注
30文章
2975浏览量
63334 -
碳化硅
+关注
关注
25文章
2900浏览量
49472
发布评论请先 登录
相关推荐
CREE(Wolfspeed)的垄断与衰落及国产碳化硅衬底崛起的发展启示

碳化硅衬底的生产过程
碳化硅衬底的特氟龙夹具相比其他吸附方案,对于测量碳化硅衬底 BOW/WARP 的影响

不同的碳化硅衬底的吸附方案,对测量碳化硅衬底 BOW/WARP 的影响

碳化硅衬底的环吸方案相比其他吸附方案,对于测量碳化硅衬底 BOW/WARP 的影响

优化湿法腐蚀后碳化硅衬底TTV管控

降低碳化硅衬底TTV的磨片加工方法

激光退火后,碳化硅衬底TTV变化管控

碳化硅的应用领域 碳化硅材料的特性与优势
碳化硅衬底,进化到12英寸!





 碳化硅IGBT绝缘衬底材料
碳化硅IGBT绝缘衬底材料
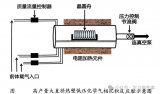










评论