硅通孔(TSV)有望成为电子器件三维芯片堆叠技术的未来。TSV互连的结构是通过首先在晶片表面蚀刻深过孔,然后用所需金属填充这些过孔来形成的。目前,铜基TSV是最具成本效益的大规模生产TSV。一旦过孔的顶部和底部都暴露出来,用铜填充的过孔就可以通过晶片提供互连。这提供了由晶片隔离和保护的坚固耐用的互连。它还提供了使用小得多的体积的互连,同时减少了对与现代微电子封装相关的大多数封装的需求。本工作使用两种方法生产铜基TSV,即ADE方法和盲孔方法。ADE方法引入了一种独特的工艺,该工艺可能与后微电子制造兼容。对两种方法制造的TSV进行横截面分析,结果表明成功形成了固体铜TSV。
随着现代微电子技术的封装尺寸迅速缩小,摩尔定律开始准确地描述集成电路所能容纳的技术数量的限制。单电子晶体管的开发,如SketchSET;然而,这让我们看到了晶体管缩放的终结[1]。随着摩尔定律的终结,一种更新的方法出现了,称为“不止摩尔”。这一新趋势试图通过减小设备的封装尺寸来改进系统。这最终提供了更高的组件密度。这将电子世界从经典的多芯片模块(其中多个芯片用于不同的功能)转变为片上系统(SOC)模型,该模型将所有东西集成到单个芯片中。然而,用目前的传统方法生产这种芯片可能是困难的。
封装尺寸的主要限制因素之一来自芯片的互连。现代技术大量使用引线键合,这可能需要很少的材料体积,但由于使用引线键,它们浪费了更多的三维空间。这是因为没有什么能与它们接触,迫使它们在空间上与芯片和彼此分离。此外,它们必须使用更多的材料进行电气隔离。引线键合的主要替代方案是利用硅通孔(TSV)。TSV是穿过晶片或芯片的互连,允许通过衬底的电连接。这项技术正开始在许多不同的设备中进行商业应用,它在包括相机[2]、摄像机和DRAM在内的许多潜在应用中显示出了良好的前景。
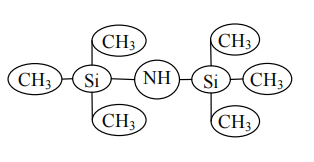
机械钻孔在微观尺度上和在宏观尺度上是一样的。它使用的钻头比所钻的孔小,并且由足够坚固的材料制成,以承受与钻孔相关的力(即硬质合金)[17]。机械钻孔的纵横比可以>10,尽管特征尺寸必须大于300μm,并且粗糙度被认为是“平均值”[18]。平均侧壁粗糙度是由于钻头的不均匀性,以及可能由于钻孔力/磨损而产生的微变形。尽管纵横比和粗糙度可能适用于TSV程序,但特征尺寸太大,在商业上不可行。
审核编辑 黄宇
-
芯片
+关注
关注
458文章
51479浏览量
429279 -
封装
+关注
关注
127文章
8095浏览量
143742 -
TSV
+关注
关注
4文章
117浏览量
81630
发布评论请先 登录
相关推荐
芯片先进封装硅通孔(TSV)技术说明

TSV三维堆叠芯片的可靠性问题
用平面锥制造100μm深10μm宽的高纵横比硅通孔

华林科纳PFA管在换热器中的应用
一文了解硅通孔(TSV)及玻璃通孔(TGV)技术

一种新型的硅基亚波长光栅耦合器设计





 华林科纳的一种新型的硅通孔 (TSV) 制造方法
华林科纳的一种新型的硅通孔 (TSV) 制造方法



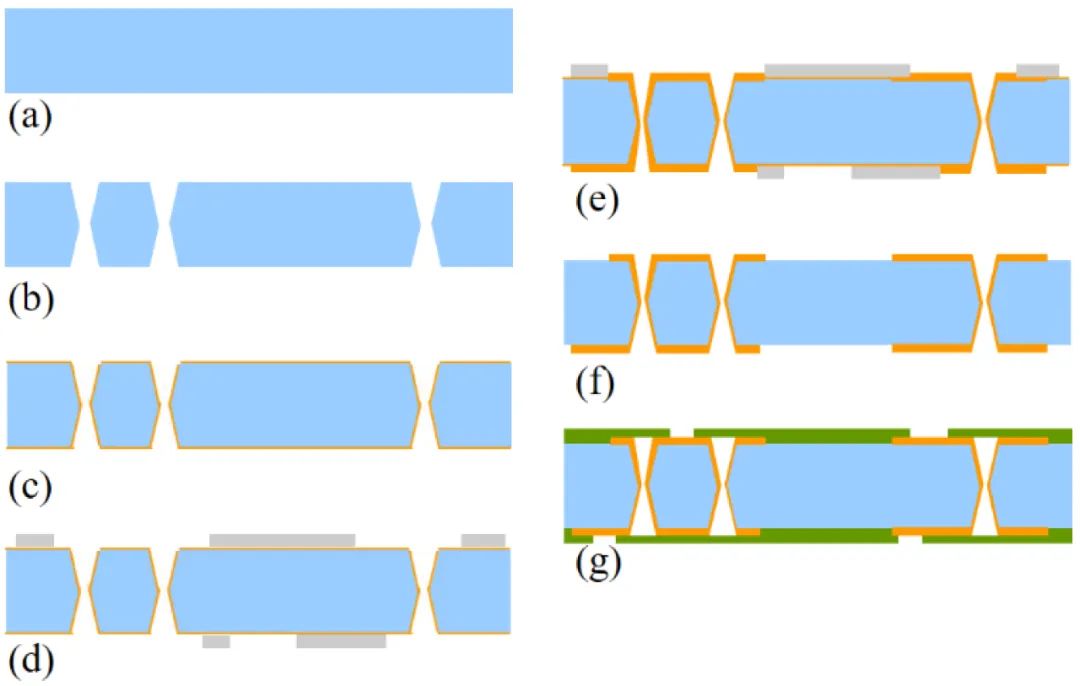












评论