Bump Metrology system—BOKI_1000
在半导体行业中,Bump、RDL、TSV、Wafer合称先进封装的四要素,其中Bump起着界面互联和应力缓冲的作用。
Bump是一种金属凸点,从倒装焊FlipChip出现就开始普遍应用,Bump的形状有多种,常见的为球状和柱状,也有块状等其他形状,下图所示为各种类型的Bump。
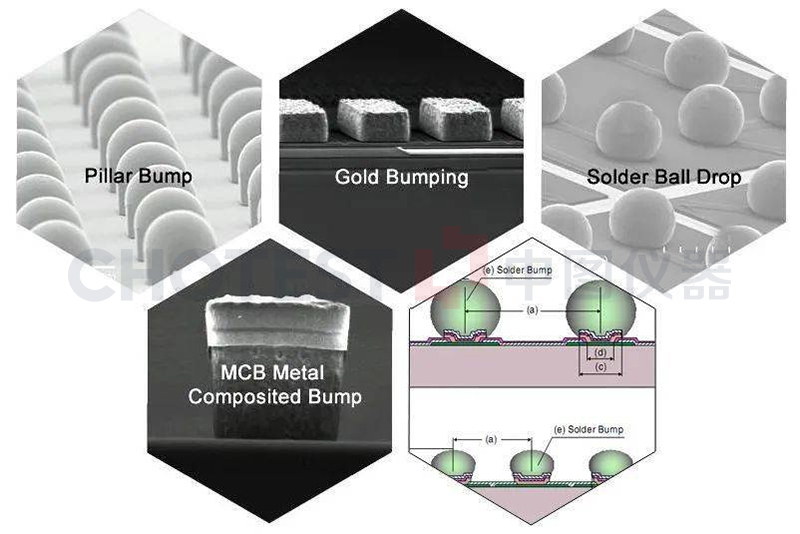
Bump起着界面之间的电气互联和应力缓冲的作用,从Bondwire工艺发展到FlipChip工艺的过程中,Bump起到了至关重要的作用。随着工艺技术的发展,Bump的尺寸也变得越来越小,从最初 Standard FlipChip的100um发展到现在最小的5um。
伴随着工艺技术的高速发展,对于Bump的量测要求也不断提高,需要把控长宽尺寸,高度均匀性,亚纳米级粗糙度、三维形貌等指标。
以粗糙度指标为例,电镀工艺后的Cu 凸点表面粗糙并存在一定的高度差,所以键合前需要对其表面进行平坦化处理,如化学机械抛光(CMP),使得键合时Cu 表面能够充分接触,实现原子扩散,由此可见把控Bump表面粗糙度是必不可缺的过程。
为了贴合工艺制程,积极响应客户Bump计量需求,中图仪器以高精度、多功能合一等优势将自研量测设备推向众多半导体客户。BOKI_1000系统支持键合、减薄、翘曲和切割后的基板,可以为包括切割后、预键合、铜焊盘图案化、铜柱、凸块(Bump)、硅通孔(TSV)和再分布层(RDL)在内的特征提供优异的量测能力。
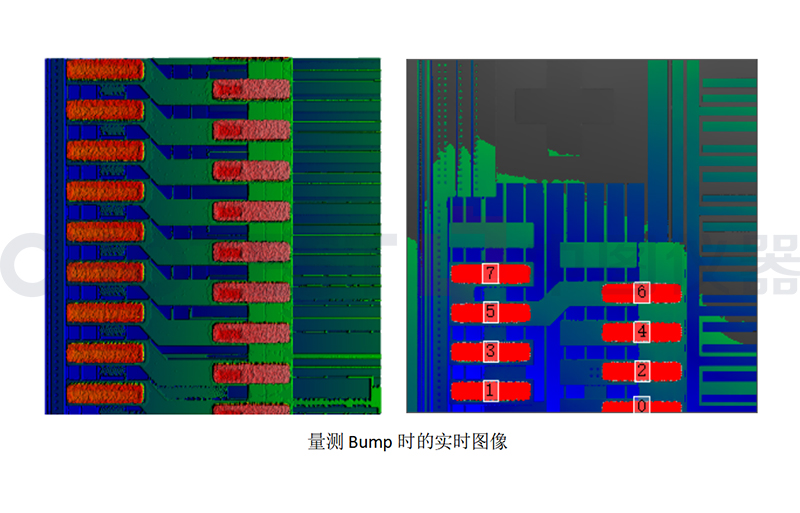
-
封装
+关注
关注
128文章
9317浏览量
149027 -
测量仪器
+关注
关注
3文章
907浏览量
46730 -
先进封装
+关注
关注
2文章
561浏览量
1057
发布评论请先 登录
AI时代算力瓶颈如何破?先进封装成半导体行业竞争新高地
2026国内嵌入式PCB功率封装技术路线全景:主机厂、Tier1、模块厂、芯片厂和板厂

封测巨头全球“圈地”,先进封装正成为AI时代的战略制高点

台积电计划建设4座先进封装厂,应对AI芯片需求
超小尺寸nanoPower 4-Bump比较器:MAX40002 - MAX40005及MAX40012 - MAX40015的深度解析
当芯片变“系统”:先进封装如何重写测试与烧录规则
晶圆级封装Bump制作中锡膏和助焊剂的应用解析

晶圆级封装(WLP)中Bump凸点工艺:4大实现方式的技术细节与场景适配




 先进封装厂关于Bump尺寸的管控
先进封装厂关于Bump尺寸的管控







评论