共读好书


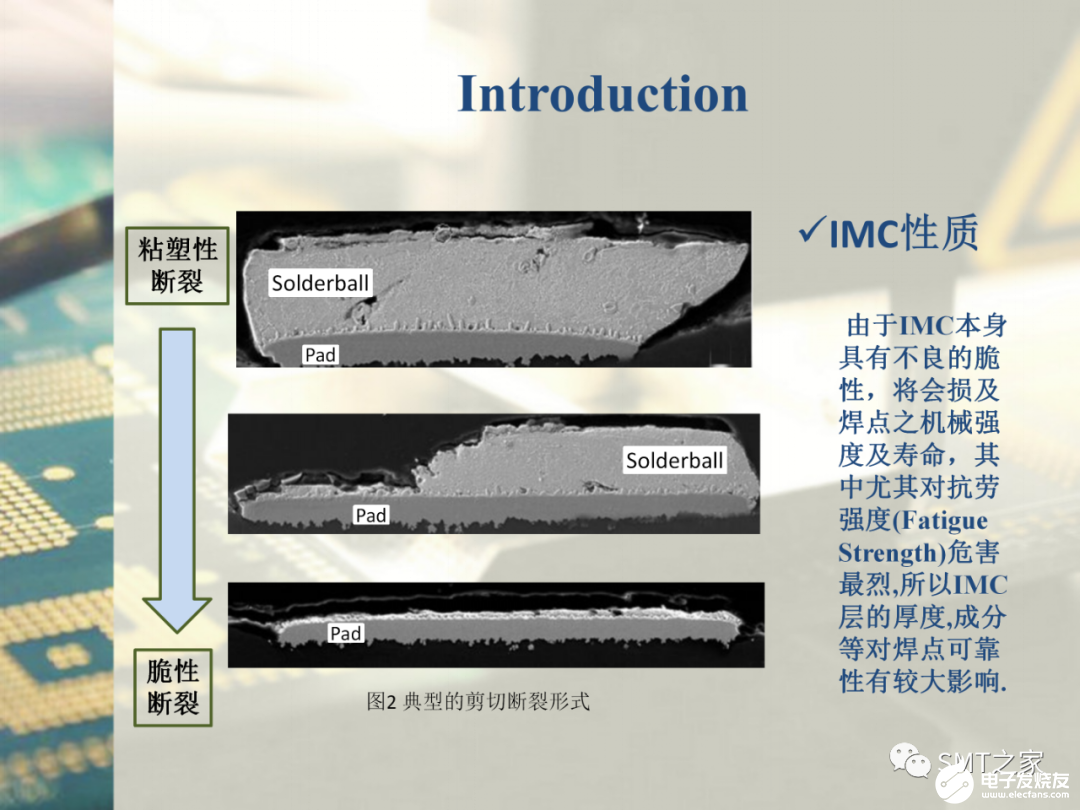








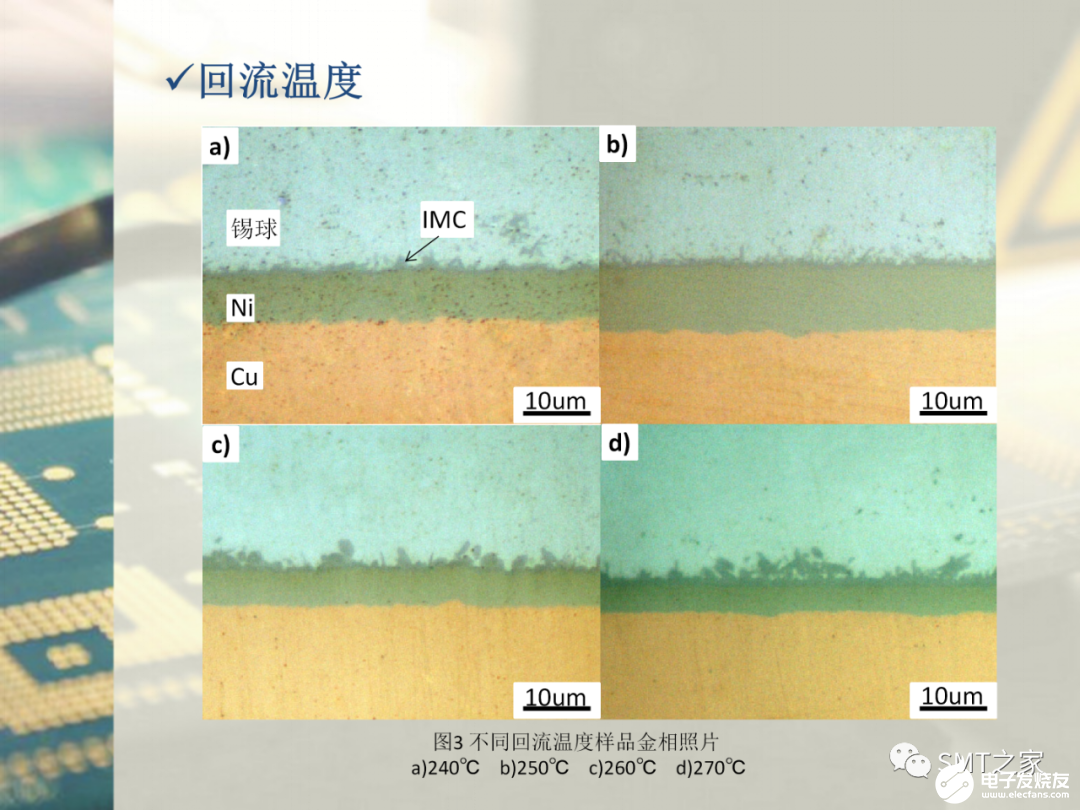
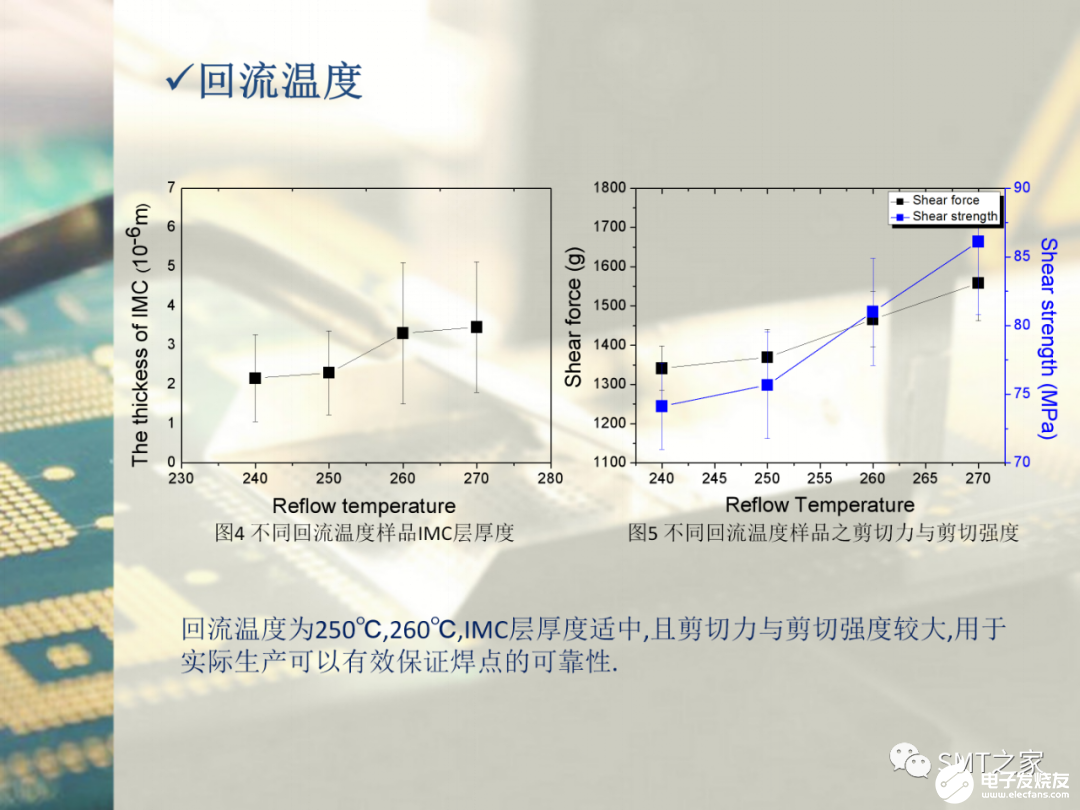
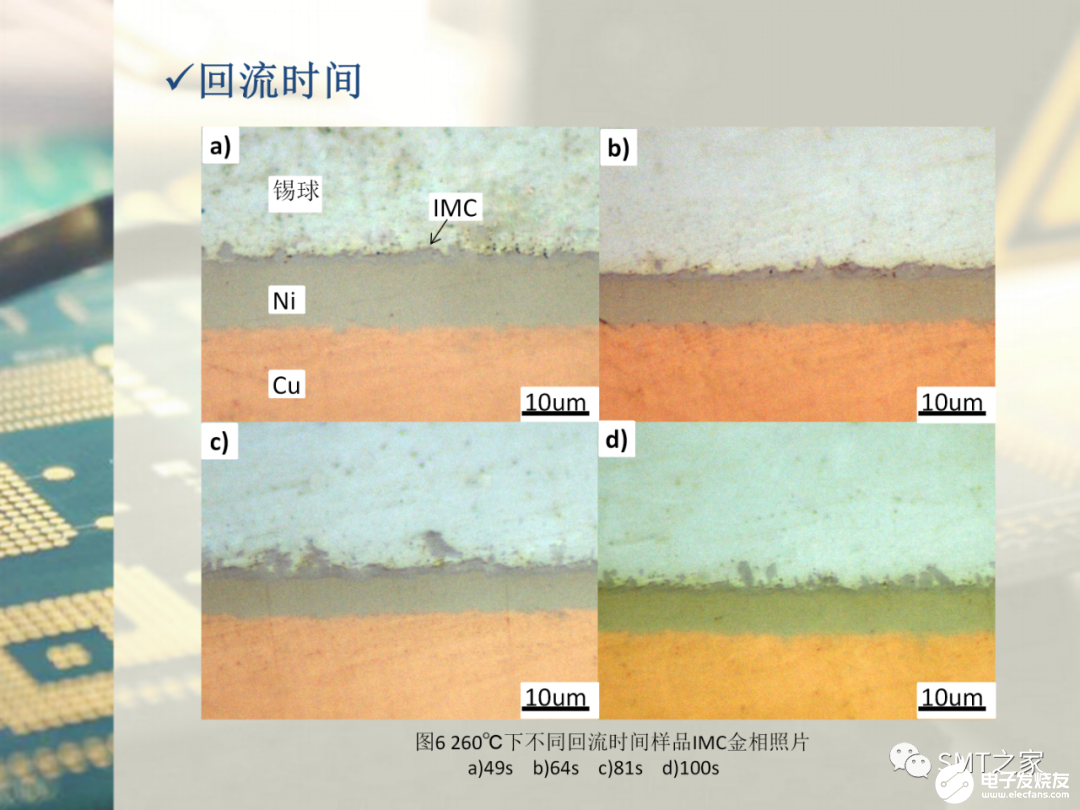
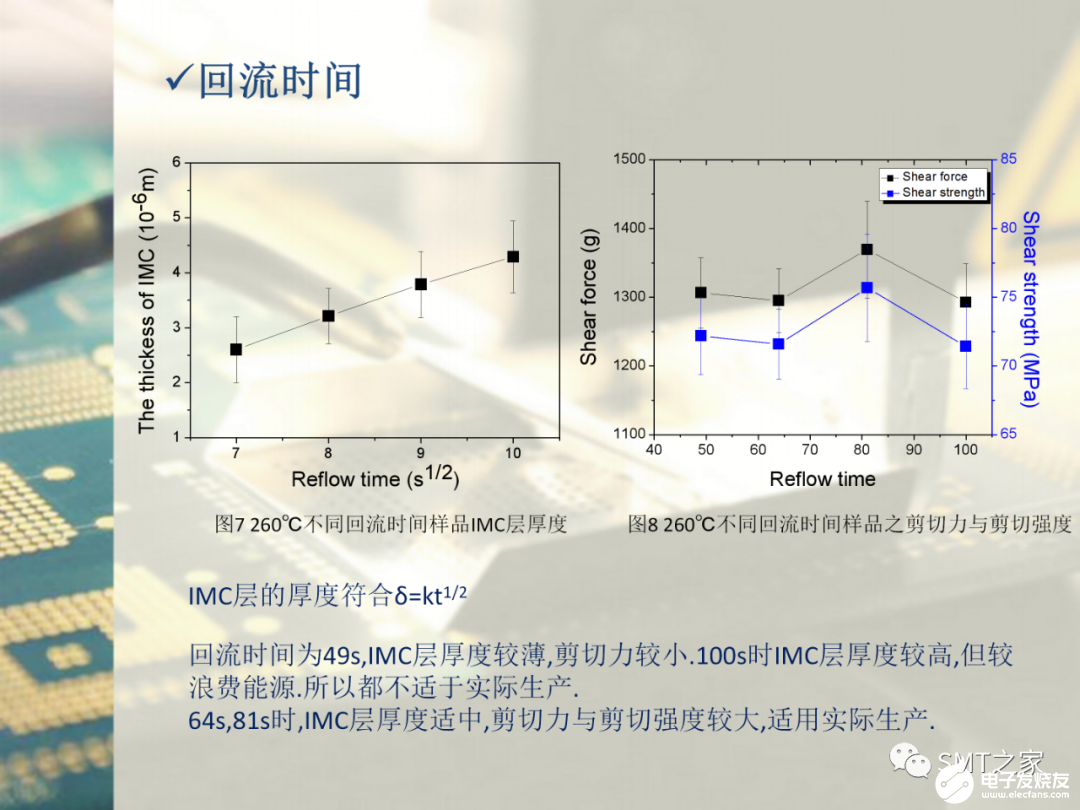
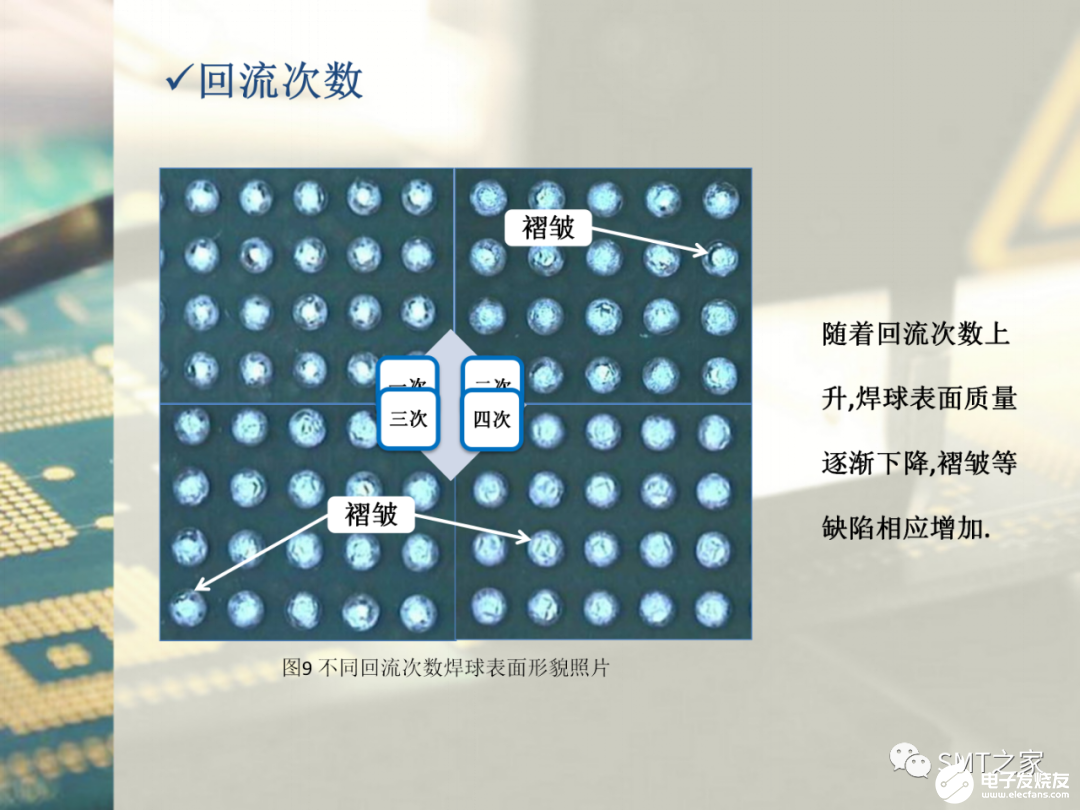
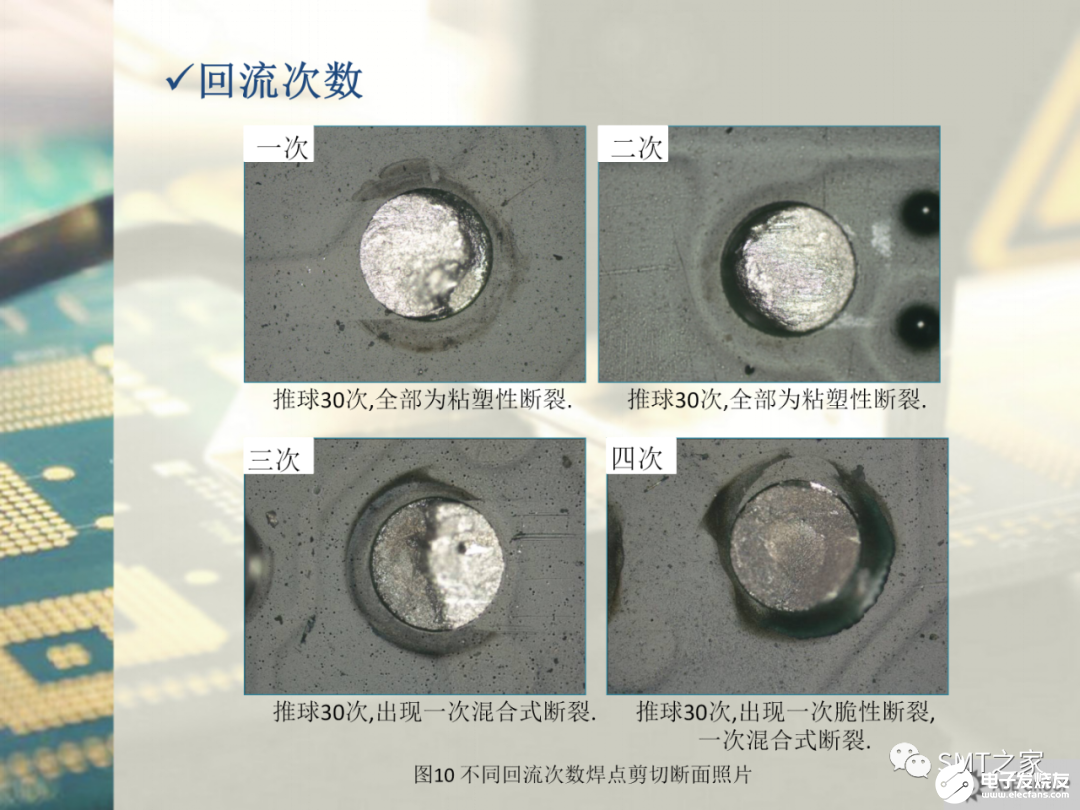
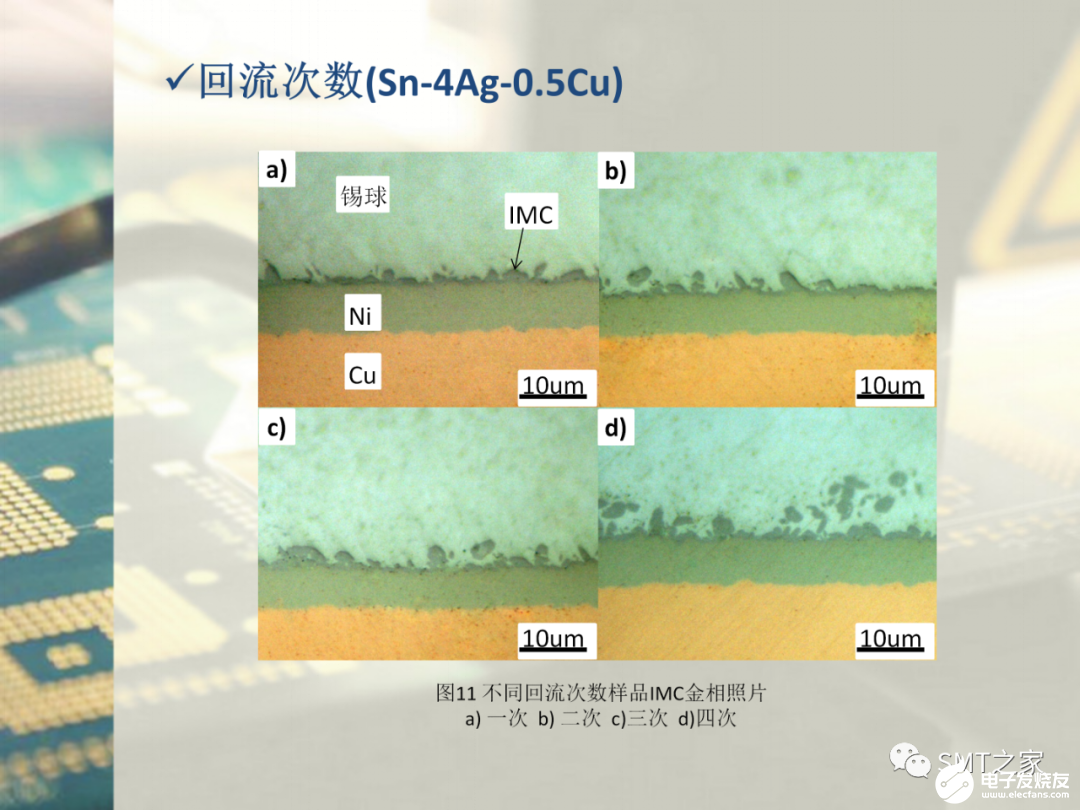
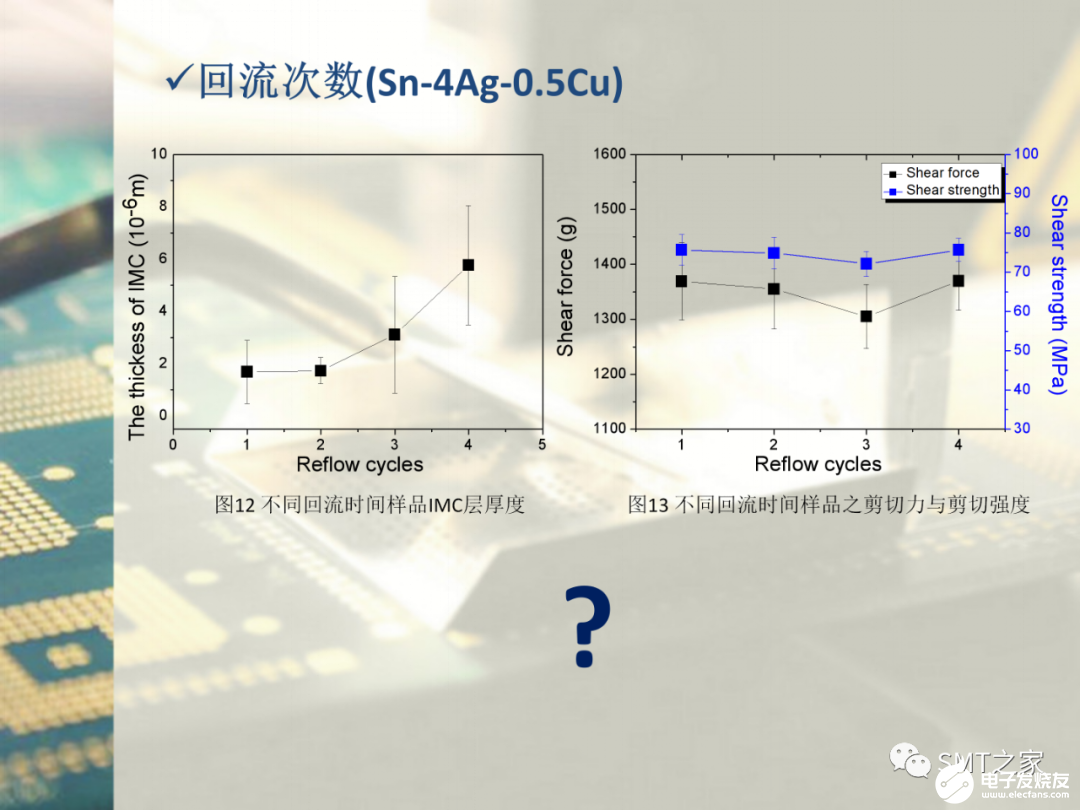
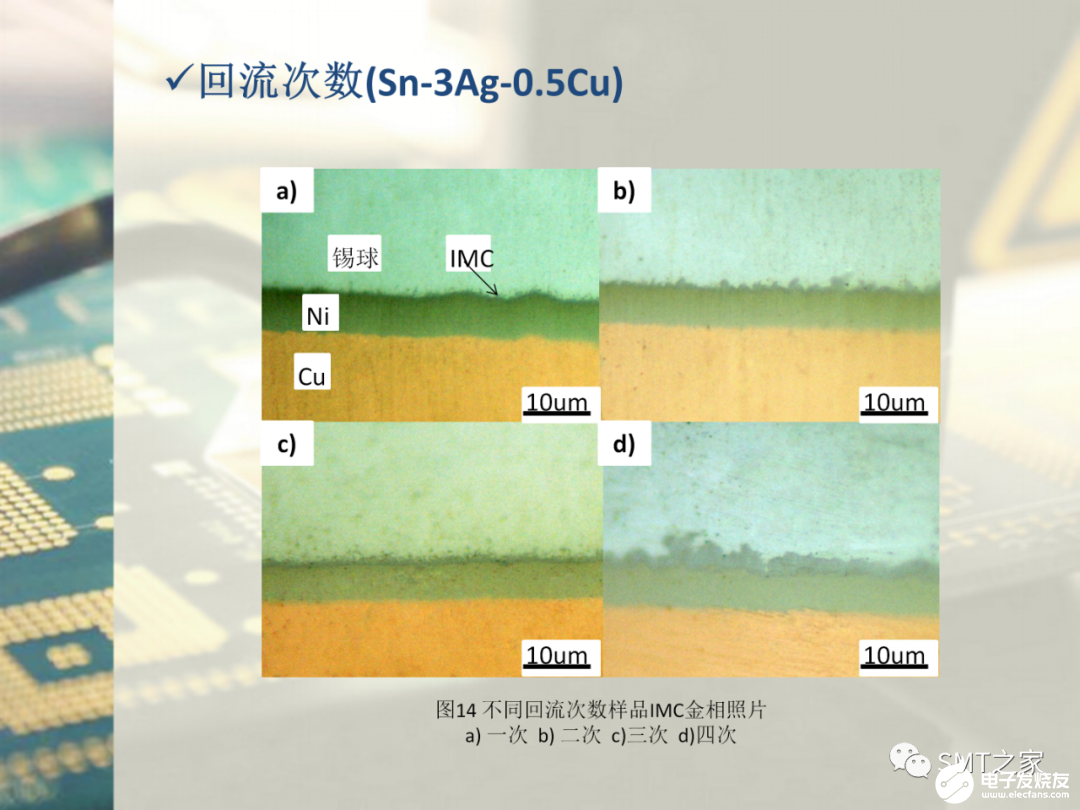
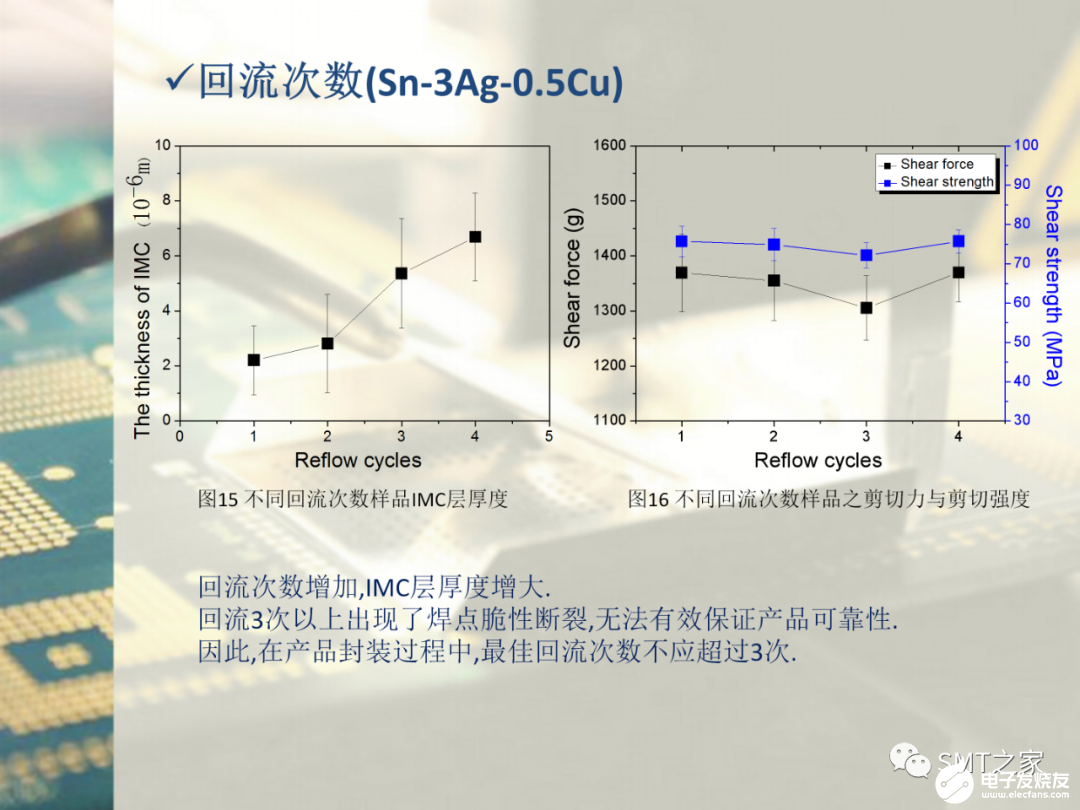
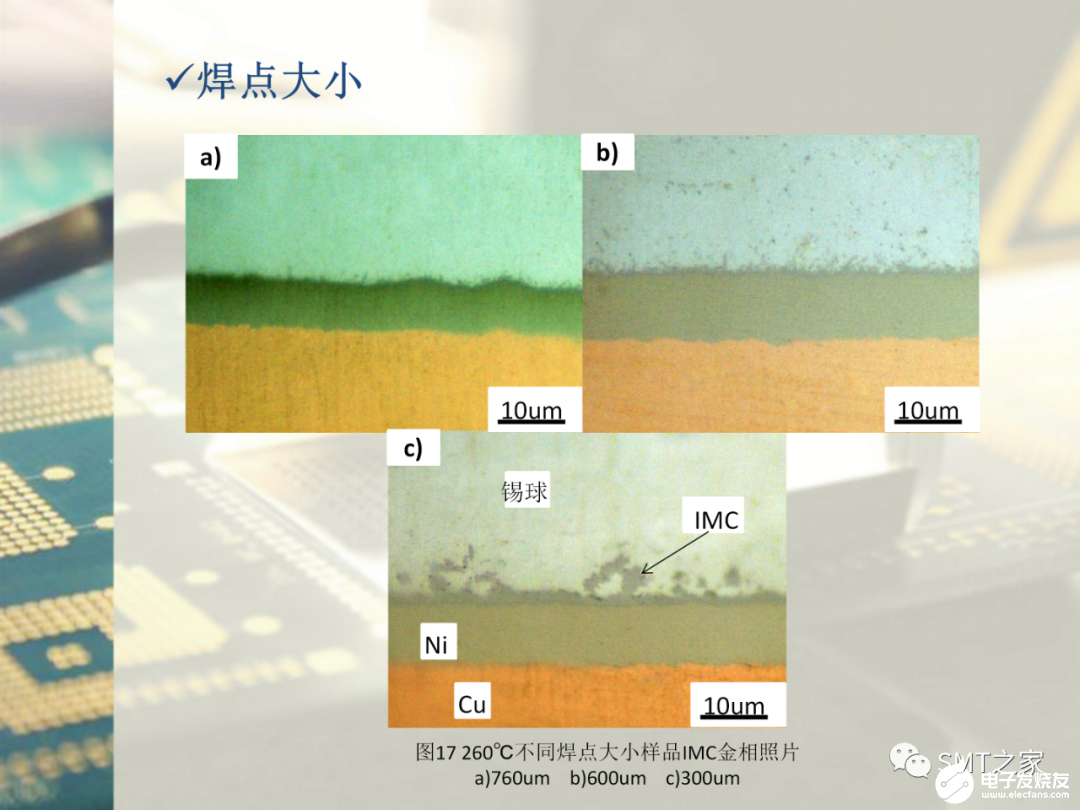
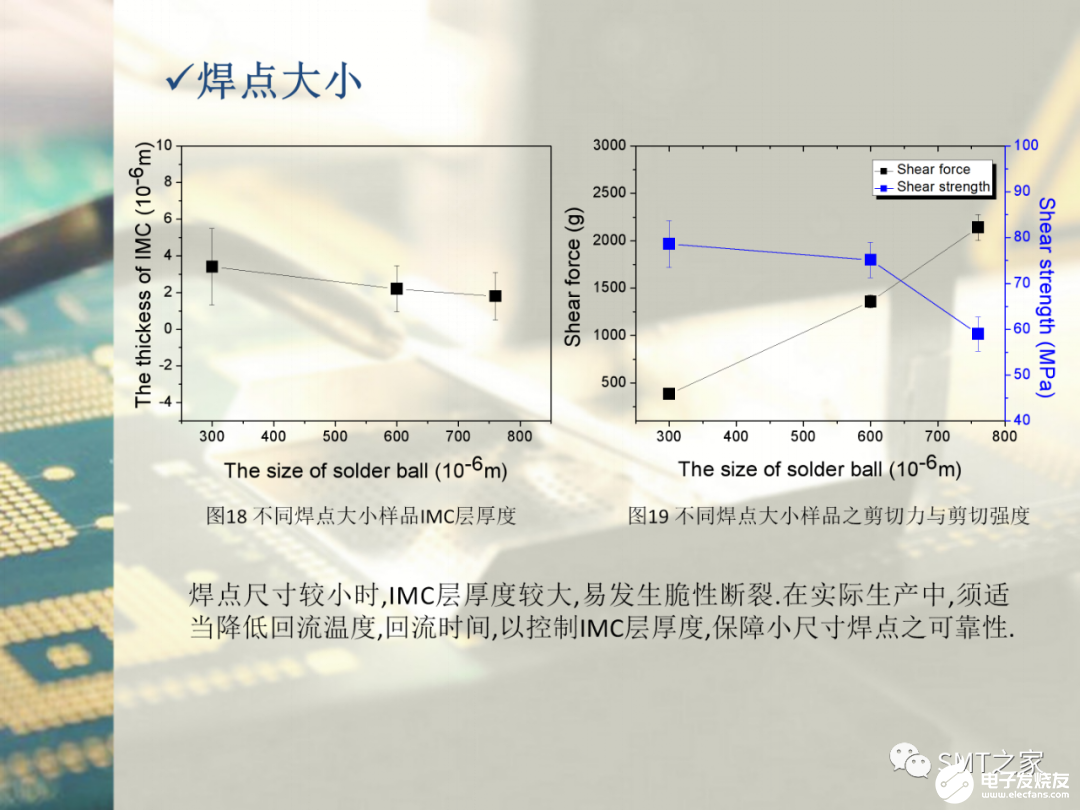



审核编辑 黄宇
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
焊锡
+关注
关注
0文章
293浏览量
18347 -
BGA
+关注
关注
5文章
549浏览量
47173 -
IMC
+关注
关注
0文章
25浏览量
4668
发布评论请先 登录
相关推荐
从原理到检测设备:全方位解读球栅阵列(BGA)测试流程
近期,小编接到一些来自半导体行业的客户咨询,他们希望了解如何进行球栅阵列(BGA)测试,包括应该使用哪些设备和具体的操作方法。 球栅阵列(BGA)作为电子封装技术的一种,具有高密度、高

BGA芯片底填胶如何去除?
BGA芯片底填胶如何去除?BGA(BallGridArray,球栅阵列)芯片底填胶的去除是一个相对复杂且需要精细操作的过程。以下是一些去除BGA芯片底填胶的详细步骤和注意事项:一、准备

大研智造激光锡球植球设备:提升车用集成电路BGA焊球可靠性(下)
球栅阵列 (Ball Grid Array,BGA) 是一种表面贴装的封装形式,凭借其外形尺寸小、引出密度高、电感寄生小、工艺成熟度高、散热性能好等优势,成为近年来集成电路的主要封装方式之一。在车用

揭秘BGA芯片植球技巧,打造完美电子连接!
BGA(Ball Grid Array,球栅阵列封装)芯片植球是电子元器件焊接领域中的一项重要技术,广泛应用于IC芯片与PCB板的连接。本文将详细介绍BGA芯片植
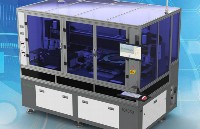
大研智造激光锡球植球机:提升车用集成电路BGA焊球可靠性(上)
球栅阵列 (Ball Grid Array,BGA) 是一种表面贴装的封装形式,凭借其外形尺寸小、引出密度高、电感寄生小、工艺成熟度高、散热性能好等优势,成为近年来集成电路的主要封装方式之一。在车用
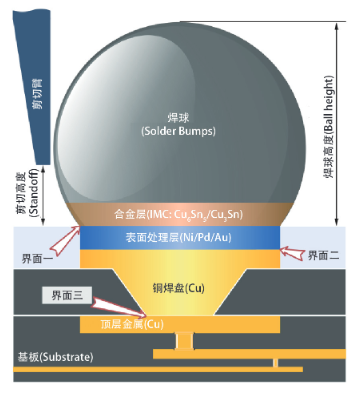
BGA芯片的封装类型 BGA芯片与其他封装形式的比较
不同的应用需求,衍生出了多种类型的BGA封装。 标准BGA(PBGA) 这是最基本的BGA封装形式,具有规则排列的焊球阵列。它适用于多种不同的应用,从消费电子产品到高性能计算设备。 细
BGA芯片的定义和原理
一、BGA芯片的定义 BGA是一种表面贴装技术(SMT)封装方式,它通过在IC芯片的底部形成一个球形焊点阵列来实现与PCB的连接。这些球形焊点,也称为焊球,通常由锡(Sn)、铅(Pb)或其他金属合金
大研智造 探秘激光锡球全自动焊锡机在耳机端子制造中的应用方案
激光锡球全自动焊锡机在耳机端子制造中具有独特优势。其利用激光精确加热的原理,可对微小焊点进行高精度焊接。对于耳机端子这种尺寸小、焊点间距近且不在同一平面的复杂结构,激光能够精准地将锡球熔化在目标焊点上,避免了传统焊接方式可能出现

不同BGA封装类型的特性介绍
BGA(Ball Grid Array,球栅阵列)封装是一种表面封装技术,广泛应用于集成电路的封装中。以下是几种不同BGA封装类型的特性介绍: 一、TBGA(Tape BGA) 特性
大研智造激光焊锡机:为BGA封装提供高效焊接的智能化选择
在电子技术快速发展的今天,BGA封装技术因其高I/O数和小型化特点成为电子制造业的关键。然而,随着电子元件的微型化,传统的热植球工艺面临精度和热损伤的挑战。激光焊锡技术以其非接触式、高精度和快速固化

BGA连接器植球工艺研究
球栅阵列(Ball Grid Array,BGA)封装具有体积小、引脚密度高、信号完整性和散热性能佳等优点,因而广泛应用于大规模集成电路的封装领域。植球工艺作为BGA封装(连接器)生产





 BGA小焊锡球与IMC生长研究(PPT)
BGA小焊锡球与IMC生长研究(PPT)

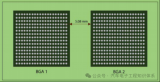
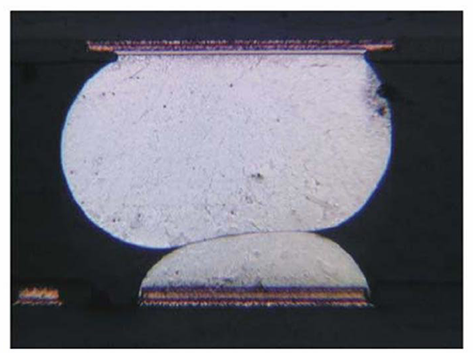










评论