BGA(Ball Grid Array)是一种高密度的表面贴装封装技术,它将芯片的引脚用焊球代替,并以网格状排列在芯片的底部,通过回流焊与印刷电路板(PCB)上的焊盘连接。然而,BGA也存在一些可靠性问题,其中最常见的就是焊点失效。本文主要介绍两种典型的BGA焊点失效模式:冷焊和葡萄球效应。
冷焊的基本内容涵盖三块:焊点杂质过量、不适当清洗、温度不足。
我们平常所说的冷焊指的是温度不足,即在焊接时由于某些因素导致的热量不足,导致焊锡没有完全熔化。
实际生产中温度不足影响冷焊的因素
1.设备热补偿性能不足,空载时测温合格,满载时温度不足导致冷焊;
2.测温板制作不合格,测试温度与实际生产温度存在差异;
3.无测温板,替代测温板与实际产品热容量不同,差异较大;
4.测温时未使用载具,实际生产有使用载具过炉导致温度差异大,以及使用载具与生产时使用载具热容量不同导致温度差异;
5.设备加热器突然故障;
6.温度曲线设置不合格,未测炉温直接生产;
7.设备报警,操作人员未确认直接按键导致设备降温;
8.温度曲线程序调用错误;
9.未升温合格即开始过板;
10.物体遮挡导致温度不足如料带等异物遮蔽。
葡萄球效应
另一类BGA 焊点失效模式称为“葡萄球效应”。
葡萄球效应产生机理为锡膏助焊剂损耗过度无法清除焊接端表面的氧化膜及锡膏锡粉颗粒表层的氧化膜,锡粉熔化但无法融合,冷却后成颗粒状。
葡萄球效应的产生很多时候是PCBA工艺人员照抄锡膏厂商推荐温度曲线,未关注恒温区温度起止点及恒温区起点到焊锡熔化温度间总时间。
应对策略
为了预防和避免冷焊和葡萄球效应的发生,需要从以下几个方面进行改进:
1.使用更长使用寿命的锡膏,减少锡膏受潮氧化和助焊剂挥发的可能性。
2.适当缩短回流焊曲线中的恒温时间,避免助焊剂过度挥发。但是,恒温时间也不能太短,否则会导致锡膏融化不均匀,影响焊接质量和可靠性。一般来说,恒温时间应该控制在60~120s之间,以达到最佳的效果。
3.使用氮气保护来降低锡膏氧化速度。
审核编辑 黄宇
-
BGA焊点
+关注
关注
0文章
5浏览量
11226 -
失效分析
+关注
关注
18文章
221浏览量
66604
发布评论请先 登录
相关推荐
BGA封装器件焊点抗剪强度测试全解析,应用推拉力机

大研智造激光锡球植球设备:提升车用集成电路BGA焊球可靠性(下)

BGA芯片的定义和原理
X-ray在芯片失效分析中的应用

BGA连接器植球工艺研究

常用的几种BGA焊点缺陷或故障检测方法

SMT贴片加工过程中,BGA焊点不饱满怎么办?

BGA焊接的工作原理、焊点检查和返工程序
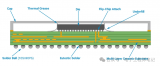
什么是葡萄球珠现象?如何解决?
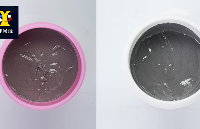




 BGA焊点失效分析——冷焊与葡萄球效应
BGA焊点失效分析——冷焊与葡萄球效应

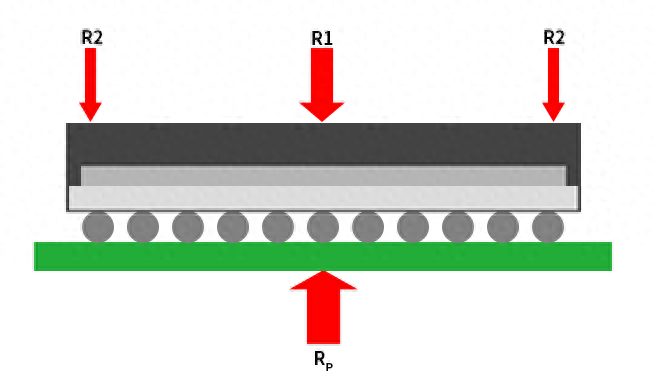













评论