4H-SiC概述(生长、特性、应用)、Bulk及外延层缺陷、光致发光/拉曼光谱法/DLTS/μ-PCD/KOH熔融/光学显微镜,TEM,SEM/散射光等表征方法。
报告详细内容
■ 介绍
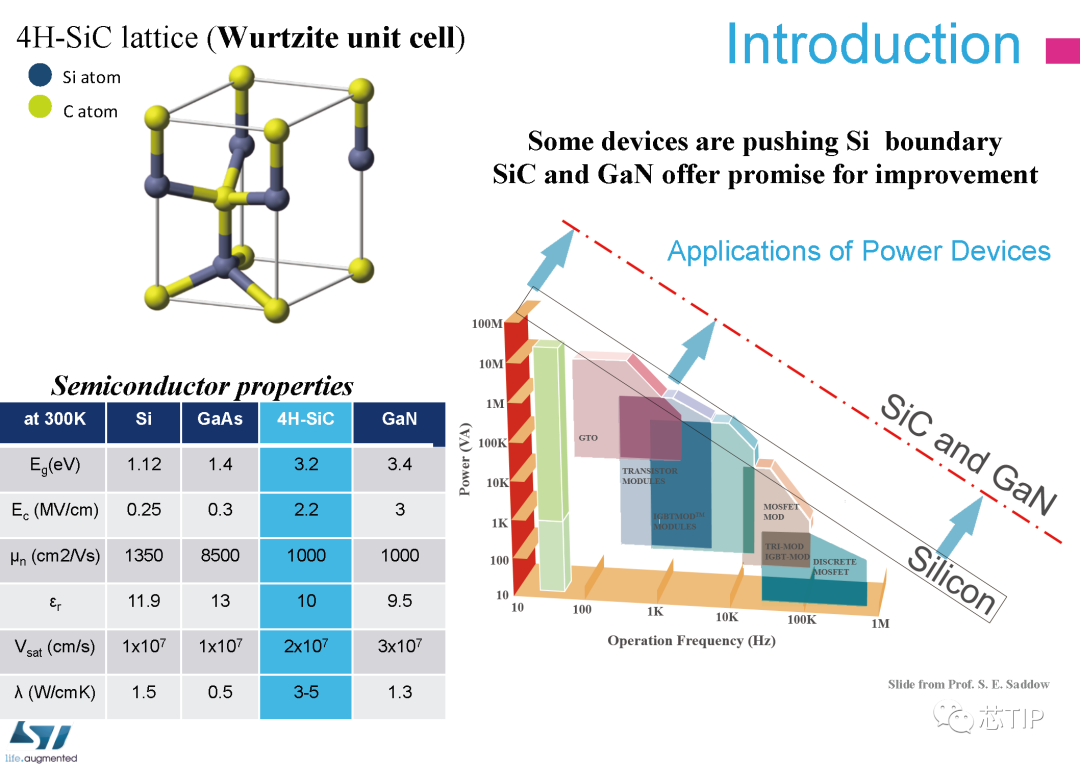
• 一些器件正在突破Si的界限,SiC和GaN提供了改进的希望。
■ 介绍

• 生长方法:
PVT - 块体(厚、高掺杂)
CVD - 外延(薄膜,中低掺杂)
■ Bulk缺陷
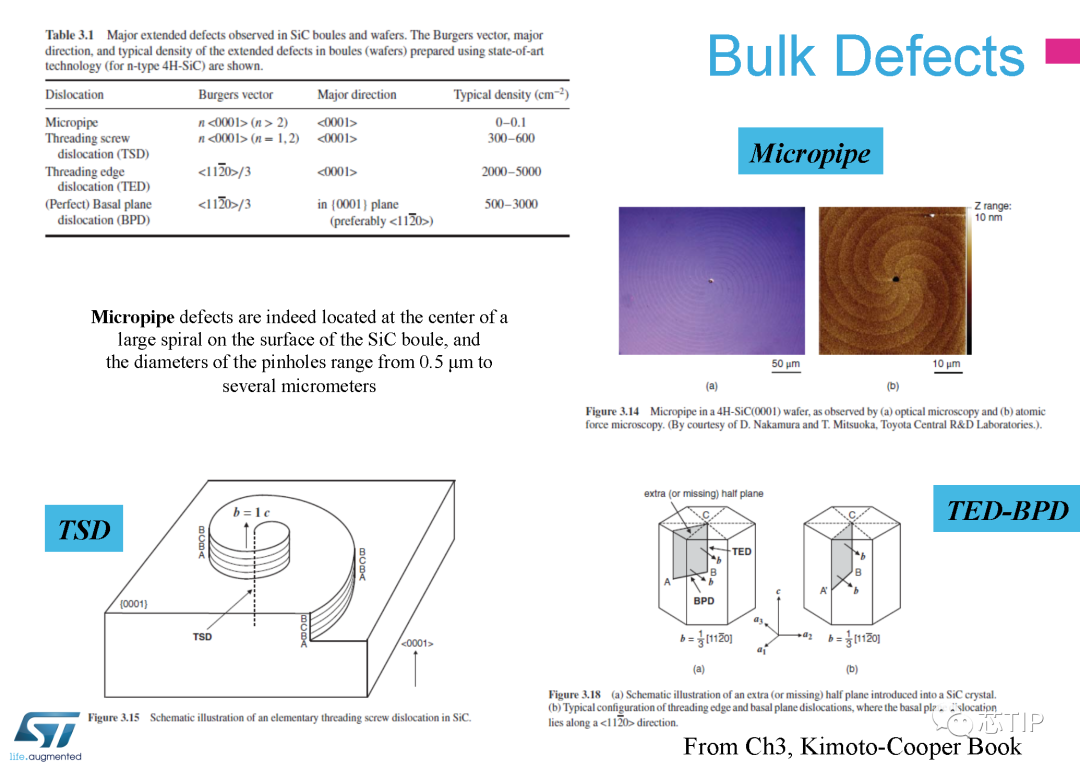
• 微管
微管缺陷确实位于SiC晶锭表面一个大螺旋的中心,针孔的直径从0.5微米到几微米不等
• TSD
• TED-BPD
■ 升华生长的多型控制

• 晶锭生长过程中的多型体混合——转换、聚结、成核——在TSD周围发生螺旋生长,以弥补多型体的不匹配
■ 晶锭生长过程中的 BPD 生成

• 由于晶格参数的变化,掺杂物的变化会影响BPD的产生
• 减少应力可以减少BPD的产生
• 大多数TED是由生长过程中沿生长方向的BPD转化而形成的
■ TSD的产生和消除

• EPD = TSD+TED+BPD
■ 减少缺陷(Bulk)
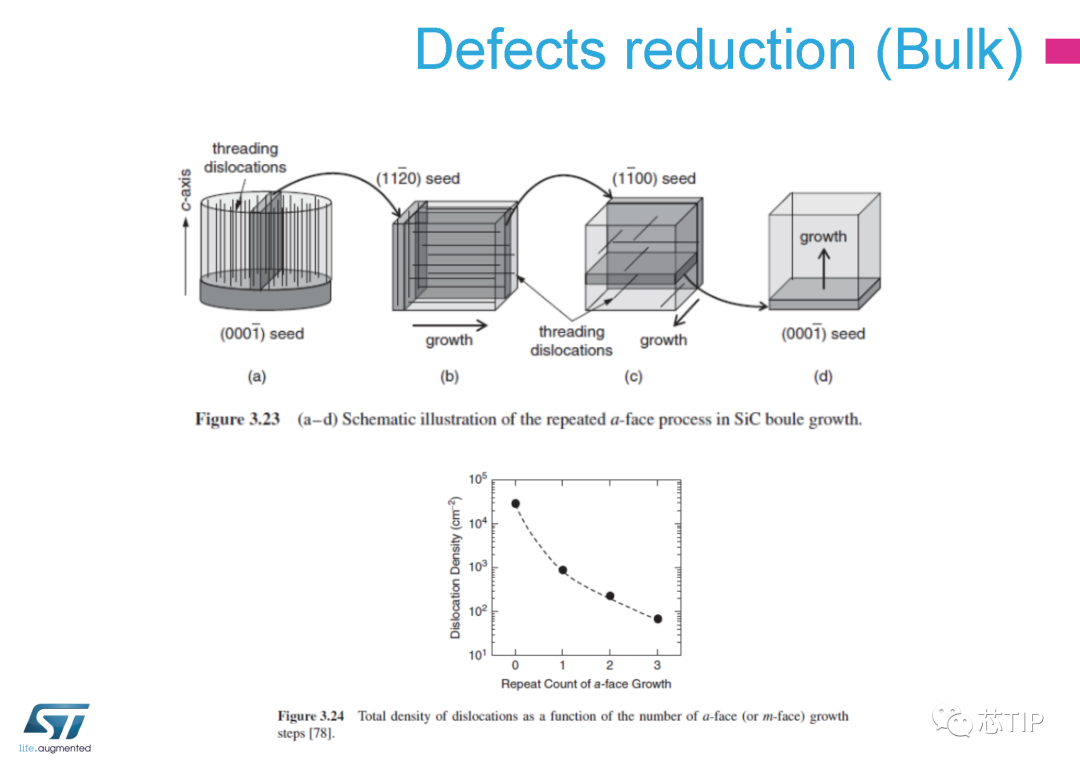
■ 外延缺陷
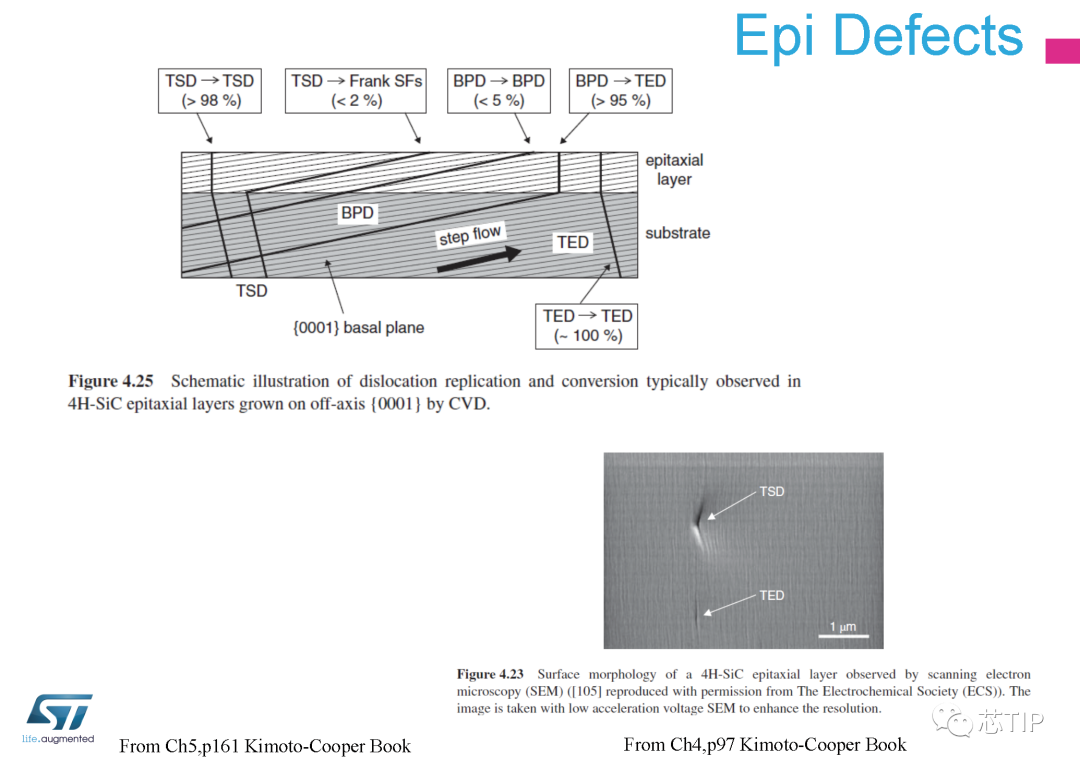
■ 外延缺陷
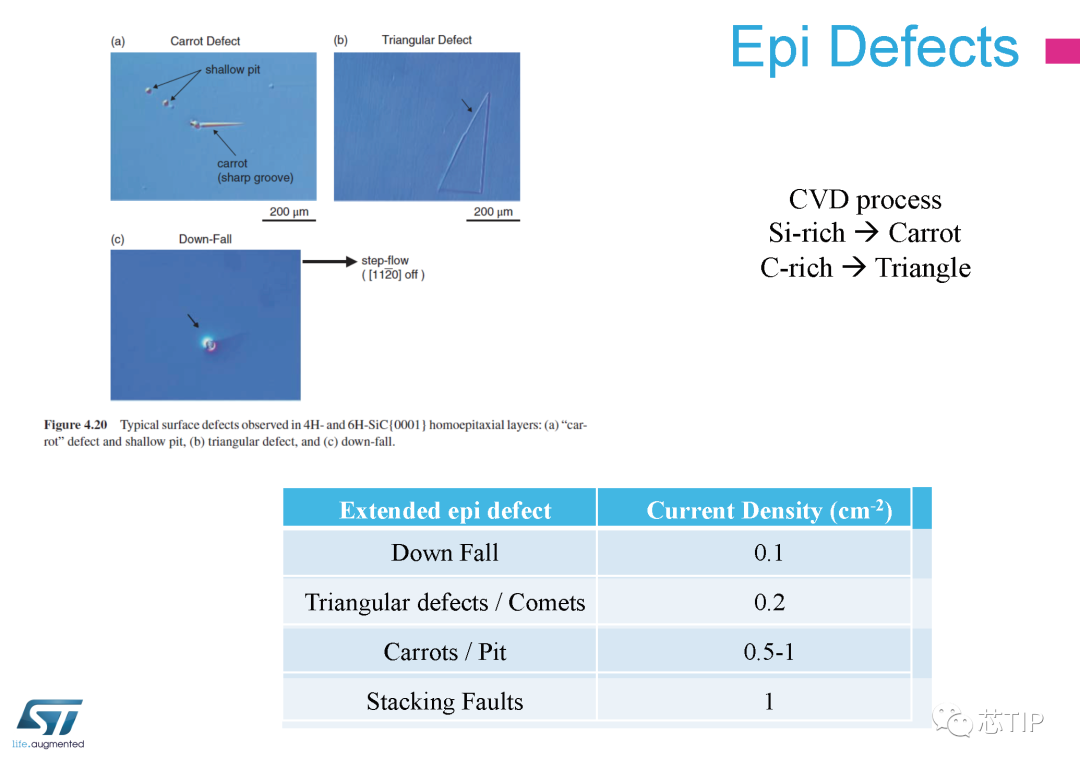
• 化学气相沉积工艺
富Si——胡萝卜缺陷
富C——三角缺陷
■ 位错与外延缺陷
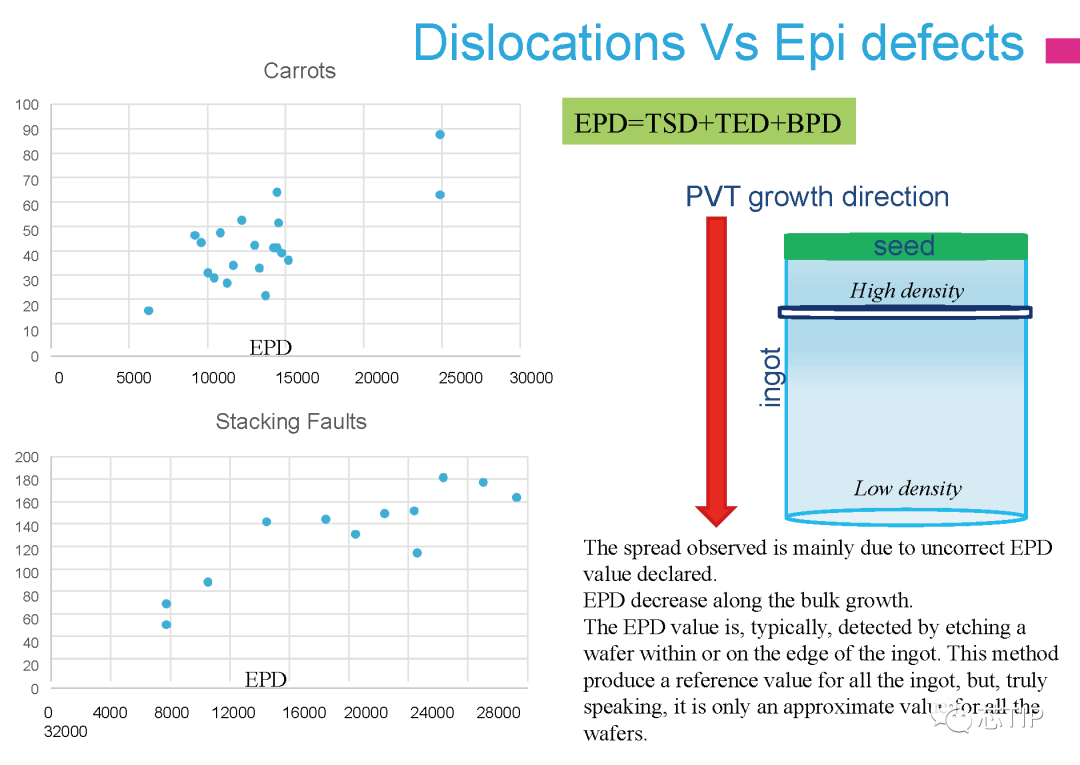
• EPD随体量增长而减少
• EPD 值通常通过在晶锭内部或边缘上蚀刻晶片来检测。
• 这种方法对所有的晶锭产生了一个参考值,但实际上,它只是对所有晶片的一个近似值
■ 外延缺陷:台阶聚集和粗糙度

• 外延工艺参数
• 对设备性能没有相关影响
• 关键生长参数:温度、生长速率、Si/C
■ 堆垛层错

■ 外延缺陷对器件的影响
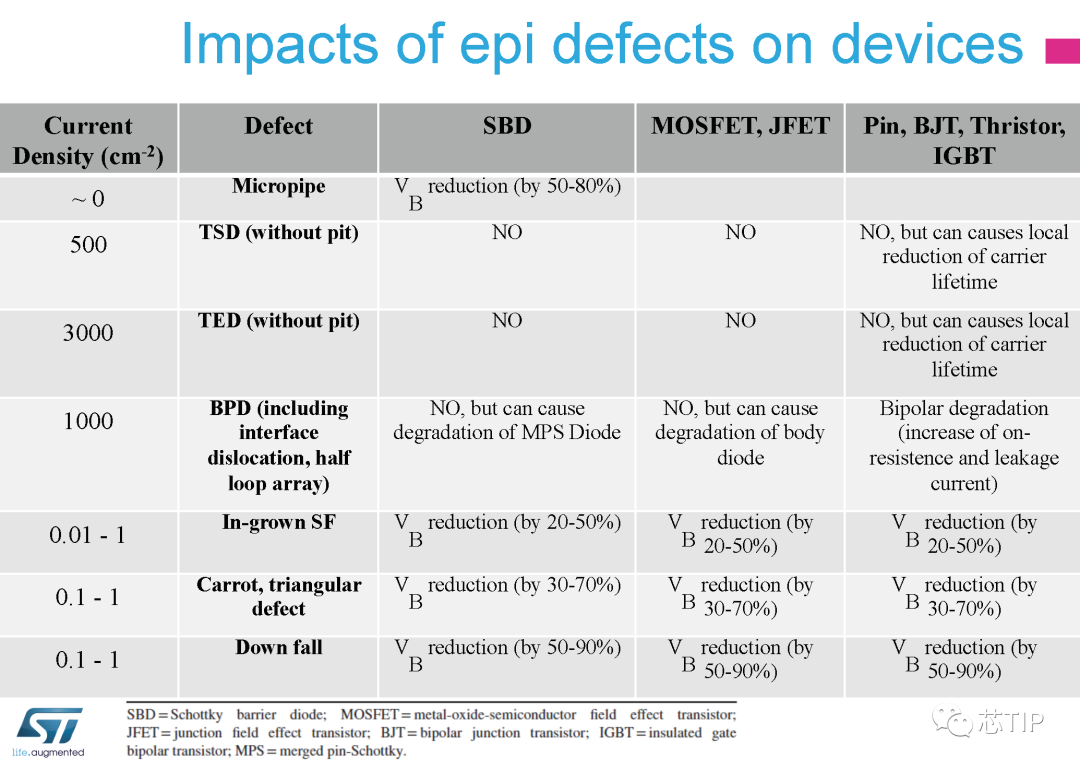
■ 微型光致发光和微型拉曼设置
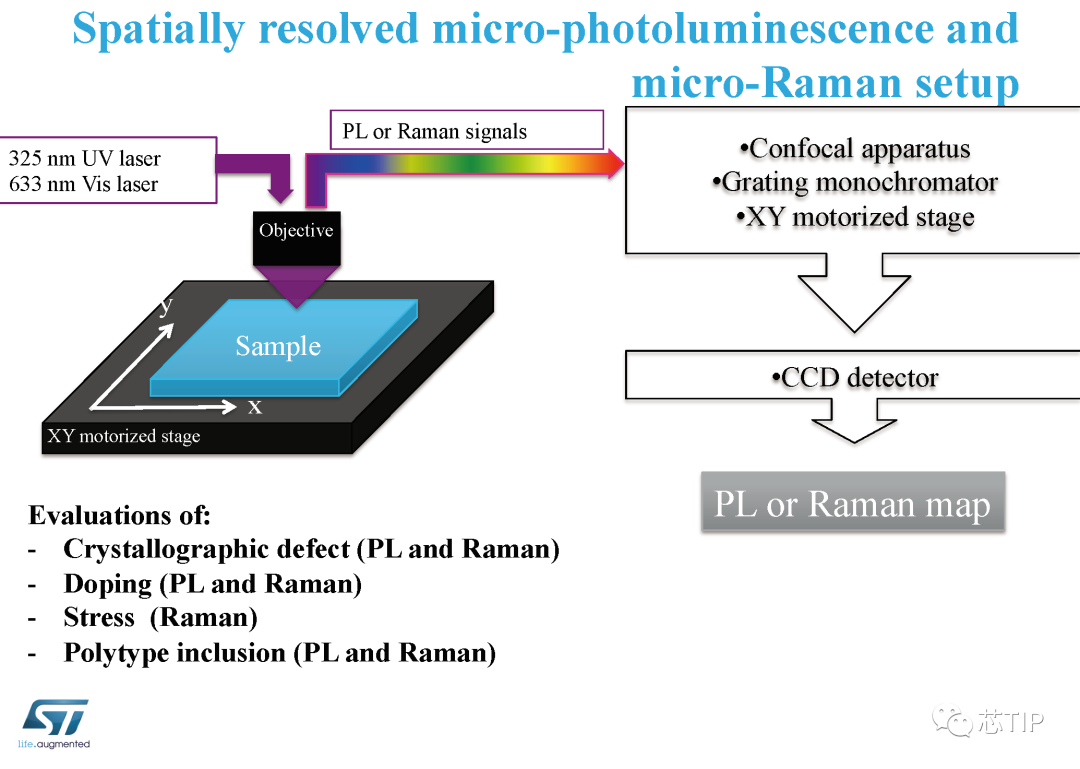
• 晶体缺陷(PL 和拉曼)
• 掺杂(PL 和拉曼)
• 应力(拉曼)
• 多型夹杂物(PL 和拉曼)
■ 堆垛层错/掺杂/应力
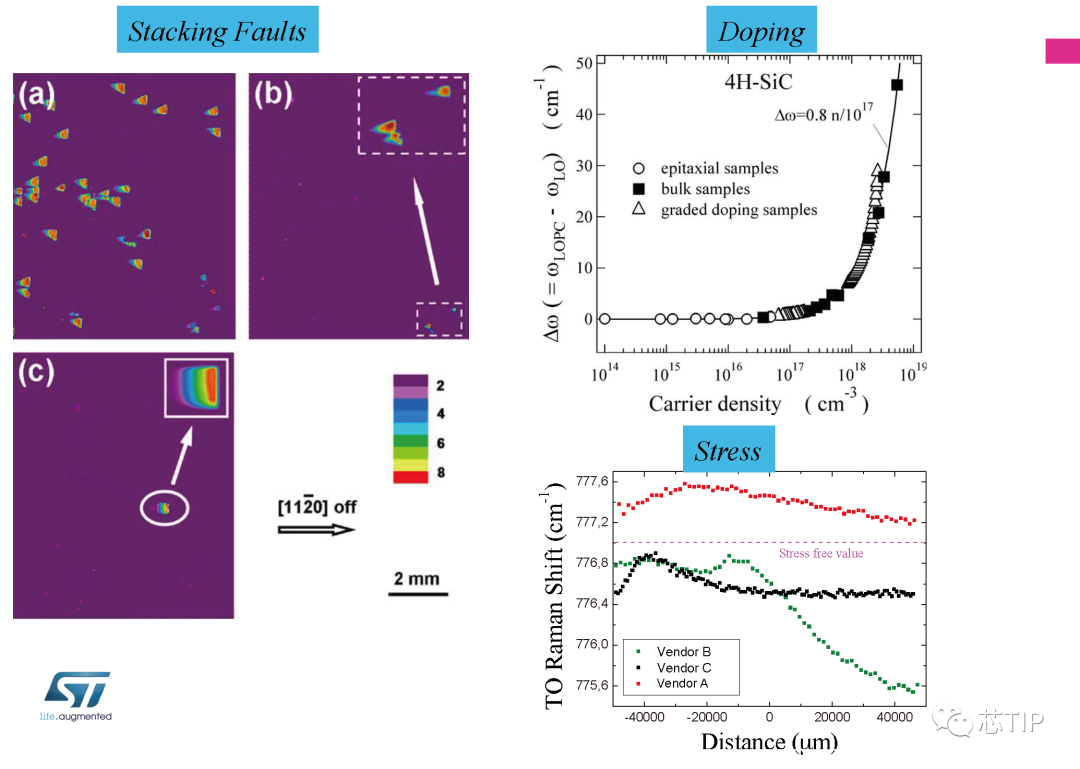
■ 多型夹杂物分析 (HeNe)

■ 点缺陷

■ μ-PCD 和 DLTS 方法
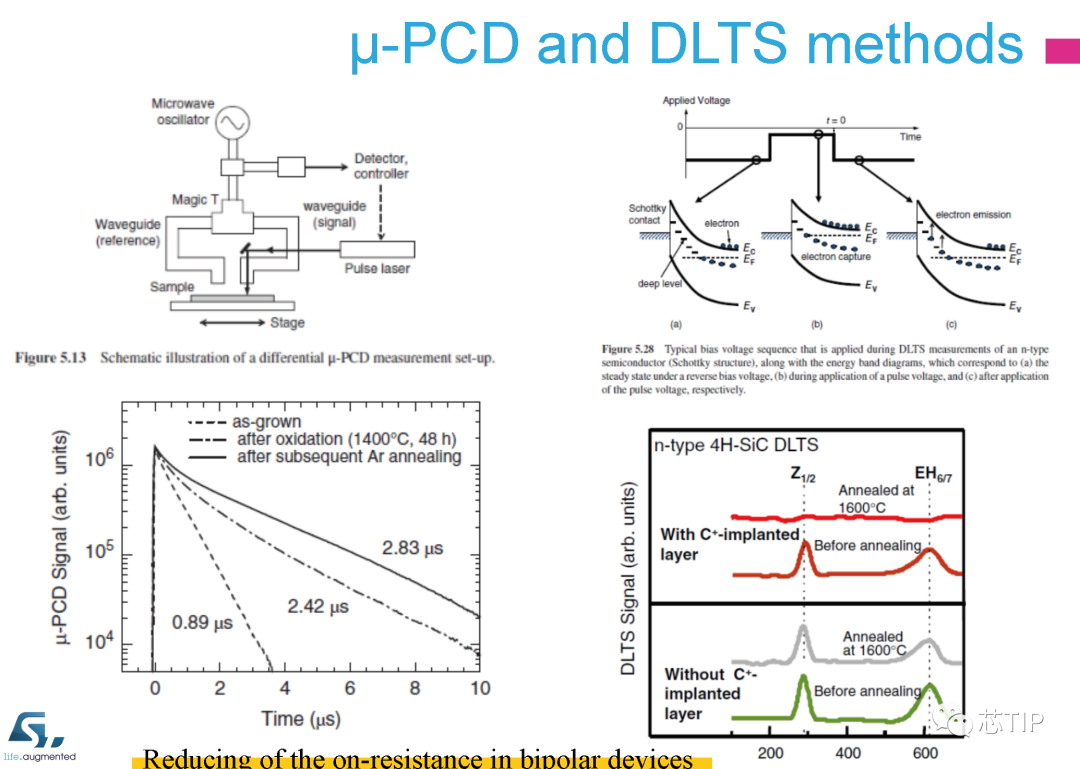
■ 离子注入致缺陷

• 离子注入过程对晶格产生损伤
• 通过在高温 (T > 1600 °C) 下进行退火,晶体被部分回收
• 然而,缺陷的聚集仍然存在并通过 PL 表征观察到
• 正在对离子剂量和退火温度进行优化
■ 坎德拉工具(散射光)
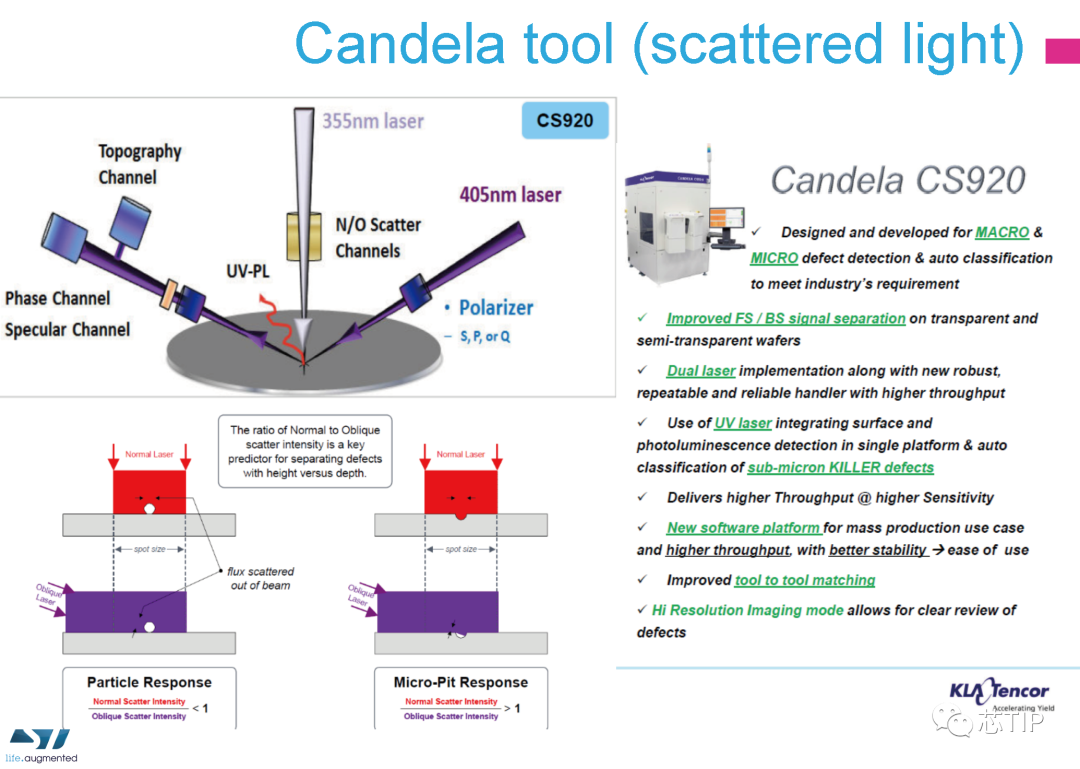
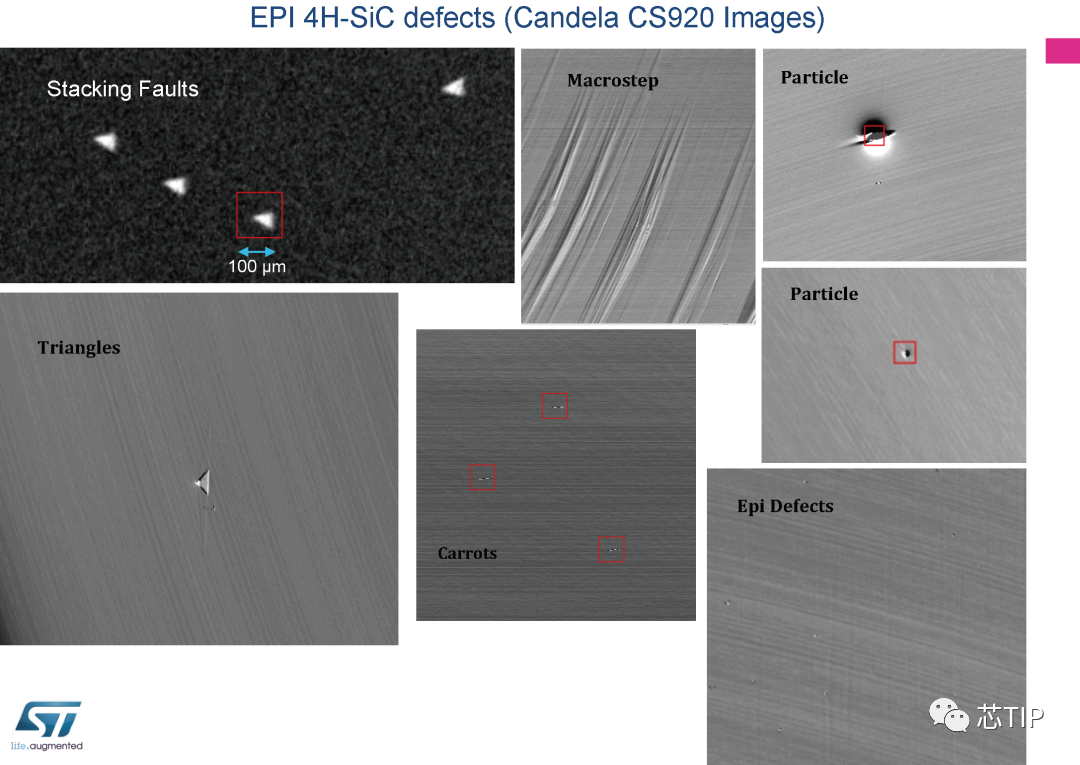
■ 总结

• 持续的质量改进
• 表征技术的广泛选择
• 来自不同供应商的不同质量
• 非破坏性 VS 破坏性表征方法(位错密度)
审核编辑:刘清
-
SEM
+关注
关注
0文章
237浏览量
14526 -
SiC
+关注
关注
30文章
2915浏览量
63064 -
TEM
+关注
关注
0文章
90浏览量
10479 -
拉曼光谱
+关注
关注
0文章
86浏览量
2787
原文标题:「芯报告」4H-SiC缺陷(cr.意法半导体)
文章出处:【微信号:CloudBrain-TT,微信公众号:云脑智库】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
相关推荐
改善4H-SiC晶圆表面缺陷的高压碳化硅解决方案

SiC功率器件性能和可靠性的提升
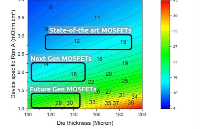
4H-SiC离子注入层的欧姆接触的制备
SiC器件中SiC材料的物性和特征,功率器件的特征,SiC MOSFET特征概述

基于简单的支架多片4H-SiC化学气相沉积同质外延生长
8英寸导电型4H-SiC单晶衬底制备与表征
天科合达谈八英寸SiC
SiC的物性和特征
如何降低SiC/SiO₂界面缺陷
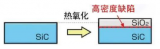
国产CVD设备在4H-SiC衬底上的同质外延实验

控制多晶硅(poly-Si)/4H-SiC异质结二极管能垒高度(ΦB)的方法
合盛新材料8英寸导电型4H-SiC衬底项目全线贯通
磨料形貌及分散介质对4H碳化硅晶片研磨质量有哪些影响





 4H-SiC缺陷概述
4H-SiC缺陷概述
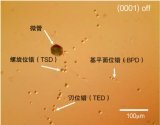










评论