日前,华为技术有限公司公布一项全新专利,命名为“封装结构及其制造方法、板级架构以及电子设备”,专利公开编号为CN117577594A,申请日期为2022年8月。
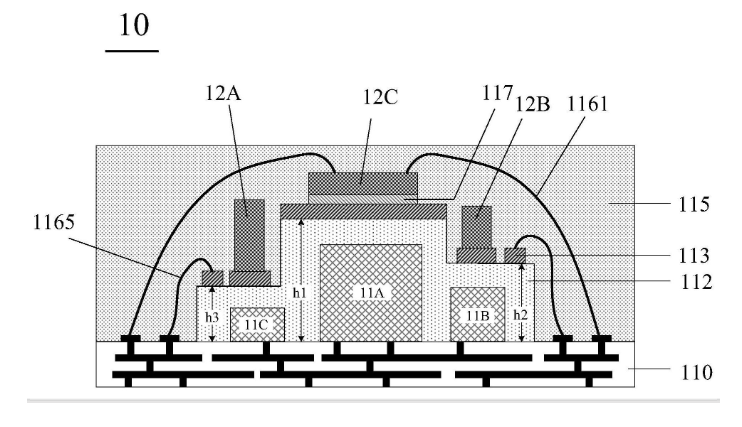
据悉,该新型专利涉及封装结构设计、制造流程、板级架构以及相应的电子设备等多方面内容。具体而言,创新性的封装结构由基板、多种不同功能的元器件、第一和第二塑封层以及金属布线层组成。巧妙地将基板上方的第一塑封层依照元器件的高度进行规划,极大地节省了高度方向的使用空间,进一步提升了封装结构的堆叠密度;此外在第一塑封层顶部还设置有金属布线层,用以配合第二塑封层将元器件稳固地安装并实现基板间的电气连通。相较于传统的封装结构,新发明在此基础上减少了一块基板的使用量,有效地降低了生产成本。同时,由于第二元器件直接被安装在第一金属布线层上,从而使整个装置具备显著的散热功效。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
元器件
+关注
关注
113文章
4753浏览量
92979 -
电子设备
+关注
关注
2文章
2823浏览量
54040 -
专利
+关注
关注
3文章
588浏览量
39292 -
华为技术
+关注
关注
0文章
40浏览量
7267
发布评论请先 登录
相关推荐
半导体封装的主要类型和制造方法
半导体封装是半导体器件制造过程中的一个重要环节,旨在保护芯片免受外界环境的影响,同时实现芯片与外部电路的连接。随着半导体技术的不断发展,封装技术也在不断革新,以满足电子设备小型化、高性能、低成本和环保的需求。本文将详细介绍半导体
封装工艺简介及元器件级封装设备有哪些
本文介绍了封装工艺简介及元器件级封装设备有哪些。 概述 电子产品制造流程涵盖半导体元件制造及整机系统集成,以晶圆切割成芯片为分界,大致分为前期工序与后期工序,如图所示。后期工序主要

长电科技申请电感封装结构专利
近日,江苏长电科技股份有限公司在电感封装技术领域取得重要突破,向国家知识产权局提交了一项名为“一种电感封装结构、相应的制备方法及封装板
OPPO摄像头模组及电子设备专利公布,防抖性能优化
近日,OPPO广东移动通信有限公司获批了一款摄像头模组及电子设备专利,公布号为CN110213415B,公布日期为2024年5月7日,申请时间为2019年6月14日。

芯片封装的力量:提升电子设备性能的关键
随着科技的飞速发展,芯片作为现代电子设备的核心部件,其性能和功能日益强大。然而,一个高性能的芯片若未能得到妥善的封装,其性能将大打折扣。因此,芯片封装技术的重要性不言而喻。本文将深入探讨芯片封

华为“电路板组件、电子设备”专利发布,聚焦设备散热问题
这份专利应用的场景是显示技术领域,旨在解决电子设备因过度发热而影响其性能这一问题。具体来说,该电路板组件包括SoC电路和射频电路,其中SoC电路位于第一电路板上,射频电路则位于第二电路
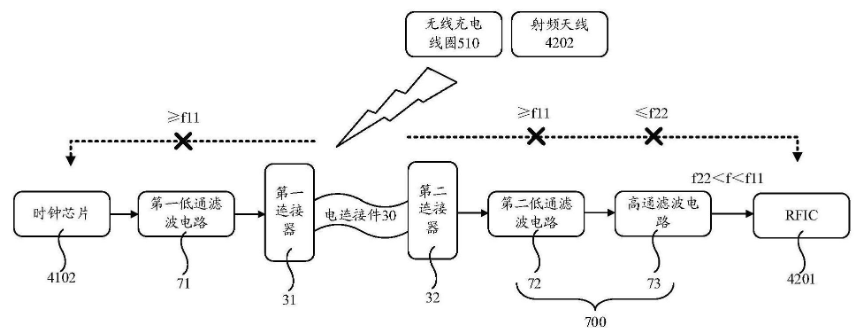
系统级封装技术综述
封装内,有效解决了传统封装面临的带宽、互连延迟、功耗和集成度方面的难题。同时将 SiP 与系统级芯片 SoC 相比较,指出各自的特点和发展趋势。 1 引言 传统的电子系
华为公布创新光通信专利
据最新消息透露,华为技术有限公司近日成功公布了一项名为“一种光模块、光通信设备及光通信系统”的专利,公开号CN117767976A。该专利的
紫光同芯微电子发布防拆芯片及电子设备专利
该项专利涵盖了半导体科技领域的创新成果,描述了一种防止硬件被拆卸的芯片设计方案以及相关产品——电子设备。该芯片包含基板、晶片及防拆部件三个主要结构组件。基板上设有多个引脚,主要负责供电;晶片则贴合在基板正面





 华为公布封装结构、封装方法、板级架构及电子设备专利
华为公布封装结构、封装方法、板级架构及电子设备专利

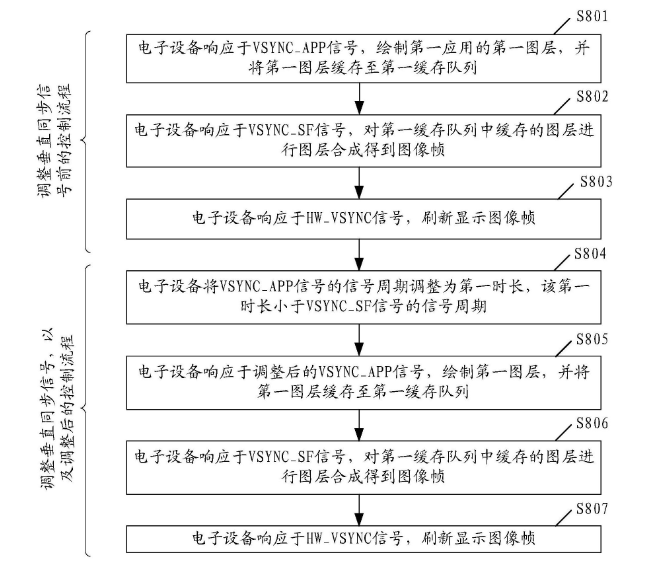













评论