据韩国媒体ETNews透露,三星电子正在研究将非导电胶(NCF)更换为模塑底部填胶(MUF),以提升公司的封装技术水平。
此前,三星一直利用非导电胶来完成半导体间的垂直连接。尽管NCF能有效避免芯片变形,但其难度较大且生产率低下的缺点使其未受到广泛认同。
据报道,三星电子拟在硅通孔(through-silicon electrode,TVS)的制造过程中引用MUF材料。TVS可以在晶圆或裸晶表面钻出许多微小的孔洞,提供垂直连接通道。而MUF则可以填充这些孔洞,减小半导体间的空隙,从而让各种垂直堆叠的半导体更加稳定。
据悉,三星已从日本引进相关设备,以推进MUF的应用。此外,SK海力士也在第三代HBM(HBM2E)之后改用MUF,尤其是针对MR-MUF进行了调整。
业内人士评价说:“相较于NCF,MR-MUF具有更高的导热性能,对工艺速度及良品率均有显著改善。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
三星电子
+关注
关注
34文章
15865浏览量
181043 -
TVS
+关注
关注
8文章
791浏览量
60639 -
晶圆
+关注
关注
52文章
4922浏览量
128047
发布评论请先 登录
相关推荐
三星电子计划新建封装工厂,扩产HBM内存
三星电子计划在韩国天安市新建一座半导体封装工厂,以扩大HBM内存等产品的后端产能。该工厂将依托现有封装设施,进一步提升
三星电子:18FDS将成为物联网和MCU领域的重要工艺
电子发烧友网报道(文/吴子鹏)今年上半年,三星在FD-SOI工艺上面再进一步。3月份,意法半导体(STMicroelectronics)宣布与三星联合推出18nm FD-SOI
发表于 10-23 11:53
•315次阅读

芯片封装胶underfill底部填充胶点胶工艺基本操作流程
的脱落。在烘烤工艺中,参数制定的依据PCBA重量的变化,具体可以咨询汉思新材料。二、预热对主板进行预热,可以提高Underfill底部填充胶的流动性。要注意的是——

详解点胶工艺用途和具体要求
电子产品芯片的微型化正变得越来越受欢迎。但是微型化带来了焊点可靠性问题。元件和基板使用锡膏进行焊接,但是由于体积太小使得焊点更容易受到应力影响而出现脱落问题。因此引入了底部填充工艺。该
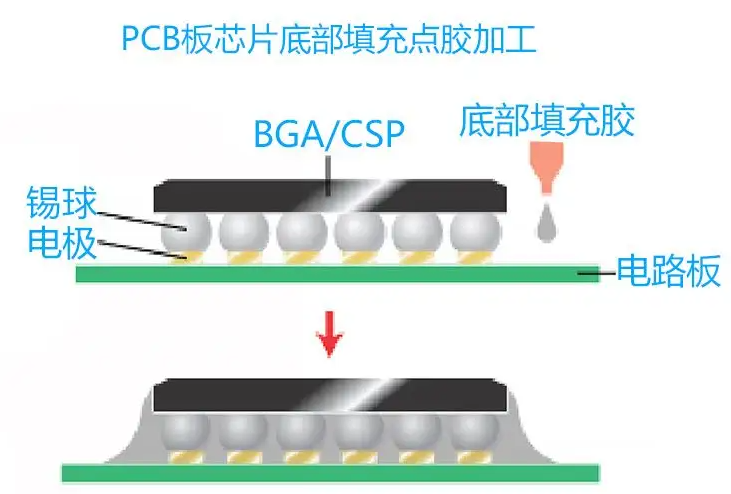
mos封装工艺是什么,MOS管封装类型
MOS封装工艺是指将制造好的MOS管芯片通过一系列步骤封装到外壳中的过程。以下是MOS封装工艺的详细步骤和相关信息:
受困于良率?三星否认HBM芯片生产采用MR-MUF工艺
芯片生产中应用MR-MUF(批量回流模制底部填充)技术的传言并不属实。 三星在HBM生产中目前主要采用非导电薄膜(NCF)技术,而非SK海力士使用的批量回流模制底部填充(MR-MUF)封装

三星效仿SK海力士,采用竞争对手主导的芯片封装工艺
就此,知情人士指出,三星此举体现出该公司提升HBM良率的决心。对此,一家行业分析机构表示,考虑到AI行业对HBM3及HBM3E芯片需求日益增长,三星有必要作出调整。
半导体封装工艺面临的挑战
半导体工艺主要是应用微细加工技术、膜技术,把芯片及其他要素在各个区域中充分连接,如:基板、框架等区域中,有利于引出接线端子,通过可塑性绝缘介质后灌封固定,使其形成一个整体,以立体结构方式呈现,最终形成半导体封装工艺。
发表于 03-01 10:30
•851次阅读

半导体封装工艺的研究分析
控,能采用精细化管理模式,在细节上规避常规问题发生;再从新时代发展背景下提出半导体封装工艺面临的挑战,建议把工作重心放在半导体封装工艺质量控制方面,要对其要点内容全面掌握,才可有效提升半导体封





 三星电子拟升级工艺,引入模塑底部填胶提升封装工艺
三星电子拟升级工艺,引入模塑底部填胶提升封装工艺













评论