什么是芯片底部填充胶,它有什么特点?
芯片底部填充胶是一种用于电子封装的胶水,主要用于底部填充bga芯片电子组件,以增强组件的可靠性和稳定性。它通常是一种环氧树脂,具有良好的粘接性和耐热性。
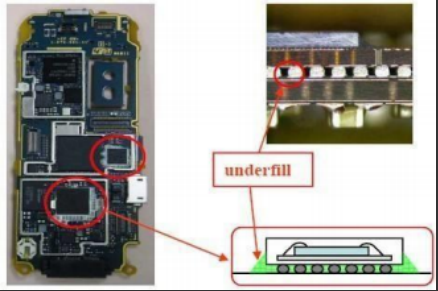
底部填充胶的特点主要有以下几点:
1,良好的粘接性:底部填充胶能够很好地粘接各种材料,包括金属、陶瓷和塑料等。
2,耐热性:底部填充胶具有良好的耐热性,可以在高温环境下保持稳定。
3,高强度:底部填充胶固化后具有高强度,能够承受较大的机械应力。
4,耐腐蚀性:底部填充胶具有良好的耐腐蚀性,能够抵抗各种化学物质的侵蚀。
5,低收缩性:底部填充胶在固化过程中收缩性低,能够减少因收缩引起的应力。
6,易于操作:底部填充胶可以通过自动设备进行精确控制和操作,提高生产效率。
总的来说,芯片底部填充胶是一种高性能的胶粘剂,主要用于电子封装领域,提高电子产品的可靠性和稳定性。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
芯片
+关注
关注
463文章
54378浏览量
468988 -
电子封装
+关注
关注
0文章
94浏览量
11413
发布评论请先 登录
相关推荐
热点推荐
超细间距倒装芯片灌封胶渗透与空洞控制 |铬锐特实业
铬锐特实业|探讨超细间距(Fine-pitch)倒装芯片封装中,底部填充胶渗透难题与空洞缺陷控制的关键技术。分析间距缩小至40-55μm时的流动性、空洞成因及行业解决方案,助力高性能

汉思新材料斩获小间距芯片填充胶专利,破解高端封装空洞难题
近日,东莞市汉思新材料科技有限公司(以下简称“汉思新材料”)成功斩获“一种温控晶振小间距芯片填充胶及其制备方法”发明专利(公开号:CN121343527A)。依托突破性创新配方设计,该产品可实现

汉思新材料:环氧底部填充胶固化后有气泡产生原因分析及解决方案
的详细分析以及相应的解决方案:汉思新材料:环氧底部填充胶固化后有气泡产生原因分析及解决方案一、气泡产生原因分析1.材料本身原因:预混胶中残留气泡:胶水在混合或运输

汉思新材料|芯片级底部填充胶守护你的智能清洁机器人
汉思新材料|芯片级底部填充胶守护你的智能清洁机器人智能清洁机器人的广泛应用随着现代科技的飞速发展,智能清洁机器人已覆盖家庭、商用两大场景:家庭中实现扫拖消全自动,商用领域应用于酒店(客

汉思新材料:底部填充胶返修难题分析与解决方案
,有的产品可能需要进行返修(如更换单个芯片或修复下方焊点)对于没有经验的新手返修也是个难题,以下是具体原因分析及相应的解决方案:一、底部填充胶返修困难原因分析材料特

汉思新材料取得一种封装芯片高可靠底部填充胶及其制备方法的专利
汉思新材料取得一种封装芯片高可靠底部填充胶及其制备方法的专利2025年4月30日消息,国家知识产权局信息显示,深圳市汉思新材料科技有限公司取得一项名为“封装




 什么是芯片底部填充胶,它有什么特点?
什么是芯片底部填充胶,它有什么特点?












评论