共读好书
帅行天 张国平 邓立波 孙蓉 李世玮 汪正平
中国科学院深圳先进技术研究院 香港科技大学香港中文大学
摘要
通过堆栈电子器件的三维集成电路 (3D-ICs) 能够缩小封装面积,并增加系统的容量和功能。在过去的几十年中,基于薄晶圆 ( 通常厚度小于 100 μm) 的硅穿孔(Through-Silicon Via,TSV) 技术已经实现了 3D-IC 封装。但是由于薄晶圆的易碎性和易翘曲的倾向,在对器件晶圆进行背部加工过程中,需要利用胶粘剂将其固定在载体上,并使薄晶圆在背部加工后易于从载体上剥离。文章介绍了用于此工艺的临时键合胶的研究现状,并对一种新型的、基于热塑性树脂的临时键合胶性能进行了系统的考察。这种新型的胶粘剂表现出优异的流变性能、热稳定性、化学稳定性和足够的粘接强度,并且易于剥离和清洗。这些研究成果拓展了可以应用于临时键合胶的聚合物范围,对促进 TSV 技术的应用具有重要意义。
1 引 言
近年来,计算机、通讯、汽车电子、航空航天工业和其它消费类产品对微电子封装提出了更高的要求,即更小、更薄、更轻、多功能与低成本。为满足这些产品的小型化需求,半导体工业需要将器件晶圆减薄至 100 μm 以下,将薄晶圆之间以硅通孔(Through-Silicon Via,TSV)垂直互连,实现高密度 3D 叠层封装,以突破摩尔定律 [1] 。超薄晶圆具有柔性、易碎性、容易翘曲和起伏等特点,因此通常先将器件晶圆用中间材料键合到较厚的载体上,经过背部减薄、TSV 开孔工艺、形成重布线层和内部互连制作之后,再输入外界能量(光、电、热及外力)使粘结层失效,之后将器件晶圆从载体上分离开来(如图 1所示),此过程即为晶圆的临时键合工艺[2,3] 。其中,用于固定薄晶圆的键合胶是临时键合工艺成功的关键。
目前,我国采用 TSV 互联技术制备图像传感器已经进入量产阶段,应用于微机电系统(MEMS)封装的 TSV 工艺也得到快速发展。在这些器件中,厚度低于 100 μm 的晶圆已经得到广泛应用,临时键合工艺正逐渐成为薄晶圆加工的主流解决方案。因此,用于薄晶圆加工的临时键合胶材料具有广阔的市场前景。据权威机构 Yole公司统计,到 2016 年,全球需要临时键合的晶圆将达 3500 万片,临时键合设备与材料的市场规模将达到 2.5 亿美元 [4] 。
临时键合胶应用前景引起了学术和工业界广泛的兴趣,目前已经开发出了一系列基于热熔融、热降解等机制进行解键合的高性能临时键合胶。由于热熔融解键合机制的临时键合胶具有易于解键合且残余粘结层易于清洗等优势,目前应用比较广泛 [5-8] 。在薄晶圆背部加工过程中,键合体系要经历高温、氧化剂、强酸、强碱及多种有机溶剂环境,因此作为临时键合材料必须具有良好的热稳定性和化学稳定性。
目前,已经有几款热塑性临时键合胶产品推向市场,但是仍然存在解键合温度高、键合/解键合效率低、价格昂贵等问题。针对这些问题,笔者开发出一种新型的热塑性临时键合胶,对其化学和热稳定性、流变性质、粘接强度等性质进行了系统考察,并模拟了一系列的晶圆背部工艺以测试键合胶的综合性能。结果表明,这种临时键合胶能很好地满足临时键合工艺的需求。
2 临时键合胶的研究现状
临时键合胶的性能主要取决于作为基础粘料的聚合物的性质,它必须具有出色的热和化学稳定性,以抵抗 3D-IC TSV 工艺中的高温以及等离子、溶剂、氧化剂和酸、碱溶液对它的侵蚀 [1]。除了要具有优异的粘接性能来抵抗晶圆减薄过程中的机械应力之外,临时性粘结层的厚度还必须在整个晶圆范围内具有高度的均匀性,即在经过所有工艺步骤后,整个晶圆范围内要有一个低的总厚度变化量 [1] 。此外,为了提高生产效率,键合阶段胶粘剂固化成型及解键合阶段粘结层失效时间需尽可能短,而且后续清洗工艺应尽量简单。目前,对键合体系主要有三种解键合释放机制:化学腐蚀/溶解、光引发与热拆。其中,化学释放法在解键合后,无法控制薄晶圆在溶液槽中漂浮,因此不适用于 TSV 集成所需的薄晶圆 [9] ;光引发释放材料对承载晶圆的透光性有严格要求;热拆方法通常要求解键合温度高于最大工作温度,胶粘剂熔体有良好的流动性且各组分不发生化学反应。
鉴于薄晶圆加工过程中的高温与强腐蚀环境以及解键合的工艺要求,选择合适的聚合物作为胶粘剂的基础粘料至关重要。科研工作者在这方面开展了大量的工作。美国佐治亚理工学院 Kohl 课题组 [10] 设计了以聚碳酸酯(PC)为基础组分的临时键合胶,其粘接能力由 PC 熔体在冷却固化后提供,解键合由高温下聚合物的热降解实现。研究发现,具有刚性主链的 PC 粘接性能优于含柔性主链的 PC,然而后者在高温下更容易降解,因此可能更适合作为胶粘剂的粘料。瑞典皇家理工学院 [11] 开发了一种基于电化学活性聚合物的胶粘剂,对键合体系施加一定的电压可以将其分开。美国 Brewer Sciences 公司 [12] 开发了一种名为 WaferBond HT1010 的胶粘剂,该胶粘剂基础粘料为聚烯烃混合物,在室温下具有极强的粘接能力,并且可以方便地进行解键合与清洗。然而其软化点仅为 180℃,高温粘接性能仍需改善。EV Group 和 Brewer Sciences 公司最近报道了一种新型的高耐热性临时键合胶,它可以在超过 300℃ 的环境下使用,并可以采用光辐照和热熔融两种方式实现解键合 [9] 。德国柏林科技大学和杜邦公司等 [3,13,14] 采用聚酰亚胺作为粘接组分开发了一种耐热、耐腐蚀的胶粘剂,用该胶粘剂键合晶圆之后,可以用激光辐照与溶剂浸泡两种方式进行解键合。日本 TOK 公司最近开发了一种新型的热塑性临时键合胶,该临时键合胶具有合适的弹性模量,可有效降低薄晶圆在加工过程中出现的翘曲倾向 [19] 。3M 公司 [3] 开发了一种可以在室温下由激光引发解键合的胶粘剂,其关键组分为一种光-热转换材料(Light to Heat Conversion Material),然而在解键合过程中需要用到有粘接能力的保护膜,薄晶圆最后还需要从保护膜上分离,降低了解键合效率。DowCorning 公司 [15] 开发了一种基于有机硅树脂的胶粘剂,其施胶固化后包含双层膜结构,解键合时直接对键合体系施加剪切力,粘结层与释放层即分离开来,简化了键合/分离过程,然而该方法导致的晶圆破片率较高。
在薄晶圆的背部加工过程中,容易发生翘曲甚至破裂。产生这种现象的原因之一是胶粘剂固化和背部加工的热循环过程中晶圆产生内应力。因此,需要对全流程中晶圆内应力分布进行理论分析,以指导胶粘剂的开发。同济大学郑百林教授课题组 [16] 运用三维有限元分析方法分别对单芯封装器件和多芯封装器件由于热变形引起的翘曲问题进行了分析,发现在单芯封装中,基底与芯片厚度比和封装材料与芯片厚度比的变化对翘曲影响较大。桂林电子科技大学牛利刚教授 [17] 采用有限元方法分析了晶圆尺寸级封装(WLCSP)器件在热循环条件下的热应力及翘曲变形情况。其研究发现,芯片厚度、PCB 厚度、BCB 厚度和上焊盘高度对WLCSP 的热应力影响较为明显,芯片厚度为 200 μm 时热应力为 70 MPa。对键合体系的有限元分析还表明,通过增加载体厚度与模量、减少粘结层与器件晶圆热膨胀系数的差值以及减小粘结层的模量与松弛时间可以减少晶圆翘曲 [18] 。
为改善上述临时键合胶基础树脂存在的合成路线复杂或成本过高等缺点,笔者开发了一种基于耐热性能良好的热塑性树脂的胶粘剂,并通过对基础树脂的改性以及对配方的优化,开发了一种基于热拆解键合机制的临时键合胶,下文将详细介绍所开发胶粘剂的性能。
3 新型临时键合胶
基础树脂的性质决定了胶粘剂的耐热、耐腐蚀等性能。在考察了一系列耐热良好的聚合物的溶解性能后,选择了热分解温度在 300℃ 以上、软化温度在 150℃ 以上且溶解性好的热塑性树脂(考虑到热滑移的解键合机理)作为临时键合胶的基础树脂,并在此基础上加入助剂形成了临时键合胶的基本配方。具体制备方法为(以下均为重量百分数):将基础树脂、增粘剂、抗氧剂和流平剂在室温下分别溶于 N,N’-二甲基甲酰胺/N,N’-二甲基乙酰胺/柠檬烯混合溶剂中,组分浓度分别为 30%、10%、1% 和 0.05%。为了充分验证此基于热拆解键合机制的临时键合胶(本文中记为 Sample-A)的可靠性,对其基本性质进行了系统的考察,并与 Brewer Sciences 公司开发的 WaferBond HT1010(本文中记为 HT1010)和最近报道的新型临时键合胶的相应性质进行了对比,并模拟了Sample-A 的一系列工艺验证,进一步确认了它在晶圆背部加工过程中的可靠性。
3.1 流变性质
在临时键合过程中,为了使临时键合胶能均匀地铺展在晶圆表面并达到足够的厚度,其初始黏度需要进行充分优化。此外,熔融状态的临时键合胶的黏度必须足够低,以便于经过背部加工后的薄晶圆通过热滑移的方法与载体平稳分离。采用流变仪测量临时键合胶的流变性质,测得Sample-A 和 HT1010 在室温下的初始黏度分别为0.7 Pa·s 和 1.5 Pa·s,Sample-A较低的黏度有助于提高粘结层厚度的均匀性。
在不同温度下,键合胶黏度的测试结果可用来预测在高温下,晶圆背部加工过程中临时键合胶的粘接性能,并确定键合体系最合适的加工温度区间和解键合温度。Sample-A 和 HT1010 的黏度与温度的关系曲线如图 2 所示。在 170℃ 时,HT1010的黏度低于 300 Pa·s,而 Sample-A 的黏度高达 1760 Pa·s。这一结果表明 Sample-A 具有良好的耐热性能,这使得它更能适应器件晶圆背部减薄过程中产生的高温环境。另一方面,在235℃ 时,Sample-A 的黏度为92 Pa·s,而日本TOK 公司最近开发的一种新型的热塑性临时键合胶在相同温度下的黏度为 650 Pa·s [19] 。在解键合过程中,临时键合胶较低的黏度可以使器件晶圆与载体晶圆更容易解键合。
3.2 热稳定性
由于临时键合体系要经受器件晶圆背部加工过程中产生的高温,因此热稳定性是临时键合胶应具备的最重要的性质之一 [20] 。通过热重分析(TGA)可评估临时键合胶的热稳定性。图 3 显示了 Sample-A 和HT1010 的热失重曲线。从热失重曲线可以看出,Sample-A 在 350℃ 以下非常稳定,在 400℃ 时失重小于 5%,而 HT1010 在270℃ 的失重已经超过 5%。另外,TOK 公司最近开发的新型热塑性临时键合胶在 350℃ 时,热失重也超过了 5% [19] 。由此可见 Sample-A 的热稳定性要强于后两种产品,较高的热稳定性能有效拓宽临时键合胶在临时键合工艺中的使用温度范围。新型热塑性材料优异的热稳定性和良好的溶解性使得它非常适合作为临时键合胶的基础树脂。
另外,为了进一步考察临时键合胶的热稳定性,我们利用差示扫描量热法(DSC)来确定临时键合胶的玻璃化转变温度(Tg)。图 4 展示了Sample-A 和 HT1010 的 DSC 曲线。通过对曲线的分析可以发现,Sample-A 的 Tg 为 86℃,而HT1010 一直加热到 180℃,依然看不到明显的玻璃化转变。尽管如此,Sample-A 较低的 Tg 并不会限制它在低于 260℃ 的温度下使用。
3.3 化学稳定性
在器件晶圆背部处理过程中,由于临时键合体系要在不同温度下经历氧化剂、强酸、强碱及多种有机溶剂等恶劣环境,因此临时键合胶良好的化学稳定性显得至关重要。将使用临时键合胶键合的晶圆对浸泡在不同的化学试剂中,并加热至不同的温度。分别浸泡 5~40 min 后,再对键合晶圆对进行解键合测试,看是否出现剥离现象。Sample-A和 HT1010 对几种化学试剂的稳定性列于表 1,“√”表示该键合晶圆对通过腐蚀试验后没有剥离。从测试结果可以看出两种临时键合胶都显示出很好的化学稳定性。
3.4 热膨胀系数
在晶圆背部打磨和 TSV 过程中,晶圆需要经历热循环过程,并在此过程中产生内应力。我们希望通过降低临时键合胶的热膨胀系数(CTE)来减小在加工过程中产生的应变。通过热机械分析(TMA)可以发现,Sample-A 和 HT1010 的CTE分别为 63 ppm/℃ 和 93 ppm/℃。最近,德国柏林科技大学和杜邦公司等共同开发了一种基于聚酰亚胺的临时键合胶,并测得其 CTE 为 50ppm/℃ [13] 。通过对上述三种临时键合胶 CTE 的对比可以发现,我们开发的新型临时键合胶在此方面具有一定的优势,同时也有进一步优化的空间。Haq 等 [18] 通过有限元仿真模拟发现,减少粘结层与器件晶圆热膨胀系数的差值有利于降低薄晶圆在冷热循环过程中的翘曲。因此,Sample-A较低的 CTE 可能有助于降低薄晶圆背部加工过程中产生的翘曲倾向。
3.5 粘接强度
在临时键合工艺中,键合体系中间的粘结层必须提供足够的机械强度以保证器件晶圆不会滑移。在晶圆键合工艺过程中,首先将临时键合胶旋涂到器件晶圆和载体晶圆上,通过烘烤除去溶剂后将两片晶圆键合在一起,冷却固化粘结层。然后采用晶片剪切的方法(如图 5 所示)在室温下测定粘结层的粘接强度。Sample-A 和HT1010 的剪切强度分别为 21 MPa 和 83 MPa。尽管Sample-A 的剪切强度低于 HT1010,但也足以满足器件晶圆的整个加工工艺。 此外,还可以通过加入交联剂、偶联剂等方法方便地调节粘接强度。
3.6 粘结层的厚度和均匀性
较厚的粘结层有利于降低薄晶圆的翘曲,临时键合工艺测试表明,粘结层的厚度至少要达到 15μm 才能保证晶圆的平整。另一方面,铺展在晶圆表面的临时键合胶必须高度均匀,因为粘结层厚度不均可能导致晶圆在背部研磨过程中发生破损和翘曲。临时键合胶粘结层的总厚度变化(TTV)越小,最终得到的晶圆的厚度就越均匀。采用 Filmetrics F50 测量晶圆上临时键合胶的厚度分布,结果如图 6 所示。经过分析发现,Sample-A 粘结层的平均厚度为 22.7 μm,标准偏差为 0.5,而HT1010 粘结层的平均厚度为 25.8μm,标准偏差为 1.6。因此,使用相同的旋涂工艺,Sample-A 的粘结层厚度比 HT1010 更均匀。另外,EV Group 和 Brewer Sciences 公司最近报道了一种新型的热塑性临时键合胶,其旋涂在晶圆上的粘接层平均厚度为 13.5 μm,平整度为±1.5% [9] 。
另外,利用超声扫描显微镜(SAM)研究了键合体系中粘结层内部的均匀性。图 7 展示了分别使用 Sample-A 和 HT1010 键合的晶圆对的 SAM 图像。可以看出,这两对晶圆之间的粘结层都是无空隙的,并且二者的粘接层分布都比较均匀,表明在键合过程中胶层没有气体溢出。
3.7 模拟工艺验证
在考察了临时键合胶的基本性能之后,采用Sample-A 键合好的晶圆对在一系列背部工艺(模拟)下进行测试。具体背部工艺流程如下:
(1)碱性环境浸泡:用 NaOH 配制 pH=10的水溶液,预热至 60℃,将键合好的晶圆对置于碱液中浸泡 3 min;
(2)湿法刻蚀:将第(1)步处理过的晶圆对置于 HF : HNO 3 =1 : 10 的混合溶液中室温浸泡4 min;
(3)晶圆表层钝化:将第(2)步处理过的晶圆对置于高温炉中,在 200℃、N 2 氛围中钝化 1 h;
(4)抛光:用 NaOH 配制 pH=13 的水溶液,预热至 60℃,将第(3)步处理过的晶圆对置于碱液中浸泡 20 min;
(5)酸性电镀液浸泡:将第(4)步中处理过的晶圆对在室温下置于酸性电镀液中浸泡 5 min;
(6)高温回流:将第(5)步处理过的晶圆对置于已经预热至 265℃ 的烘箱中,烘烤 10 min,然后冷却至室温。
在上述一系列的模拟工艺验证过程中,键合体系表现出良好的化学和热稳定性,没有出现剥离和溢胶现象。在经过模拟高温回流焊工艺后,键合体系亦未发生变化。所有的工艺验证完成后,在 235℃ 下将器件晶圆通过热滑移的方法从载体晶圆上剥离,解键合过程平稳。解键合后的晶圆没有任何破裂和翘曲的迹象。最后在旋涂仪上使用自制的清洗剂清除晶圆表面残留的临时键合胶,晶圆表面的残余胶用拉曼光谱检查。由图 8 可以看出,经过 3 次清洗,仍然可以观察到临时键合胶的特征峰,而经过 6 次清洗后,特征峰消失,表明晶圆表面的残余胶已经完全清洗干净。
4 总 结
本文通过对目前国内外临时键合胶研究现状的概述,总结了目前临时键合胶研究存在的一些共性问题和将来的发展趋势,并引出对笔者开发的新型热塑性临时键合胶性能的系统考察。这种临时键合胶能够使键合的晶圆在高温下进行背部加工,并很容易地在 235℃ 下解键合。这种热塑性的基础树脂被溶解在一种安全的溶剂中,通过旋涂形成无空隙的厚粘结层,并且粘结层在晶圆表面具有很好的均匀性。该临时键合胶还具有低的热膨胀系数,良好的化学稳定性和足够的粘接强度。此外,解键合后残余在晶圆表面的临时键合胶很容易被完全清除。这项工作进一步拓展了可作为临时键合胶的聚合物材料范围,对促进TSV 技术的应用具有重要意义。
审核编辑 黄宇
-
晶圆
+关注
关注
52文章
5007浏览量
128459 -
键合
+关注
关注
0文章
65浏览量
7936
发布评论请先 登录
相关推荐
晶圆为什么要减薄
揭秘3D集成晶圆键合:半导体行业的未来之钥

晶盛机电减薄机实现12英寸30μm超薄晶圆稳定加工
苏州芯睿首台Aviator 12寸先进封装临时键合(TB)设备顺利出机
ERS electronic推出具备光子解键合和晶圆清洗功能的全自动Luminex机器
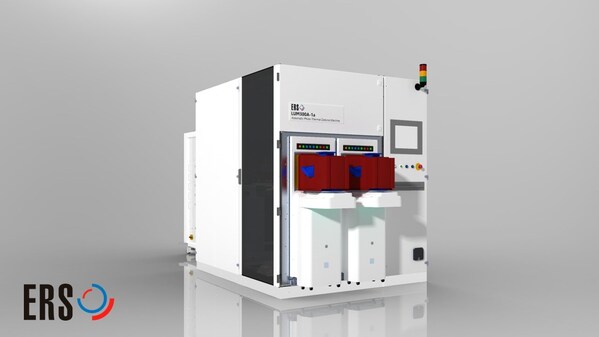
晶圆键合设备:半导体产业链的新“风口”





 用于薄晶圆加工的临时键合胶
用于薄晶圆加工的临时键合胶















评论