引言
自20世纪90年代以来,半导体晶片清洗目前被研究以解决前端和后端污染问题。主要问题之一是表面颗粒污染。微电子、MEMS或3D工艺中的许多应用需要非常干净的表面。其中,直接晶片键合(DWB)在颗粒清洁度方面有非常严格的要求。事实上,对于200毫米的硅晶片,已知直径为1微米的颗粒会产生直径约为1厘米的键合缺陷。这里,除了粒子的经典表面表征之外,DWB技术可以被提议作为测试兆频超声波技术用于粒子污染物去除表征的效率的有用方式。英思特将这项工作的重点放在使用创新的兆频超声波清洁技术清洁颗粒表面,并使用这两种技术对其进行表征。
实验与讨论
英思特公司在这些实验中使用了径向均匀面积的兆频超声波换能器MegPie(参见图1)。该换能器将声能耦合到由基底和换能器表面形成的充满流体的间隙中。在图1a中,高阻表就位,声能关闭。在图1b中,兆频超声波功率是开启的,频率约为1MHz,功率密度为1W/cm。我们可以看到流体内部产生的兆声波。这种形式和谐振器设计确保了在没有扫描运动的情况下,在旋转基底的整个表面上均匀的声学剂量。持续监控正向和反射RF功率以及晶体温度,确保一致和可重复的声学处理条件。
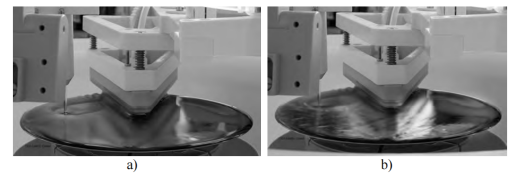
图1:面积兆频超声波换能器
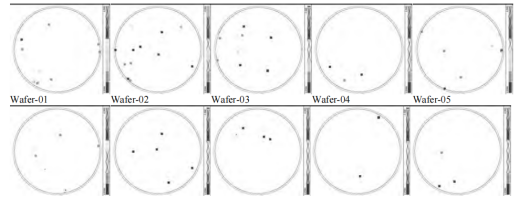
图2:Megpie清洗前后的晶圆示例
在图2中,我们可以看到粒子贴图的例子。大多数剩余的粒子根本没有移动。这意味着MegPie工艺不会同时添加和去除大量颗粒,而是持续清洁表面。
结论
图案化表面带来的挑战使得使用DWB作为颗粒去除效率的测试工具变得更加有趣。事实上,很难描述非平面表面上的颗粒污染。例如,我们已经通过在硅晶片的顶面锯出100μm深的线来构图晶片。在锯切之后,由于颗粒污染,不可能将晶片结合到干净的表面上。在这种表面上,也不建议用刷子清除颗粒,因为锋利的线边缘可能会切割刷子材料。然后,我们使用Megpie来清洁表面。在图3中,我们可以看到我们能够将该表面焊接在干净的晶片上,这证明了图案化表面上的清洁技术的良好效率。

图3:在切割100μm深的线后,图案化晶片的声学特征
审核编辑 黄宇
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
相关推荐
或许,大家会说,晶圆知道是什么,清洗机也懂。当单晶圆与清洗机放一起了,大家好奇的是到底什么是单晶圆
![的头像]() 发表于
发表于 03-07 09:24
•56次阅读
都说晶圆清洗机是用于晶圆清洗的,既然说是全自动的。我们更加好奇的点一定是如何自动实现
![的头像]() 发表于
发表于 01-10 10:09
•242次阅读
晶圆清洗加热器的原理主要涉及感应加热(IH)法和短时间过热蒸汽(SHS)工艺。 下面就是详细给大家说明的具体工艺详情: 感应加热法(IH):这种方法通过电磁感应原理,在不接触的情况下对
![的头像]() 发表于
发表于 01-10 10:00
•164次阅读
8寸晶圆的清洗工艺是半导体制造过程中至关重要的环节,它直接关系到芯片的良率和性能。那么直接揭晓关于8寸晶圆的
![的头像]() 发表于
发表于 01-07 16:12
•178次阅读
? 1、不同型号的8寸晶圆清洗机,其清洗槽的尺寸可能会有所不同。例如,某些设备可能具有较大的清洗槽以容纳更多的
![的头像]() 发表于
发表于 01-07 16:08
•130次阅读
一、概述
晶圆背面涂敷工艺是在晶圆背面涂覆一层特定的材料,以满足封装过程中的各种需求。这种工艺不仅可以提高芯片的机械强度,还可以优化散热性能,确保芯片的稳定性和可靠性。
二、材料选择
![的头像]() 发表于
发表于 12-19 09:54
•454次阅读

晶圆的TTV、BOW、WARP、TIR是评估晶圆质量和加工精度的重要指标,以下是它们的详细介绍:
TTV(Total Thickness
![的头像]() 发表于
发表于 12-17 10:01
•953次阅读

晶圆微凸点封装,更常见的表述是晶圆微凸点技术或晶圆级
![的头像]() 发表于
发表于 12-11 13:21
•372次阅读
本文介绍了一种利用全息技术在硅晶圆内部制造纳米结构的新方法。 研究人员提出了一种在硅晶圆内部制造纳米结构的新方法。传统上,
![的头像]() 发表于
发表于 11-18 11:45
•480次阅读
本文简单介去除晶圆表面颗粒的原因及方法。
在12寸(300毫米)晶圆厂中,清洗是一个至关重要的工序。晶圆厂会购买大量的高纯度湿化学品如硫酸,盐酸,双氧水,氨水,氢氟酸等用于清洗
![的头像]() 发表于
发表于 11-11 09:40
•638次阅读
GaAs晶圆作为常用的一类晶圆,在半导体功率芯片和光电子芯片都有广泛应用。而如何处理好该类晶圆的
![的头像]() 发表于
发表于 10-30 10:46
•680次阅读

晶圆键合技术是一种先进的半导体制造工艺,它通过将两块或多块晶圆在一定的工艺条件下紧密结合,形成一
![的头像]() 发表于
发表于 10-21 16:51
•886次阅读
在晶圆制造良率部分讨论的工艺变化会影响晶圆分选良率。在制造区域,通过抽样检查和测量技术检测工艺变
![的头像]() 发表于
发表于 10-09 09:45
•741次阅读

以下是关于碳化硅晶圆和硅晶圆的区别的分析: 材料特性: 碳化硅(SiC)是一种宽禁带半导体材料,具有比硅(Si)更高的热导率、电子迁移率和击穿电场。这使得碳化硅
![的头像]() 发表于
发表于 08-08 10:13
•2175次阅读
该发明涉及一种晶圆清洗设备及晶圆定位装置、定位方法。其中,晶
![的头像]() 发表于
发表于 05-28 09:58
•492次阅读

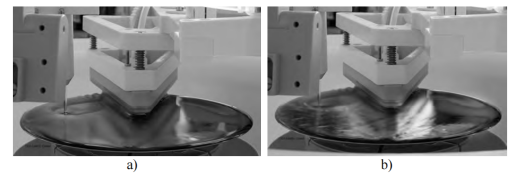
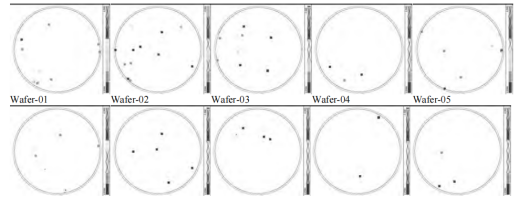






 通过晶圆粘合来评估创新兆声清洗技术
通过晶圆粘合来评估创新兆声清洗技术













评论