近期,北京北方华创微电子装备有限公司荣获“晶圆清洗设备及其晶圆定位装置、晶圆定位方法”专利,专利号cn113539918b,授权日期为2024年5月17日,申请日期为2021年6月30日。

该发明涉及一种晶圆清洗设备及晶圆定位装置、定位方法。其中,晶圆定位装置主要用于带有定位部的晶圆定位,其结构包括密封腔体、密封盖、承载组件、定位组件和导向组件。密封盖可开合地安装在密封腔体上,承载组件可旋转地置于密封腔体内,用于承载晶圆并使其绕轴旋转;定位组件则安装在密封腔体内,与定位部配合实现晶圆定位;导向组件则位于承载组件上方的密封腔体内,与承载晶圆的边缘部分间隙配合,引导晶圆运动。此发明能提升晶圆定位装置的稳定性,防止晶圆在定位过程及定位后受污染。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
晶圆
+关注
关注
52文章
4973浏览量
128284 -
清洗设备
+关注
关注
0文章
22浏览量
7143 -
北方华创
+关注
关注
0文章
56浏览量
10692
发布评论请先 登录
相关推荐
晶圆为什么要减薄
,满足晶圆的翘曲度的要求。但封装的时候则是薄一点更好,所以要处理到100~200um左右的厚度,就要用到减薄工艺。 满足封装要求 降低封装厚度 在电子设备不断向小型化、轻薄化发展的趋势下,对集成电路芯片的厚度有严格限制。通过
晶圆背面涂敷工艺对晶圆的影响
一、概述
晶圆背面涂敷工艺是在晶圆背面涂覆一层特定的材料,以满足封装过程中的各种需求。这种工艺不仅可以提高芯片的机械强度,还可以优化散热性能,确保芯片的稳定性和可靠性。
二、材料选择


碳化硅晶圆和硅晶圆的区别是什么
以下是关于碳化硅晶圆和硅晶圆的区别的分析: 材料特性: 碳化硅(SiC)是一种宽禁带半导体材料,具有比硅(Si)更高的热导率、电子迁移率和击
投资30亿新币,德国晶圆制造商世创电子新加坡建造的半导体晶圆工厂正式开幕
。 投资566亿!台积电布局新加坡 本周三(6月12日),德国晶圆制造商世创电子(Siltronic)耗资20亿欧元(约30亿新币、155亿人民币)在新加坡建造的半导体





 北方华创微电子:晶圆清洗设备及晶圆定位装置专利
北方华创微电子:晶圆清洗设备及晶圆定位装置专利

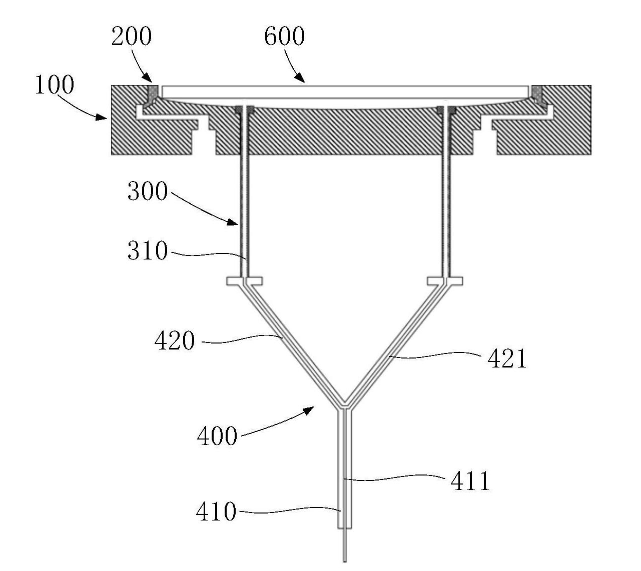
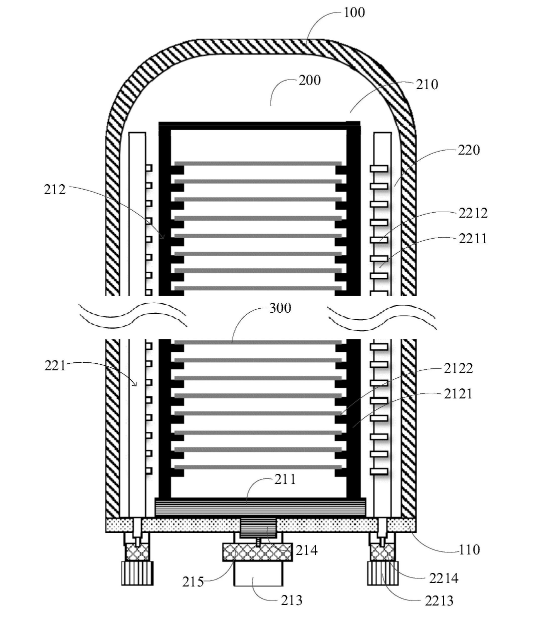













评论