电子发烧友网报道(文/周凯扬)随着去年年底首台高NA EUV光刻系统正式交货给英特尔,ASML这条新的产品线似乎即将开启新一轮的先进晶圆制造设备统治。可正如别的先进技术一样,ASML已经开始在规划下一代的Hyper-NA EUV光刻系统了。
从High-NA到Hyper-NA
在描述光学仪器角分辨率的瑞利准则等式(CD = k1 • λ / NA)中,CD为关键尺寸,又名线宽,代表了光刻工艺中的图形处理精度。为了进一步提高这一精度,只有从k1(k1系数)、λ(光源波长)和NA(数值孔径)上下手。其中k1是光刻工艺中由多个因素影响的系数,但其物理极限已经被确定在了0.25,所以提高精度的可行方案就被限制在了更小的光线波长和更高的数值孔径上。
2022年,ASML宣布了基于0.55NA打造的新一代EUV光刻系统,系列代号为EXE:5000,首个EXE:5000机器打造的芯片将基于英特尔的2nm逻辑工艺节点。然而,面对延续摩尔定律的难度越来越高,在埃米时代,即便是0.55NA的系统,很快也会变得不够看,不少厂商甚至都已经开始考虑多重曝光,然而多重曝光是一种良率不高但成本颇高的方案。

ASML EUV系统研究路线图 / ASML
为了解决这一问题,在imec举办的ITF World 2024大会上,ASML再度宣布下一代EUV光刻系统的路线图。ASML将从2028年开始打造具备0.75NA的Hyper-NA系统,预计于2030年开始交付,2030年之后ASML甚至可能会继续向0.85NA推进。
HyperNA带来的挑战
尽管ASML表示Hyper-NA是未来EUV机器的必行之路,但目前0.75NA的EUV机器尚在可行性研究阶段,相关的研究、系统和材料都还八字没有一撇。对于更高NA的EUV系统而言,ASML面临的首个挑战就是光学系统。
在高于0.55的NA下,偏振方向对光线影响进一步提高,甚至是抵消了光源发出的光线。为此,高NA系统中需要加入偏光镜片,但这种镜片本身也会阻挡/吸收光线,从而降低系统效率,进一步增加成本。
更重要的是,目前ASML的EUV系统光学系统由蔡司独家供应,因为只有他们拥有打造平坦度极高的EUV反射镜片。虽然用于更高NA的镜片还没有被打造出来,但蔡司表示他们可以在光学上解决这一挑战。
该系统面临的另一大挑战就是光刻胶,目前用于0.55NA EUV光刻系统的光刻胶虽然可以达到厚度要求,但其灵敏度还达不到0.33NA系统所用光刻胶的水准,因此所需的曝光剂量较大,影响了生产效率。而在0.75NA下,势必需要更薄的光刻胶,届时也会对光刻胶的材料提出更高的挑战。不仅如此,光刻胶的三维效应也会进一步加剧,光刻胶本身的结构设计也要做出改良。
要知道,对于ASML来说,并非造出更高NA的系统后就万事大吉了,他们也需要和行业伙伴合作,将每小时的晶圆产量维持在一个相对合理高效的水平。
最后就是成本问题,0.33NA EUV系统的价格在1.2亿美元左右,而0.55NA EUV系统的价格则飙升至3亿到4亿美元。ASML CTO Martin Van den Brink表示,如果Hyper-NA系统的价格增长幅度和0.55NA系统一样的话,那么哪怕对台积电这样的晶圆大厂而言,从经济角度上看也是不可行的。
-
光刻机
+关注
关注
31文章
1201浏览量
49032 -
ASML
+关注
关注
7文章
738浏览量
43637
发布评论请先 登录
高数值孔径投影光刻中的偏振效应

Amphenol Hyper Cool Edge Connectors:高性能连接解决方案
【新品发布】经过中科院盖章认证的低功耗Hyper-Hall芯片,技术达国际先进水平!

上海光机所在全息光刻研究方面取得进展

改善光刻图形线宽变化的方法及白光干涉仪在光刻图形的测量

改善光刻图形垂直度的方法及白光干涉仪在光刻图形的测量

ASML官宣:更先进的Hyper NA光刻机开发已经启动
MEMS制造领域中光刻Overlay的概念
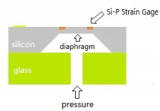
为什么光刻要用黄光?
减少光刻胶剥离工艺对器件性能影响的方法及白光干涉仪在光刻图形的测量

光刻胶剥离液及其制备方法及白光干涉仪在光刻图形的测量




 Hyper-NA光刻系统,价格会再次翻倍吗?
Hyper-NA光刻系统,价格会再次翻倍吗?






评论