通常,光刻胶只是用作构建图形步骤中的临时掩膜。因此,光刻工艺的最后一步通常是需要去除光刻胶,我们称之为去胶或者除胶。并且对去胶过程的要求是:迅速去胶且没有残留,对衬底以及沉积在上面的材料无损伤,因此这并不是很容易实现的步骤。这里我们称用于去除光刻胶的溶剂或者溶液为去胶剂或者去胶液、除胶剂,lift-off工艺中我们也称之为剥离液。
光刻胶薄膜的溶解度
非交联型的光刻通常可以使用普通光刻胶去胶剂进行处理并且无残留。如果去胶效果不良,应考虑以下可能的原因:
正胶在140℃左右开始热交联(例如在坚膜、干法刻蚀或涂胶阶段),这大大降低了它的溶解度。如果可以的话,应降低处理温度。
光学诱导交联是通过深紫外光辐射(波长 < 250 nm)并结合高温使得光刻胶不能溶解在去胶剂中,这种情况在蒸发镀层(如金属化、溅射或干法刻蚀)中很常见。由于超短波辐射的穿透深度较低,所以只有光刻胶的表面受到交联的影响。
负胶在较高的温度下处理其交联可以通过后续的工艺步骤进一步加强,这步会导致光刻胶的去除变得更加困难。另外,干法刻蚀过程中,重新沉积在光刻胶上的材料将会成为去胶过程中的障碍层,从而导致光刻胶的去除变得更加困难。
溶剂型去胶剂
丙酮
丙酮一般不推荐作为光刻胶的去胶剂,因为它具有很高的蒸气压力。如果使用了丙酮,应在丙酮蒸发和形成条纹前使用异丙醇清洗丙酮处理过的样品。不建议对丙酮进行加热以增加其溶解度,因为其蒸汽压力高,极易发生火灾危险。
NMP及NEP
NMP(1-甲基-2-吡咯烷酮),NEP(氮乙基吡咯烷酮)是去除光刻胶层的一种普遍适用的溶剂。NMP的蒸气压非常低,可以加热到80℃,以便能够去除更多交联的光刻胶薄膜。由于NMP已被列为对生殖有害物质,应考虑替代品,如DMSO。
DMSO
DMSO(二甲亚砜)加热至60- 80℃时,作为光刻胶去胶剂的性能可与NMP的性能相媲美,是NMP的一种“安全溶剂”替代品。 DMSO容易从空气中吸收水汽, 另外DMSO人体皮肤有渗透性 ,操作时注意防护。
原则上,其他溶剂也适合用作去胶剂:IPA,PGMEA(PMA),甲乙酮(MEK)或稀释剂,可用于溶解稳定性不是很强的光刻胶的残留。但是,在大多数情况下,用这些溶剂作为去胶液则需要更长的时间。溶剂去除剂同样适用于酚醛树脂型光刻胶以及所有聚合物光刻胶(例如PMMA)。
碱性去胶剂
如果衬底材料的化学稳定性允许,且不使用特殊的去除剂,那么可以使用最简单高效的碱性去胶剂,最常见的是氢氧化钠(NaOH)和氢氧化钾(KOH)溶液。4%的KOH溶液将在几秒钟内去除所有基于酚醛树脂基的光刻胶以及电子束光刻胶,专门为耐碱而设计光科技啊除外。当我们将NaOH或KOH的浓度增加到40%时,可用于去胶比较困难的稳定性胶,特别是硬烘后的光刻胶结构。碱性溶液通常不能完全去除光刻胶残留物,但是在这种情况下会在光刻胶膜产生下蠕变。然后或多或少地将残留物带离衬底上,然后将其完全清除。但是,应该考虑到,高浓度的碱性溶液也可能腐蚀硅晶圆,从而破坏表面。综上所述 可以使用基于缓冲碱性盐的浓缩显影剂(碱当量浓度1.1N)来替代碱性溶液实现去胶。这种显影液在未稀释状态下可以迅速去除大多数光刻胶膜。
四甲基氢氧化铵(TMAH)溶液也用作去除剂,最大浓度为25%。在此浓度下,TMAH可与高浓度的NaOH和KOH溶液媲美。TMAH也会侵蚀硅,在使用过程中同样需要小心。由于TMAH的消耗量较低,稀释型的TMHA溶液更容易操作,而且对环境更友好。碱性水去胶剂不适用于所有聚合物(PMMA,聚苯乙烯,碳氢化合物)。但是,我们可以利用此特点用于两层胶系统(PMMA /光刻胶;碳氢/光刻胶)应用,以选择性去除上层光刻胶层。
通用去胶方案
通用去除剂
在去胶发生困难的情况下(例如在密集的等离子蚀刻或溅射之后),超声或兆声清洗会对去除光刻胶带来很大的帮助。但是,在此过程中必须保护衬底上的敏感结构,否则将其破坏如下图1所示,所以我们建议这种带有高深宽比的结构的样品最好使用兆声辅助而不是超声辅助处理。由于溶解的光刻胶的含量增加,去胶剂随着长时间的发展其去胶效果在逐渐变弱。即使仍未达到理论上的饱和极限(远高于50%的固含量),使用过溶液会随着颗粒的富集并变得不透明,因此不再适合进行重复清洗。常见的做法是级联清洗。在此过程中,去除剂用于三个不同的清洗步骤。将样品放在第一个溶液池中,此步骤中几乎完全去除光刻胶残留物。然后将样品转移到第二个溶液池中,然后转移到第三个槽中,在最后一个步骤后用去离子水冲洗干净。一旦达到预定的溶解能力,就将第一个浴液丢弃,将第二个和第三个浴液向上移动一个位置。
除此之外的功能还可以通过强氧化酸来实现,例如王水,食人鱼,硫酸或硝酸。这些酸用于最终清洁。但是除了环境保护方面(废酸的处理),这些混合物通常不仅侵蚀光刻胶,而且也会腐蚀衬底表面的其他材料。
免责声明:文章来源汶颢 www.whchip.com 以传播知识、有益学习和研究为宗旨。转载仅供参考学习及传递有用信息,版权归原作者所有,如侵犯权益,请联系删除。
审核编辑 黄宇
-
光刻胶
+关注
关注
10文章
318浏览量
30254
发布评论请先 登录
相关推荐
晶圆表面光刻胶的涂覆与刮边工艺的研究
光刻胶成为半导体产业的关键材料
如何成功的烘烤微流控SU-8光刻胶?
导致光刻胶变色的原因有哪些?
光刻胶涂覆工艺—旋涂
光刻胶的硬烘烤技术





 光刻胶去胶工艺
光刻胶去胶工艺
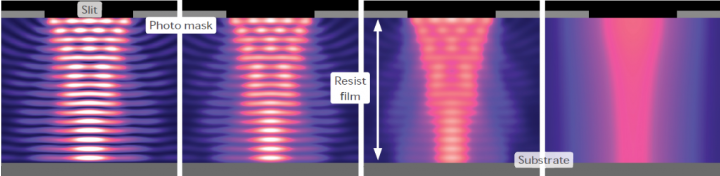
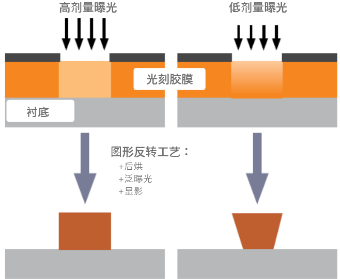
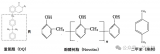











评论