底部填充工艺在倒装芯片(Flip Chip)上的应用是一种重要的封装技术,旨在提高封装的可靠性和延长电子产品的使用寿命。以下是该工艺的主要应用和优势:
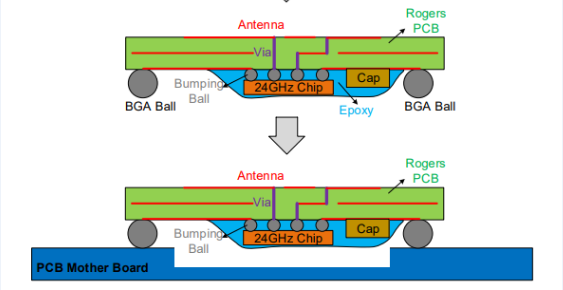
增强可靠性:倒装芯片封装中的焊点(常为金锡合金或铅锡合金)在热循环过程中承受巨大应力,容易导致疲劳和失效。底部填充材料(通常是高粘度环氧树脂,含有大量SiO2填充物)填充芯片与基板间的空隙,形成刚性支撑结构,有效分散应力,增强封装的机械强度和热稳定性。
改善热性能:底部填充材料具有一定的热传导性,帮助芯片产生的热量快速传递至基板,再散发到外部,从而降低工作温度,提升电子设备的长期可靠性和性能。
防潮保护:填充材料能防止水分渗透到芯片下方,减少湿气引起的焊点腐蚀或爆裂,尤其是在高温处理如回流焊过程中,避免“爆米花”效应,即水分在高温下迅速蒸发导致的内部压力增大和破裂。
提升抗冲击能力:在受到跌落、振动等外力时,底部填充增加了封装结构的韧性,减少内部损伤,保护芯片免受物理冲击。
应力重分配:通过底部填充,焊点上的热应力在芯片、填充物、基板及所有焊点间重新分配,避免应力集中在芯片边缘的外围焊点上,显著降低焊点的应变水平,从而提高焊点的疲劳寿命,据实践证明,这可以将焊点的疲劳寿命提高10至100倍。
底部填充工艺流程通常包括:
点胶:在芯片与基板之间预设位置精确施加底部填充材料,此步骤要求极高精度,以避免污染其他元件。
毛细管效应填充:利用胶水的流动性和毛细作用自动填充芯片底部空间。
固化:加热促使底部填充材料固化,形成稳定的封装结构。
检查与测试:
固化完成后,进行光学或X射线检查,以验证底部填充是否均匀、完全,以及是否存在气泡或其他缺陷。随后,还需进行电气性能测试,确保封装后的芯片功能正常。
底部填充材料的选择:
底部填充材料的选择需综合考虑流动性、固化特性、热膨胀系数、热导率、介电性能等因素。随着芯片尺寸的缩小和集成度的提高,对底部填充材料提出了更高要求,如更低的固化温度、更快的固化速度、更好的流动性和更优的热管理能力。
底部填充工艺在倒装芯片封装中的应用显著提升了封装的性能、可靠性和寿命。通过增强焊点的可靠性、改善热性能、提供防潮保护和提升抗冲击能力,底部填充工艺成为现代电子封装技术中不可或缺的一部分。随着技术的不断进步,底部填充工艺将持续演进,以满足日益增长的高性能、小型化和多功能电子设备的需求。这种工艺是现代半导体封装技术的关键组成部分,尤其适用于高性能、高密度和高可靠性要求的电子产品中。
-
芯片
+关注
关注
453文章
50360浏览量
421622 -
芯片封装
+关注
关注
11文章
477浏览量
30559 -
倒装芯片
+关注
关注
1文章
88浏览量
16223 -
底部填充剂
+关注
关注
0文章
6浏览量
5430
发布评论请先 登录
相关推荐




 底部填充工艺在倒装芯片上的应用
底部填充工艺在倒装芯片上的应用
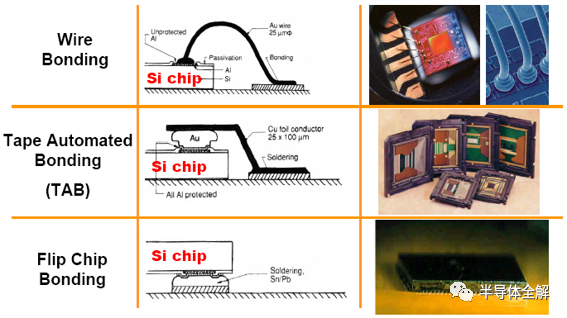

















评论