芯片封装底部填充材料如何选择?芯片封装底部填充材料的选择是一个复杂而关键的过程,它直接影响到芯片封装的可靠性和性能。底部填充材料(Underfill)的主要功能是在芯片与基板之间提供额外的机械支撑和热应力缓冲,以应对由于不同材料热膨胀系数(CTE)差异所导致的应力问题。以下是一些关于芯片封装底部填充材料选择的重要考虑因素:

一,底部填充材料特性
耐高温性:
底部填充材料需要能够在高温环境下保持稳定,以应对封装过程中的高温处理。
常见的耐高温材料包括有机硅胶、环氧树脂以及新型耐高温芯片UV胶水等。
电绝缘性:
底部填充材料必须具备良好的电绝缘性,以防止芯片底部与其他元件或底座发生电接触。
这对于确保电路的正常运行和防止短路至关重要。
粘附性:
底部填充材料需要能够牢固地粘附在芯片和基板之间,以提供稳定的机械支撑和保护。
流动性:
材料的流动性对于填充效果至关重要。高粘度的材料能够确保在填充过程中不会流动或渗透到芯片上,但也需要足够的流动性以充分填充芯片与基板之间的间隙。
热膨胀系数(CTE):
底部填充材料的CTE值应与芯片和基板的CTE值相匹配,以减少因热膨胀系数差异而产生的热应力。
固化速度和条件: 固化速度和所需的温度会影响生产效率和成本。快速固化可以提高产量,但可能需要更高的温度,这可能会对某些敏感组件造成损害。
机械强度: 强度高的材料能提供更好的保护,减少芯片在受到外部冲击或压力时损坏的风险。
化学稳定性: 底部填充材料应具有良好的化学稳定性,能够抵抗封装环境中可能遇到的化学物质,如清洁剂或溶剂。
二,底部填充材料应用场景
倒装芯片底部填充胶(Flip-Chip Underfill):
用于芯片与封装基板互连凸点之间间隙的填充,对精度要求极高(微米级)。
需要选择高纯度、低粘度、快速固化的材料,以确保填充效果和工艺效率。
球栅阵列底部填充胶(BGA Underfill):
用于封装基板与PCB印制电路板之间互连的焊球之间的填充,对精度要求相对较低(毫米级)。可以选择具有较好流动性和机械保护性能的材料。
三,具体材料
环氧树脂:
环氧树脂是底部填充材料的常用选择,因为它具有良好的粘附性、绝缘性和耐高温性能。
通过在树脂中添加增韧改性剂,可以克服环氧树脂柔韧性不足的弱点,提高底部填充胶的性能。
有机硅胶:
有机硅胶也具有良好的耐高温性和电绝缘性,适用于对温度要求较高的封装场景。
新型耐高温芯片UV胶水:
这类材料具有快速固化、耐高温和良好粘附性的特点,适用于对工艺效率有较高要求的封装场景。
四、其他考虑因素
成本:
底部填充材料的成本也是选择时需要考虑的因素之一。在保证性能的前提下,应选择成本合理的材料。
环保性:
随着环保意识的提高,底部填充材料的环保性也成为了一个重要的考虑因素。应优先选择无毒、无害、可回收的材料。
工艺兼容性:
底部填充材料应与现有的封装工艺相兼容,以确保工艺的稳定性和可靠性。
工艺适应性: 底部填充材料应适合所采用的填充方法,例如毛细管流动、喷射点胶或预成型件。
综上所述,芯片封装底部填充材料的选择需要根据具体的应用场景、材料特性和成本等因素进行综合考虑。在选择过程中,应充分了解各种材料的优缺点和适用范围,以确保选择的材料能够满足封装工艺和性能要求。
-
pcb
+关注
关注
4338文章
23282浏览量
403099 -
材料
+关注
关注
3文章
1278浏览量
27520 -
芯片封装
+关注
关注
11文章
544浏览量
30949
发布评论请先 登录
相关推荐





 芯片封装底部填充材料如何选择?
芯片封装底部填充材料如何选择?
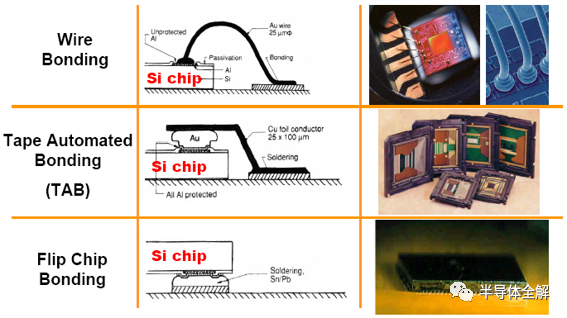





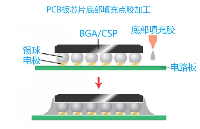

















评论