共读好书
Die Bound芯片键合,是在封装基板上安装芯片的工艺方法。本文详细介绍一下几种主要的芯片键合的方法和工艺。
什么是芯片键合

芯片键合的流程

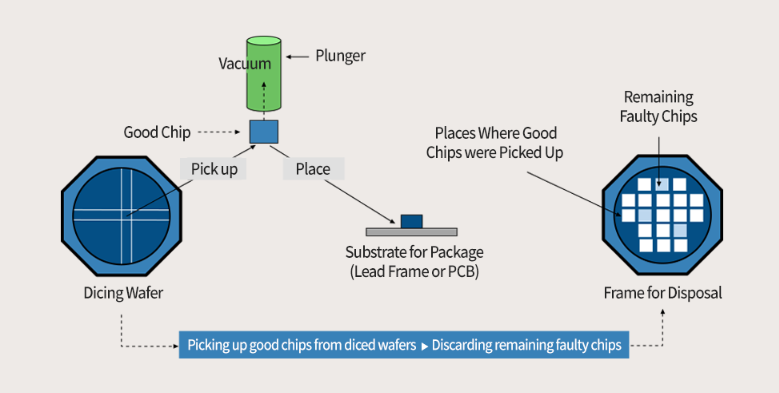
芯片弹压

芯片粘合工艺
这就是为什么最近使用模贴膜(DAF)的更先进的粘合方法是首选的原因。虽然DAF有一些昂贵和难以处理的缺点,但它的厚度可以很好的控制,并且简化了工艺过程,因此它的使用量逐渐增加。
模贴膜(DAF)粘接
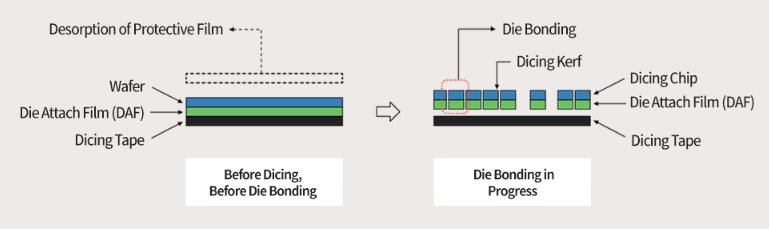
欢迎扫码添加小编微信

扫码加入知识星球,领取公众号资料

原文标题:Die Bonding 芯片键合的主要方法和工艺
文章出处:【微信公众号:半导体封装工程师之家】欢迎添加关注!文章转载请注明出处。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
封装
+关注
关注
128文章
9380浏览量
149202
发布评论请先 登录
相关推荐
热点推荐
半导体芯片制造技术——“芯片键合”工艺技术的详解;
如有雷同或是不当之处,还请大家海涵。当前在各网络平台上均以此昵称为ID跟大家一起交流学习! 作为半导体制造的后工序,封装工艺包含背面研磨(Back Grinding)、划片(Dicing)、芯片键

半导体封装“焊线键合(Wire Bonding)”线弧相关培训的详解;
如有雷同或是不当之处,还请大家海涵。当前在各网络平台上均以此昵称为ID跟大家一起交流学习! 半导体引线键合(Wire Bonding)是应用最广泛的键合技术,也是半导体封装

氧浓度监控在热压键合(TCB)工艺过程中的重要性
随着半导体产品高性能、轻薄化发展,封装技术作为连接芯片与外界环境的桥梁,其重要性日益凸显。在众多封装技术中,热压键合(Thermal Compression Bonding)

半导体后道制程“芯片键合(Die Bonding)”工艺技术的详解;
,还请大家海涵,如有需要可看文尾联系方式,当前在网络平台上均以“ 爱在七夕时 ”的昵称为ID跟大家一起交流学习! 作为半导体芯片制造的后道工序,芯片封装工艺包含背面研磨(Back Grinding)、划片(Dicing)、




 Die Bonding 芯片键合的主要方法和工艺
Die Bonding 芯片键合的主要方法和工艺














评论