来源:科技新报
2024 年 Semicon Taiwan 国际半导体展完美落幕,先进封装成为突破摩尔定律的关键,尤其以面板级扇出型封装(FOPLP)成为备受关注的下一代技术,同时也是封测厂、面板厂极力布局的方向。
事实上,台湾地区封测厂推动 FOPLP 已有七八年,但因为良率问题未见显著成效,客户也持观望态度,因此没有太多终端应用落地。然而,台积电董事长魏哲家在 7 月 18 日法说会指出,正在研究 FOPLP 技术,预期三年后技术可成熟,无疑是给这项技术「添一把火」,内外地区设备商、封测厂、面板厂全热起来,一起冲刺技术落地。
FOPLP 会取代 CoWoS 吗?
FOPLP 技术是 FOWLP 技术的延伸,以方形基板进行 IC 封装,可使封装尺寸更大、降低生产成本。据经济部说法,以面板产线进行 IC 封装,方形面积相较晶圆有更高的利用率,达到 95%,即相同单位面积下,可摆放更多的芯片数量。然而,因封装尺寸更大,面临面板翘曲、均匀性和良率问题。至于 FOPLP 的 Panel(面板)载板可采用 PCB 或者液晶面板用的玻璃载板,包括台积电在内厂商都开始研究玻璃载板的可行性。

G3.5 FOPLP Glass Panel 生产面积。(Source:群创)
台积电开发的 FOPLP 可想象成「矩形 InFO」,整合台积电 3D fabric 平台其他技术,发展出 2.5D / 3D 等先进封装,以用于高阶产品应用,最快 2027 年亮相。据日经报导,台积电正与设备及原物料供应商合作研发面板级芯片封装技术,目前仍在早期阶段。据悉,试验中的矩形基板尺寸为 510×515mm,但有消息称新定案版本为 600×600mm。
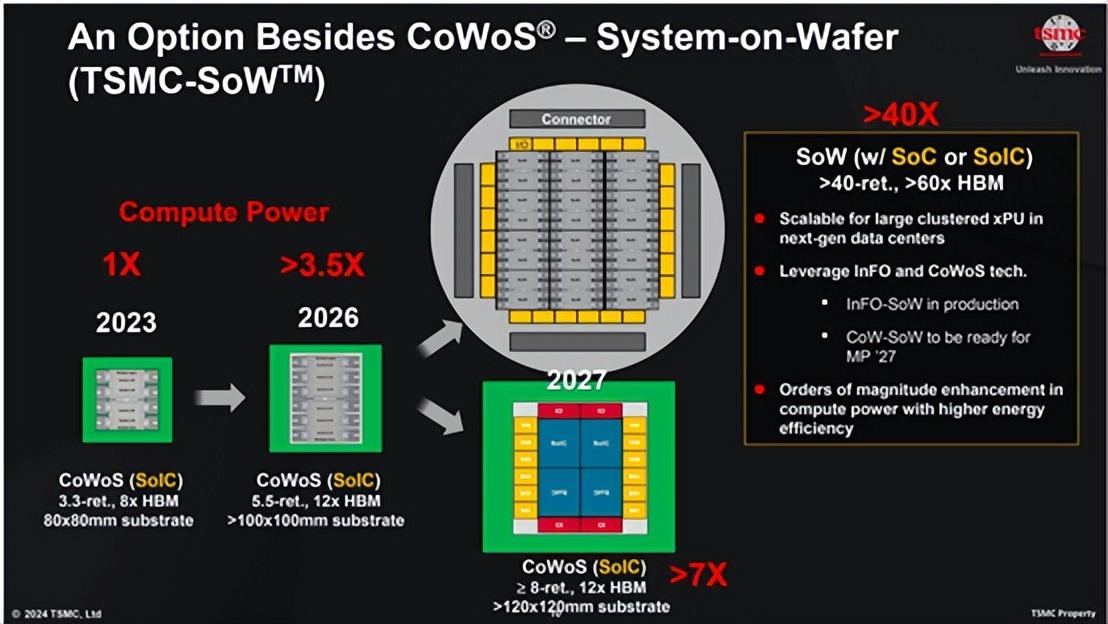
半导体设备业者认为,FOPLP 生态链发展主要看台积电,但随着 AI 持续发展,在算力提升又必须兼顾成本的考量下,FOPLP 仍是未来需发展的方向。这项技术应该不会取代 CoWoS,而是提供客户在成本考量下的新解决方案。
随着半导体技术的迅猛发展,对芯片封装工艺的要求也不断增长。尤其是针对高频、射频、电源和传感器等芯片的处理,封装技术的发展显得尤为重要。而在众多封装技术中,扇出型面板级封装(Fan-Out Panel Level Packaging, FOPLP)以其独特的优势逐渐脱颖而出,成为行业的焦点。
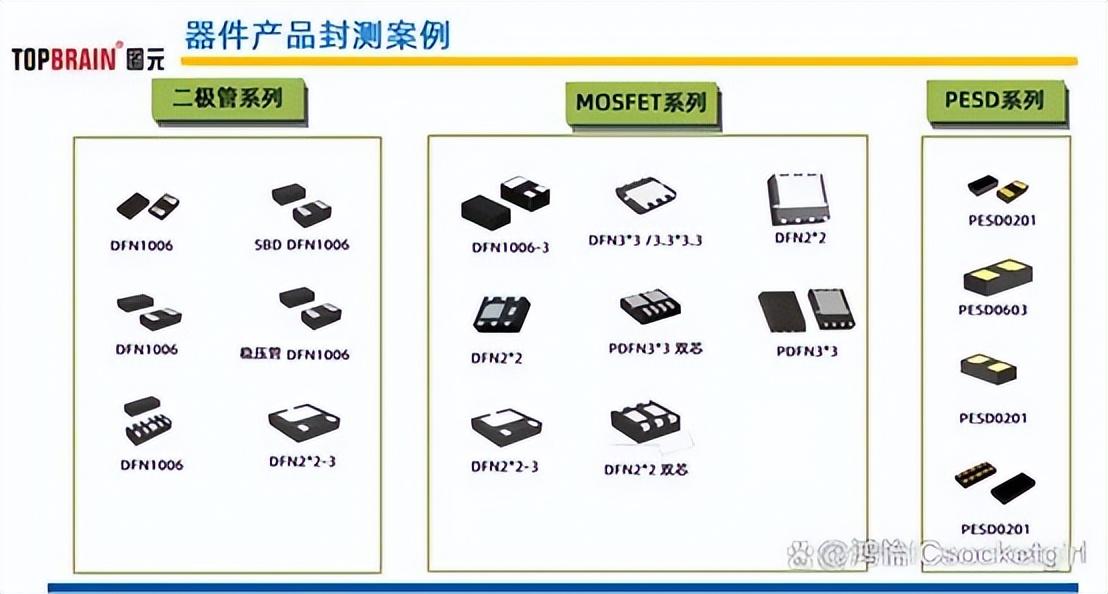
FOPLP板级封装技术特点
1. 扩展封装面积
FOPLP技术将单个芯片及其周边电路安装在更大面积的材料面板上,形成扇出形状。这种方法可以显著减少芯片间连线的长度,从而降低传输损耗和讯号干扰,提高电性能。
2. 提高集成度
与传统封装技术相比,FOPLP能够容纳更多的芯片和功能集成在一起,适合于复杂的多芯片模组封装。FOPLP通过增加面板面积来增加封装密度,使得更多功能单元可以集成在有限的空间内,从而提高系统性能。
3. 优化热管理
FOPLP技术在封装过程中使用了更优质的热导材料,通过合理设计提升散热能力,降低芯片运行温度,增强可靠性和寿命。
FOPLP在不同芯片类型中的应用
射频芯片
在射频芯片领域,FOPLP技术拥有显著的优势。射频芯片对信号稳定性和降噪能力有很高的要求。FOPLP技术能够更有效地隔离噪声干扰,提供更好的信号传输路径,同时通过封装结构的优化提升信号质量和传输速率。
电源芯片需要高效的散热性能,以及良好的电性能和机械强度。FOPLP技术通过高密度集成和优化散热路径,保障电源芯片在高功率条件下的稳定运行。此外,FOPLP技术还提供卓越的机械强度,确保封装的稳定性和可靠性。
芯片模组
芯片模组是多种芯片协同工作的系统单元。FOPLP技术能够通过集成多个芯片在一块面板上,简化模组设计,提高系统集成度。此外,FOPLP技术优化了芯片之间的互连结构,提高模块的整体性能和可靠性。
高频芯片
高频芯片在通信设备中起着至关重要的作用,要求拥有高带宽、低延迟和高信号传输质量。FOPLP技术在封装过程中可以有效降低信号损耗,优化信号传输路径,从而提高高频芯片的性能和可靠性。
数字芯片
数字芯片涵盖了处理器、控制器等核心组件。FOPLP技术通过改进封装设计,提高芯片的散热和电性能,使得数字芯片在工作过程中能够更加稳定和高效地运行。
传感器芯片
传感器芯片用于检测和反馈环境变化,对体积和能耗要求较高。FOPLP技术通过优化封装面积和电路设计,提高传感器芯片的灵敏度和精度,同时降低功耗和提升抗干扰能力。
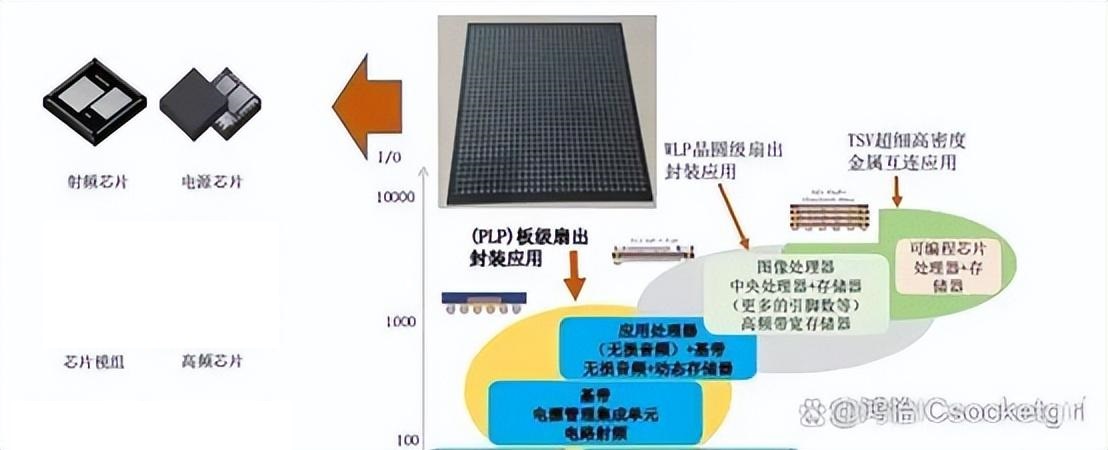
FOPLP封装对芯片测试的优势
1. 更高的测试效率
FOPLP封装由于集成度高、封装面积大,能够在一次测试过程中检验更多的芯片。相较于传统封装技术,FOPLP封装显著提高了测试效率和测试速度,降低测试成本。
2. 提供更全面的测试数据
由于FOPLP封装技术优化了芯片之间的连接和信号传输路径,使得在测试过程中能够获得更全面、更准确的测试数据,提供了更好的芯片性能评估基础。
3. 改善散热性能
在测试过程中,芯片的温度管理尤为重要。FOPLP封装技术通过优化散热路径,确保芯片在高功耗运行条件下的温度控制,从而提高测试结果的准确性和稳定性。
4. 灵活的测试方案
FOPLP封装技术具备高度的灵活性,因此可以根据不同芯片的特性和需求进行个性化的测试方案设计。无论是高频芯片、射频芯片还是电源芯片,FOPLP封装技术都能够提供适合的测试方案,保障测试结果的一致性和可靠性。
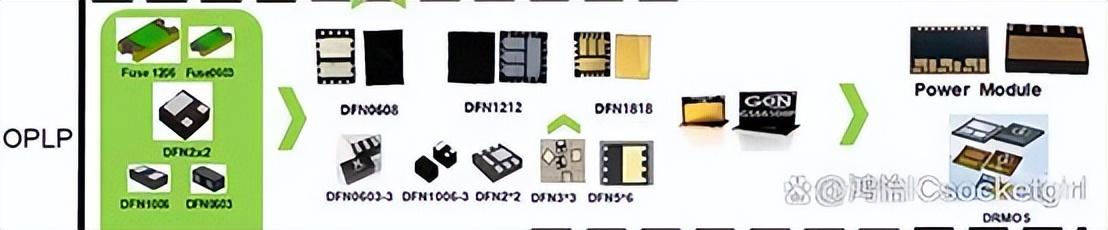
定制化测试座的必要性
尽管FOPLP封装在许多方面展现了巨大的优势,但在芯片测试过程中,测试座的设计和制造往往需要针对具体应用进行定制。这是因为不同类型的芯片及其应用场景对测试座的要求各不相同,包括:
1. 特定的电性和机械要求
不同类型的芯片在测试过程中需要具备特定的电性和机械要求。例如,高频芯片需要具有优良的信号隔离能力,电源芯片需要良好的散热性能等。因而,测试座的设计必须根据芯片的具体特性进行专门设计。
2. 高度灵活的连接结构
FOPLP封装中的高集成度和多芯片共存特性,要求测试座需要具备高度灵活的连接结构,以适应不同芯片的测试需要。标准化的测试座往往难以满足这一需求,因此定制化的设计成为必要。
3. 精确的数据采集和分析能力
高性能芯片对测试数据的精度和分析能力有着很高的要求,为了能够精确采集和分析测试数据,测试座必须具备专业化和高精度的设计。标准产品无法完全满足这一需求,必须根据具体芯片进行定制。#百家快评#
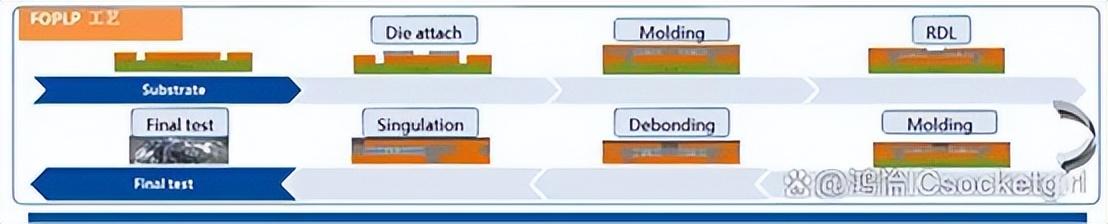
随着芯片技术和封装工艺的发展,FOPLP板级封装凭借其优异的扩展性、高集成度和优化的热管理能力,在射频芯片、电源芯片、传感器芯片等领域展现了显著的技术优势。同时,FOPLP封装在芯片测试过程中具备更高的效率和更全面的数据获取能力。但由于不同芯片在电性能、机械要求及连接结构方面的特性各异,测试座需针对具体应用进行定制,确保测试过程的准确性和可靠性。
OSAT、面板大厂布局多年,2024 年逐步开花结果
台积电布局 FOPLP 以前,早期投入这项技术的台湾地区厂商包括力成、群创和日月光。力成 2018 年在新竹科学园区三厂开始兴建,启动全球第一座 FOPLP 量产基地,正式布局高阶封装领域。执行长谢永达指出,看好未来在 AI 世代,异质封装将采用更多 FOPLP 解决方案,预计 2026~2027 年会导入量产。
封测龙头日月光 FOPLP 产品将在明年第二季开始出货,面板尺寸从 300×300mm 已经扩张至 600×600mm,目前高通与其洽谈 PMIC(电源管理IC)产品。此外,AMD 也与日月光、力成洽谈 PC CPU 产品。
面板大厂群创近年积极转型,自 2017 年便投入研发,目前试量产线月产能约 1,000 片,今年下半年可望量产。目前首期产能已被订光,并开始启动第二期扩产计划,主要客户为恩智浦、意法半导体等国际 IDM 大厂,未来将视客户需求将月产能逐步提升至 15,000 片,以 PMIC 产品为主。
盘点台湾地区 FOPLP 相关供应链,有湿制程领域弘塑、溅镀/水平式电浆蚀刻设备厂友威科、雷射修补设备商东捷、载板干制程设备厂群翊、RDL制程设备亚智科技、电浆清洗及雷射打印厂商钛升、自动化设备商万润、开发 FOPLP 特殊合金载板鑫科材料等。
CoWoS、FOPLP 后,下一个是 CoPoS 吗?
随着先进封装转换至 panel level(面板级),半导体设备商将提出另一个说法,即所谓的「CoPoS」(Chip-on-Panel-on-Substrate),即是 CoWoS「面板化」,以面板(Panel)取代晶圆(Wafer),将芯片排列在矩形基板上,最后再透过封装制程连接到底层的载板上,让多颗芯片可以封装一起。
CoPoS 这项技术处于早期初期,初步判断需要三五年才有机会到位,目前仍以 CoWoS、FOPLP 是较为明确的技术路线图。
然而,FOPLP 受限于线宽及线距问题,目前应用仍以 PMIC 等成熟制程为主,待技术成熟后才会导入到主流消费性 IC 产品,TrendForce 预期时间约落在今年下半年至 2026 年;至于更高阶的 AI GPU 应用,则是 2027-2028年有望落地,与台积电董事长魏哲家预期至少三年后的量产时间相一致,他表示,目前尚未有成熟的解决方案,支持大于十倍光罩尺寸(Reticle size)芯片,预期三年后 FOPLP 将开始导入后,台积电也将做好准备。
-
台积电
+关注
关注
44文章
5822浏览量
177198 -
日月光
+关注
关注
0文章
160浏览量
20231 -
先进封装
+关注
关注
2文章
570浏览量
1074
发布评论请先 登录
日月光携手楠梓电投资高雄新厂
长电科技2025年先进封装营收创历史新高
台积电如何为 HPC 与 AI 时代的 2.5D/3D 先进封装重塑热管理

2026年AI芯片破局指南:晶圆厂不再是瓶颈,先进封装才是核心胜负手
先进封装市场迎来EMIB与CoWoS的格局之争
环旭电子整合真空印刷塑封与铜柱移转技术 推动系统级先进封装应用
FCCSP驱动下的半导体封装新格局
强强合作 西门子与日月光合作开发 VIPack 先进封装平台工作流程




 整合为王,先进封装「面板化」!台积电、日月光、群创抢攻FOPLP,如何重塑封装新格局?
整合为王,先进封装「面板化」!台积电、日月光、群创抢攻FOPLP,如何重塑封装新格局?





评论