2014年4月21号,北京——Altera公司(Nasdaq: ALTR) 与台积公司今日共同宣布双方携手合作采用台积公司拥有专利的细间距铜凸块封装技术为Altera公司打造20 nm Arria® 10 FPGA与 SoC,Altera公司成为首家采用此先进封装技术进行量产的公司,成功提升其20 nm器件系列的质量、可靠性和效能。
Altera公司全球营运及工程副总裁Bill Mazotti表示:「台积公司提供了一项非常先进且高度整合的封装解决方案来支持我们的Arria 10器件,此项产品为业界最高密度的20 nm FPGA单芯片。这项封装技术不仅为Arria 10 FPGA和 SoC 带来相当大的助力,并且协助我们解决在20 nm封装技术上所面临的挑战。」
相较于一般标准型铜凸块解决方案,台积公司先进的覆晶球门阵列(Flip Chip BGA)封装技术利用细间距铜凸块提供Arria 10器件更优异的质量和可靠性,此项技术能够满足高性能 FPGA对多凸块接点的需求,亦提供较佳的凸块焊接点疲劳寿命,并且改善电迁移(Electro-migration)以及超低介电系数介电层(Extra Low-K Layer)之低应力表现,对于使用先进硅片技术生产的产品而言,这些都是非常关键的特性。
台积公司北美子公司资深副总经理David Keller表示:「台积公司铜凸块封装技术针对使用超低介电材料以及需要微间距(小于150微米)凸块的先进硅片产品创造卓越的价值,我们很高兴Altera公司采用此高度整合的封装解决方案。」
Altera公司现在发售采用台积公司20SoC工艺及其创新封装技术所生产的Arria 10 FPGA。Arria10 FPGA与 SoC具备在FPGA业界中最高密度的单芯片,与先前的28 nmArria系列相比,此全新系列器件功耗减少高达40%,更多相关讯息请浏览或连络Altera公司当地销售代表。
台积公司铜凸块封装技术适合应用于大尺寸芯片及细间距产品,此项技术包含台积公司可制造性设计(DFM)/可靠性设计(DFR)实作工具,能够针对较宽的组装工艺参数范围及较高的可靠性进行封装设计与结构的调整,此项技术的生产级组装良率优于99.8%。
-
Altera
+关注
关注
37文章
791浏览量
154582 -
封装技术
+关注
关注
12文章
562浏览量
68145
发布评论请先 登录
相关推荐
苹果或将成为首家市值4万亿美元公司
先进封装的核心概念、技术和发展趋势





 Altera公司成为首家采用此先进封装技术进行量产的公司
Altera公司成为首家采用此先进封装技术进行量产的公司




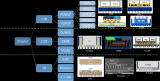











评论