以下文章来源于不懂聊封装 ,作者大名叫懂懂
一.前言
IC载板(封装基板)具备高密度、高精度、高性能、小型化和轻薄化等一系列优良特性,成为现代电子产品中不可或缺的关键组件。IC载板的结构如下图所示,在中间芯板的两面多次压合增层制成,其作用是为芯片提供电气连接和机械支撑。一个完整的芯片系统通常由裸芯片(即晶圆片)和封装体组成,而封装体包括封装基板、固封材料和引线等部分。封装基板作为核心部分,连接裸芯片与外部电路,确保电信号的传输与散热效果。同时,IC载板还具备抗高温、高频性能,能够支撑未来更多电子器件的高速运算与数据处理需求。
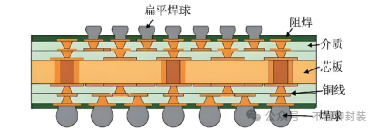
有机IC载板的起源可以追溯到集成电路(IC)封装技术的发展早期。随着半导体行业的快速进步,芯片的集成度和性能需求不断提高,传统的封装技术如陶瓷和金属基板逐渐无法满足更高密度、低成本和轻量化的要求。
20世纪70年代,电子设备的需求开始呈现小型化、低成本和高性能的发展趋势,推动了有机封装材料的应用。在这个阶段,陶瓷和金属基板,它们虽然具备良好的热导率和机械强度,但加工成本高且材料本身较重,不利于小型化和大规模生产,而有机材料(如环氧树脂)具备重量轻、易于加工和低成本的优势,成为一个理想的替代选择。有机IC载板最初是从印刷电路板(PCB)技术中发展而来,借鉴了PCB中常用的有机材料,如FR-4和聚酰亚胺(PI)等。
有机IC载板在20世纪90年代开始广泛应用,这是因为随着消费电子和计算机产业的蓬勃发展,对集成电路封装的需求从低端产品扩展到高性能计算和通信领域。有机基板的优点不仅体现在材料成本上,还在于其适应性强、可以实现更复杂的多层结构,适用于各种先进封装技术如BGA(球栅阵列封装)和CSP(芯片尺寸封装)。
与常规PCB板相比,有机IC载板的线宽和线距更为精细,板子的尺寸也更小,这使得它能够满足主流芯片的严苛要求。在线宽/线距达到50μm/50μm时,常规PCB已经属于高端产品,而在封装基板制造领域,30μm/30μm以内的线宽/线距已属于常规标准。这种更精密的设计满足了现代高性能芯片对于体积小、信号传输效率高的需求。
随着技术朝着高密度和高精度方向发展,封装基板在PCB市场中的占比逐步提升。根据Prismark的数据显示,2000年封装基板在PCB市场中的占比为8.43%,到2020年这一比例已增长至15.68%。预计到2026年,封装基板在PCB市场的占比将进一步上升至21.11%。这一增长趋势反映出封装基板在现代电子产品中的重要性,特别是在高性能计算、5G通信、物联网和其他先进应用领域,封装基板已成为核心基础材料。
二.材料选择
1. 芯板材料—BT树脂
“BT”树脂是由日本三菱瓦斯化学公司开发的一种具有特殊性能的树脂材料,其名称来源于该公司推出的化学商品名。BT树脂由双马来酰亚胺(Bismaleimide,简称BMI)和氰酸酯(Cyanate Ester,简称CE)树脂通过合成反应制备而成,具有优异的热稳定性、机械强度和电气性能[1]。这种材料的开发始于1972年,当时三菱瓦斯化学公司就着手研究如何将BT树脂应用于电子封装领域。到1977年,BT板首次成功应用于芯片封装,标志着其作为高性能封装材料的潜力得到了初步验证。
在随后的几十年中,三菱瓦斯化学公司持续优化和改进BT树脂的性能,特别是针对电子封装和高频应用的需求。通过对基础BT树脂的不断改性,该公司开发出了多种不同类型的BT树脂材料,以满足电子产品性能日益复杂的需求。到20世纪90年代末,三菱瓦斯化学已推出十几种不同品类的BT树脂产品,覆盖多个应用领域。
在日本、美国、欧洲等地区,BT树脂在高性能、高频电路用PCB的制造中得到了越来越广泛的应用。尤其是在过去两三年里,它已经成为全球范围内迅速崛起的高密度互连(HDI)技术中积层多层板(Build-Up Multilayer, BUM)和封装用基板的重要材料之一。BT树脂凭借其出色的电气性能、低损耗和高稳定性,特别适用于需要精密互连和高频传输的应用场景,推动了这些先进封装技术的发展,并成为电子行业中不可或缺的基础材料。
2. 增层材料—BT树脂
ABF胶膜(Ajinomoto Build-up Film)的起源可以追溯到20世纪90年代,由日本味之素公司开发,最初是为了应对半导体封装技术日益复杂的需求而诞生的。随着芯片集成度的提高,传统的PCB材料难以满足高密度互连(HDI)和微型化封装的要求。为解决这一问题,味之素利用其在化工领域的优势,开发出了一种专门用于IC载板制造的增层胶膜材料——ABF胶膜。
ABF材料的开发标志着半导体封装材料的一次重要技术突破。它不仅满足了更精细、更密集的电路互连需求,还具备良好的电气性能和热稳定性,适用于高速、高频信号的传输环境。这一材料的推出推动了积层多层板(BUM)和先进封装技术的快速发展,并迅速在全球半导体制造行业中获得广泛应用,成为IC封装中的关键材料之一。
这种胶膜材料通常被应用于IC载板的增层工艺中,通过半加成法(SAP)或改良半加成法(mSAP)将其压合在芯板上,形成精细的导线图形,支持更密集的互连布局。随着芯片封装的复杂性不断增加,ABF材料在满足高密度和高性能需求方面发挥着至关重要的作用,已成为现代高端封装技术的标准材料之一。
三.工艺制备(增层SAP)介绍
有机IC载板是一种采用半加成法(SAP)工艺的封装基板,通过在增层胶膜上构建电子线路。增层胶膜的一个显著特点是其不含玻纤成分,这种设计使得它在制造高精细度电子线路方面表现优异。由于没有玻纤的干扰,增层胶膜能够更好地适应微小电路结构的需求,确保信号传输的可靠性和一致性。
此外,增层胶膜封装基板的另一个重要优势在于其叠层技术的应用。这种技术使得制造多层线路板成为可能,从而在有限的空间内实现高密度互连,满足现代电子设备对小型化和高性能的要求。通过精确的层叠设计,增层胶膜可以支持多层电路的集成,极大地提升了电路板的功能密度和性能[2]。
通过这些技术和工艺的结合,有机IC载板在高端封装领域中扮演着至关重要的角色,为现代电子产品提供了强大的支持。随着技术的不断进步,有机IC载板的应用前景将更加广泛,成为推动电子行业发展的关键力量。
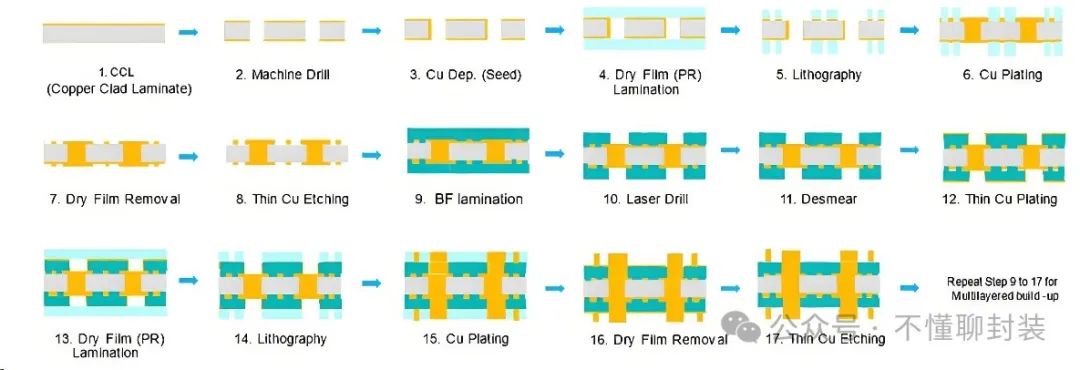
加工流程的核心包括多个关键步骤,每个环节都至关重要,以确保最终产品的高质量和可靠性。
真空压合:首先,将增层胶膜与芯板进行真空压合。此步骤需要在特定的温度和压力下进行,以确保两者的紧密结合。通常会使用热压机,在精确控制的条件下使增层胶膜与芯板充分融合,形成稳定的基础结构。良好的层压质量对后续工艺的成功至关重要。
激光钻孔:紧接着,通过激光钻孔技术形成微孔。此过程利用高能激光束精确打孔,能够在不损伤材料的情况下实现微米级的孔径。关键在于激光的焦点控制和移动速度,确保孔的直径和位置精确,且孔壁光滑,为后续的化学处理打下良好基础。
除胶渣:钻孔后,进行除胶渣,以清洁孔壁。这一步骤通常使用化学溶剂或超声波清洗,确保孔内无任何残留物。残留物不仅会影响导电性,还可能导致电路缺陷,因此彻底清洁至关重要。
种子层形成:接下来,通过化学镀铜或溅射技术形成导电的种子层。这个过程要求对化学药水的浓度、温度和反应时间进行严格监控,以实现均匀的镀层厚度。种子层的质量直接影响后续电镀的效果,是确保良好导电性能的基础。
电镀加厚:然后,进行电镀工艺对线路进行加厚,并填充激光钻孔形成的微孔。电镀过程中,必须控制电流密度和时间,以确保电镀层的均匀性和厚度。这一步骤至关重要,确保导电路径的完整性,同时提供足够的机械强度。
干膜移除:接下来,移除干膜,清除多余的材料。此步骤通常通过化学溶剂进行,目的是去掉覆盖在电路上的保护膜,以露出电镀完成的导电线路,确保电路的清晰和准确。
闪蚀:最后,通过闪蚀去除多余的种子层。闪蚀是一种选择性去除技术,使用适当的化学药水,仅去除未被电镀覆盖的种子层。这一步骤确保电路的纯净度,同时提升产品的电气性能。
整个过程中,关键的挑战在于精确控制每个步骤的化学药水及工艺参数,确保形成高精度的导电互连线路,特别是在种子层的形成和微孔填充过程中。工艺必须高度精确,以确保电气性能和结构完整性。由于这些特点,该封装基板技术在先进封装领域具有广泛的应用,尤其适用于高密度封装需求,如高性能计算、5G通信和人工智能设备等领域,推动着电子产品向更高性能和更小型化的方向发展。
四.国内发展的特点
1. 产业链高度集中,公司间关系稳定且紧密
有机封装基板的产能集中度远高于其他类型的印制电路板(PCB)。全球约80%的市场份额由日本、韩国和中国台湾地区的前十大有机封装基板生产商占据,展现出明显的规模优势。相比之下,中国大陆目前只有华南地区的少数几家公司具备相对简单的封装基板生产技术。
最终采购需求主要集中在高通、三星、苹果、小米和联发科等大型科技公司。这些公司由于订购数量庞大且交期集中,通常采用包产方式进行采购,以确保供应的稳定性。该行业对供应商资质要求极高,尤其是在产品质量和交期方面,认证过程复杂且耗时。例如,三星的供应商认证周期长达24个月。一旦供应商通过认证,企业通常不会轻易更换合作伙伴。
从产业链关系来看,相当一部分的有机封装基板巨头源自集成电路设计或封测行业,体现了垂直整合的特点。例如,矽品科技通过其封测业务拓展了全懋科技,进入有机封装基板市场;联电科技则通过欣兴科技在这一领域展开业务。而南亚与景硕则来自其他行业背景。
2. 尽管技术发展迅速,但基板材料仍处于垄断状态
有机封装基板在技术特征、工艺方法以及产品形态上,具备多种技术发展路线。其关键技术特征在于对线宽和线距(L/S)的把控。目前,有机封装基板的典型线宽和线距达到15 μm/15 μm级别,而传统的“板级”印制电路板(PCB)的线宽和线距则为30 μm/30 μm级别之间。为了满足更高密度的芯片封装需求,出现了一种介于二者之间的新产品形态——类载板(SLP),其线宽和线距小于30 μm/30 μm,特别适用于芯片封装。
在工艺方法方面,有机封装基板的发展趋势呈现出减成蚀刻法、半加成法(SAP)和改良半加成法(mSAP)共同应用的趋势。这些工艺方法不断改进,不仅使引线扇出更加精细、导线间距更加密集,还减少了产品所需的层压次数,提高了生产效率。
在产品形态方面,为了应对晶圆扇出封装技术(InFo-WLP)带来的潜在价值链转移和产业链整合,有机封装基板生产商逐渐从传统的标准芯片级封装(CSP)和焊球阵列(BGA)等产品形态,转向开发更具前景的三维嵌入式基板产品。这种三维嵌入技术不仅能提升封装密度,还能增强产品的整体性能。
尽管工艺技术在不断进化,但大多数刚性有机封装基板仍主要依赖几种关键基材,尤其是双马来酞亚胺三嗪树脂(BT树脂)和增层胶膜(ABF)材料。这些材料由少数几家日本公司垄断,如三菱瓦斯和昭和电工掌握的BT树脂,以及味之素公司掌握的ABF胶膜。由于这些材料经过多年测试和迭代,与客户的生产工艺高度匹配,因此在市场上具有较强的垄断性。
3. 企业和行业发展的关键是稳定的供应和用户联系
从当前行业现状来看,有机封装基板的发展面临着两大主要障碍:高技术难度和材料壁垒。由于这些基板的生产和应用需要较高的专业技术,许多潜在客户在初始阶段难以进入市场,这使得行业内竞争格局变得复杂且高度集中。
这一现状说明了封装基板发展必须依赖于两个关键因素:一方面,需要建立广泛的客户基础,以确保产品的市场需求和应用场景;另一方面,稳定的材料供应同样至关重要,材料供应链的可靠性直接影响到生产效率和产品质量。这意味着行业参与者不仅要关注与下游客户的紧密联系,还需要积极整合上游材料供应商,以保障原材料的及时供应和技术支持。
一旦企业能够成功构建起稳定的上下游关系,将有助于降低市场风险,并增强行业的整体竞争力。在我国集成电路快速发展的背景下,有机封装基板的发展潜力巨大,有望再现中低端印制电路板在历史上的快速崛起。因此,行业各方应共同努力,打破现有的技术壁垒和材料限制,以推动有机封装基板的创新与应用,为未来的市场增长奠定坚实基础[3]。
-
集成电路
+关注
关注
5396文章
11643浏览量
363700 -
半导体
+关注
关注
335文章
27826浏览量
223839 -
封装
+关注
关注
127文章
8033浏览量
143534 -
IC载板
+关注
关注
5文章
54浏览量
15913
原文标题:高密度IC载板全解读:从材料选择到技术优势,一文看懂
文章出处:【微信号:深圳市赛姆烯金科技有限公司,微信公众号:深圳市赛姆烯金科技有限公司】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
相关推荐
器件高密度BGA封装设计
高密度印制电路板(HDI)简介
探讨高密度小间距LED屏工艺
高密度PCB(HDI)检验标准
高密度印制电路板(HDI),高密度印制电路板(HDI)是什么
指导分享高密度光纤配线架安装方法
高密度光纤配线架值得冲吗





 详细解读高密度IC载板
详细解读高密度IC载板
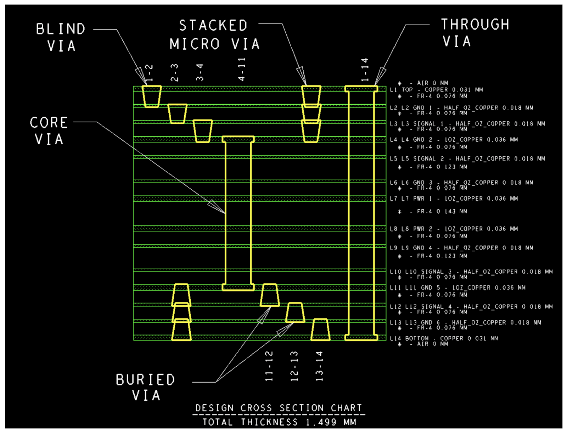













评论