晶圆键合是十分重要的一步工艺,本文对其详细介绍。
什么是晶圆键合胶?
晶圆键合胶(wafer bonding adhesive)是一种用于将两个晶圆永久性或临时地粘接在一起的胶黏材料。
怎么键合与解键合?
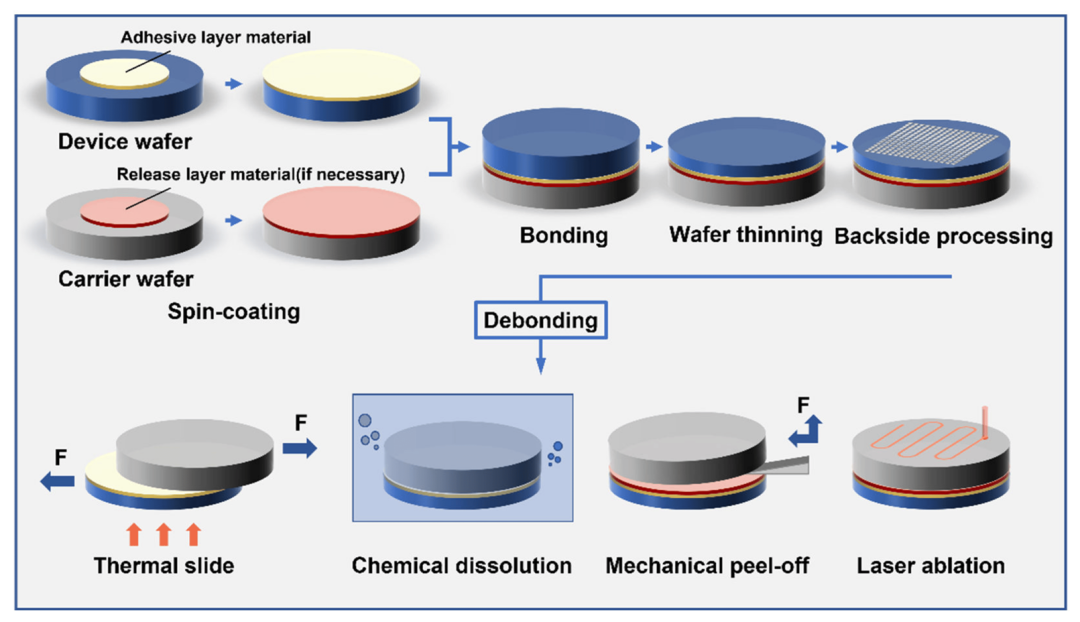
如上图,键合过程:
1.清洁和处理待键合晶圆表面。
2.将两个待键合的晶圆对准并贴合在一起。
3.施加压力和温度,促进键合胶之间的粘接。
4.继续保温,使键合材料达到最佳粘接强度。
解键合过程,有四种方案:
1,热解键合:一种是高温失去黏性,另一种是高温将键合胶融化,再施加一个平移力,使其滑动分离
2,化学药水溶解:利用化学药剂溶解键合胶
3,机械剥离,利用机械力将两片晶圆分离
4,激光解键合:用激光照射晶圆键合胶,激光能量被粘合剂材料吸收,导致局部温度急剧升高,键合胶被破坏而使两片晶圆分离。
目前,12寸的先进封装厂,用激光解键合的方式较为普遍。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
原文标题:晶圆键合胶如何进行键合与解键合的?
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
相关推荐
生电子共享或原子的相互扩散,从而使两种金属间实现原子量级上的键合。图1在IC封装中,芯片和引线框架(基板)的连接为电源和信号的分配提供了电路连接。有三种方式实现内部连
![的头像]() 发表于
发表于 01-06 12:24
•216次阅读

引线键合 引线键合,又称压焊,是半导体封装工艺中的关键环节,对封装的可靠性和最终产品的测试良率具有决定性影响。 以下是对引线键合的分述: 引线键合概述 引线
![的头像]() 发表于
发表于 01-02 10:18
•297次阅读

微流控芯片键合技术的重要性 微流控芯片的键合技术是实现其功能的关键步骤之一,特别是在密封技术方面。键合
![的头像]() 发表于
发表于 12-30 13:56
•131次阅读
去除晶圆键合边缘缺陷的方法主要包括以下几种:
一、化学气相淀积与平坦化工艺
方法概述:
提供待键合
![的头像]() 发表于
发表于 12-04 11:30
•330次阅读

一、超声键合辅助的多层键合技术 基于微导能阵列的超声键合多层键合技术: 在超声
![的头像]() 发表于
发表于 11-19 13:58
•234次阅读

潘明东 朱悦 杨阳 徐一飞 陈益新 (长电科技宿迁股份公司) 摘要: 铝带键合作为粗铝线键合的延伸和发展,键合焊点根部损伤影响了该工艺的发展
![的头像]() 发表于
发表于 11-01 11:08
•1583次阅读

晶圆键合技术是一种先进的半导体制造工艺,它通过将两块或多块晶圆在一定的工艺条件下紧密结合,形成一
![的头像]() 发表于
发表于 10-21 16:51
•664次阅读
DieBound芯片键合,是在封装基板上安装芯片的工艺方法。本文详细介绍一下几种主要的芯片键合的方法和工艺。什么是芯片键合在半导体工艺中,“
![的头像]() 发表于
发表于 09-20 08:04
•1033次阅读

金丝键合强度测试仪是测量引线键合强度,评估键合强度分布或测定键
![的头像]() 发表于
发表于 07-06 11:18
•743次阅读

发展空间较大。对半导体芯片键合装备进行了综述,具体包括主要组成机构和工作原理、关键技术、发展现状。半导体芯片键合装备的主要组成机构包括晶
![的头像]() 发表于
发表于 06-27 18:31
•1528次阅读

Luminex machines set a new standard when it comes to flexibility, cost-effectiveness, and throughput "临时键合和解键
![的头像]() 发表于
发表于 05-29 17:39
•587次阅读
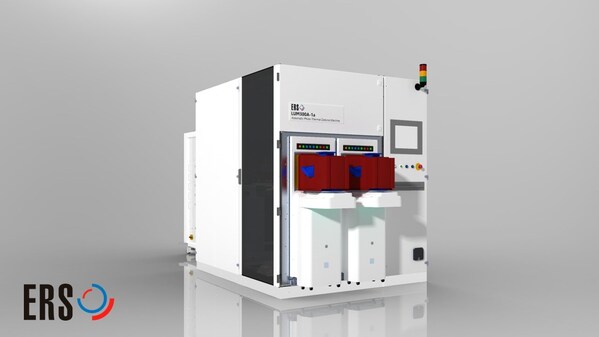
晶圆与载板分离。 当前,激光拆键合是主要的拆键合技术发展方向。激光拆
![的头像]() 发表于
发表于 03-26 00:23
•3067次阅读

共读好书 周岩 刘劲松 王松伟 彭庶瑶 彭晓飞 (沈阳理工大学 中国科学院金属研究所师昌绪先进材料创新中心江西蓝微电子科技有限公司) 摘要: 目前,键合铜丝因其价格低廉、具有优良的材料性能等特点
![的头像]() 发表于
发表于 02-22 10:41
•1325次阅读

芯片堆叠封装存在着4项挑战,分别为晶圆级对准精度、键合完整性、晶圆减薄与均匀性控制以及层内(层间
发表于 02-21 13:58
•5955次阅读

晶圆键合是一种将两片或多片半导体晶片通过特定的工艺条件,使其紧密结合并形成一个整体的技术。这种技术在微电子、光电子以及MEMS(微机电系统)等领域有着广泛的应用。
![的头像]() 发表于
发表于 02-21 09:48
•2159次阅读

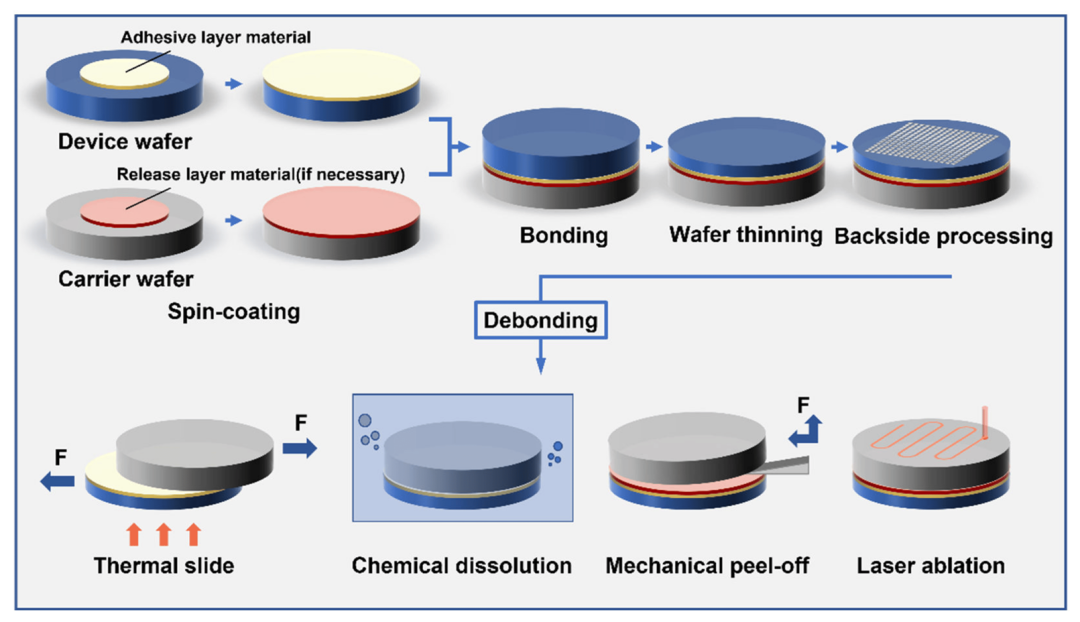


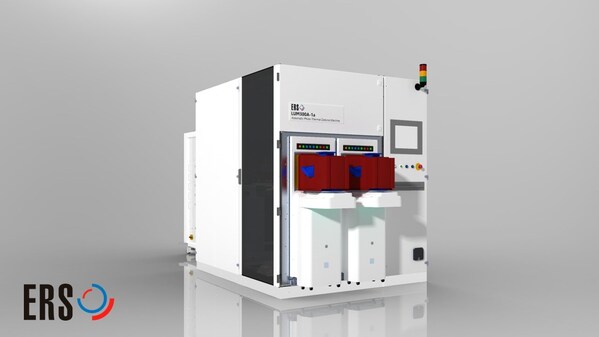






 晶圆键合胶的键合与解键合方式
晶圆键合胶的键合与解键合方式


















评论