离子轰击的不均匀性
干法刻蚀通常是物理作用和化学作用相结合的过程,其中离子轰击是重要的物理刻蚀手段。在刻蚀过程中,离子的入射角和能量分布可能不均匀. 如果离子入射角在侧壁的不同位置存在差异,那么离子对侧壁的刻蚀效果也会不同。在离子入射角较大的区域,离子对侧壁的刻蚀作用更强,会导致该区域的侧壁被刻蚀得更多,从而使侧壁产生弯曲。此外,离子能量的不均匀分布也会产生类似的效果,能量较高的离子能够更有效地去除材料,造成侧壁在不同位置的刻蚀程度不一致,进而引起侧壁弯曲 。
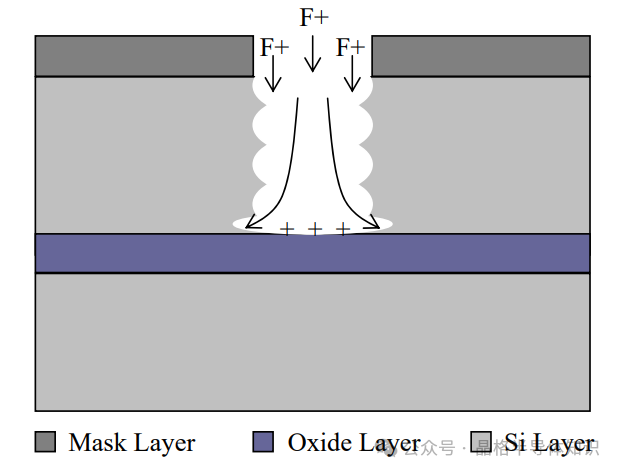
光刻胶的影响光刻胶在干法刻蚀中起着掩膜的作用,保护不需要被刻蚀的区域。然而,光刻胶在刻蚀过程中也会受到等离子体的轰击和化学反应的影响,其性能可能会发生变化. 如果光刻胶的厚度不均匀、在刻蚀过程中的消耗速率不一致,或者光刻胶与衬底之间的附着力在不同位置有所不同,都可能导致刻蚀过程中对侧壁的保护作用不均匀。例如,光刻胶较薄或附着力较弱的区域,可能会使下方的材料更容易被刻蚀,从而导致侧壁在这些位置出现弯曲 。
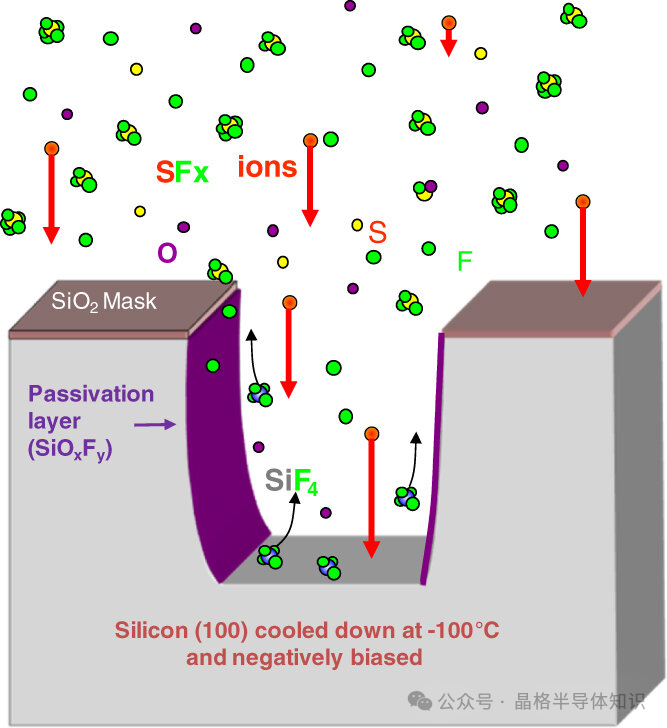
衬底材料特性的差异被刻蚀的衬底材料本身可能存在特性差异,如不同区域的晶体取向、掺杂浓度等可能不完全相同。这些差异会影响刻蚀速率和刻蚀选择性. 以晶体硅为例,不同晶向的硅原子排列方式不同,其与刻蚀气体的反应活性和刻蚀速率也会有所差异。在刻蚀过程中,这种由于材料特性差异导致的刻蚀速率不同,会使得侧壁在不同位置的刻蚀深度不一致,最终导致侧壁弯曲 。设备相关因素刻蚀设备的性能和状态对刻蚀结果也有重要影响。例如,反应腔内的等离子体分布不均匀、电极的不均匀磨损等问题,都可能导致刻蚀过程中离子密度、能量等参数在晶圆表面的分布不均匀. 此外,设备的温度控制不均匀、气体流量的微小波动等,也可能会影响刻蚀的均匀性,进而导致侧壁弯曲 。
-
光刻胶
+关注
关注
10文章
322浏览量
30452 -
刻蚀
+关注
关注
2文章
192浏览量
13221
原文标题:干法刻蚀时侧壁为什么会弯曲
文章出处:【微信号:wc_ysj,微信公众号:旺材芯片】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
相关推荐
干法刻蚀的概念、碳硅反应离子刻蚀以及ICP的应用

上海伯东IBE离子束刻蚀机介绍
半导体湿法和干法刻蚀
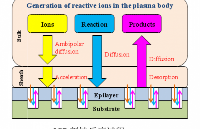
射频电源的功率与频率对刻蚀结果的影响
芯片制造中的湿法刻蚀和干法刻蚀

晶圆表面温度对干法刻蚀的影响

干法刻蚀工艺的不同参数
为什么干法刻蚀又叫低温等离子体刻蚀

半导体干法刻蚀技术解析





 干法刻蚀时侧壁为什么会弯曲
干法刻蚀时侧壁为什么会弯曲


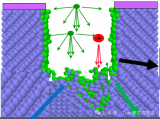
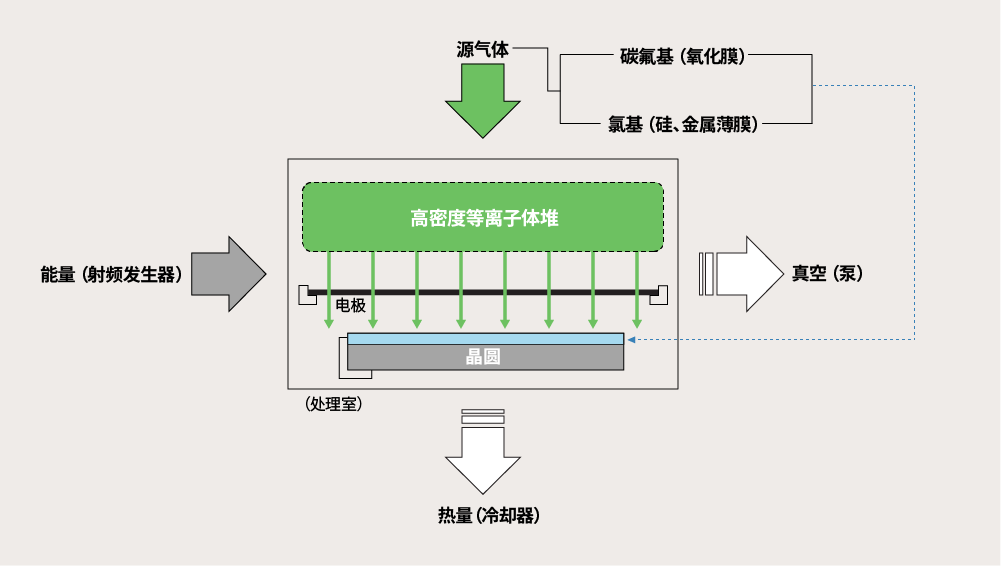
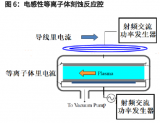











评论