以下文章来源于半导体产业研究,作者深芯盟产业研究部
一、光电共封CPO的演变与优势
光电封装技术经历了从传统铜缆到板上光学,再到2.5D和3D光电共封装的不断演进。这一发展历程展示了封装技术在集成度、互连路径和带宽设计上的持续突破。未来,光电共封技术将进一步朝着更高集成度、更短互连路径和更高带宽方向发展,为提升数据中心和高性能计算的能效与速度提供双重动力。

图源: Tian, W. et al., Micromachines, Progress in Research on Co-Packaged Optics, 2023.
图1 光电封装技术的演变历程
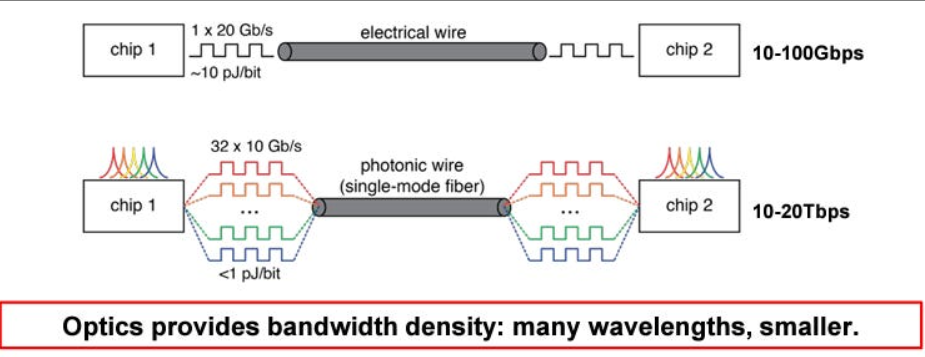
图源:SEMI VISION
图2 电线带宽与光子线带宽
图中显示,光子线通过多波长复用技术和小型化设计,大幅提升带宽密度,成为高性能数据传输的优选技术。电线提供 10 到 100 Gbps 的带宽,对应的能耗较高(~10 pJ/bit)。相比之下,光子线(如单模光纤)可实现10到20 Tbps的超高带宽,而能量消耗则大幅降低至不到1 pJ/bit。
二、玻璃基板CPO的未来
玻璃基板以其低损耗、高封装密度和光学透明性,成为CPO技术的关键驱动力,国内外企业正积极探索其在数据中心和人工智能领域的广泛应用。下表是光电共封领域硅基板和玻璃基板的关键特性对比:

表1硅基板与玻璃基板在光电共封装领域中的材料特性对比
玻璃作为载板在光电共封装中具有低电学损耗和光学透明性等优势,但目前玻璃基板的加工技术尚存挑战,如打孔、电镀与清洗工艺仍需优化,散热性能亦有提升空间。然而,未来通过改进玻璃材料特性、开发高精度波导加工技术、创新玻璃-金属复合方案以及优化散热设计和生产工艺,玻璃基板的潜力将得到充分释放。这将为光电共封装技术的高速、低功耗和高密度发展提供重要支撑,使玻璃基板成为未来封装领域的核心技术之一。
三、玻璃基板CPO集成芯片结构图
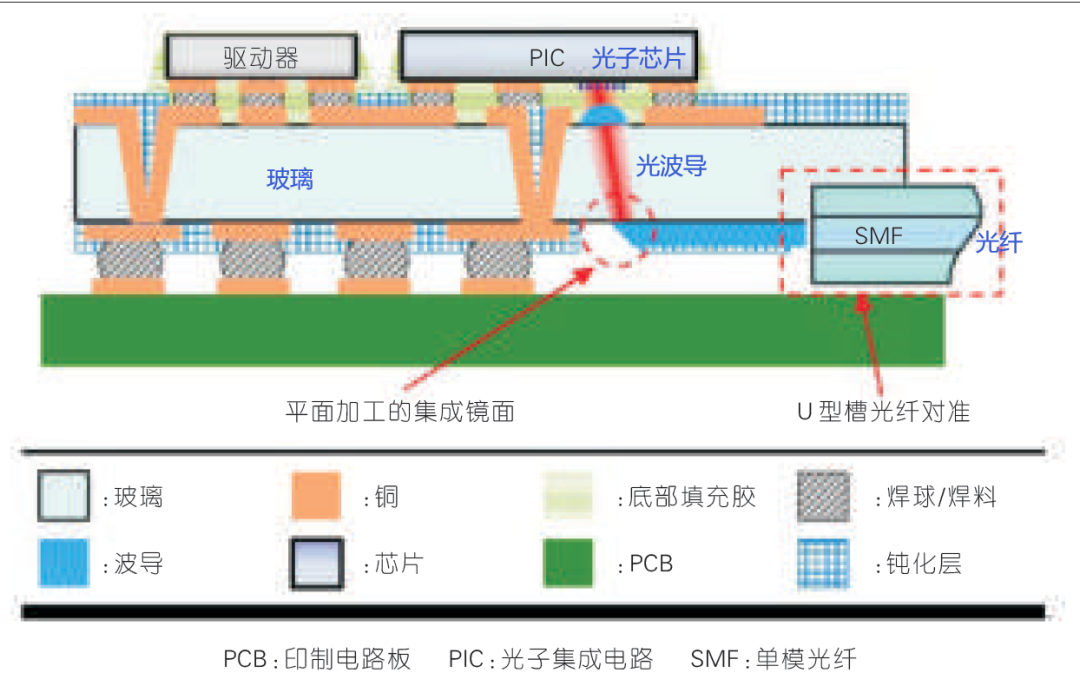
图源:CHOU B C, SATO Y, SUKUMARAN V, et al. "Modeling, Design, and Fabrication of Ultrahigh Bandwidth 3D Glass Photonics (3DGP) in Glass Interposers" [C]//2013 IEEE 63rd Electronic Components and Technology Conference (ECTC). USA: IEEE, 2013: 286-291. DOI: 10.1109/ECTC.2013.6575585.
图3 玻璃基板3D集成光波导封装示意图
佐治亚理工Bruce C. Chou等人提出了一种基于玻璃载板的光电混合封装方案,如图所示,此方案通过在玻璃载板中集成光波导实现光信号与电信号的高效耦合,驱动器、光子集成芯片(PIC)和跨阻放大器(TIA)倒装安装在玻璃基板表面,光信号通过有机透镜聚焦到玻璃基板背面的光波导中,再通过U型槽与单模光纤(SMF)对准耦合。电信号则通过玻璃基板中的金属通孔(TGV)引出,从而实现光电协同功能。
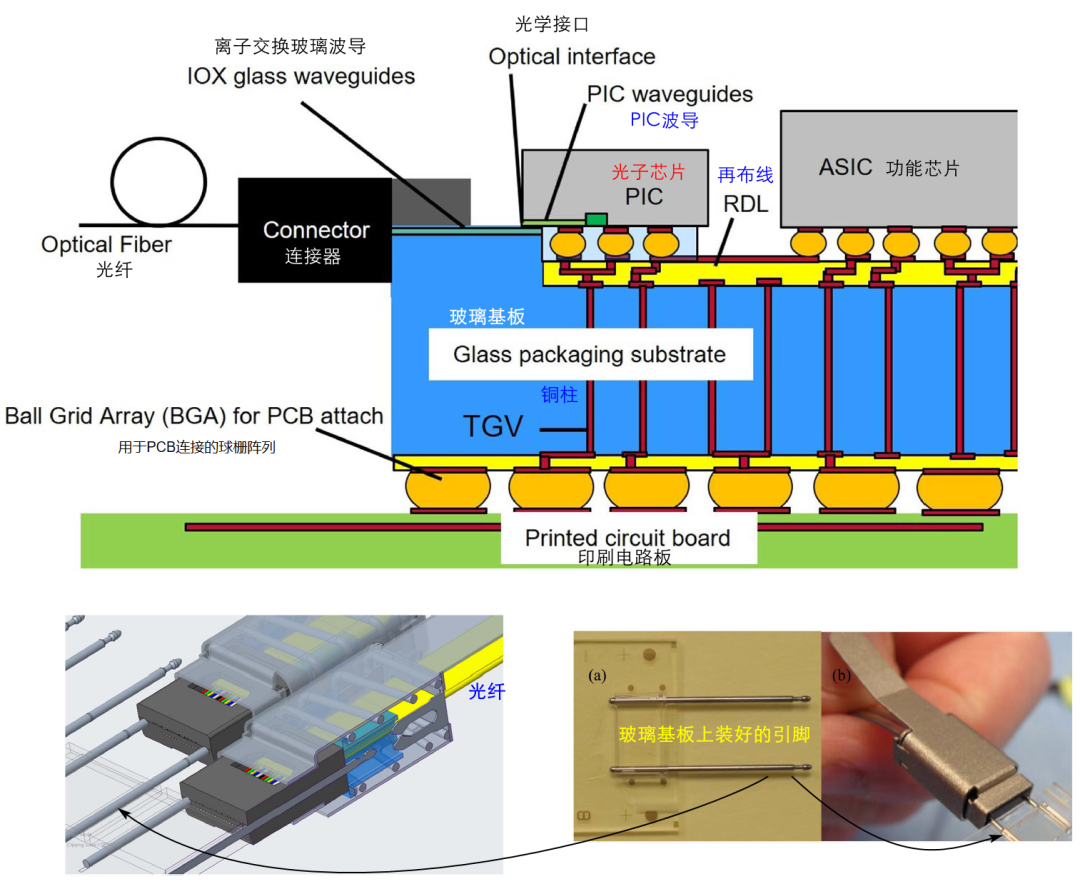
图源:Lars Brusberg et al., "Glass Platform for Co-Packaged Optics," IEEE Journal of Selected Topics in Quantum Electronics, Vol. 29, No. 3, May/June 2023.
图4 集成光波导芯片的TGV封装结构图与器件原型图
康宁公司Lars Brusberg 等人介绍了一种基于玻璃基板的 TGV 封装结构,其设计集成了顶层单面腔体与光波导芯片,以实现高效的光电互连。位于顶层单面腔体的玻璃基板中嵌入重布线层(RDLs),用于在功能芯粒与光子芯片之间提供高速电气通道。通过玻璃通孔(TGV)在基板内实现电路连接。TGV和RDLs使上层集成电路(ICs)与印刷电路板(PCB)之间实现了电气扇出。同时,通过腔体内的RDL重布线层与电气凸点将光子芯片PIC与离子交换玻璃IOX光波导的垂直距离最小化至1微米,确保低损耗连接。模型图展示了结合导向针的低外形光纤连接器,其设计实现了高精度对准和回流焊兼容性,为光电器件的低成本、高效率封装提供了示范。
四、国内外三家玻璃基板CPO落地项目分析
1. 英特尔的玻璃基板CPO芯片
英特尔不仅是首家成功开发并大规模生产硅光子连接产品的企业,更是以其卓越的产品可靠性,赢得了全球主要云服务提供商的信赖。目前,英特尔正在开发玻璃基板和光互连技术,以推动高性能计算和人工智能的未来发展。玻璃基板以高互连密度、优异的热稳定性和精确制造能力支持大规模芯片封装。光互连技术通过光计算互连模块实现低功耗(5 pJ/bit)、高带宽(4 Tbps)的数据传输,有效突破传统电气I/O瓶颈,广泛适用于数据中心和AI基础设施等场景。英特尔计划到2030年实现玻璃基板量产,并推进OCI模块的商业化落地。
2. 深光谷科技的高速光通信器件项目
在CIOE 2024展会上,深光谷科技展示了其在CPO光电集成互连领域的一系列创新成果,包括CPO光电集成互连interposer TGV/TSV芯片、3D波导光子互连芯片、多芯光纤扇入扇出器件以及模式复用器件等空分复用技术。其中,基于玻璃通孔光电转接(TGV Interposer)技术的CPO玻璃基interposer芯片成为全场亮点。这款芯片采用先进的混合封装技术,实现了晶圆与芯片的高效集成,其优异的性能已通过验证,展现出卓越的应用潜力。
深光谷科技董事长杜路平博士在接受媒体采访时指出,玻璃基interposer芯片的核心优势在于提供更宽的带宽和更低的制造成本。通过采用2.5D封装技术,该方案显著减小了产品体积,同时大幅提升了容量密度,为数据中心提供了高密度、大容量的光引擎解决方案,精准匹配未来算力行业对高性能存储的迫切需求。
3. 上交大无锡光芯研究院(CHIPX)的玻璃基板CPO项目
上海交通大学无锡光子芯片研究院(CHIPX)依托在薄膜铌酸锂(LNOI)光子芯片及飞秒激光直写3D光子芯片领域的技术优势,积极推进基于玻璃基板的CPO技术研发。研究院开发的玻璃芯基板(GCS)结合TGV技术,具备高密度、大面积、低损耗的光电封装优势。通过集成片上有源器件(TFT)与无源器件(IPD),CHIPX实现了光电融合计算、传感和互连,在CPO技术中突破多通道光耦合、高带宽电连接、封装散热和3D基板封装等技术难题。其创新设计显著提升数据传输效率和能效比,为AI和HPC提供强大支持,并在云计算、大数据分析和物联网领域展现广阔应用前景。CHIPX于2021年12月由上海交通大学、无锡市滨湖区政府及蠡园经济开发区共同成立。
国内企业在玻璃基板光电共封技术上已取得突破,但与英特尔等国际领先企业相比,仍存在一定的技术差距。特别是在光计算互连模块、低功耗数据传输及量产能力方面,国内企业需要进一步攻克技术壁垒。
五、国内企业玻璃基板光电封装探索
深光谷科技通过创新性的TGV技术和2.5D封装,推出了玻璃基interposer芯片及CPO光电集成互连产品,在CPO光电集成领域具有明显优势。其解决了高密度封装与高性能需求的矛盾,特别是在数据中心和AI基础设施市场展现了卓越的应用潜力。然而,其在技术专利布局、全球化推广以及规模化生产能力上仍需进一步突破。
上交大无锡光芯研究院(CHIPX)依托上海交通大学的科研实力,在玻璃基板光电共封领域构建了核心技术优势。通过开发玻璃芯基板(GCS)及结合TGV技术,其在高带宽电连接、多通道光耦合等方面实现了技术突破。但当前其技术转化路径尚未完全清晰,产业化推进速度较为缓慢,市场竞争力仍需提升。
目前,除深光谷科技和CHIPX外,国内企业如光迅科技、华工科技、天孚通信和中际旭创也在玻璃基板光电封装领域积极布局。光迅科技依托成熟的市场渠道与高校合作开展高密度封装研究;华工科技聚焦智能制造优化玻璃基板器件性能;天孚通信专注微型化与高可靠性光电互连模块开发;中际旭创在高速光模块中引入玻璃基板技术,不断强化核心专利布局。国内企业正通过多维创新推动光电共封技术发展。
结语
玻璃基板凭借其优异的电学性能、低信号传输损耗特性以及大规模制造潜力,正助力光电共封装芯片向更高带宽、更低功耗和更高封装密度方向发展,为光电集成领域实现关键技术突破奠定基础。尽管国内企业在技术积累和量产能力上与国际巨头存在差距,但通过持续创新和产业化布局,已展现出强劲的发展潜力。未来,随着玻璃基板加工技术和产业链协同能力的不断提升,国内企业有望在玻璃基板光电共封领域实现突破,为高性能计算和人工智能提供更强支撑。
-
玻璃基板
+关注
关注
1文章
106浏览量
11108 -
硅半导体
+关注
关注
0文章
36浏览量
8095 -
先进封装
+关注
关注
2文章
570浏览量
1074
原文标题:【先进封装】玻璃基板赋能光电共封(CPO)
文章出处:【微信号:深圳市赛姆烯金科技有限公司,微信公众号:深圳市赛姆烯金科技有限公司】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
CPO光电共封装如何破解数据中心“功耗-带宽”困局?
燧原科技联合曦智科技推出国内首款xPU-CPO光电共封芯片

光电共封装
【限免】光电CPO产业链齐聚杭州!参会名单&议程公布!2024光电合封CPO及异质集成大会9月27杭州论剑!
CPO技术加速未来数据中心网络发展
CPO模块电光同步贴装新方案——京瓷高精度无源对准技术解析




 光电共封装技术CPO的演变与优势
光电共封装技术CPO的演变与优势





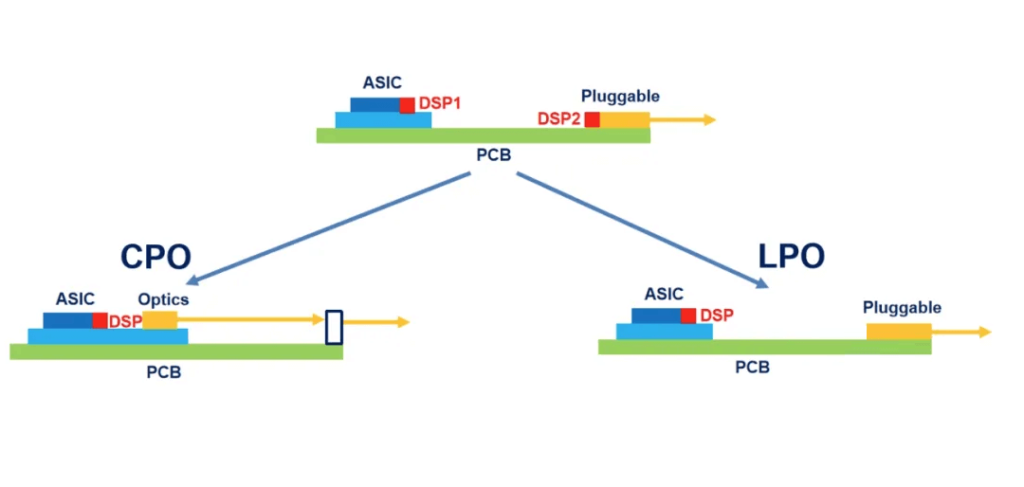
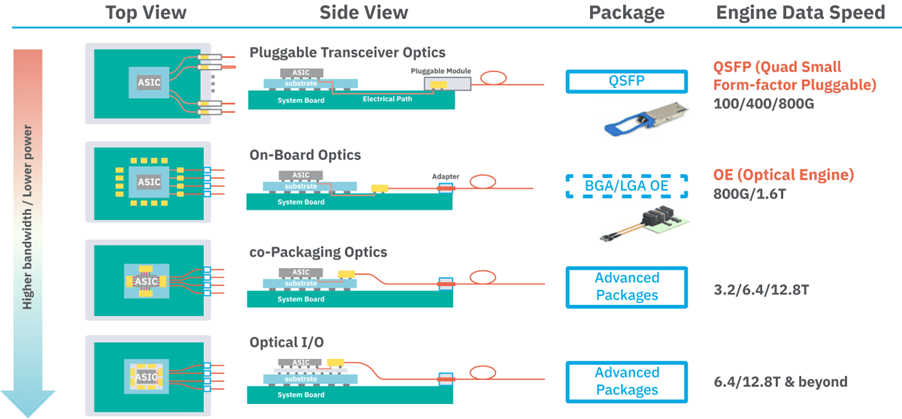



评论