来源:iSABers青禾晶元
近日,青禾晶元集团在天津滨海高新区创新创业园迎来了新厂房的开工仪式,这标志着公司迈入了规模化发展的新篇章。
开工仪式上,天津滨海高新区领导也莅临仪式现场,对青禾晶元过往的成就给予了高度评价,并对公司的未来发展充满了信心。
新厂房占地17000平方米,投资规模巨大,将被打造成为集生产、研发、测试于一体的半导体键合技术创新中心。项目建成投产后,预计年产先进半导体设备约100台套,年产值近15亿元。新厂房将满足W2W混合键合、C2W混合键合、倒装键合、超高真空常温键合、热压键合等多型号设备的同时生产需求。
作为半导体行业的佼佼者,青禾晶元一直在先进半导体键合集成技术领域深耕细作。公司在混合键合技术和C2W技术方面取得了显著突破。自主研发的12寸C2W和W2W键合机对准精度达到±50nm,键合后精度优于±100nm,性能已比肩国际龙头企业。这些技术不仅实现了芯片间的互联互通,显著提升了产品的集成度和可靠性,而且以更高的灵活性支持单独测试筛选优质芯片再进行键合,降低了整体缺陷率,同时支持异构集成,减少了材料浪费,降低了成本。
未来,青禾晶元将重点攻关2.5D/3D先进封装用键合设备,并计划推出更多高端产品,以满足市场不断升级的需求。
青禾晶元将继续秉承创新、务实、进取的精神,紧跟全球半导体产业发展趋势,不断推陈出新,满足市场多样化需求,并积极拓展国外市场,加强与海外客户的合作,将先进技术和产品推向世界舞台。同时携手国内半导体企业,共同推动中国半导体产业的崛起与繁荣。
-
芯片
+关注
关注
463文章
54463浏览量
469607 -
半导体
+关注
关注
339文章
31279浏览量
266712 -
键合
+关注
关注
0文章
107浏览量
8307
发布评论请先 登录
北方华创发布12英寸芯片对晶圆混合键合设备Qomola HPD30
大事件 | 桥田磁力换模产品全新厂房落成

详解先进封装中的混合键合技术




 青禾晶元新厂房开工,混合键合与C2W技术引领产业升级
青禾晶元新厂房开工,混合键合与C2W技术引领产业升级



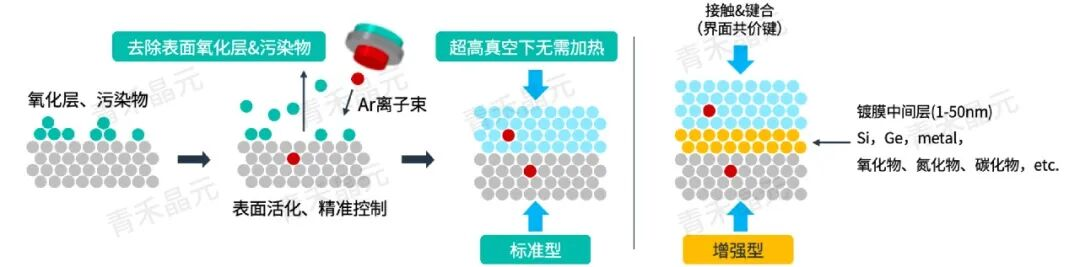







评论