


声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
plasma
+关注
关注
0文章
11浏览量
2335
原文标题:Plasma工艺介绍
文章出处:【微信号:深圳市赛姆烯金科技有限公司,微信公众号:深圳市赛姆烯金科技有限公司】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
相关推荐
热点推荐
NTC热敏芯片键合工艺介绍
随着半导体技术的持续创新及进步,NTC热敏芯片键合工艺也不断发展。目前,芯片键合工艺为顺应行业发展需求,正逐步往高度集成、低功耗、高可靠的方向前进。为了让大家更充分地了解NTC芯片键合工艺,EXSENSE为大家
芯片键合工艺技术介绍
在半导体封装工艺中,芯片键合(Die Bonding)是指将晶圆芯片固定到封装基板上的关键步骤。键合工艺可分为传统方法和先进方法:传统方法包括芯片键合(Die Bonding)和引线键合(Wire

SOI工艺技术介绍
在半导体行业持续追求更高性能、更低功耗的今天,一种名为“SOI(Silicon-On-Insulator)”的工艺技术逐渐成为行业焦点。无论是智能手机、自动驾驶汽车,还是卫星通信系统,SOI技术都在幕后扮演着关键角色。
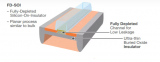
目前最先进的半导体工艺水平介绍
当前全球半导体工艺水平已进入纳米级突破阶段,各大厂商在制程节点、材料创新、封装技术和能效优化等方面展开激烈竞争。以下是目前最先进的半导体工艺水平的详细介绍: 一、制程工艺突破 英特尔1
晶圆部件清洗工艺介绍
晶圆部件清洗工艺是半导体制造中确保表面洁净度的关键环节,其核心在于通过多步骤、多技术的协同作用去除各类污染物。以下是该工艺的主要流程与技术要点:预处理阶段首先进行初步除尘,利用压缩空气或软毛刷清除

混合键合(Hybrid Bonding)工艺介绍
所谓混合键合(hybrid bonding),指的是将两片以上不相同的Wafer或Die通过金属互连的混合键合工艺,来实现三维集成,在Hybrid Bonding前,2D,2.5D及3D封装都是采用

混合键合工艺介绍
所谓混合键合(hybrid bonding),指的是将两片以上不相同的Wafer或Die通过金属互连的混合键合工艺,来实现三维集成,在Hybrid Bonding前,2D,2.5D及3D封装都是采用

等离子技术赋能电池生产,成就卓越性能
为粘合剂、涂料、镀层和密封剂创造完美的附着条件。仅需数秒的在线处理工艺,即可显著提升电池生产的质量、安全性和效率,助力可持续交通和储能解决方案的发展。 Openair-Plasma activation




 Plasma工艺介绍
Plasma工艺介绍





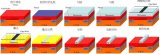




评论