文章来源:半导体与物理
原文作者:jjfly686
氮化钛(TiN)是一种具有金属光泽的陶瓷材料,其晶体结构为立方晶系,化学稳定性高、硬度大(莫氏硬度9-10)、熔点高达2950℃。在半导体领域,TiN展现出优异的导电性(电阻率约25 μΩ·cm)、抗腐蚀性和热稳定性,使其成为芯片制造中的关键材料。此外,TiN在紫外至深紫外波段(UV-DUV)具有高吸收系数(约10^5 cm⁻¹),远高于SiO₂或Al₂O₃等材料,这一特性使其在光刻工艺中发挥重要作用。
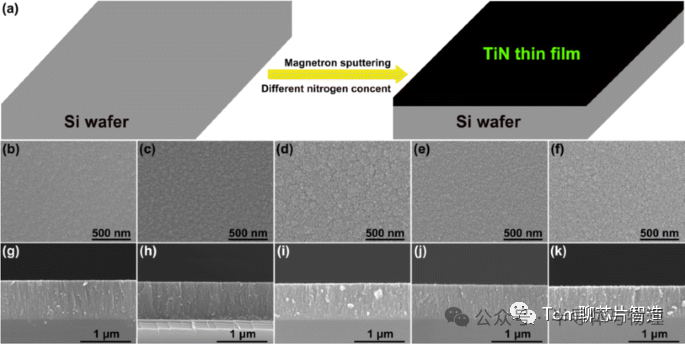
TiN的制造工艺与化学原料
1. 化学气相沉积(CVD)
利用前驱体气体(如四(二甲氨基)钛,TDMAT)在高温下分解,与NH₃或N₂反应生成TiN。

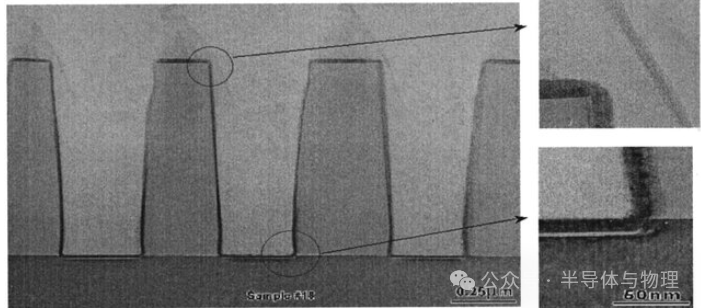
2. 原子层沉积(ALD)
原理:通过交替通入钛源(如TiCl₄)和氮源(如NH₃),逐层生长薄膜。
特点:精度高(可控制单原子层厚度),适合复杂三维结构,但沉积速率较慢。

TiN在芯片制造中的核心作用
1. 金属栅极的功函数调控
在先进制程中,TiN被用作高k金属栅极(High-k Metal Gate)的关键材料。其功函数约为4.7-5.1 eV,适合作为PMOS的栅极材料。通过掺杂铝(Al)或共溅射Al/Ti靶材,可调节TiN的功函数至硅导带附近(约4.1 eV),从而兼容NMOS需求。例如,铝的引入会改变TiN与栅介质界面的电子特性,使功函数向硅导带偏移,优化晶体管的阈值电压。
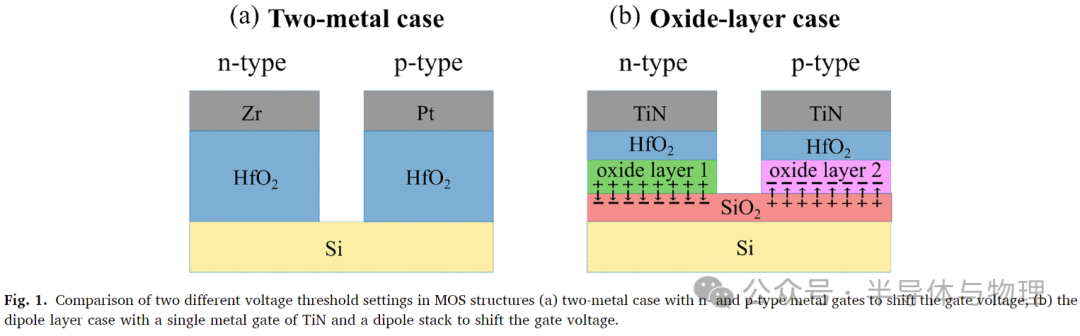
2. 阻挡层:防止金属扩散
TiN的致密结构可有效阻挡铜(Cu)或钨(W)等金属向硅衬底扩散。例如,在铜互连工艺中,TiN作为阻挡层沉积在SiO₂表面,避免铜原子渗透导致器件失效。实验表明,10 nm厚的TiN层即可将铜扩散速率降低至可忽略水平。
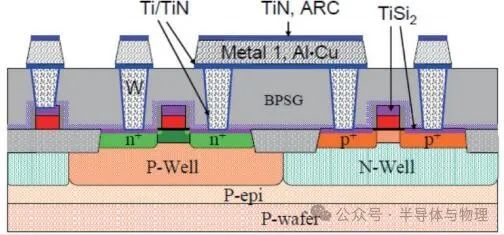
3. 光刻抗反射层(ARC)
在光刻工艺中,TiN的高吸收系数可减少基底反射光引起的驻波效应,提升图案精度。例如,在DUV光刻中,TiN抗反射层可将反射率从30%降至5%以下,确保曝光图形的边缘清晰。
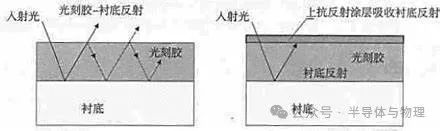
4. 黏附层与蚀刻阻挡层
TiN可增强不同材料间的黏附力,如铜与SiO₂的结合。此外,在钨栅极蚀刻工艺中,TiN作为蚀刻阻挡层,防止蚀刻剂(如SF₆/Cl₂)穿透至下方的栅极氧化物,保护器件结构完整性。
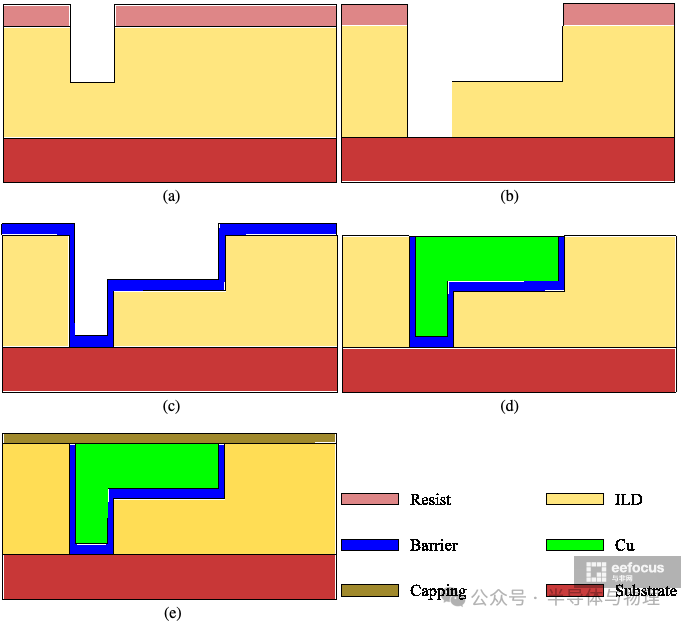
TiN在金属栅极叠层中的应用
以28 nm以下制程的FinFET为例,TiN的应用流程如下:
虚拟栅极去除:通过化学机械抛光(CMP)暴露多晶硅虚拟栅极,并刻蚀形成沟槽。
高k介质沉积:在沟槽内沉积HfO₂等高k介质层。
TiN沉积:采用ALD或PVD工艺沉积TiN作为功函数层。
钨填充:在TiN上沉积钨作为导电层,TiN在此过程中同步发挥阻挡层作用,防止钨扩散。
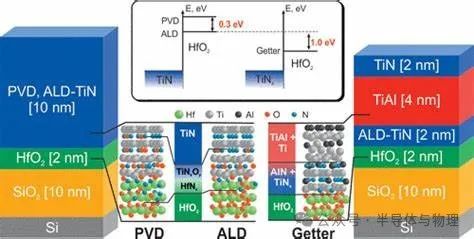
-
半导体
+关注
关注
335文章
28071浏览量
226136 -
芯片制造
+关注
关注
10文章
650浏览量
29143 -
陶瓷材料
+关注
关注
0文章
42浏览量
10126
原文标题:芯片制造中的氮化钛(TiN)
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
相关推荐




 氮化钛在芯片制造中的重要作用
氮化钛在芯片制造中的重要作用

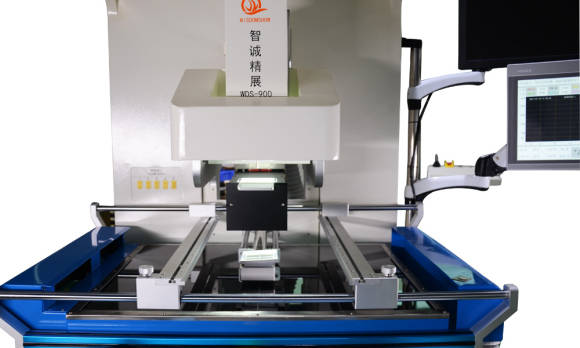















评论