新型键合材料对于在高级半导体制造工艺中保持超薄晶圆的完整性至关重要。有了新型材料的配合,临时键合在晶圆减薄工艺中愈发成为可能。
随着半导体晶圆制程对缩小特征尺寸和引入全尺寸3D集成需求高涨,晶圆越来越薄。虽然现在已经有了将晶圆减薄至低于100微米的工艺,但获得更薄晶圆(<50 μm)的代价却是令它们变得极度脆弱,因为深度的减薄工艺和后端的金属化工艺会给超薄晶圆施加额外应力,从而导致翘曲或断裂。
晶圆减薄工艺包括用聚合物键合材料,将器件晶圆暂时接合到承载晶圆上,并通过苛刻的后端稳定晶圆工艺来支撑超薄的器件衬底。至于剥离技术,三种主流的剥离晶片衬底的方法有:热滑动剥离、机械剥离和激光剥离,其中发展最迅速的为后两种剥离技术。
下表整理了三种剥离方法的主要特性:

热滑动剥离、机械剥离和激光剥离法正成为下一代超薄半导体晶圆的关键推动力。三种方法各有优势,技术工艺也在不断取得进步,为先进封装应用领域带来创新推动力。下一代超薄晶圆制造业中,临时键合正在飞速发展,这些剥离方法也将在半导体行业得到更多的应用。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
相关推荐
→ Pre-treatment →back metal 即贴胶纸→减薄→硅刻蚀→撕胶纸→前处理→背面金属化 1,tape 在晶圆正面贴上上图所示的蓝色胶带,保护
![的头像]() 发表于
发表于 02-12 09:33
•207次阅读

在半导体制造的复杂流程中,晶圆历经前道工序完成芯片制备后,划片工艺成为将芯片从晶圆上分离的关键环
![的头像]() 发表于
发表于 02-07 09:41
•683次阅读

,满足晶圆的翘曲度的要求。但封装的时候则是薄一点更好,所以要处理到100~200um左右的厚度,就要用到减薄
![的头像]() 发表于
发表于 12-24 17:58
•619次阅读
工艺中常用的材料包括:
芯片粘结剂:作为浆料涂覆到晶圆背面,之后再烘干。采用这种方法,成本较低,同时可以控制键合层厚度并且提高单位时间产量。
WBC胶水:其成分
![的头像]() 发表于
发表于 12-19 09:54
•453次阅读

基于石英玻璃外延GaN的工艺改进方法主要包括以下几个方面:
一、晶圆片制备优化
多次减薄处理:
采用不同材料的浆液和磨盘对石英玻璃进行多次
![的头像]() 发表于
发表于 12-06 14:11
•420次阅读

去除晶圆键合边缘缺陷的方法主要包括以下几种:
一、化学气相淀积与平坦化工艺
方法概述:
提供待键合的晶
![的头像]() 发表于
发表于 12-04 11:30
•399次阅读

将两个晶圆永久性或临时地粘接在一起的胶黏材料。 怎么键合与解键合? 如上图,键合过程: 1.清洁
![的头像]() 发表于
发表于 11-14 17:04
•1085次阅读

近日,武汉芯丰精密科技有限公司宣布,其自主研发的第二台12寸超精密晶圆减薄机已成功交付客户。这一里程碑事件标志着芯丰精密在高端晶
![的头像]() 发表于
发表于 10-28 17:18
•706次阅读
晶圆键合技术是一种先进的半导体制造工艺,它通过将两块或多块晶圆在一定的
![的头像]() 发表于
发表于 10-21 16:51
•882次阅读
电子发烧友网站提供《2.5薄型晶圆组件90°弯曲.pdf》资料免费下载
发表于 09-03 14:21
•0次下载
在本系列第七篇文章中,介绍了晶圆级封装的基本流程。本篇文章将侧重介绍不同晶圆级封装方法所涉及的各项工艺。
![的头像]() 发表于
发表于 08-21 15:10
•2175次阅读

近日,国内领先的半导体设备制造商晶盛机电传来振奋人心的消息,其自主研发的新型WGP12T减薄抛光设备成功攻克了12英寸晶圆
![的头像]() 发表于
发表于 08-12 15:10
•836次阅读
Luminex machines set a new standard when it comes to flexibility, cost-effectiveness, and throughput "临时键合和解键合是基板
![的头像]() 发表于
发表于 05-29 17:39
•630次阅读
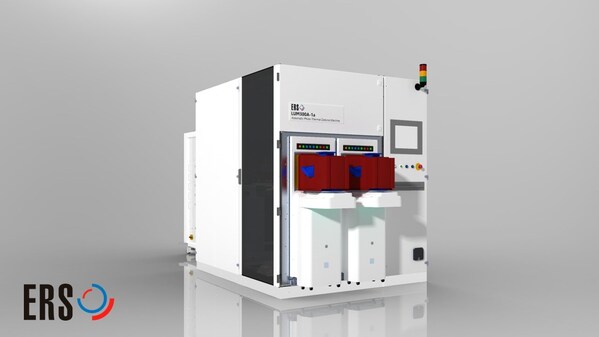
的容量和功能。在过去的几十年中,基于薄晶圆 ( 通常厚度小于 100 μm) 的硅穿孔(Through-Silicon Via,TSV) 技术已经实现了 3D-IC 封装。但是由于薄
![的头像]() 发表于
发表于 03-29 08:37
•1401次阅读
晶圆与载板分离。 当前,激光拆键合是主要的拆键合技术发展方向。激光拆键合技术是将临时
![的头像]() 发表于
发表于 03-26 00:23
•3178次阅读


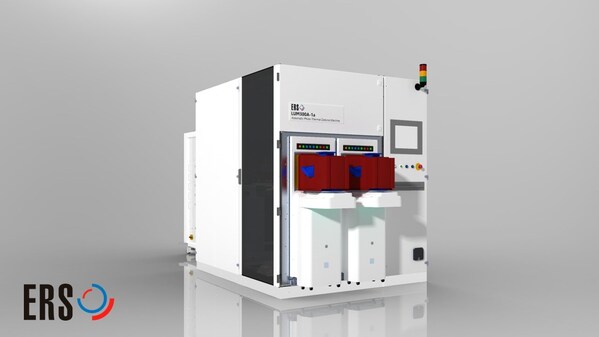




 临时键合在晶圆减薄工艺中将愈发成为可能
临时键合在晶圆减薄工艺中将愈发成为可能
















评论