台积电一条龙布局再突破,完成全球首颗3D IC封装技术,预计2021年量产。业界认为,台积电3D IC封装技术主要为未来苹果新世代处理器导入5纳米以下先进制程,整合人工智能(AI)与新型存储器的异质芯片预作准备,有望持续独揽苹果大单。
台积电向来不评论接单与客户状况。业界认为,台积电正式揭露3D IC封装迈入量产时程,意味全球芯片后段封装进入真正的3D新纪元,台积电掌握先进制程优势后,结合先进后段封装技术,对未来接单更具优势,将持续维持业界领先地位。
先进封装近来被视为延伸摩尔定律的利器,透过芯片堆叠,大幅提升芯片功能。台积电这几年推出的CoWoS及整合扇出型封装(InFO),就是因应客户希望一次到位,提供从芯片制造到后段封装的整合服务。
台积电强调,CoWoS及整合扇出型封装(InFO)仍是2.5D IC封装,为了让芯片效能更强,芯片业花了相当的时间,开发体积小、功能更复杂的3D IC,这项技术需搭配难度更高的矽钻孔(TSV)技术,以及晶圆薄化、导电材质填孔、晶圆连接及散热支持。
尽管台积电未透露合作开发对象,业界认为,3D IC封装技术层次非常高,主要用来整合最先进的处理器、数据芯片、高频存储器、CMOS影像感应器与微机电系统(MEMS),一般需要这种技术的公司,多是国际知名系统厂。以台积电技术开发蓝图研判,苹果应该是首家导入3D IC封装技术的客户。
-
台积电
+关注
关注
44文章
5712浏览量
167384 -
苹果
+关注
关注
61文章
24504浏览量
201002
原文标题:台积电完成全球首颗3D IC封装技术,苹果或是首个客户
文章出处:【微信号:xinlun99,微信公众号:芯论】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
相关推荐
消息称台积电完成CPO与先进封装技术整合,预计明年有望送样
西门子扩大与台积电合作推动IC和系统设计
台积电封装,新规划
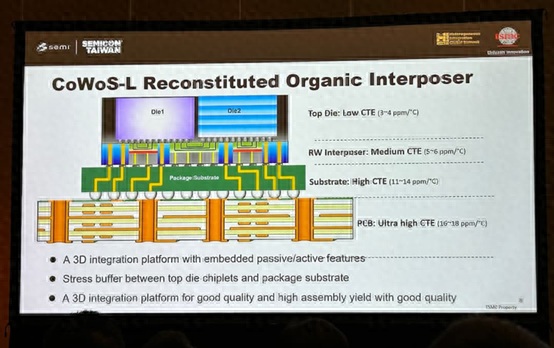




 台积电完成全球首颗3D IC封装技术,有望持续独揽苹果大单
台积电完成全球首颗3D IC封装技术,有望持续独揽苹果大单













评论