台积电此次揭露 3D IC 封装技术成功,正揭开半导体工艺的新世代。目前业界认为,此技术主要为是为了应用在5纳米以下先进工艺,并为客制化异质芯片铺路,当然也更加巩固苹果订单。
台积电近几年推出的 CoWoS 架构及整合扇出型封状等原本就是为了透过芯片堆栈摸索后摩尔定律时代的路线,而真正的3D封装技术的出现,更加强化了台积电垂直整合服务的竞争力。尤其未来异质芯片整合将会是趋势,将处理器、数据芯片、高频内存、CMOS 影像传感器与微机电系统等整合在一起。
台积电强调,CoWoS及整合扇出型封装(InFO)仍是2.5D IC封装,为了让芯片效能更强,芯片业花了相当的时间,开发体积小、功能更复杂的3D IC,这项技术需搭配难度更高的矽钻孔(TSV)技术,以及晶圆薄化、导电材质填孔、晶圆连接及散热支持。
封装不同工艺的芯片将会是很大的市场需求,半导体供应链的串联势在必行。所以令台积电也积极投入后端的半导体封装技术,预计日月光、矽品等封测大厂也会加速布建3DIC封装的技术和产能。不过这也并不是容易的技术,需搭配难度更高的工艺,如硅钻孔技术、晶圆薄化、导电材质填孔、晶圆连接及散热支持等,将进入新的技术资本竞赛。
台积电总裁魏哲家表示,尽管半导体处于淡季,但看好高性能运算领域的强劲需求,且台积电客户组合将趋向多元化。不过目前台积电的主要动能仍来自于 7 纳米工艺,2020年6纳米才开始试产,3D封装等先进技术届时应该还只有少数客户会采用,业界猜测苹果手机处理器应该仍是首先引进最新工艺的订单。更进一步的消息,要等到5月份台积大会时才会公布。
-
传感器
+关注
关注
2554文章
51681浏览量
758419 -
芯片
+关注
关注
458文章
51516浏览量
429415 -
台积电
+关注
关注
44文章
5712浏览量
167384
原文标题:台积电完成全球首颗 3D IC 封装,预计明年量产
文章出处:【微信号:WW_CGQJS,微信公众号:传感器技术】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
相关推荐
消息称台积电完成CPO与先进封装技术整合,预计明年有望送样
西门子扩大与台积电合作推动IC和系统设计
台积电封装,新规划
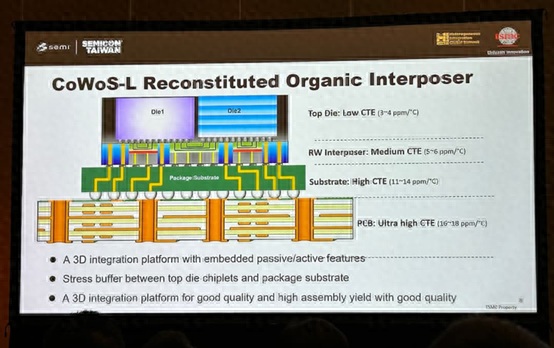




 台积电完成全球首颗 3D IC 封装
台积电完成全球首颗 3D IC 封装













评论